6月11日消息,據(jù)韓國(guó)媒體Thelec報(bào)道,三星上個(gè)月在2024年IEEE上發(fā)表的一篇題為《用于HBM堆疊的D2W(芯粒到芯片)銅鍵合技術(shù)研究》的論文,提到16層及以上的高帶寬內(nèi)存(HBM)必須采用混合鍵合技術(shù)(Hybrid bonding)。
據(jù)了解,混合鍵合是下一代封裝技術(shù),目的是芯片透過(guò)硅穿孔(TSV)或微型銅線進(jìn)行垂直堆疊時(shí),中間沒有凸點(diǎn)。韓媒The Elec指出,由于是直接堆疊,所以混合鍵合也稱為“直接鍵合”。
與目前三星所使用的熱壓焊接(TC)相比,Hybrid bonding可焊接更多芯片堆疊,維持更低的堆疊高度并提高熱排放效率。三星指出,降低高度是采用混合鍵合的主因,內(nèi)存高度限制在775微米內(nèi),在這高度中須封裝17個(gè)芯片(即一個(gè)基底芯片和16個(gè)核心芯片),因此縮小芯片間的間隙,是內(nèi)存大廠必須克服的問(wèn)題。
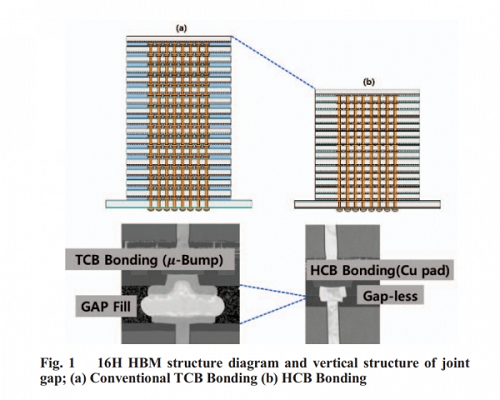
最開始DRAM大廠計(jì)劃盡可能減少核心芯片的厚度,或者減少凸點(diǎn)間距,但除混合鍵合外,這兩種方法都已達(dá)極限。知情人士透露,很難將核心芯片做得比30微米更薄。由于凸點(diǎn)具有體積,通過(guò)凸塊連接芯片會(huì)有一定局限性。
三星4月使用子公司Semes的混合鍵合設(shè)備制作了16層的HBM樣品,并表示芯片運(yùn)作正常。目前貝思半導(dǎo)體(BESI)和韓華精密機(jī)械(Hanwha Precision Machinery)也在開發(fā)混合鍵合設(shè)備。傳聞三星計(jì)劃在2025年制造出16層堆疊的HBM4樣品,并于2026年量產(chǎn)。


