在AI、HPC的催化下,先進(jìn)封裝擁有更小I/O間距和更高密度的RDL線間距。全球大廠無(wú)不更新迭代更先進(jìn)的制造設(shè)備以實(shí)現(xiàn)更密集的I/O接口和更精密的電氣連接,設(shè)計(jì)更高集成、更高性能和更低功耗的產(chǎn)品,從而鎖定更多的市場(chǎng)份額。
化學(xué)濕制程、電鍍及自動(dòng)化設(shè)備領(lǐng)導(dǎo)供應(yīng)商Manz亞智科技,以RDL不斷精進(jìn)的工藝布局半導(dǎo)體封裝市場(chǎng)。日前,Manz擴(kuò)大RDL 研發(fā)版圖,聚焦于高密度的玻璃通孔及內(nèi)接導(dǎo)線金屬化工藝,并將技術(shù)應(yīng)用于下一代半導(dǎo)體封裝的TGV玻璃芯基材,能夠達(dá)到更高的封裝效能及能源傳遞效率外,還可透過(guò)板級(jí)制程,滿足高效率和大面積的生產(chǎn),從而降低生產(chǎn)成本。
Manz RDL制程以厚實(shí)的研發(fā)基礎(chǔ)和前瞻的技術(shù)創(chuàng)新,應(yīng)用版圖再擴(kuò)大
憑借近四十年在化學(xué)濕制程(洗凈、蝕刻、通孔工藝設(shè)備)、自動(dòng)化及電鍍等生產(chǎn)設(shè)備解決方案領(lǐng)域的豐富經(jīng)驗(yàn),Manz持續(xù)為全球十大載板廠及面板廠提供穩(wěn)定量產(chǎn)的有力支持,在IC載板和顯示器行業(yè)中扮演著重要角色。基于在有機(jī)材料上發(fā)展的RDL技術(shù),以及多年在傳輸玻璃載板領(lǐng)域的經(jīng)驗(yàn),近年來(lái)Manz成功地將這些技術(shù)應(yīng)用于半導(dǎo)體封裝領(lǐng)域。通過(guò)RDL工藝制作內(nèi)接金屬導(dǎo)線,為芯片與電路板之間的上下信號(hào)傳遞搭建了通道,應(yīng)用于FOPLP及TGV玻璃芯基材,滿足了高縱深比的直通孔、高真圓度等制程需求。這兩種封裝技術(shù)的開(kāi)發(fā),旨在滿足客戶對(duì)封裝體積小、高效能及高散熱的嚴(yán)苛要求。

▲ Manz RDL方案應(yīng)用于板級(jí)先進(jìn)封裝及TGV玻璃芯基材
制程技術(shù)再升級(jí)封裝再創(chuàng)新局
Manz RDL 制程設(shè)備解決方案無(wú)縫整合化學(xué)濕制程工藝前后制程,并確保電鍍后的基板表面均勻性最高可達(dá) 95%,銅厚度超過(guò) 100 μm。這不僅提高了芯片密度,還改善了散熱性。
l 電鍍?cè)O(shè)備并支持高達(dá)10 ASD的高電鍍電流密度,提高整體制造能力。
l 新型的垂直電鍍銅無(wú)需使用治具,透過(guò)專利的整機(jī)設(shè)計(jì)即可完成單面電鍍銅制程,可節(jié)省治具的購(gòu)置與維護(hù)成本,還能實(shí)時(shí)監(jiān)控制程中的電鍍藥水成分,確保制程的穩(wěn)定與高效。
l 多分區(qū)陽(yáng)極設(shè)計(jì),提升電鍍均勻性達(dá)95 %,線寬線距最小達(dá)到5μm / 5 μm。.
針對(duì)高深寬比需求,Manz RDL制程設(shè)備可完整完成清洗、蝕刻、通孔以及電鍍填孔的工藝任務(wù),搭配自動(dòng)化設(shè)備,可提供整合度高的玻璃芯基材解決方案,達(dá)成大于100um的高真圓度通孔,優(yōu)化器件電力與訊號(hào)傳輸,提升芯片效能。
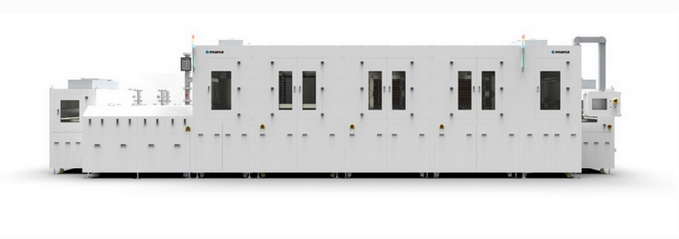
▲ Manz 電鍍?cè)O(shè)備可依據(jù)客戶制程需求,實(shí)現(xiàn)單、雙面電鍍,加速產(chǎn)速
技術(shù)組合開(kāi)拓新應(yīng)用場(chǎng)景
Manz 擁有廣泛的技術(shù)組合、豐富的設(shè)備產(chǎn)線以及涵蓋多元領(lǐng)域的生產(chǎn)設(shè)備經(jīng)驗(yàn),在RDL設(shè)備及技術(shù)的研發(fā)布局方面具備堅(jiān)實(shí)的基礎(chǔ)。因此,Manz的設(shè)備能夠有效協(xié)助芯片制造商生產(chǎn)出涵蓋低、中、高階的各類芯片封裝,滿足市場(chǎng)多樣化的需求。如:AI芯片(GPU\CPU\邏輯存儲(chǔ))、汽車電子芯片(Power IC/ADAS/RF/RADAR)、5G應(yīng)用芯片(低軌道衛(wèi)星通訊、高射頻收發(fā)器、SiP)以及電子產(chǎn)品(SOC、RF、PMIC、MEMS、Driver IC)。
Manz 與客戶攜手共進(jìn),引領(lǐng)行業(yè)發(fā)展
Manz 致力于為客戶量身打造并落實(shí)制程生產(chǎn)的最佳方案,從開(kāi)發(fā)項(xiàng)目初期,Manz 便與客戶緊密合作,深入探討生產(chǎn)制程的每一個(gè)環(huán)節(jié),以確保能為客戶贏得最快速的市場(chǎng)上市時(shí)機(jī)。目前,已與全球來(lái)自不同產(chǎn)業(yè)投入板級(jí)封裝的客戶緊密合作,提供單一設(shè)備甚至是以自動(dòng)化整合整廠設(shè)備的解決方案,助力他們?cè)陲L(fēng)云突變的市場(chǎng)競(jìng)爭(zhēng)中始終保持卓越的競(jìng)爭(zhēng)力。
當(dāng)前生成式AI引爆了整個(gè)市場(chǎng),對(duì)先進(jìn)封裝、異構(gòu)集成、高效基板的巨量需求前所未有,成為半導(dǎo)體市場(chǎng)的主要增量。基于TGV的玻璃基板封裝處于起勢(shì)階段,相關(guān)AI產(chǎn)品將在3-5年內(nèi)開(kāi)花結(jié)果。面對(duì)產(chǎn)業(yè)對(duì)新材料、新技術(shù)的挑戰(zhàn),Manz亞智科技與國(guó)內(nèi)產(chǎn)業(yè)鏈進(jìn)行過(guò)多次深入合作,涵蓋產(chǎn)、學(xué)、研,旨在有效推進(jìn)國(guó)內(nèi)板級(jí)封裝的建設(shè)。Manz集團(tuán)亞洲區(qū)總經(jīng)理林峻生先生表示:「我們將繼續(xù)發(fā)揮自身在技術(shù)和市場(chǎng)方面的積累,通過(guò)整合,積極推動(dòng)板級(jí)封裝實(shí)現(xiàn)產(chǎn)業(yè)化落地,全方位推進(jìn)國(guó)內(nèi)在先進(jìn)封裝的發(fā)展,為整個(gè)產(chǎn)業(yè)生態(tài)的建設(shè)貢獻(xiàn)出更多的力量。」
在政策紅利的傾斜下,國(guó)內(nèi)半導(dǎo)體廠商紛紛擴(kuò)建先進(jìn)封裝項(xiàng)目。其中,新技術(shù)TGV玻璃芯基材以及板級(jí)封裝作為提效或降本的新技術(shù)手段備受關(guān)注,各大廠商紛紛躍躍欲試,以期不斷增強(qiáng)產(chǎn)業(yè)國(guó)際競(jìng)爭(zhēng)力、創(chuàng)新力及技術(shù)力。林峻生先生指出:「為了給予客戶全方位的技術(shù)工藝與服務(wù),迎接這一波板級(jí)封裝的快速成長(zhǎng),我們與供應(yīng)鏈在上下游制程工藝及設(shè)備的整合、材料使用等方面都保持著密切的合作。通過(guò)凝聚供應(yīng)鏈的共同目標(biāo),我們致力于為客戶提供更創(chuàng)新的板級(jí)封裝制程工藝技術(shù),打造高效生產(chǎn)解決方案,并不斷優(yōu)化制程良率及降低制造成本。我們提供以市場(chǎng)為導(dǎo)向的板級(jí)封裝RDL一站式整體解決方案,打造共榮共贏的供應(yīng)鏈生態(tài)。」


