4月25日消息,如今的高端計算芯片越來越龐大,臺積電也在想盡辦法應(yīng)對,如今正在深入推進CoWoS封裝技術(shù),號稱可以打造面積接近8000平方毫米、功耗1000W級別的巨型芯片,而性能可比標準處理器高出足足40倍。
目前,臺積電CoWoS封裝芯片的中介層面積最大可以做到2831平方毫米,是臺積電光罩尺寸極限的大約3.3倍——EUV極紫外光刻下的光罩最大可以做到858平方毫米,臺積電用的是830平方毫米。
NVIDIA B200、AMD MI300X等芯片,用的都是這種封裝,將大型計算模塊和多個HBM內(nèi)存芯片整合在一起。

明年或稍晚些時候,臺積電會推出下一代CoWoS-L封裝技術(shù),中介層面積可以做到4719平方毫米,是光罩極限的大約5.5倍,同時需要10000平方毫米(100x100毫米)的大型基板。
它可以整合最多12顆HBM內(nèi)存,包括下一代HBM4。
這還不算完,臺積電還計劃進一步將中介層做到7885平方毫米,也就是光照極限的約9.5倍,并需要18000平方毫米的基板,從而封裝最多4顆計算芯片、12顆HBM內(nèi)存,以及其他IP。
要知道,這已經(jīng)超過了一個標準的CD光盤盒(一般142×125毫米)!
仍然沒完,臺積電還在繼續(xù)研究SoW-X晶圓級封裝技術(shù),目前只有Cerabras、特斯拉使用。
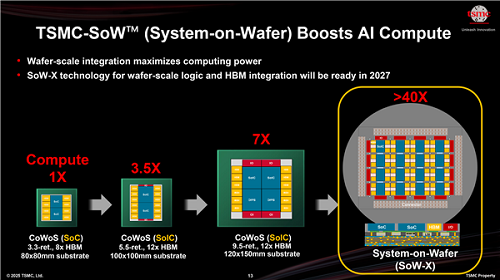
如此巨型芯片除了需要復(fù)雜的封裝技術(shù),更會帶來高功耗、高發(fā)熱的挑戰(zhàn),臺積電預(yù)計能達到1000W級別。
為此,臺積電計劃在CoWoS-L封裝內(nèi)的RDL中介層上,直接集成一整顆電源管理IC,從而縮短供電距離,減少有源IC數(shù)量,降低寄生電阻,改進系統(tǒng)級供電效率。
這顆電源管理IC會使用臺積電N16工藝、TSV硅通孔技術(shù)制造。
散熱方面,直觸式液冷、浸沒式液冷,都是必須要考慮的。
另外,OAM 2.0模塊形態(tài)的尺寸為102×165毫米,100×100毫米基板已經(jīng)接近極限,120×150毫米就超過了,因此需要行業(yè)同步制定新的OAM形態(tài)標準。