英飛凌最近推出了系列650V混合SiC單管(TO247-3pin和TO-247-4pin)。用最新的650V/SiC/G6/SBD續(xù)流二極管,取代了傳統(tǒng)Si的Rapid1快速續(xù)流二極管,配合650V/TS5的IGBT芯片(S5/H5),進(jìn)一步優(yōu)化了系統(tǒng)效率、性能與成本之間的微妙平衡。

IGBT混搭SiC SBD續(xù)流二極管,在硬換流的場合,至少有兩個主要優(yōu)勢:
·沒有Si二極管的反向恢復(fù)損耗Erec
·降低30%以上IGBT的開通損耗Eon
因此,在中小功率光伏與UPS等領(lǐng)域,IGBT混搭SiC SBD續(xù)流二極管具有較高性價比。
此次,我們將利用英飛凌強(qiáng)大且豐富的器件SPICE模型,同樣在Simetirx的仿真環(huán)境里,測試不同類型的續(xù)流二極管,對IGBT開通特性及Eon的影響。
特別提醒
仿真無法替代實驗,僅供參考。
選取仿真研究對象
IGBT:650V/50A/S5、TO247-4pin(免去發(fā)射極電感對開通的影響)
FWD:650V/30A/50A Rapid1二極管和650V/20A/40A SiC/G6/SBD二極管
Driver IC:1EDI20I12AF驅(qū)動芯片,隔離單通道,適合快速IGBT和SiC驅(qū)動
搭建仿真電路
如下圖1所示,搭建了雙脈沖仿真電路,溫度設(shè)為常溫。
驅(qū)動回路
驅(qū)動芯片(1EDI20I12AF),對下管Q1(IKZ50N65ES5)門級的開關(guān)控制,與上管D1續(xù)流二極管進(jìn)行換流。參照Datasheet的條件,驅(qū)動IC原邊5V供電及5V的控制信號,驅(qū)動IC輸出的驅(qū)動電壓15V/0V給到Q1的門級,驅(qū)動電阻Rgon和Rgoff都設(shè)置為23.1Ω,再假設(shè)20nH左右的門級PCB走線電感。
主回路部分
設(shè)置母線電壓400V,在器件外的上管、下管和母線附近各設(shè)置10nH,總共30nH(參照規(guī)格書中的雙脈沖測試條件,Lσ=30nH)。根據(jù)仿真中的驅(qū)動脈沖寬度與開關(guān)電流要求,設(shè)置雙脈沖的電感參數(shù)。

圖1:雙脈沖仿真電路圖
仿真結(jié)果分析
根據(jù)上述電路,通過選取不同的續(xù)流二極管D1的型號進(jìn)行仿真,對比觀察Q1的IGBT在開通過程的變化。如圖2和圖3所示,在IGBT的開通過程中,當(dāng)續(xù)流管D1的型號從650V/50A/Rapid1切換到650V/40A/SiC/G6/SBD后,開通電流Ic的電流尖峰(由D1的反向恢復(fù)電荷Qrr形成),從虛線(50A/Rapid1)的巨大包絡(luò),顯著變?yōu)閷嵕€(40A/SBD)的小電流過沖;同時電壓Vce在第二段的下降速度也明顯加快,使得電流Ic與電壓Vce的交疊區(qū)域變小。因此,體現(xiàn)在開通損耗Eon上,前者虛線(50A/Rapid1)為Eon=430uJ,降為實線(40A/SBD)的Eon=250uJ,占比為58%,即Eon降幅約40%。
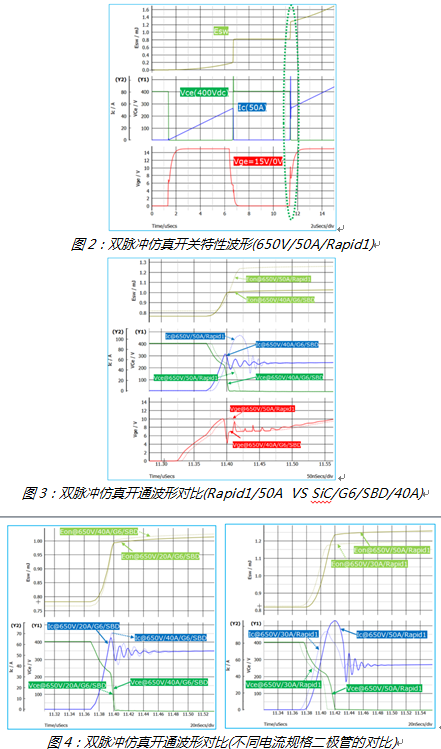
為了進(jìn)一步驗證二極管D1的影響,分別用兩種不同電流進(jìn)行橫向?qū)Ρ取S缮鲜鰣D4的仿真結(jié)果可見:同為650V/SiC/G6/SBD二極管的Qrr本身很小,不同電流規(guī)格(40A和20A),其Ic電流尖峰和開通損耗Eon都很接近。相對而言,50A和30A的650V/Rapid1的二極管,才能體現(xiàn)出一定的差異。
以上仿真是在門級電阻Rgon=23.1Ω、驅(qū)動電壓Vge=15V/0V和外部電感Lσ=30nH的條件下進(jìn)行的,如果采用不同門級電阻Rgon=18Ω或35Ω、Vge=15V/-8V和不同外部電感(如Lσ=15nH)時,從Rapid1/50A到SiC/G6/SBD/40A,IGBT開通損耗Eon的變化趨勢又將如何呢?
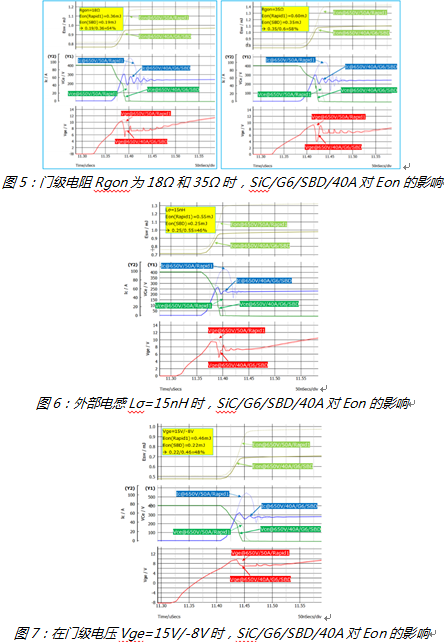
由上述幾組仿真結(jié)果來看,在一定門級電阻Rgon范圍,一定外部電感條件Lσ,以及不同門級電壓Vge時,均可以看到650V/40A/SiC/SBD二極管,給IGBT開通帶來約50%左右的Eon損耗降低。
文章最后,我們再討論一個問題:選擇Vge=15V/0V與Vge=15V/-8V,對650V/50A/S5的TO247-4pin的單管的開關(guān)損耗Eon/Eoff有影響嗎?
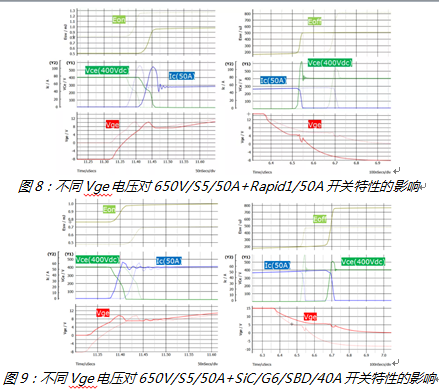
在圖8和圖9中,虛線表示Vge=15V/0V,而實線表示Vge=15V/-8V;粗略來看,對Eon的影響可以忽略,而對Vge的負(fù)壓,可以減少Eoff差不多有50%(以Vce尖峰作為代價)。仿真雖然無法定量,至少可以定性地提醒大家,在設(shè)計與實測的時候,不要隨意忽視Vge對開關(guān)特性的影響,尤其是快速型的IGBT。
期望上述的仿真分析,對大家深入理解650V混合SiC的開關(guān)特性有所幫助。

