4 月 24 日消息,臺積電 2025 年北美技術(shù)論壇不僅公布了最先進的 A14 邏輯制程,在先進封裝領(lǐng)域也有多項重要信息公布。
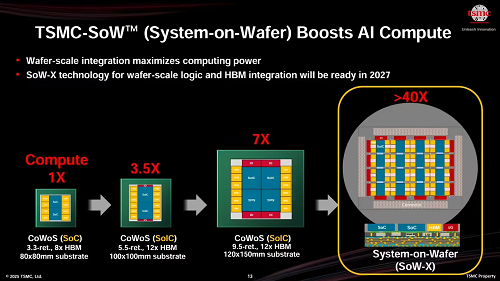
臺積電表示該企業(yè)計劃在 2027 年量產(chǎn) 9.5 倍光罩尺寸的 CoWoS,從而能夠以臺積電先進邏輯技術(shù)將 12 個或更多的 HBM 堆疊整合到一個封裝中,這意味著單封裝可容納的芯片面積將相較此前進一步提升。
而在更大的晶圓尺寸封裝系統(tǒng)方面,臺積電則帶來了 SoW 系統(tǒng)級晶圓技術(shù)的新版本 SoW-X。該技術(shù)采用不同于 SoW-P 的 Chip-Last 流程(IT之家注:先在晶圓上構(gòu)建中介層再添加芯片),計劃于 2027 年量產(chǎn)。
臺積還介紹了其它一系列高性能集成解決方案,包括用于 HBM4 的 N12 和 N3 制程邏輯基礎(chǔ)裸晶(Base Die)、運用 COUPE 緊湊型通用光子引擎技術(shù)的 SiPh 硅光子整合。

▲ 未來的 HPC / AI 芯片需要復(fù)雜的整合集成
此外臺積電也公布了用于 AI 的新型集成型電壓調(diào)節(jié)器 / 穩(wěn)壓器 IVR。與電路板上的獨立電源管理芯片 PMIC 相比,IVR 具備 5 倍的垂直功率密度傳輸。
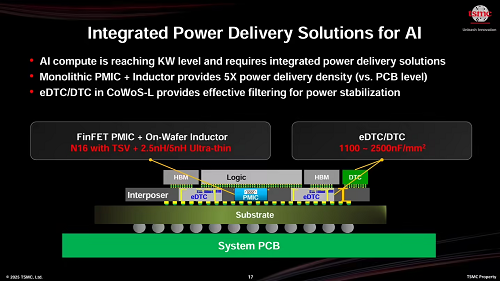

本站內(nèi)容除特別聲明的原創(chuàng)文章之外,轉(zhuǎn)載內(nèi)容只為傳遞更多信息,并不代表本網(wǎng)站贊同其觀點。轉(zhuǎn)載的所有的文章、圖片、音/視頻文件等資料的版權(quán)歸版權(quán)所有權(quán)人所有。本站采用的非本站原創(chuàng)文章及圖片等內(nèi)容無法一一聯(lián)系確認(rèn)版權(quán)者。如涉及作品內(nèi)容、版權(quán)和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當(dāng)措施,避免給雙方造成不必要的經(jīng)濟損失。聯(lián)系電話:010-82306118;郵箱:[email protected]。

