10 月 30 日消息,分析機構(gòu) TrendForce 集邦咨詢表示,三大 HBM 內(nèi)存巨頭在對堆疊高度限制、I/O 密度、散熱等要求的考量下,已確定于 HBM5 20hi(注:即 20 層堆疊)世代使用混合鍵合 Hybrid Bonding 技術(shù)。
該機構(gòu)認為,在 HBM4、HBM4e 兩代產(chǎn)品上 SK 海力士、三星電子、美光三家企業(yè)均會推出 12hi、16hi 版本以滿足對不同容量的需求,其中 12hi 產(chǎn)品將繼續(xù)使用現(xiàn)有的微凸塊鍵合技術(shù),16hi 產(chǎn)品技術(shù)路線尚未確定。
此外英偉達未來 AI GPU 將與 HBM5 內(nèi)存以 3D 堆疊而非現(xiàn)有 2.5D 的形式集成。
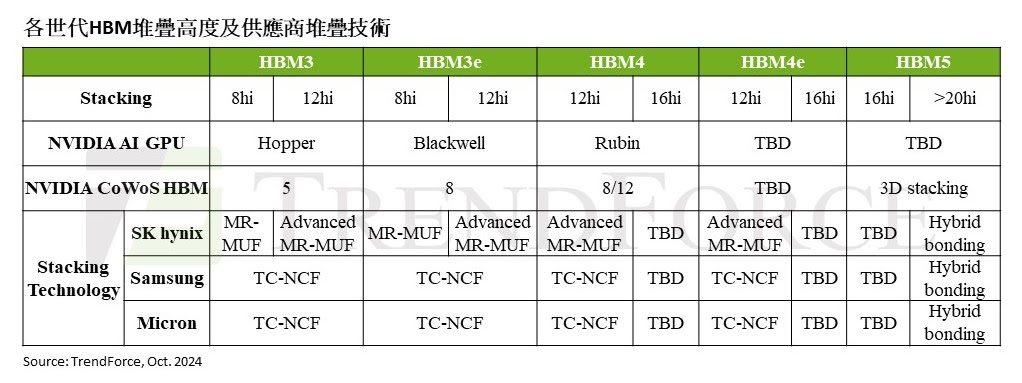
機構(gòu)表示,無凸塊的混合鍵合技術(shù)可容納較多堆疊層數(shù),也能容納較厚的晶粒厚度,以改善翹曲問題,能提升芯片傳輸速度,散熱表現(xiàn)也更為優(yōu)異,但還需克服微粒控制等技術(shù)問題。
在 HBM4(e)16hi 產(chǎn)品上是否采用混合鍵合是一個兩難問題:提前導(dǎo)入混合鍵合固然可及早經(jīng)歷新堆疊技術(shù)的學(xué)習(xí)曲線,確保 HBM5 20Hi 順利量產(chǎn),但也意味著額外的設(shè)備投資,此前在微凸塊鍵合上積累的技術(shù)優(yōu)勢也將部分損失。
混合鍵合需以 WoW(晶圓對晶圓)模式堆疊,不僅對前端生產(chǎn)良率提出了更高要求,也意味著第一層(也是每一層)DRAM 芯片的尺寸需與底部 Base Die 相同。
而 HBM 內(nèi)存的 Base Die 正走向外部化、定制化,臺積電等同時具備先進 Base Die 生產(chǎn)與 WoW 堆疊能力的企業(yè)有望更深程度參與 HBM 生產(chǎn),從而改變 HBM + 先進封裝鏈條的商業(yè)模式。


