據(jù)業(yè)內(nèi)最新消息顯示,韓國(guó)DRAM芯片大廠三星和SK海力士都計(jì)劃在即將推出的新一代高帶寬內(nèi)存(HBM)中采用新的混合鍵合(Hybrid Bonding)技術(shù)。
晶圓鍵合也被稱為混合鍵合,即芯片垂直堆疊,通過(guò)硅穿孔(TSV)或微型銅線連接,I/O直接連接,沒(méi)有用到凸塊連接。根據(jù)芯片堆疊方式,還有分為晶圓到晶圓(wafer-to-wafer)、晶圓到裸晶(wafer-to-die)和裸晶到裸晶(die-to-die)。
現(xiàn)在的DRAM是在同一晶圓單元層兩側(cè)周邊元件,這會(huì)使表面積擴(kuò)大,而3D DRAM則是基于現(xiàn)有的平面DRAM單元來(lái)做垂直堆疊,就像目前的3D NAND的單元垂直堆疊一樣。三星和SK海力士都計(jì)劃在不同DRAM晶圓上制造“單元”(Cell)和周邊元件(peripherals),然后再通過(guò)混合鍵合連接,這將有助于控制器件的面積、提高單元密度。
SK海力士曾在其第三代8層堆疊的HBM2E上進(jìn)行過(guò)測(cè)試,使用混合鍵合制程后,通過(guò)了所有可靠性測(cè)試。SK海力士還評(píng)價(jià)了該HBM在高溫下的使用壽命,檢查產(chǎn)品出貨后客戶在芯片黏合過(guò)程中可能出現(xiàn)的潛在問(wèn)題。目前,SK海力士計(jì)劃在新一代的HBM4上采用混合鍵合技術(shù)。
目前三星也在研究4F Square DRAM,并有望在生產(chǎn)中應(yīng)用混合鍵合技術(shù)。4F Square是一種單元數(shù)組結(jié)構(gòu),與目前商業(yè)化的6F Square DRAM相比,可將芯片表面積減少30%。
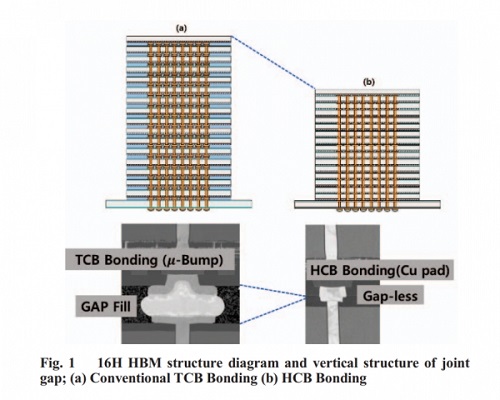
另外,三星在其論文中指出,未來(lái)16層及以上的HBM必須采用混合鍵合技術(shù)(Hybrid bonding)。三星稱,降低堆疊的高度是采用混合鍵合的主因,內(nèi)存高度限制在775微米內(nèi),在這高度中須封裝17個(gè)芯片(即一個(gè)基底芯片和16個(gè)核心芯片),因此縮小芯片間的間隙,是內(nèi)存大廠必須克服的問(wèn)題。
三星今年4月使用子公司Semes的混合鍵合設(shè)備制作了16層的HBM樣品,并表示芯片運(yùn)作正常。
另一家DRAM大廠美光此前在COMPUTEX 2024記者會(huì)上表示,公司也正著手開(kāi)發(fā)HBM4,會(huì)考慮采用包括混合鍵合在內(nèi)等相關(guān)技術(shù),目前一切都在研究中。


