近日,,中國科學(xué)技術(shù)大學(xué)微電子學(xué)院龍世兵教授課題組聯(lián)合中科院蘇州納米所加工平臺在氧化鎵功率電子器件領(lǐng)域取得重要進展,分別采用氧氣氛圍退火和N離子注入技術(shù),,首次研制出了氧化鎵垂直槽柵場效應(yīng)晶體管。
功率半導(dǎo)體器件是電力電子系統(tǒng)中的核心元件,,主要用于電力設(shè)備的電能變換和控制電路中的大功率,,應(yīng)用場景包括工業(yè)控制、可再生能源與新能源系統(tǒng)、電動汽車,、軌道交通等,。隨著新能源汽車等行業(yè)的發(fā)展及其不斷提高的對電力系統(tǒng)控制能力的要求,以及傳統(tǒng)的Si等半導(dǎo)體材料逐步接近物理極限,,氧化鎵作為新一代功率半導(dǎo)體材料,,其禁帶寬帶大、擊穿場強高,,有望在未來功率器件領(lǐng)域發(fā)揮重要的作用,。另外,氧化鎵半導(dǎo)體材料能夠采用熔體法生長,,未來在成本上將比SiC和GaN等材料更具優(yōu)勢,。
氧化鎵材料應(yīng)用難點
①難以實現(xiàn)氧化鎵的p型摻雜,這導(dǎo)致氧化鎵場效應(yīng)晶體管面臨著增強型模式難以實現(xiàn)和功率品質(zhì)因數(shù)難以提升等問題,。
②氧化鎵垂直場效應(yīng)晶體管適應(yīng)于制備高壓大電流器件,,相較于制備水平結(jié)構(gòu)的MBE樣品,其材料具有較低成本,。但氧化鎵垂直晶體管的若干種結(jié)構(gòu)中,,FinFET雖然性能較為優(yōu)異,但工藝難度大,,難以實現(xiàn)大規(guī)模量產(chǎn),。
因此急需設(shè)計新結(jié)構(gòu)氧化鎵垂直型晶體管,攻克增強型晶體管所需要的電流阻擋層技術(shù)(Currentblocking layer),,并運用電流阻擋層制備出新設(shè)計的氧化鎵垂直柵槽晶體管,。
氧化鎵垂直槽柵場效應(yīng)晶體管技術(shù)邏輯
該研究分別采用了氧氣氛圍退火和氮(N)離子注入工藝制備了器件的電流阻擋層,并配合柵槽刻蝕工藝研制出了不需P型摻雜技術(shù)的氧化鎵垂直溝槽場效應(yīng)晶體管結(jié)構(gòu),。氧氣氛圍退火和N離子注入所形成的電流阻擋層均能夠有效隔絕晶體管源,、漏極之間的電流路徑,當(dāng)施加正柵壓后,,會在柵槽側(cè)壁形成電子積累的導(dǎo)電通道,,實現(xiàn)對電流的調(diào)控。氧化鎵在氧氣氛圍退火能夠在表面形成補償型缺陷,,從而形成高阻層,。
氧氣氛圍退火工藝是氧化鎵較為獨特的一種技術(shù)手段,這種方式的靈感來源于硅工藝的成功秘訣之一——半導(dǎo)體硅的氧氣氛圍退火,。類似于硅在氧氣氛圍退火可形成高阻表面層,,氧化鎵采用該手段制備電流阻擋層(相比于離子注入)具有缺陷少、無擴散,、成本低等特點。N離子注入MOSFET基于工業(yè)化高能離子注入設(shè)備,采用N離子注入摻雜工藝,,當(dāng)N注入濃度為5×1018cm-3時,,制備的垂直槽柵MOSFET閾值電壓達到4.2V(@1A/cm2),飽和電流密度高達702.3A/cm2,,導(dǎo)通電阻10.4mΩ·cm2,。此外,通過調(diào)節(jié)N離子注入濃度,,器件的擊穿電壓可達到534V,,為目前電流阻擋層型氧化鎵MOSFET器件最高值,功率品質(zhì)因數(shù)超過了硅單極器件的理論極限,。兩項工作為氧化鎵晶體管找到了新的技術(shù)路線和結(jié)構(gòu)方案,。
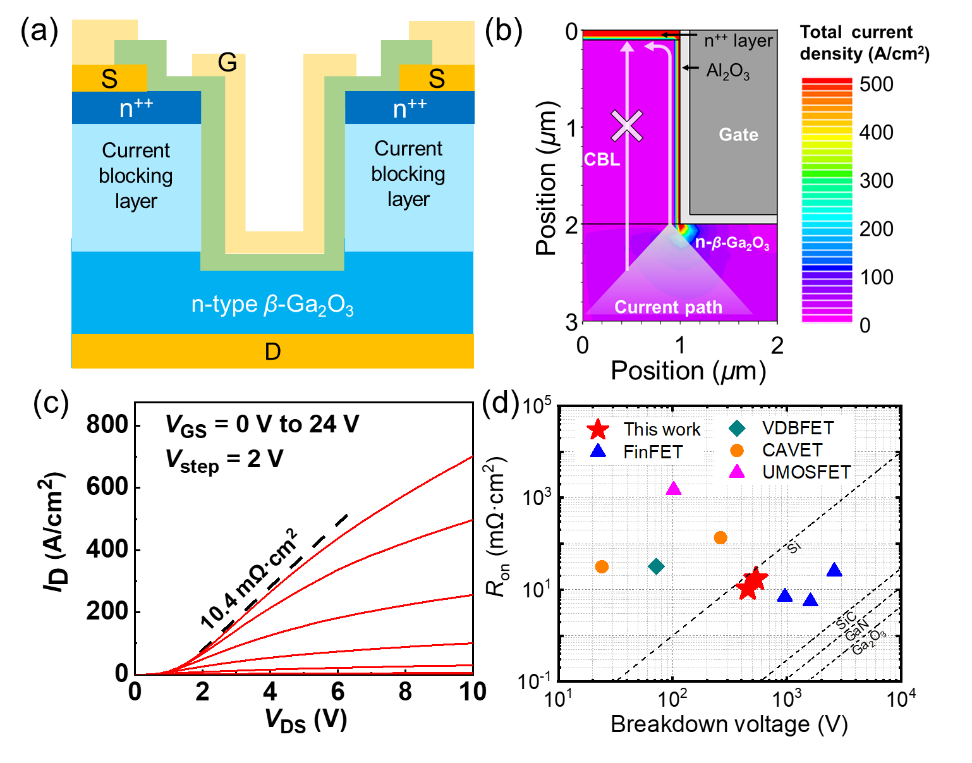
圖1(a)氧化鎵垂直槽柵場效應(yīng)晶體管結(jié)構(gòu)示意圖;(b)器件工作原理示意圖,;
(c)N離子注入晶體管的輸出曲線,;(d)與已報道的氧化鎵垂直場效應(yīng)晶體管的性能比較。
該研究得到了國家自然科學(xué)基金,、中國科學(xué)院戰(zhàn)略性先導(dǎo)研究計劃,、中國科學(xué)院前沿科學(xué)重點研究計劃、廣東省重點領(lǐng)域研究發(fā)展計劃及中國科學(xué)院微電子研究所微電子器件與集成技術(shù)重點實驗室開放課題的資助,,也得到了中國科學(xué)技術(shù)大學(xué)微納研究與制造中心,、信息科學(xué)實驗中心、行星探索與前瞻性技術(shù)前沿科學(xué)中心,,中國科學(xué)院蘇州納米技術(shù)與納米仿生研究所納米加工平臺,、納米真空互聯(lián)實驗站(Nano-X),以及中科院納米器件與應(yīng)用重點實驗室的支持,。相關(guān)研究成果分別以“Enhancement-modeβ-Ga2O3U-shaped gate trench vertical MOSFET realized by oxygen annealing”和“702.3 A·cm-2/10.4 mΩ·cm2Vertical β-Ga2O3U-Shape Trench Gate MOSFET with N-Ion Implantation”為題在線發(fā)表于Applied Physics Letters,、IEEE Electron Device Letters期刊。文章的第一作者分別為中國科大博士生周選擇和馬永健,,中國科大龍世兵教授,、徐光偉特任副研究員和蘇州納米所張曉東副研究員為共同通訊作者。
APL論文鏈接:https://doi.org/10.1063/5.0130292
IEEE EDL論文鏈接:https://ieeexplore.ieee.org/document/10013743
更多精彩內(nèi)容歡迎點擊==>>電子技術(shù)應(yīng)用-AET<<


