眾所周知,半導體是一個非常典型的周期性行業(yè),這個特征從上游的設備、材料,到芯片設計,再到晶圓制造,整個產業(yè)鏈都表現(xiàn)得淋漓盡致,哪怕僅僅是芯片封裝中所需要的小小ABF載板也不例外。
十年前,由于臺式機、筆記本電腦市場的消退,致使ABF載板嚴重供過于求,整個產業(yè)都陷入了低潮,但在十年后,ABF產業(yè)卻戰(zhàn)火重燃。高盛證券指出,ABF載板供給缺口將由去年的15%提高至今年的20%,并應會持續(xù)到2023年以后。更有數(shù)據顯示,即使到了2025年,ABF的供需缺口仍有8.1%。

圖源:兆豐國際匯整
兜兜轉轉,那么這次,是什么再次吹響了ABF載板“反攻號角”?
“大功臣”先進封裝
先進封裝,大家應該都不陌生。近些年,隨著芯片工藝制程不斷向前推進,為了繼續(xù)延續(xù)摩爾定律,先進封裝應運而生,并成為各大IDM廠和晶圓廠爭相進入的戰(zhàn)場。而先進封裝之所以能成為推動ABF載板發(fā)展的大功臣,就要從ABF載板開始說起。
什么是ABF載板?所謂ABF載板是IC載板中的一種,而IC載板又是一種介于IC半導體及PCB之間的產品,作為芯片與電路板之間連接的橋梁,可以保護電路完整,同時建立有效的散熱途徑。
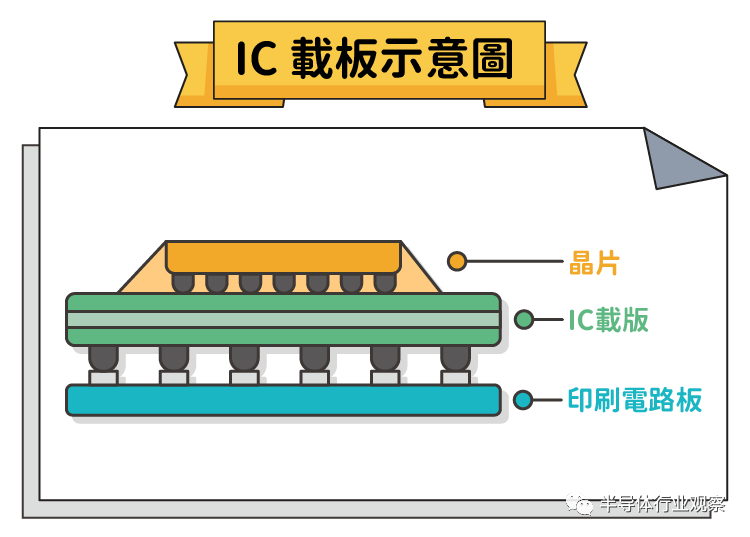
圖源:stockfeel
根據基材的不同,IC載板可以分為BT 載板和ABF載板,相較于BT載板,ABF材質可做線路較細、適合高腳數(shù)高訊息傳輸?shù)腎C,具有較高的運算性能,主要用于CPU、GPU、FPGA、ASIC等高運算性能芯片。

圖源:stockfeel
上文提到,先進封裝是為延續(xù)摩爾定律而生,原因在于先進封裝能協(xié)助芯片整合在面積不變下,促成更高的效率,透過chiplet封裝技術,將來自不同制程、不同材料的個別芯片設計置于中介層基板之上的異質整合技術,要將這些芯片整合在一起,就是需要更大的ABF載板來放置。換言之,ABF載板耗用的面積將隨chiplet技術而變大,而載板的面積越大,ABF的良率就會越低,ABF載板需求也會進一步提高。

圖源:Cadence
目前,先進封裝技術包括FC BGA、FC QFN、2.5D/3D、WLCSP、Fan-Out等多種形式,其中,F(xiàn)CBGA憑借內部采FC、外部采BGA的封裝方式,成為目前主流的封裝技術。作為ABF載板應用較多的封裝技術,F(xiàn)CBGA I/O數(shù)量達到32~48,因而擁有非常優(yōu)異的性能與成本優(yōu)勢。此外,2.5D封裝的I/O數(shù)量也相當高,是2D FC封裝的數(shù)倍以上,在顯著提升高階芯片效能的同時,所需的 ABF載板也變得更為復雜。
以臺積電的CoWoS技術為例,從2012年首度推出至今,根據Interposer的不同,這項封裝技術已經可分為 CoWoS-S、CoWoS-R和CoWoS-L三種,目前第五代CoWoS-S已進入量產,預計于 2023年量產第六代CoWoS-S。作為先進封裝技術之一,CoWoS采用了大量高階ABF,不論面積、層數(shù)都高于FCBGA,良率也遠低于FCBGA,從這方面來看,未來勢必將消耗大量ABF產能。
除臺積電外,Intel在2014年發(fā)布的嵌入式多芯片互連橋接(Embedded Multi-die Interconnect Bridge, EMIB)技術,其I/O數(shù)高達250~1000,提高芯片互連密度,并且將硅中介層內嵌于ABF,節(jié)省掉大面積的硅中介層。此舉雖然降低了成本,但卻增加了ABF的面積、層數(shù)與制作難度,將消耗更多ABF產能。據了解,Eagle Stream新平臺的Sapphire Rapids將是首款具備EMIB + Chiplet的Intel Xeon數(shù)據中心產品,推估ABF消耗面量將是Whitley平臺1.4倍以上。
由此可見,先進封裝技術的出現(xiàn)毫無疑問成為了推動ABF載板需求的大功臣。
Server及AI領域需求升級
如果說先進封裝技術是大功臣,那么數(shù)據中心和人工智能兩大應用興起就是頭號“助力員”。當前,為滿足HPC、AI、網通及各項基礎建設的需求,無論是CPU、GPU、網通芯片,還是特殊應用芯片(ASIC)等關鍵芯片,都將加速內容升級的速度,進而往大尺寸、高層數(shù)、線路高密度這三個方向發(fā)展,而這樣的發(fā)展趨勢勢必會拉高市場對于ABF載板的需求。
一方面,上文提到的先進封裝作為提升芯片算力、降低芯片平均價格的一大利器,再加上數(shù)據中心和人工智能等領域的興起對算力提出的全新要求,越來越多的CPU、GPU等大算力芯片開始向先進封裝邁進。今年至今為止,最為震撼的應該就是3月份蘋果推出的M1 Ultra芯片。
據了解,M1 Ultra采用了Apple自定義的封裝架構Ultra Fusion,基于臺積電InFO-L封裝技術的架構,透過硅中介板連接2顆M1 Max裸晶,建構出SoC,可以最大程度縮小面積并提升性能。要知道,與此前處理器所用到的封裝技術相比,M1 Ultra所采用的InFO-L封裝技術需要采用大面積的ABF,所需面積為M1 Max 的兩倍,且精密度要求更高。
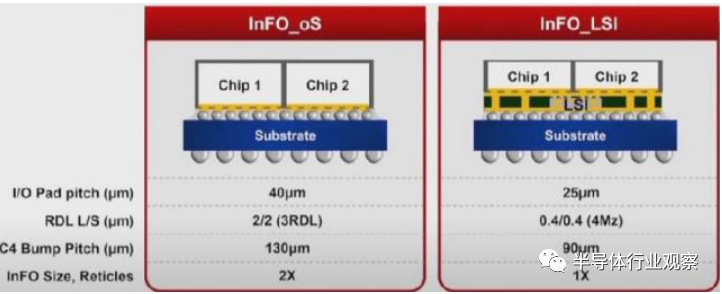
圖源:臺積電
除蘋果M1 Ultra芯片外,英偉達服務器GPU Hopper 與超威半導體的RDNA 3 PC GPU 都將在今年改采 2.5D 封裝,今年4月,也有媒體報道,日月光先進封裝切入美國一流服務器芯片廠商供應鏈。
兆豐國際匯整數(shù)據顯示,PC CPU中,預測2022~ 2025年PC CPU/GPU ABF消耗面積分別約為11.0%和8.9% CAGR,CPU/GPU 2.5D/3D封裝ABF消耗面積則分別高達36.3%和99.7% CAGR。而服務器CPU中,預測2022~ 2025年CPU/GPU ABF消耗面積約10.8%和16.6% CAGR,CPU/GPU 2.5D/3D封裝ABF消耗面積約48.5%和58.6% CAGR。

種種跡象意味著,大算力芯片向先進封裝邁進將成為ABF 載板需求成長的主因。
另一方面,就是AI、5G、自動駕駛、物聯(lián)網等新技術、新應用的興起。以此前最為熱門的元宇宙來說,AR/VR等頭顯設備作為未來元宇宙重要的入口,背后隱藏著巨大的芯片機會,而這些芯片機會也將成為推動ABF載板市場增長的新增長力。
今年年初,天風國際分析師郭明錤曾發(fā)布報告透露了蘋果AR/MR設備新動向。報告顯示,蘋果此次的AR/MR設備將配備雙CPU,分別為4nm、5nm制程,由臺積電獨家開發(fā);雙CPU均使用ABF載板,這也意味著,蘋果AR/MR設備將采用雙ABF載板。郭明錤預測,2023/2024/2025年,蘋果AR/MR裝備出貨量分別有望達300萬部、800-1000萬部與1500–2000萬部,對應ABF載板需求600萬片/1600-2000萬片/3000-4000萬片。
順便提一下,蘋果對于AR/MR設備的目標是10年后可取代iPhone。數(shù)據顯示,目前iPhone活躍用戶超10億人,而且始終在穩(wěn)步上升,即便按照當前數(shù)據來算,未來10年,蘋果至少需要售出10億臺AR裝置,這就意味著僅僅蘋果AR/MR設備所需要的ABF載板數(shù)量就超過20億片。
隨著谷歌、Meta、亞馬遜、高通、字節(jié)跳動等各大巨頭的加入,未來市場競爭只會更激烈,帶動著ABF載板的需求也將更為旺盛。

圖源:IDC
六大廠商齊擴產
面對如此強勁的市場增長趨勢和不斷擴大的供需缺口,ABF載板大廠的產能擴建也早已提上日程。
目前ABF載板主要有七大供貨商,2021年供貨比重分別是欣興21.6%、景碩7.2%、南電13.5%、Ibiden 19.0%、Shinko 12.1%、AT&S 16.0%、Semco 5.1%,2022年除Semco外,其余廠商于皆有進行擴產。

欣興電子
欣興電子將2022年的資本支出上調至358.58億新臺幣,80%-85%的資本支出將用于IC載板擴產,其中70%將用于擴大中國臺灣新竹的ABF載板產能。
其楊梅廠在去年下半年先生產ABF載板的成熟制程產品,目前楊梅廠第一期已經量產,第二期第三期的裝機,將在未來幾個月完成,預估到2023年可以達到滿載。整體欣興今年載板增產約20%,主要還是會以ABF載板為主。
景碩科技
景碩今年前三季產能提升都是以既有的新豐廠為主,第四季起楊梅新廠可望加入,該廠主要是以生產ABF載板為主,將一直可擴充到明年第三季,景碩因ABF產能相較較小,今年估ABF產能可增三至四成。
去年10月,景碩稱2022年擴產主要以ABF載板為主,資本支出暫估為80億元,將擴充ABF載板產能達3-4成的水平。
南亞電路
南亞電路今年也是在兩岸擴產,包括錦興廠、昆山廠(主力擴BT載板),以及下半年將加入的樹林廠以及昆山二期,目前樹林新廠已在機臺認證,接下來進行產品認證,估下半年就會投產,若速度快可能Q3底就會量產,明年Q1放量。
南亞電路板自估,今年在ABF載板部分,樹林一期產能可以多一成,昆山二期也可以多一成的產能,整體來看,今年產能可以較去年多出二成,而隨著明年第一季新產能大放量,南亞電路板ABF載板產能可以多出三成。
Ibiden(揖斐電)
2021年4月,揖斐電宣布,為了應對旺盛的客戶需求,計劃對旗下河間業(yè)務場(岐阜縣大垣市河間町)投資1,800億日元、增產高性能IC封裝基板。上述增產工程預計于2023年度完工量產。此外,其位于日本岐阜縣大野町的新工廠,則預計最快量產時間在2025年。
Shinko(新光電工)
Shinko去年10月宣布,計劃在千曲市建設新工廠,以擴大倒裝芯片型封裝的生產能力。2022~2025年的投資額為1400億日元,通過資本投資的產能預計將比以往增加50%。今年5月,Shinko宣布,將在長野縣千曲市建設的新工廠將于2024年度下半年啟動。
Shinko表示,在全球半導體需求不斷增長的情況下,將主要擴大面向高性能半導體的FCBGA封裝基板的生產。
AT&S(奧特斯)
去年6月,AT&S AG 計劃在獲得監(jiān)事會批準后,在東南亞建立新的 IC 基板生產基地。據了解,該計劃投資總額高達 17 億歐元,用于2021 年至 2026 年期間在東南亞地區(qū)為高性能處理器生產 ABF 基板,生產場地總面積約為 200,000 平方米,計劃于2024年底開始量產。
據悉,AT&S目標是在2025年躋身全球三大ABF載板供貨商,去年3月決定全面擴大重慶的 ABF 基板生產面積,并為此追加了大約 2 億歐元的投資預算,今年也將專注重慶三廠產能的釋放。

圖源:AT&S
寫在最后
雖然上述ABF大廠皆已展開擴產計劃,但是由于產能釋放需要時間,且上游關鍵材料ABF基膜產能增速較低,限制了ABF載板產能釋放,更重要的是,由于芯片面積增大致使當前ABF良率降低,疊加半導體行業(yè)自身的周期性特征,未來ABF載板會如何發(fā)展,依舊是個未知數(shù)。


