ASML CEO:限制不能阻止中國(guó)技術(shù)進(jìn)步,但會(huì)損害美國(guó)經(jīng)濟(jì)
2021-04-15
來(lái)源:半導(dǎo)體行業(yè)觀察
據(jù)彭博社報(bào)道,ASML 首席執(zhí)行官Peter Wennink日前表示,對(duì)華出口管制不僅不能停止其技術(shù)進(jìn)步,而且還會(huì)損害美國(guó)經(jīng)濟(jì)。此前,華盛頓和北京之間的貿(mào)易緊張局勢(shì)導(dǎo)致該荷蘭公司的先進(jìn)芯片設(shè)備在中國(guó)的銷售受到限制。
Wennink在周三的在線行業(yè)活動(dòng)中說(shuō):“我相信,如果您確定存在經(jīng)濟(jì)風(fēng)險(xiǎn),那么出口管制將不是管理經(jīng)濟(jì)風(fēng)險(xiǎn)的正確方法,他進(jìn)一步指出,如果您讓中國(guó)無(wú)法獲得技術(shù),這也將使非中國(guó)經(jīng)濟(jì)體失去大量工作和大量收入。
Wennink說(shuō),由于缺乏外國(guó)技術(shù),中國(guó)需要很長(zhǎng)時(shí)間才能建造自己的半導(dǎo)體設(shè)備和技術(shù),但這個(gè)決定帶來(lái)的結(jié)果是最終非中國(guó)公司將被排除在全球最大的芯片市場(chǎng)之一之外。
據(jù)美國(guó)商務(wù)部估計(jì),如果美國(guó)與中國(guó)在半導(dǎo)體業(yè)務(wù)上的業(yè)務(wù)被完全切斷,則會(huì)影響美國(guó)粵800億至1,000億美元的銷售并造成125,000個(gè)工作崗位的丟失。
ASML是制造尖端芯片所需的先進(jìn)的極紫外光刻設(shè)備的壟斷者,它是三星電子公司和臺(tái)灣半導(dǎo)體制造公司的重要供應(yīng)商,按照他們的計(jì)劃,他們本來(lái)想大舉進(jìn)軍中國(guó),而北京方面希望建立一個(gè)世界一流的本土芯片產(chǎn)業(yè),以擺脫國(guó)外進(jìn)口的依賴。要達(dá)成這項(xiàng)成就,將需要ASML的一種EUV機(jī)器。然而,由于持續(xù)的貿(mào)易緊張局勢(shì),該公司在讓荷蘭政府續(xù)簽向中國(guó)出口該系統(tǒng)的許可證方面面臨困難。
Wennink在一月份表示,ASML尚未將其最新的EUV機(jī)器運(yùn)往中國(guó),因?yàn)槿栽趯で蠛商m政府的出口許可證申請(qǐng),并補(bǔ)充說(shuō)荷蘭,歐洲和美國(guó)政府之間一直在進(jìn)行談判。
ASML分享光刻機(jī)最新路線圖,1.5nm指日可待
在2月舉行的SPIE高級(jí)光刻會(huì)議上,ASML(ASML.US)展示了有關(guān)其深紫外線(DUV)和極紫外線(EUV)曝光系統(tǒng)的最新信息。筆者最近采訪了ASML的Mike Lercel,就這些演示文稿進(jìn)行了深入討論。
深紫外
盡管EUV得到了所有關(guān)注,但大多數(shù)層仍仍然使用DUV系統(tǒng)曝光,在可預(yù)見的將來(lái),這可能仍然適用。
ASML已生產(chǎn)了兩個(gè)DUV平臺(tái),即用于干式曝光工具的XT平臺(tái)和用于浸沒的NXT平臺(tái)。NXT是更快,更復(fù)雜的平臺(tái)。
對(duì)于領(lǐng)先的沉浸式技術(shù),ASML推出了面向ArF浸入(ArFi)的第四代NXT平臺(tái)——NXT:2050i。新系統(tǒng)具有新的晶圓處理機(jī)(wafer handler),晶圓載物臺(tái)(wafer stage),標(biāo)線片載物臺(tái)(reticle stage),投影透鏡(projection lens),激光脈沖展寬器(laser pulse stretcher)和浸沒罩(immersion hood)。這樣就可以更快地進(jìn)行硅片對(duì)硅片的排序,更快的測(cè)量,防護(hù)膜偏斜校正(pellicle deflection )以及具有改善覆蓋率的改善斑點(diǎn)。新系統(tǒng)的吞吐量為每小時(shí)295個(gè)晶圓(wph)。較長(zhǎng)期的計(jì)劃是建立一個(gè)330 wph的系統(tǒng)(見圖1)。
ASML現(xiàn)在正在采用NXT平臺(tái),并在第一臺(tái)面向ArF Dry的NXT:1470系統(tǒng)上移植干鏡,該系統(tǒng)提供300wph(比NXT:20250i快一點(diǎn),因?yàn)樗鼪]有沉浸開銷)。NXT:1470的300 wph吞吐量高于XT:1460K的約200 wph的吞吐量。將來(lái),NXT:1470的吞吐能力將進(jìn)一步提高到330 wph(見圖1)。還計(jì)劃以330 wph的速度將KrF干鏡移植到NXT平臺(tái)上(見圖1)。
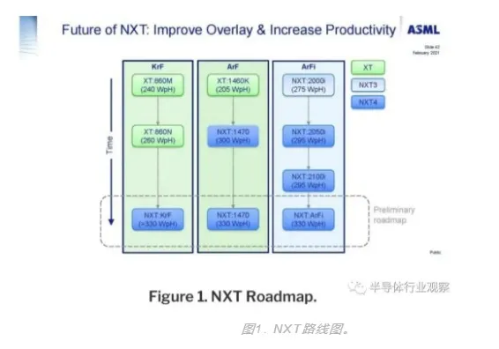
EUV(0.33NA)
隨著三星和臺(tái)積電在7nm和5nm邏輯生產(chǎn)以及三星在1z DRAM生產(chǎn)中加大對(duì)標(biāo)準(zhǔn)0.33數(shù)值孔徑(NA)系統(tǒng)的使用,EUV曝光的晶圓數(shù)量正在迅速增長(zhǎng)(見圖2)。

NXE:3400C系統(tǒng)自2019年底推出以來(lái)一直在發(fā)貨,而新的NXE:3600D應(yīng)該在今年晚些時(shí)候開始發(fā)貨。每個(gè)新系統(tǒng)都提供了改進(jìn)的吞吐量和覆蓋。
圖3給出了將在下一部分討論的0.33 NA和High-NA 0.55NA系統(tǒng)的摘要。

1.第一列列出了從NXE3400B系統(tǒng)(最初的生產(chǎn)系統(tǒng))開始的過(guò)去,現(xiàn)在和將來(lái)的系統(tǒng)。
2.第二列提供每個(gè)系統(tǒng)的引入日期。值得注意的是,新的NXE:3600D應(yīng)該在今年晚些時(shí)候以更高的性能交付,而第一批高NA系統(tǒng)應(yīng)該在2022年晚些時(shí)候交付。
3.第三列給出了系統(tǒng)的數(shù)值孔徑,其中0.33NA代表當(dāng)前系統(tǒng),而0.55NA代表正在開發(fā)的高NA系統(tǒng)。
4.接下來(lái)的兩列顯示了ASML證明的20mJ / cm 2和30mJ / cm 2劑量的通量。這些吞吐量基于更典型的DRAM應(yīng)用中每個(gè)硅片的96 field。
5.發(fā)貨的系統(tǒng)數(shù)量是IC Knowledge對(duì)2020年第4季度按類型發(fā)貨的NXE:3400B和NXE:3400C系統(tǒng)數(shù)量的估計(jì),ASML不提供這個(gè)。
6.下一欄是NXE:3400B當(dāng)前的可用性約85%,NXE:3400C當(dāng)前的可用性約90%。3400C具有新的模塊化容器,可減少停機(jī)時(shí)間。長(zhǎng)期ASML的長(zhǎng)期目標(biāo)是使其達(dá)到DUV系統(tǒng)典型的95%可用性。
7.最后一欄介紹了有關(guān)系統(tǒng)和用法的一些注釋。我們認(rèn)為7nm邏輯生產(chǎn)主要在3400B上進(jìn)行,而5nm在3400C上進(jìn)行。我們預(yù)計(jì)即將在未來(lái)一到兩年內(nèi)投入生產(chǎn)的3nm工藝將主要在3600D系統(tǒng)上生產(chǎn)。
密集圖案EUV的關(guān)鍵推動(dòng)因素是Pellicles的可用性,現(xiàn)在有可用Pellicles可用。Pellicles的使用會(huì)降低生產(chǎn)量,是否使用Pellicles取決于你所打印的圖案密度。圖4顯示了EUV Pellicles透射的狀態(tài)。

當(dāng)前在生產(chǎn)中使用了一些Pellicles。
High-NA EUV(0.55NA)
High-NA現(xiàn)在已經(jīng)從PowerPoint幻燈片發(fā)展到工程設(shè)計(jì),再到構(gòu)建模塊和框架。預(yù)計(jì)首批High-NA工具(0.55NA)將于2022年下半年交付。這些EXE:5000系統(tǒng)可能與EXE:5200系統(tǒng)一起用于研發(fā),原因是EXE:5200系統(tǒng)將于2025/2026年成為第一批High-NA生產(chǎn)系統(tǒng)。(見圖3)。
當(dāng)前的0.33NA系統(tǒng)一次曝光即可打印到大約30nm的間距。現(xiàn)在正在進(jìn)行工作以一次曝光來(lái)演示28nm以及最終26nm的線條和空間。臺(tái)積電目前正在生產(chǎn)的5nm工藝的M0間距為28nm,我們認(rèn)為這一層在當(dāng)前生產(chǎn)中可能是雙圖案的EUV,而其余使用EUV的層則是單圖案。對(duì)于將于今年晚些時(shí)候開始出現(xiàn)風(fēng)險(xiǎn)試產(chǎn)的的臺(tái)積電3nm工藝,我們預(yù)計(jì)將有幾個(gè)EUV雙圖案金屬層。目前估計(jì)0.55NA系統(tǒng)進(jìn)入生產(chǎn)的時(shí)間大約在2025/2026時(shí)間范圍內(nèi),我們可能會(huì)看到2nm的代工廠和Intel的5nm工藝正在生產(chǎn),然后再進(jìn)行廣泛的EUV雙重打樣。055NA EUV可能會(huì)首先出現(xiàn)在晶圓廠的生產(chǎn)中。
圖5展示了高NA EUV的技術(shù)價(jià)值。

與0.33NA EUV相比,0.55NA EUV的另一個(gè)值是較高的對(duì)比度,這就讓他們可以以低得多的劑量打印出密集的特征,從而提高了通量(圖3是特定劑量的通量,不考慮降低劑量)。圖6展示了0.55NA的優(yōu)勢(shì)。
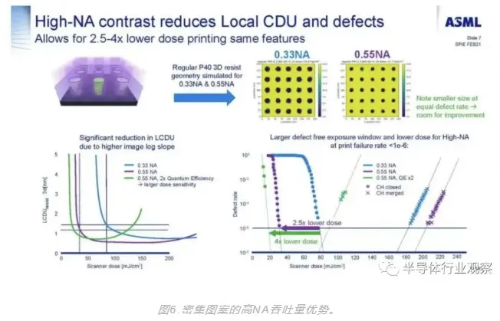
還正在進(jìn)行改進(jìn)的EUV掩模吸收層的工作,以提高對(duì)比度和分辨率,請(qǐng)參見圖7,并要改進(jìn)光刻膠,請(qǐng)參見圖8。

當(dāng)前,他們正在制造用于高NA工具的模塊和框架。
ASML繼續(xù)在其整個(gè)DUV和EUV系統(tǒng)產(chǎn)品組合中提高吞吐量和分辨率。隨著高NA系統(tǒng)制造的進(jìn)行,通往1.5nm邏輯及更高工藝的道路正在醞釀之中。

