文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.191267
中文引用格式: 周小康,馬奎,梁蓓. IGBT模塊失效機(jī)理和主動(dòng)熱控制綜述[J].電子技術(shù)應(yīng)用,2020,46(2):18-23.
英文引用格式: Zhou Xiaokang,Ma Kui,Liang Bei. Summary of IGBT module failure mechanism and active thermal control[J]. Application of Electronic Technique,2020,46(2):18-23.
0 引言
電力電子設(shè)備因其能量轉(zhuǎn)換效率高、主動(dòng)可控性和較快的動(dòng)態(tài)響應(yīng)速度等優(yōu)點(diǎn)[1],廣泛應(yīng)用于對于可靠性需求較高的新能源發(fā)電、航空航天、高速機(jī)車牽引、混合動(dòng)力電動(dòng)汽車和工業(yè)電機(jī)驅(qū)動(dòng)等領(lǐng)域中。在這些場合應(yīng)用時(shí),電力電子設(shè)備會(huì)面臨各種或規(guī)律或不規(guī)律的功率大波動(dòng)以及各種周期或非周期性的強(qiáng)機(jī)械振動(dòng)等極端工況[2],相關(guān)統(tǒng)計(jì)[3]表明,在光伏發(fā)電系統(tǒng)中計(jì)劃外的檢修有37%是由變流器故障引起的。而在變流器中[4](如圖1所示)功率器件常被列為最易失效的部件,同時(shí)根據(jù)調(diào)查,在工業(yè)中最常用的功率器件是IGBT[3]。目前,對電力電子設(shè)備可靠性的研究主要包括失效機(jī)理研究、壽命預(yù)測[5]、狀態(tài)監(jiān)測[6]和主動(dòng)熱控制[7]等。
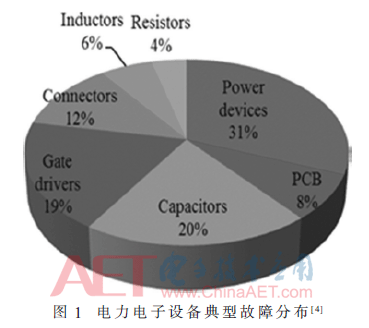
本文首先梳理了近年來國內(nèi)外IGBT模塊失效機(jī)理的相關(guān)研究內(nèi)容,其次重點(diǎn)總結(jié)了主動(dòng)熱控制方向的研究工作,分別對主動(dòng)冷卻、熱電制冷和電參數(shù)法這三種主動(dòng)熱控制方法的研究進(jìn)展進(jìn)行了分析,最后從提高器件封裝可靠性設(shè)計(jì)、改善器件運(yùn)行外部工況角度對IGBT模塊主動(dòng)熱控制方向的未來工作進(jìn)行展望。
1 IGBT故障模式和失效機(jī)理
對于IGBT模塊,它的失效涉及電、熱、機(jī)械等多方因素[8],并且失效過程與IGBT本身的動(dòng)態(tài)特性是密切相關(guān)的。其失效機(jī)理根據(jù)時(shí)效性可以分為兩種:過應(yīng)力失效和磨損失效。過應(yīng)力失效是瞬時(shí)的、災(zāi)難性的;而磨損失效則是長時(shí)效性的,器件內(nèi)部疲勞會(huì)隨時(shí)間逐步累積,同時(shí)伴隨著外部電路及工況等因素的相互影響,導(dǎo)致器件性能逐漸退化直至失效。
1.1 過應(yīng)力失效機(jī)制
過應(yīng)力失效主要與功率芯片的過壓過流過熱等情況的發(fā)生有關(guān)。在芯片發(fā)生過壓與過流時(shí),模塊內(nèi)部會(huì)產(chǎn)生大量熱量從而導(dǎo)致器件過熱損毀,并且器件存在發(fā)生二次擊穿的風(fēng)險(xiǎn)[9]。由于過應(yīng)力失效發(fā)生的瞬時(shí)性,因此需要確保選用IGBT模塊時(shí)留有足夠的安全裕量或器件充分散熱,以保證模塊在安全工作區(qū)內(nèi)運(yùn)行。
1.1.1 短路
IGBT模塊運(yùn)行的各個(gè)時(shí)間段都有發(fā)生短路現(xiàn)象的可能。開啟期間的IGBT發(fā)生柵極電壓過高[10]和外部故障可能就會(huì)引起短路。導(dǎo)通狀態(tài)期間靜態(tài)閂鎖[11]或由二次擊穿引起的過溫[12-14]以及能量沖擊[15-16]等現(xiàn)象也會(huì)引起模塊短路。關(guān)斷期間動(dòng)態(tài)閂鎖[17-18]或高壓擊穿[19-20]同樣可能導(dǎo)致器件短路。而關(guān)閉狀態(tài)下的熱失控現(xiàn)象也會(huì)造成模塊故障。短路機(jī)制如表1所示。

在IGBT關(guān)斷瞬間,IGBT會(huì)存在高壓、大電流現(xiàn)象。由于IGBT在關(guān)斷時(shí),首先關(guān)斷元胞區(qū),再關(guān)斷過渡區(qū)(元胞區(qū)與終端區(qū)中間過渡的部分),最后才是關(guān)斷器件的終端區(qū)。由于關(guān)斷IGBT自身不同區(qū)域存在時(shí)差,會(huì)存在如當(dāng)元胞區(qū)己經(jīng)關(guān)斷時(shí),存留于IGBT器件內(nèi)部的電流就會(huì)立即往仍處于開通狀態(tài)的區(qū)域(比如終端區(qū))涌去造成電流集聚現(xiàn)象,而電流過度集中則會(huì)形成電流絲,進(jìn)而促發(fā)器件內(nèi)部產(chǎn)生動(dòng)態(tài)雪崩現(xiàn)象,這在文獻(xiàn)[22]中稱為延遲故障。通過實(shí)驗(yàn)和數(shù)值模擬驗(yàn)證,大的漏電流導(dǎo)致熱失控[23],而通過研究發(fā)現(xiàn),可以通過 EC這個(gè)能量節(jié)點(diǎn)來解釋反復(fù)短路操作中災(zāi)難性故障和磨損故障的失效機(jī)理。當(dāng)短路能量低于EC時(shí),IGBT還能繼續(xù)重復(fù)運(yùn)作104次。但是,當(dāng)短路能量遠(yuǎn)遠(yuǎn)超出EC時(shí),由于熱失控,IGBT在首次短路后就很可能會(huì)發(fā)生故障。盡管在現(xiàn)有技術(shù)研究[24-25]中已經(jīng)進(jìn)行了許多實(shí)驗(yàn)和數(shù)值模擬,但能量大于EC時(shí)所發(fā)生的失效由于IGBT過應(yīng)力失效的瞬時(shí)性,依舊難以分析。
1.1.2 斷路
IGBT的斷路故障源于振動(dòng)所導(dǎo)致外部斷開,以及由于短路電流過大引起的鍵合線剝離或破裂[26]。它可能產(chǎn)生電流脈沖,輸出電流或電壓失真,并在一段時(shí)間后導(dǎo)致其他組件的二次故障。斷路也可能是由于沒有柵極驅(qū)動(dòng)信號(hào),如設(shè)備中元件的損壞以及IGBT與設(shè)備之間連接線損壞等[27]。
1.2 磨損
對于典型的多層引線鍵合IGBT模塊(圖2),當(dāng)變流器處理大范圍的隨機(jī)波動(dòng)功率時(shí),電流使IGBT模塊長期承受熱循環(huán)沖擊[28]。由于IGBT各層材料與芯片的熱膨脹系數(shù)(Coefficient of Thermal Expansion,CTE)的差異與溫度波動(dòng)相結(jié)合導(dǎo)致了各層的熱形變。其中,鍵合線失效[29-33]和焊料層失效[34-36]是磨損失效的主要方式。

1.2.1 鍵合線失效
眾所周知,典型多層引線鍵合IGBT模塊內(nèi)的三個(gè)易失效的點(diǎn)是硅芯片互連的鋁鍵合線、硅芯片-DCB焊點(diǎn)以及DCB-基板焊點(diǎn)[29]。IGBT模塊中最常見的失效機(jī)制之一是鍵合線剝離。這種失效機(jī)制是由于CTE失配(鋁和硅之間)與溫度波動(dòng)的耦合所造成的[30]。圖3(a)展示了結(jié)溫變化幅度較大的熱疲勞測試中,裂紋沿著鋁鍵合線與芯片表面的接觸界面的兩端傳播到中心的一種裂紋擴(kuò)展現(xiàn)象。當(dāng)裂紋到達(dá)中心時(shí),鍵合線會(huì)翹起[31-32]。根據(jù)文獻(xiàn)[33],通過在硅芯片頂部安裝應(yīng)變緩沖器或使用將連接線粘到硅芯片上的涂層等不同的技術(shù)手段,可以延緩鍵合線的翹曲現(xiàn)象。鍵合線根部開裂是標(biāo)準(zhǔn)鍵合IGBT模塊中可能出現(xiàn)的另一種失效機(jī)制。這種失效是由歐姆自熱所造成的,因此鍵合線根部裂紋是一種比翹曲更為漫長的失效機(jī)制[32]。


1.2.2 焊料層失效
引線鍵合的IGBT模塊的另一個(gè)主要失效機(jī)制是焊料空洞和開裂[34]。在一個(gè)標(biāo)準(zhǔn)的IGBT模塊中有兩個(gè)焊料層:硅芯片DCB之間的焊料層和DCB基板之間的焊料層。因?yàn)镈CB基板與基板之間的CTE失配系數(shù)高于DCB基板與Si之間的,所以DCB基板與基板之間的焊料層更為脆弱。而由于CTE失配,各層材料之間產(chǎn)生交變應(yīng)力,使材料彎曲變形并產(chǎn)生蠕變疲勞,導(dǎo)致焊料層出現(xiàn)裂紋和空洞,進(jìn)而影響了器件內(nèi)熱量的有效傳導(dǎo)(正反饋過程),加速了器件的老化進(jìn)程。而芯片連接的熱阻增加也將引發(fā)嚴(yán)重的局部加熱使芯片損毀[35]。
功率器件的磨損失效過程十分復(fù)雜,文獻(xiàn)[36]認(rèn)為焊料失效是IGBT失效的主要失效機(jī)理,文獻(xiàn)[37]發(fā)現(xiàn)鍵合線故障總是出現(xiàn)在焊料層過溫后。同時(shí)在老化試驗(yàn)中,有70%的功率模塊最終失效表現(xiàn)是鍵合線剝離或熔斷[38]。因此器件磨損失效是鍵合線和焊料層失效共同作用下的表現(xiàn)。
2 主動(dòng)熱控制
功率器件的主動(dòng)熱控制,是將器件結(jié)溫作為反饋量,通過控制器件電氣參數(shù)或外部條件對器件運(yùn)行狀態(tài)進(jìn)行調(diào)整以提高功率器件的可靠性,并延長器件的使用壽命的一種技術(shù)。功率器件的主動(dòng)熱控制可分為內(nèi)部熱控制和外部熱控制[39]。
2.1 外部熱控制
外部熱控制主要通過在器件外部添加散熱裝置按照一定的控制策略調(diào)節(jié)器件外殼到環(huán)境的熱阻,以達(dá)到調(diào)整器件散熱方式和散熱速率的效果。
2.1.1 主動(dòng)冷卻
主動(dòng)冷卻是指冷媒循環(huán)傳熱,利用媒介將熱量從器件內(nèi)部加速帶出至環(huán)境中。目前主動(dòng)冷卻的方式有:風(fēng)冷、直接液冷、微通道、兩相強(qiáng)制對流、射流沖擊以及噴霧換熱。
標(biāo)準(zhǔn)的主動(dòng)冷卻方法中,風(fēng)扇以恒定的速度驅(qū)動(dòng),并施加恒定的偏壓。若以溫度調(diào)節(jié)的方式來區(qū)分,如圖5所示,它是一種前饋控制的方法,在系統(tǒng)中,功率耗散和環(huán)境溫度都會(huì)被調(diào)節(jié)模塊所感應(yīng)到,然后調(diào)制風(fēng)扇轉(zhuǎn)速,來將給定位置處的溫度(TX)降至最低[40]。其優(yōu)點(diǎn)在于這個(gè)系統(tǒng)是開環(huán)的(即它不受穩(wěn)定性問題和環(huán)境條件的影響),這種主動(dòng)冷卻的方法可以預(yù)測溫度變化,也就是說,可以在溫度發(fā)生任何變化之前對干擾(功耗的變化)作出反應(yīng),從而使系統(tǒng)擁有更高的效率。其限制是無法直接監(jiān)測和調(diào)節(jié)TX,而TX是一個(gè)實(shí)際變量,其值會(huì)受給定的參考值的約束[41]。

IGBT應(yīng)用過程中,IGBT的散熱設(shè)計(jì)需要考慮選擇單側(cè)冷卻或雙側(cè)冷卻。而與單側(cè)冷卻液相比,雙面冷卻液可以散去器件內(nèi)76%以上的熱量。然而,常規(guī)焊接式的IGBT很難滿足雙面冷卻的要求。而相較于焊接式的IGBT,壓接式IGBT是最為合適的候選模塊,其可靠性高,且兩側(cè)的導(dǎo)熱系數(shù)高[42],但其造價(jià)較高,使用范圍較窄。目前,大部分的冷卻方式,如強(qiáng)迫風(fēng)冷和單相液冷,都使用單側(cè)冷卻。當(dāng)散熱面比較大的時(shí)候有各種各樣的被動(dòng)冷卻方法將熱量散出,但如果可用于散熱的面積很小,則不可避免地需要使用到主動(dòng)冷卻方法。
2.1.2 熱電制冷
熱電制冷主要利用珀?duì)柼?yīng)將器件溫度傳至環(huán)境中,其制冷效果主要取決于電偶對材料的熱電勢[43-44]。由于半導(dǎo)體材料具有較高的熱電勢,因此,可以用它來制成小型的熱電制冷器。由于熱電制冷器不需要介質(zhì),又無機(jī)械部件,可靠性高,并可以逆向運(yùn)轉(zhuǎn),而且溫度可以精確地控制在±0.01 ℃[45],在電子設(shè)備或電子元器件的熱控制方面得到了比較廣泛的應(yīng)用。早期的熱電制冷主要注重靜態(tài)的熱負(fù)載的研究[46],但隨著電力電子技術(shù)的發(fā)展,器件工況越來越復(fù)雜,就需要將器件溫度作為一種動(dòng)態(tài)熱負(fù)載來看待,即需要考慮更多的問題如額外功耗以及新的控制電路等[47]。目前,熱電制冷(TEC)已成為制冷領(lǐng)域的一個(gè)重要發(fā)展方向,但是由于其轉(zhuǎn)換效率過低且材料成本較高,難以得到廣泛應(yīng)用。
2.2 內(nèi)部熱控制
內(nèi)部熱控制主要從器件發(fā)熱源頭上進(jìn)行溫度控制,可調(diào)節(jié)的因素包括開關(guān)頻率、開關(guān)調(diào)制方式和驅(qū)動(dòng)波形等,如圖6所示[48]。
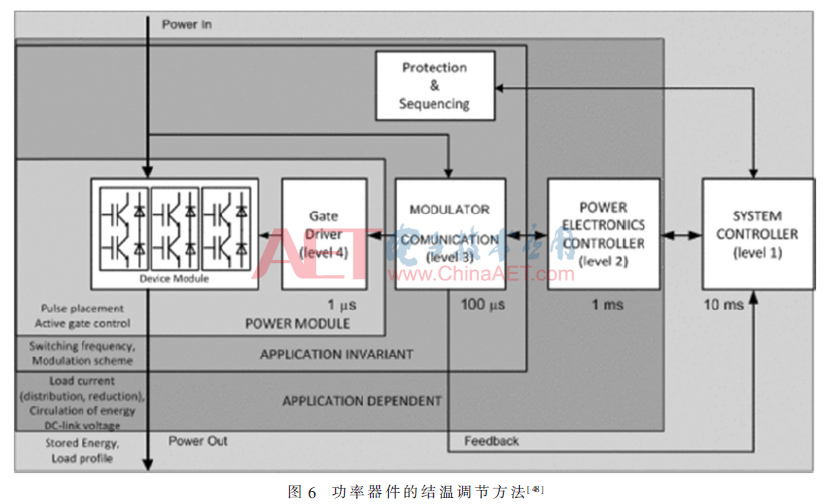
(1)開關(guān)頻率
功率器件在應(yīng)用中,開關(guān)頻率的大小直接影響開關(guān)損耗,因此可以通過調(diào)節(jié)開關(guān)頻率對器件結(jié)溫進(jìn)行控制。文獻(xiàn)[49]中報(bào)道了幾種方法,主要用改變脈沖寬度調(diào)制(PWM)的頻率來限制最大結(jié)溫。在文獻(xiàn)[50]中采用了相同的技術(shù),其目的也是采用滯環(huán)頻率控制來限制結(jié)溫變化,對變頻器啟動(dòng)階段的溫度沖擊抑制效果進(jìn)行了實(shí)驗(yàn)驗(yàn)證,具有良好的控制效果。
(2)開關(guān)調(diào)制方式
眾所周知,器件損耗也會(huì)受到開關(guān)調(diào)制方式的影響,因此也可以通過改變開關(guān)調(diào)制方式來控制結(jié)溫。文獻(xiàn)[51]、文獻(xiàn)[52]中通過在連續(xù)和離散的60°PWM之間的轉(zhuǎn)換來減少損耗以達(dá)到控制結(jié)溫的效果,但由于對電流紋波的影響有所不同,需要仔細(xì)考慮應(yīng)用。
(3)開關(guān)驅(qū)動(dòng)波形調(diào)整
器件開關(guān)損耗還受門極驅(qū)動(dòng)信號(hào)的影響,因此可以通過調(diào)整開關(guān)驅(qū)動(dòng)波形實(shí)現(xiàn)損耗控制[53]。實(shí)現(xiàn)方式是通過外部驅(qū)動(dòng)電路設(shè)計(jì)以調(diào)節(jié)驅(qū)動(dòng)電壓的幅值、上升時(shí)間、下降時(shí)間等。因此,該方法對驅(qū)動(dòng)電路的精度和速度有著較高要求。
綜上所述,不同設(shè)備都可以通過主動(dòng)熱控制來實(shí)現(xiàn)功率模塊中熱循環(huán)的減少。主動(dòng)冷卻可以通過外部設(shè)施來達(dá)到降低器件內(nèi)部結(jié)溫的目的,但氣溫過低時(shí)無法通過利用其進(jìn)行升溫操作,使用時(shí)需要集成其他設(shè)備來完成這一操作;熱電制冷可以通過珀?duì)柼?yīng)平滑結(jié)溫,但其轉(zhuǎn)換效率過低且材料價(jià)格高昂;電參數(shù)法可以直接從發(fā)熱源頭控制溫度,但只能通過控制開關(guān)損耗來降低結(jié)溫,而這種控制卻是以降低系統(tǒng)性能為代價(jià),使用時(shí)需要根據(jù)實(shí)際情況來平衡。
3 結(jié)論
本文系統(tǒng)地綜述和比較了IGBT模塊的各種失效機(jī)理,包括過應(yīng)力失效和磨損失效。并重點(diǎn)介紹了主動(dòng)熱控制這種提高電力電子系統(tǒng)可靠性的實(shí)現(xiàn)手段。
借助對失效機(jī)理的研究,內(nèi)部對IGBT模塊以優(yōu)化封裝結(jié)構(gòu)、優(yōu)化材料、優(yōu)化開關(guān)等方法提高電力電子設(shè)備的運(yùn)行可靠性,外部通過主動(dòng)冷卻,根據(jù)功耗和環(huán)境溫度的變化調(diào)節(jié)散熱效率維持恒溫來提高IGBT模塊的可靠性。
功率器件通常工作在隨機(jī)的功率下,因此利用主動(dòng)熱控制技術(shù)能很好地實(shí)現(xiàn)對于結(jié)溫的控制,但同時(shí),作為新興的一種熱保護(hù)手段,它也還有很多限制,比如在進(jìn)行控制時(shí)并沒有一個(gè)整體的系統(tǒng)框架,環(huán)境溫度與功耗兩者之間的調(diào)節(jié)仍無準(zhǔn)確算法,無法對每次開關(guān)都進(jìn)行完美控制,也沒有考慮模塊的老化所導(dǎo)致的問題以及如何平衡器件性能和溫度控制之間的關(guān)系等。總而言之,研究IGBT功率模塊的主動(dòng)熱控制技術(shù)具有十分重要的理論和實(shí)際工程意義。
參考文獻(xiàn)
[1] JI B,SONG X,MENG W,et al.Integrated condition monitoring for vehicle-ready power modules[C].Transportation Electrifcation Asia-Pacifc(ITEC Asia-Pacifc),2014 IEEE Conference and Expo,Beijing,2014:1-6.
[2] YANG S,BRYANT A,MAWBY P,et al.An industry-based survey of reliability in power electronic converters[J].IEEE Transactions on Industry Applications,2011,47(3):1441-1451.
[3] RAVEENDRAN V,ANDRESEN M,LISERRE M.Improving onboard converter reliability for more electric aircraft with lifetime-based control[J].IEEE Transactions on Industrial Electronics,2019,66(7):5787-5796.
[4] MOORE L M,POST H N.Five years of operating experience at a large,utility-scale photovoltaic generating plant[J].Progress in Photovoltaics:Research & Applications,2008,16(3):249-259.
[5] 王彥剛,Chamund Dinesh,李世平,等.功率IGBT模塊的壽命預(yù)測[J].機(jī)車電傳動(dòng),2013(2):13-17,27.
[6] 劉賓禮,肖飛,羅毅飛,等.基于集電極漏電流的IGBT健康狀態(tài)監(jiān)測方法研究[J].電工技術(shù)學(xué)報(bào),2017,32(16):183-193.
[7] ANDRESEN M,BUTICCHI G,F(xiàn)ALCK J,et al.Active thermal management for a single-phase H-Bridge inverter employing witching frequency control[C].Proceedings of PCIM Europe 2015,International Exhibition and Conference for Power Electronics, Intelligent Motion,Renewable Energy and Energy Management,Nuremberg,Germany,2015:1-8.
[8] THEBAUD J M,WOIRGARD E,ZARDINI C,et al.Strategy for designing accelerated aging tests to evaluate IGBT power modules lifetime in real operation mode[J].IEEE Transactions on Components and Packaging Technologies,2003,26(2):429-438.
[9] MAURO C,CASTELLAZZI A.Reliability of high-power IGBT modules for traction applications[C].IEEE 45th Annual International Reliability Physics Symposium,2007.
[10] PERPINA X,SERVIERE J F,JORDA X,ET AL.Over-current turn-off failure in high voltage IGBT modules under clamped inductive load[C].2009 13th European Conference on Power Electronics and Applications,Barcelona,2009:1-10.
[11] BALIGA B J.Fundamental of power semicondu-ctordevices[M].Springer,2008:938-948.
[12] HOWER P L,KRISHNA REDDI V G.Avalanche injection and second breakdown in transistors[J].IEEE Transactions on Electron Devices,1970,17(4):320-335.
[13] Shen Chih-Chieh,KEFNER A R,BERNING D W,et al.Failure dynamics of the IGBT during turn-off for unclamped inductive loading conditions[C].Conference Record of 1998 IEEE Industry Applications Conference.Thirty-Third IAS Annual Meeting(Cat.No.98CH36242),St.Louis,MO,USA,1998:831-839.
[14] BREGLIO G,IRACE A,NAPOLI E,et al.Experimental detection and numerical validation of different failure mechanisms in IGBTs during unclamped inductive switching[J].IEEE Transactions on Electron Devices,2013,60(2):563-570.
[15] BENMANSOUR A,AZZOPARDI S,MATIN J C,et al.Failure mechanisms of trench IGBT under various short-circuit conditions[C].2007 IEEE Power Electronics Specialists Conference.IEEE,2007.
[16] CHOKHAWALA R S,CATT J,KIRALY L.A discussion on IGBT short-circuit behavior and fault protection schemes[J].IEEE Transactions on Industry Applications,1995,31(2):256-263.
[17] HEUMANN K,QUENUM M.Second breakdown and latch-up behavior of IGBTs[C].1993 Fifth European Conference on Power Electronics and Applications.IET,1993.
[18] TAKATA I.Non thermal destruction mechanisms of IGBTs in short circuit operation[C].Proceedings of the 14th International Symposium on Power Semiconductor Devices and ICs.IEEE,2002.
[19] Wang Bo,Hu An,Tang Yong,et al.Analysis of voltage breakdown characteristic of IGBT[J].Diangong Jishu Xuebao(Transactions of China Electrotechnical Society),2011,26(8):145-150.
[20] MASAYASU I,HOTTA K,KAWAJI S,et al.Investigation of IGBT turn-on failure under high applied voltage operation[J].Microelectronics Reliability,2004,44:1431-1436.
[21] HOON O K,KIM Y C,LEE K H,et al.Investigation of short-circuit failure limited by dynamic-avalanche capa-bility in 600-V punchthrough IGBTs[J].IEEE Transactions on Device and Materials Reliability,2006,6 (1):2-8.
[22] LASKA T,MILLER G,PFAFFENLEHNER M,et al.Short circuit properties of Trench-/Field-Stop-IGBTs-design aspects for a superior robustness[C].ISPSD′03.2003 IEEE 15th International Symposium on Power Semicon-ductor Devices and ICs,2003.Proceedings.,Cambridge,UK,2003:152-155.
[23] LEFEBVRE S,KHATIR Z,SAINT-EVE F.Experimental behavior of single-chip IGBT and COOLMOS devices under repetitive short-circuit conditions[J].IEEE Transactions on Electron Devices,2005,52(2):276-283.
[24] KHATIR Z,LEFEBVRE S,SAINT-EVE F.Experimental and numerical investigations on delayed short-circuit failure mode of single chip IGBT devices[J].Microelectronics Reliability,2007,47(2-3):422-428.
[25] CIAPPA M.Selected failure mechanisms of modern power modules[J].Microelectronics Reliability,2002,42(4-5):653-667.
[26] LOH W S,CORFIELD M,LU H,et al.Wire bond relia-bility for power electronic modules-effect of bonding temperature[C].2007 International Conference on Thermal, Mechanical and Multi-Physics Simulation Experiments in Microelectronics and Micro-Systems.EuroSime,2007.
[27] SMITH K S,RAN L,PENMAN J.Real-time detection of intermittent misfiring in a voltage-fed PWM inverter induction-motor drive[J].IEEE Transactions on Industrial Electronics,1997,44(4):468-476.
[28] LAI W,CHEN M Y,RAN L,et al.Experimental investigation on the effects of narrow junction temperature cycles on die-attach solder layer in an IGBT module[J].IEEE Transactions on Power Electronics,2017,32(2):1431-1441.
[29] CHRISTOPHE D,SICONOLF I S,MOURRA O,et al.MOSFET gate open failure analysis in power electronics[C].2013 Twenty-Eighth Annual IEEE Applied Power Electronics Conference and Exposition(APEC).IEEE,2013.
[30] KOVACEVIC I F,DROFENIK U,KOLAR J W.New physical model for lifetime estimation of power modules[C].The 2010 International Power Electronics Conference-ECCE ASIA-.IEEE,2010:2106-2114.
[31] 周文棟,王學(xué)梅,張波,等.IGBT模塊鍵合線失效研究[J].電源學(xué)報(bào),2016,14(1):10-17.
[32] 王學(xué)梅,張波,吳海平.基于失效物理的功率器件疲勞失效機(jī)理[J].電工技術(shù)學(xué)報(bào),2019,34(4):717-727.
[33] CIAPPA M.Selected failure mechanisms of modern power modules[J].Microelectronics Reliability,2002,42(4-5):653-667.
[34] 李亞萍,周雒維,孫鵬菊.IGBT功率模塊加速老化方法綜述[J].電源學(xué)報(bào),2016,14(6):122-135.
[35] PECHT M.Prognostics and health management of electronics[M].Encyclopedia of Structural Health Monitoring,2009.
[36] DE D R,SCHEUERMANN U,SCHLANGENOTTO H,et al.Semiconductor power devices:physics,characteristics,reliability[M]. Springer,2018.
[37] KRUGER M,TRAMPERT S,MIDDENDORF A,et al.Earlystate crack detection method for heel-cracks in wire bond interconnects[C].2014 IEEE 64th Electronic Components and Technology Conference(ECTC).IEEE,2014:114-118.
[38] 王春雷,鄭利兵,方化潮,等.鍵合線失效對于IGBT模塊性能的影響分析[J].電工技術(shù)學(xué)報(bào),2014,29(S1):184-191.
[39] ANDRESEN M,BUTICCHI G,LISERRE M.Study of relia-bility-efficiency tradeoff of active thermal control for power electronic systems[J].Microelectronics Reliability,2016,58:119-125.
[40] LIU H B,LIU H H,LIU S T,et al.Investigation of load current feed-forward control strategy for wind power grid connected inverter through VSC-HVDC[C].AIP Conference Proceedings.AIP Publishing,2018,1971(1):040012
[41] Qian Cheng,GHEITAGHY A M,F(xiàn)an Jiajie,et al.Thermal management on IGBT power electronic devices and modules[J].IEEE Access,2018,6:12868-12884.
[42] LUO Z,AHN H,NOKALI M.A thermal model for insulated gate bipolar transistor module[J].IEEE Transactions on Power Electronics,2004,19:902-907.
[43] DISALVO F J.Thermoelectric cooling and power generation[J].Science,1999,285(5428):703-706.
[44] 郭琛,潘開林,程浩.熱電制冷技術(shù)的研究進(jìn)展[J].微納電子技術(shù),2018,55(12):927-931.
[45] SLACK G A,ROWE D M.Thermoelectric Handbook.Boca Raton,1995.
[46] ABBAS T,ABD_ELSALAM K M,KHODAIRY K H.CPU thermal management of personal and notebook computer(Transient study)[C].2010 3rd International Conference on Thermal Issues in Emerging Technologies Theory and Applications.IEEE,2010.
[47] LI C,JIAO D,JIA J,et al.Thermoelectric cooling for power electronics circuits:modeling and active temperature control[C].IEEE Transactions on Industry Applications,2014,50(6)3995-4005.
[48] ANDRESEN M,LISERRE M,BUTICCHI G.Review of active thermal and lifetime control techniques for power electronic modules[C].2014 16th European Conference on Power Electronics and Applications,Lappeenranta,2014:1-10.
[49] BLASKO V,LUKASZEWSKI R,SLADKY R.On line thermal model and thermal management strategy of a three phase voltage source inverter[C].Conference Record of the 1999 IEEE Industry Applications Conference.Thirty-Forth IAS Annual Meeting(Cat.No.99CH36370).IEEE,1999,2:1423-1431.
[50] MURDOCK D A,TORRES J E R,CONNORS J J,et al.Active thermal control of power electronic modules[J].IEEE Transactions on Industry Applications,2006,42(2):552-558.
[51] WECKERT M,ROTH-STIELOW J.Chances and limits of a thermal control for a three-phase voltage source inverter in traction applications using permanent magnet synchronous or induction machines[C].Proceedings of the 2011 14th European Conference on Power Electronics and Applications.IEEE,2011:1-10.
[52] CALZO G L,LIDOZZI A,SOLERO L,et al.Thermal regulation as control reference in electric drives[C].2012 15th International Power Electronics and Motion Control Conference(EPE/PEMC).IEEE,2012:DS2c.18-1-DS2c.18-7.
[53] WU T,CASTELLAZZI A.Temperature adaptive IGBT gate-driver design[C].Proceedings of the 2011 14th European Conference on Power Electronics and Applications.IEEE,2011:1-6.
作者信息:
周小康1,馬 奎1,2,梁 蓓1,2
(1.貴州大學(xué) 大數(shù)據(jù)與信息工程學(xué)院,貴州 貴陽550025;
2.半導(dǎo)體功率器件可靠性教育部工程研究中心,貴州 貴陽550025)

