文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.190961
中文引用格式: 伍文俊,蘭雪梅. GaN FET的結(jié)構(gòu)、驅(qū)動(dòng)及應(yīng)用綜述[J].電子技術(shù)應(yīng)用,2020,46(1):22-29,38.
英文引用格式: Wu Wenjun,Lan Xuemei. Overview on GaN FET structure, driving and its application[J]. Application of Electronic Technique,2020,46(1):22-29,38.
0 引言
氮化鎵(GaN)為第三代寬禁帶半導(dǎo)體材料,在高溫、高壓、高頻等應(yīng)用場(chǎng)合其半導(dǎo)體器件的特性都要優(yōu)于Si基半導(dǎo)體器件,因此,在電力電子的應(yīng)用領(lǐng)域備受矚目。
用GaN材料制成的功率器件GaN FET具有低的擊穿電壓、低的閾值電壓、低的柵極電荷Qg,其開關(guān)頻率高,導(dǎo)通電阻小。GaN FET優(yōu)越的特性與其器件結(jié)構(gòu)有極大的關(guān)系。但是它的缺點(diǎn)也不可忽視,在高頻應(yīng)用場(chǎng)合表現(xiàn)極為明顯,比如其對(duì)寄生參數(shù)極其敏感,高頻使用時(shí)極易使柵極電壓產(chǎn)生振蕩,引起柵極過電壓,導(dǎo)致器件工作不穩(wěn)定,甚至不安全。因此相較于傳統(tǒng)的Si基半導(dǎo)體器件的驅(qū)動(dòng)電路,GaN FET的驅(qū)動(dòng)要求更為嚴(yán)苛。GaN FET的進(jìn)步、應(yīng)用的發(fā)展與其器件結(jié)構(gòu)和驅(qū)動(dòng)電路有密不可分的聯(lián)系,因此,其器件結(jié)構(gòu)和驅(qū)動(dòng)電路的研究很有意義。本文將對(duì)當(dāng)前國內(nèi)外GaN FET的器件結(jié)構(gòu)、驅(qū)動(dòng)電路及其在電機(jī)驅(qū)動(dòng)、LED驅(qū)動(dòng)、光伏逆變器、POL等場(chǎng)合中的應(yīng)用進(jìn)行綜述。
1 GaN FET的器件結(jié)構(gòu)及工作原理
GaN FET器件的結(jié)構(gòu)目前主要有耗盡型(Depletion mode,D-mode)和增強(qiáng)型(Enhancement mode,E-mode)。增強(qiáng)型GaN FET又分單體GaN和Cascade GaN(共柵共源)。
1.1 耗盡型GaN FET
耗盡型GaN FET的器件結(jié)構(gòu)如圖1所示。耗盡型GaN FET采用Si材料作為GaN FET的基片,在Si基片基礎(chǔ)上生長出高阻性的GaN晶體層,即氮化鎵通道層(GaN channel)。一般在GaN層和Si襯底層之間添加氮化鋁(AIN)絕緣層作為氮化鎵緩沖層(GaN buffer),將器件和襯底隔離開來。AlGaN層存在GaN層和柵極(G)、源極(S)和漏極(D)之間;AlGaN層和GaN層之間可以產(chǎn)生具有高電子遷移率、低電阻特性的二維電子氣(Two-Dimensional Electron Gas,2DEG),且它的濃度隨AlGaN厚度先線性增加,然后達(dá)到飽和。

與Si傳統(tǒng)器件不同,耗盡型GaN FET由于氮化物極強(qiáng)的極化效應(yīng),AlGaN/GaN異質(zhì)結(jié)可以通過自發(fā)極化和壓電極化效應(yīng)在其界面形成很高濃度2DEG導(dǎo)電溝道,在零柵壓下,器件處于導(dǎo)通狀態(tài)。因此往往需要負(fù)壓關(guān)斷。耗盡型GaN FET不同于Si MOSFET的是,由于其柵極下方不存在與S極連接的P型寄生雙極性區(qū),因此沒有寄生體二極管,故而器件開關(guān)損耗小、具有對(duì)稱的傳導(dǎo)特性。因此GaN FET可由正柵源電壓VGS或正柵漏電壓VGD驅(qū)動(dòng)。
1.2 增強(qiáng)型GaN FET
對(duì)于耗盡型GaN FET,要關(guān)斷器件,必須加負(fù)柵壓。這意味著電路中一旦有耗盡型GaN FET,就會(huì)增加?xùn)艠O驅(qū)動(dòng)設(shè)計(jì)的復(fù)雜性,而且易發(fā)生誤導(dǎo)通,有直通的潛在威脅,使電路穩(wěn)定性和安全性降低。增強(qiáng)型GaN FET則相反,只有加正偏壓才會(huì)導(dǎo)通,減小了電路復(fù)雜性,穩(wěn)定性和安全性也較好。目前,增強(qiáng)型GaN FET主要是在耗盡型高電子遷移率晶體管(Gallium Nitride High Electron Mobility Transistor,GaN HEMT)結(jié)構(gòu)的基礎(chǔ)上改進(jìn)而成。目前主要的增強(qiáng)型GaN FET結(jié)構(gòu)方案包括:P型柵、凹槽柵、Cascode結(jié)構(gòu)等。
1.2.1 P型柵結(jié)構(gòu)
有很多學(xué)者研究P型柵結(jié)構(gòu)的GaN FET,如圖2所示[1-2]。與耗盡型不同的是,P型柵結(jié)構(gòu)是在AlGaN勢(shì)壘層上生長了一個(gè)帶正電的P型GaN柵極,如圖2中的P-GaN層。P型GaN層可以拉升AlGaN勢(shì)壘層的能帶,起到耗盡2DEG的作用,以實(shí)現(xiàn)常斷特性。當(dāng)施加足夠的正VGS時(shí),使柵源電壓大于閾值電壓,P-GaN層的內(nèi)電場(chǎng)被削弱,2DEG濃度上升,形成導(dǎo)通溝道,GaN FET器件導(dǎo)通。隨著VGS的降低且小于閾值電壓,溝道又逐漸關(guān)閉,GaNFET器件關(guān)斷。因此,這種結(jié)構(gòu)主要是通過控制P型柵極勢(shì)壘的電位,升降A(chǔ)lGaN勢(shì)壘層的能帶,使2DEG的濃度改變來實(shí)現(xiàn)對(duì)GaNFET器件的通斷控制。

文獻(xiàn)[3]在P型柵結(jié)構(gòu)的基礎(chǔ)上,采用在P-GaN層上沉積TiN金屬,形成三層掩膜的柵極結(jié)構(gòu),從而實(shí)現(xiàn)肖特基接觸,如圖3所示。這種結(jié)構(gòu)存在柵極場(chǎng)板,可增加高壓應(yīng)用場(chǎng)板設(shè)計(jì)的靈活性。實(shí)驗(yàn)證明,這種結(jié)構(gòu)具有低柵極電阻、降低高漏源電壓VDS時(shí)的導(dǎo)通電阻RDS-ON等優(yōu)勢(shì),且相比采用歐姆接觸的P-GaN結(jié)構(gòu),此結(jié)構(gòu)降低了柵極漏電流。

1.2.2 凹槽柵結(jié)構(gòu)
凹槽柵[4]結(jié)構(gòu)如圖4所示,此結(jié)構(gòu)通過電感耦合等離子體(Inductively Couple Plasma,ICP)干法刻蝕技術(shù)刻蝕掉柵極下方區(qū)域一定厚度的AlGaN勢(shì)壘層,當(dāng)AlGaN勢(shì)壘層厚度減薄到一定程度時(shí),溝道內(nèi)的2DEG濃度會(huì)足夠低[5]。凹型柵極下方的整個(gè)AlGaN勢(shì)壘層被去除,柵極下的2DEG消失,柵極金屬下沉積了Al2O3膜作為柵極電介質(zhì),可防止由于器件尺寸越來越小而引發(fā)嚴(yán)重柵極漏電流、擊穿電壓過低等問題。在零柵壓下,2DEG濃度小到可以忽略,器件處于關(guān)斷狀態(tài)。只有施加正柵壓后,導(dǎo)電通道才會(huì)恢復(fù),實(shí)現(xiàn)器件導(dǎo)通,即實(shí)現(xiàn)增強(qiáng)型特性。但除去柵極下方的勢(shì)壘層,AlGaN勢(shì)壘層其他區(qū)域的未被減薄,2DEG濃度保持原有水平。因此,凹槽柵技術(shù)制成的GaN FET在飽和電流和跨導(dǎo)方面較有優(yōu)勢(shì)。

1.2.3 Cascode結(jié)構(gòu)
Cascode結(jié)構(gòu)是由高壓耗盡型GaN HEMT和低壓增強(qiáng)型Si MOSFET(金屬氧化物半導(dǎo)體場(chǎng)效應(yīng)晶體管)級(jí)聯(lián)構(gòu)成的,如圖5所示。
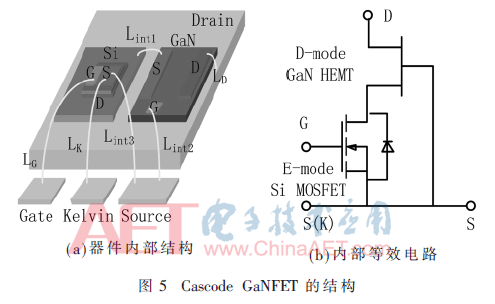
從結(jié)構(gòu)可知,當(dāng)器件不加?xùn)艍呵衣┰措妷捍笥诹銜r(shí),工作在正向阻斷模態(tài);當(dāng)柵壓大于Si MOSFET的閾值電壓時(shí),器件正向?qū)ǎ灰坏㏒i MOSFET反向?qū)ǎ骷⒐ぷ髟诜聪驅(qū)B(tài)。又因?yàn)镾i MOSFET的漏源電壓Vds_Si給GaN HEMT的柵源電壓Vgs_GaN提供負(fù)偏置電壓,因此控制Si MOSFET的通斷即可控制GaN HEMT的通斷。當(dāng)然,這種結(jié)構(gòu)由于引入了硅基器件,因此對(duì)封裝的要求較高,體積也較大。
與其他結(jié)構(gòu)GaNFET相比,Cascode GaNFET的結(jié)構(gòu),電壓等級(jí)較高、驅(qū)動(dòng)電壓范圍較寬,但對(duì)dv/dt和di/dt敏感,特別是在高頻時(shí),共源電感過大[6]可能會(huì)使器件損壞。Andrew等人通過將智能柵極驅(qū)動(dòng)與Si MOSFET集成,驅(qū)動(dòng)耗盡型GaN HEMT,形成智能Cascade GaNFET,如圖6所示。該智能Cascade GaNFET內(nèi)置電流檢測(cè)、可調(diào)輸出電阻、可調(diào)電流檢測(cè)率和智能數(shù)字控制[7]。實(shí)驗(yàn)表明,此改進(jìn)的Cascode結(jié)構(gòu)通過利用動(dòng)態(tài)開關(guān)技術(shù),可以減少柵極振蕩、降低高電壓和電流轉(zhuǎn)換速率、解決dv/dt和di/dt問題,優(yōu)化EMI。
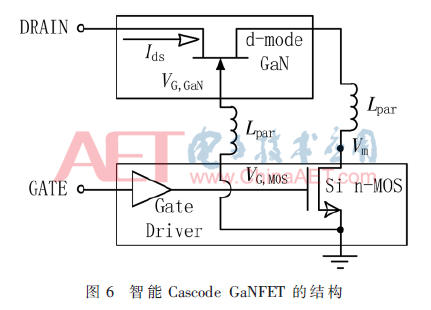
2 GaN FET的產(chǎn)品現(xiàn)狀
目前,生產(chǎn)耗盡型GaN FET的公司主要有美國Cree,其產(chǎn)品主要的參數(shù)如表1所示,為推廣耗盡型GaNHEMT的應(yīng)用,Transphorm公司推出了Cascode結(jié)構(gòu)的GaN FET。從表1可知Cree公司的GaN FET的閾值電壓為負(fù)值,充分體現(xiàn)了它在零柵壓下的常通特性。

增強(qiáng)型GaN FET的生產(chǎn)商則相對(duì)較多,主要包括中國香港的EPC、加拿大的GaN Systems、日本Panasonic公司等,它們的主要參數(shù)見表2。從表2可知,在增強(qiáng)型GaN FET產(chǎn)品中,GaN Systems公司的電壓電流等級(jí)較高,但閾值電壓較小;EPC公司的電壓等級(jí)較低,驅(qū)動(dòng)電壓范圍最窄,導(dǎo)通損耗較大,但漏極電流等級(jí)最多;Panasonic公司的電壓和電流等級(jí)最少,閾值電壓最低,但開通較快;Transphorm公司的電壓等級(jí)較高,驅(qū)動(dòng)范圍最廣,閾值電壓較高[8],使用較安全。
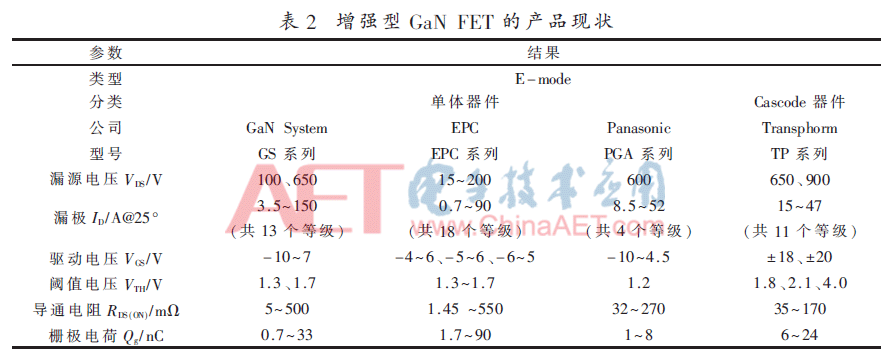
表3是GaN FET主要的封裝形式,從表可知,增強(qiáng)型GaN FET的封裝結(jié)構(gòu)中貼片式的使用較多,直插式的較少。貼片式的外部引腳寄生效應(yīng)影響較小,但不利于散熱;直插式則相反,其散熱能力較好,但高頻時(shí)往往易受寄生參數(shù)影響。
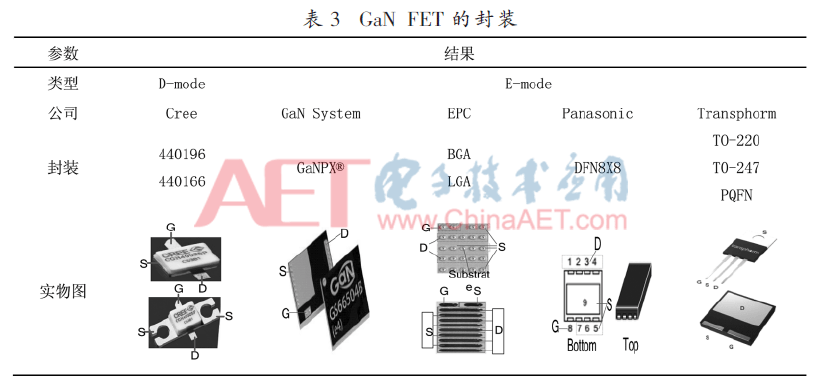
此外,除單體GaN器件,還有集成式GaN模塊產(chǎn)品。目前GaN集成形式最多的是GaN半橋模塊,主要有EPC和GaN Systems在生產(chǎn)。其中EPC2104(100 V,30 A)、GS66508T(650 V,30 A)分別是兩家公司等級(jí)最高的GaN半橋模塊產(chǎn)品。
3 GaN FET的驅(qū)動(dòng)
3.1 隔離方式
驅(qū)動(dòng)電路位于主電路與控制電路之間,其輸出與主電路有耦合關(guān)系,其輸入與控制電路相連。因此,驅(qū)動(dòng)電路往往需要隔離設(shè)計(jì)。一般的隔離方式主要分為光耦隔離和變壓器隔離。目前,相較于變壓器隔離,GaN FET驅(qū)動(dòng)電路的隔離中用光耦隔離[9-10]的較多。光耦隔離的參數(shù)設(shè)計(jì)較簡(jiǎn)單,但其輸出需要隔離驅(qū)動(dòng)電源。目前,GaN FET驅(qū)動(dòng)電路的分類主要是由分立元件構(gòu)成的驅(qū)動(dòng)電路和以集成器件為主構(gòu)成的驅(qū)動(dòng)電路。
3.2 驅(qū)動(dòng)電路的基本要求
增強(qiáng)型GaN FET的低柵源電壓VGS、低閾值電壓VTH以及寄生參數(shù)等影響,使得傳統(tǒng)的Si驅(qū)動(dòng)電路不再適用于GaN,GaNFET的驅(qū)動(dòng)要求更為嚴(yán)格,其驅(qū)動(dòng)電路至少具備以下三個(gè)功能:
(1)驅(qū)動(dòng)信號(hào)可靠性。驅(qū)動(dòng)信號(hào)的可靠性對(duì)于驅(qū)動(dòng)電路來說是很重要的,驅(qū)動(dòng)信號(hào)一旦不穩(wěn)定極有可能損壞GaN器件。因此,一定要保證驅(qū)動(dòng)信號(hào)可靠傳輸。一般在通信系統(tǒng)中或使用頻率在兆赫茲等級(jí)以上時(shí),常用微波驅(qū)動(dòng)(Drive-by-Mcrowave,DBM)技術(shù)來傳輸驅(qū)動(dòng)信號(hào)[11]。
(2)抗擾性能。GaN FET的低閾值電壓使其對(duì)di/dt、dv/dt和寄生電感極其敏感,若驅(qū)動(dòng)的抗擾性不好,開關(guān)頻率的增加不僅使器件損耗增多,嚴(yán)重時(shí)還會(huì)損壞器件。因此,驅(qū)動(dòng)需要較好的抗擾性。一般采取減小共源電感、增加驅(qū)動(dòng)電阻等方法提高驅(qū)動(dòng)抗擾性。
(3)漏源回路寄生電感小。GaN FET柵極信號(hào)的噪聲[12]和振蕩很強(qiáng),一旦回路寄生電感過大會(huì)導(dǎo)致關(guān)斷時(shí)出現(xiàn)過電壓和寄生振蕩,導(dǎo)致額外的損耗。因此可優(yōu)化驅(qū)動(dòng)回路,減小寄生電感。
3.3 分立式GaN FET驅(qū)動(dòng)電路
增強(qiáng)型GaN FET一般的分立式驅(qū)動(dòng)電路如圖7所示。分立式驅(qū)動(dòng)電路由驅(qū)動(dòng)電源VCC、PWM信號(hào)、隔離和柵極電阻RG等基本部分組成。前面幾部分主要是給GaN FET提供驅(qū)動(dòng)電壓VGS。

圖8為GaN FET峰值箝位驅(qū)動(dòng)電路。通過加入二極管-電阻-電容網(wǎng)絡(luò)對(duì)柵極進(jìn)行箝位保護(hù)[13],此箝位電路可以有效抑制開通過程的柵極電壓峰值和漏極電流峰值。其中,R1和C1可使器件快速開關(guān)并抑制柵極電壓峰值,但在關(guān)斷過程會(huì)產(chǎn)生負(fù)的柵極電壓尖峰;故用D1、R3支路提高關(guān)斷時(shí)C1的放電速率,且R3越大,C1放電越快。
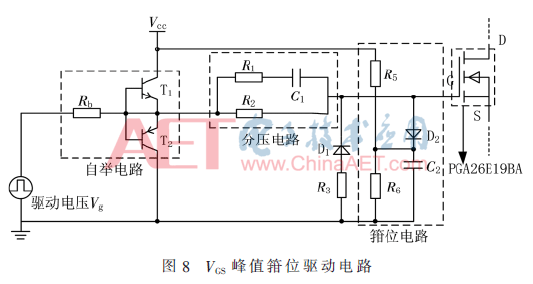
文獻(xiàn)[14]提出了一種降低反向?qū)〒p耗的GaN FET的新型柵驅(qū)動(dòng)電路,如圖9所示。作者在分壓型驅(qū)動(dòng)的基礎(chǔ)上加入了由電阻R3、電容C3、P溝道MOSFET自激開關(guān)Q1和二極管Dg組成的電路,如圖9虛線部分所示。其中,C3、R3的值要比C2、R2的值大得多,因此,C2比C3充放電快得多。關(guān)斷時(shí),未改進(jìn)前的分壓驅(qū)動(dòng)中,分壓電容C2存儲(chǔ)的電荷會(huì)產(chǎn)生高負(fù)VGS使反向?qū)〒p耗增加。改進(jìn)后,加入的虛線部分電路可使C2放電,使VGS幾乎降為零。另外,VGS受二極管Dg的正向壓降限制。因此,該驅(qū)動(dòng)設(shè)計(jì)有效減少了器件反向特性引起的損耗。

文獻(xiàn)[15]基于Transphorm公司的雙向GaN,設(shè)計(jì)具有抗dv/dt的雙向GaN FET驅(qū)動(dòng)電路,如圖10所示。數(shù)字隔離器具有高共模瞬態(tài)抗擾度,可防止高dv/dt的影響;鐵氧體磁珠用來抑制柵極電壓的振蕩;緩沖電路放在器件附近可以抑制浪涌電壓。
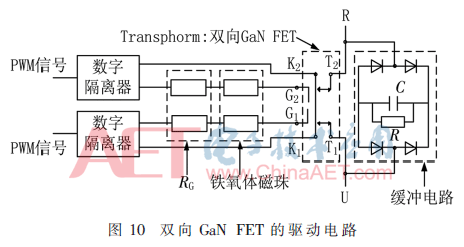
目前,已有的可變柵極驅(qū)動(dòng)在瞬態(tài)期間或之外只能改變每次開關(guān)事件的一次單驅(qū)動(dòng)參數(shù),而文獻(xiàn)[16]設(shè)計(jì)的有源驅(qū)動(dòng)在開關(guān)瞬態(tài)期間,可激活0.12 Ω~64 Ω間的任意上拉或下拉柵極驅(qū)動(dòng)輸出電阻,且達(dá)到6.7 GHz的有效電阻更新率,電路如圖11所示。實(shí)驗(yàn)表明,開環(huán)有源柵極驅(qū)動(dòng)能保持低開關(guān)損耗,減少過沖、振蕩和EMI。

3.4 集成式GaN FET驅(qū)動(dòng)電路
一般的分立式驅(qū)動(dòng)電路分立元件多,電路結(jié)構(gòu)較復(fù)雜,導(dǎo)致保護(hù)也復(fù)雜,從而可靠性變差。因此,實(shí)際應(yīng)用中大多采用集成驅(qū)動(dòng)電路。集成式驅(qū)動(dòng)電路主要由驅(qū)動(dòng)芯片和其他元件組成,如圖12所示。而在GaN FET的集成驅(qū)動(dòng)中,常用的驅(qū)動(dòng)芯片有LM5113[17-22]、UCC27611[9,21]、UCC21520[23]等。

3.4.1 LM5113集成式驅(qū)動(dòng)電路
LM5113是專為驅(qū)動(dòng)同步buck或半橋配置的高端和低端增強(qiáng)型GaN FET而設(shè)計(jì)的驅(qū)動(dòng)芯片。該芯片采用自舉技術(shù)生成高端偏置電壓,并在內(nèi)部將其箝位在5.2 V,防止柵極電壓超過GaN FET 的最大柵源電壓額定值。
文獻(xiàn)[22]提出了三電平驅(qū)動(dòng)技術(shù),驅(qū)動(dòng)電路如圖13所示。只有當(dāng)在死區(qū)時(shí)間,CON為高信號(hào)時(shí),下管Vgs變?yōu)閂x(Vx<Vth)。理論上,當(dāng)Vx接近Vth時(shí),反向?qū)▔航禐?。實(shí)驗(yàn)證明,與兩電平驅(qū)動(dòng)相比,該驅(qū)動(dòng)使GaN FET反向?qū)▔航档玫接行Ы档停瑥亩岣吡俗儞Q器的效率。

3.4.2 UCC27611集成式驅(qū)動(dòng)電路
UCC27611是單通道高速柵極驅(qū)動(dòng)器,驅(qū)動(dòng)電壓VREF被內(nèi)部線性穩(wěn)壓器精確穩(wěn)壓至5 V。其具有最低寄生電感的封裝和引腳分配,減少了上升和下降時(shí)間并限制了振鈴。文獻(xiàn)[21]采用的集成驅(qū)動(dòng)電路如圖14所示,此電路的回路面積只有原來的1/30,有效減少了寄生電感,從而減少了對(duì)驅(qū)動(dòng)電壓的干擾。

文獻(xiàn)[9]基于UCC17611設(shè)計(jì)的集成驅(qū)動(dòng)不同于圖14,其設(shè)計(jì)的電路在驅(qū)動(dòng)橋壁上管時(shí)驅(qū)動(dòng)信號(hào)先經(jīng)通用CMOS鎖相環(huán)集成電路CD4046,再經(jīng)光耦數(shù)字隔離器Si8610BC后才由UCC27611驅(qū)動(dòng),而下管驅(qū)動(dòng)信號(hào)則不隔離直接經(jīng)過UCC27611驅(qū)動(dòng)。這種方式可以避免橋壁直通,因?yàn)樯瞎艿尿?qū)動(dòng)信號(hào)經(jīng)過光耦等元件后,必定與下管驅(qū)動(dòng)信號(hào)不同步,有延時(shí)。
3.4.3 UCC21520集成式驅(qū)動(dòng)電路
UCC21520是隔離雙通道柵極驅(qū)動(dòng)器,輸出的兩通道驅(qū)動(dòng)信號(hào)互補(bǔ)。當(dāng)PWM信號(hào)INA為高電平時(shí),輸出OUTA驅(qū)動(dòng)上管開通;INB為高電平時(shí),輸出OUTB驅(qū)動(dòng)下管,且INA與INB是互補(bǔ)信號(hào)。文獻(xiàn)[23]采用UCC21520設(shè)計(jì)了含有源箝位的GaNFET驅(qū)動(dòng)如圖15所示。由于芯片內(nèi)部集成有死區(qū)電路,所以可通過改變驅(qū)動(dòng)電路中外接電阻R29的阻值來調(diào)節(jié)死區(qū)。磁珠起減緩柵極電路中產(chǎn)生較大電壓振蕩的作用;穩(wěn)壓管用來防止柵源電壓VGS波動(dòng)太大使開關(guān)損壞;箝位三極管V6可抑制干擾導(dǎo)致誤開通的現(xiàn)象。可見,該集成驅(qū)動(dòng)電路的抗擾性較好。
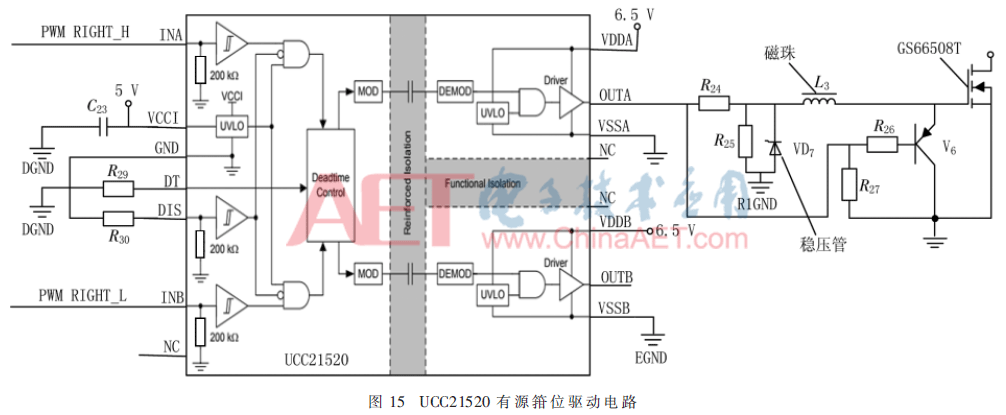
4 GaN FET的典型應(yīng)用
4.1 在電機(jī)驅(qū)動(dòng)中的應(yīng)用
眾所周知,在電力工業(yè)中60%以上負(fù)載是電機(jī)。在節(jié)能減排的大環(huán)境下,電機(jī)的驅(qū)動(dòng)變換器向低功耗、高功率密度、高效率發(fā)展。為實(shí)現(xiàn)這些目標(biāo),人們把目光轉(zhuǎn)向GaN等功率器件,利用GaN FET的特性提高電機(jī)驅(qū)動(dòng)變換器的性能。
文獻(xiàn)[1]針對(duì)5 kW三相電機(jī),采用了GaN 3×3逆變模塊完成了矩陣變換器的控制,大大減小了系統(tǒng)的損耗和體積。在10 kHz工作時(shí),變換器效率達(dá)到96%,功耗低于1 W,體積減少不少于1%。
同樣在5 kW電機(jī)驅(qū)動(dòng)中,由于傳統(tǒng)隔離柵極驅(qū)動(dòng)器在高溫下光耦的使用壽命短,因此文獻(xiàn)[24]設(shè)計(jì)了適于高溫的帶隔離的微波驅(qū)動(dòng)半橋柵極驅(qū)動(dòng)器。此驅(qū)動(dòng)采用PGA26C09DV,使得GaN逆變器工作在1 MHz時(shí),開關(guān)損耗恒為0.9 W,效率達(dá)到了94%[11],且在140°的環(huán)境溫度中也能提供足夠的柵極功率。
文獻(xiàn)[25]通過對(duì)采用型號(hào)為TPH3206LD的GaN FET和型號(hào)為IPL60R185P7的Si MOSFET的三相逆變器的性能比較后發(fā)現(xiàn),開關(guān)頻率在10 kHz~100 kHz變化時(shí),GaN逆變器的開關(guān)損耗占總損耗的12%~55%、效率在97.8%~96.4%之間;而Si的損耗為36%~77%,10 kHz時(shí)效率只有96.9%。可見,GaN逆變器應(yīng)用到電機(jī)驅(qū)動(dòng)中,其性能要優(yōu)于Si的,也更有潛力。
4.2 在LED驅(qū)動(dòng)中的應(yīng)用
LED壽命長、效率高、節(jié)能等優(yōu)勢(shì)使其越來越受歡迎,但LED是直流供電,因此變換器成為其必不可少的一部分。由于變換器極貼近LED燈,這要求變換器小型化、能在高溫下運(yùn)行。而小型化需要開關(guān)頻率在兆赫茲范圍,因此GaN等新型寬禁帶半導(dǎo)體在LED驅(qū)動(dòng)中有潛在的市場(chǎng)。
Eric等人提出一種小而簡(jiǎn)單的模擬磁滯控制谷底開關(guān)(準(zhǔn)諧振)浮動(dòng)Buck變換器[26],該變換器使用了GaN FET器件。并通過實(shí)驗(yàn)證明,600 V GaN FET在MHz頻率等級(jí)的優(yōu)越開關(guān)性能使得變換器尺寸有效減小,從而進(jìn)一步提高了功率密度,并使20 W的LED在2.5~4.4 MHz時(shí)效率達(dá)到91.2%。可見,GaN FET在LED驅(qū)動(dòng)應(yīng)用的前景非常可觀。
4.3 其他應(yīng)用場(chǎng)合
4.3.1 光伏逆變器
光伏電池板與電網(wǎng)存在電氣連接,逆變器的高頻行為所導(dǎo)致的共模電壓通過光伏板與大地之間的寄生電容,形成共模電流,而共模電流會(huì)引起并網(wǎng)電流的畸變,產(chǎn)生電磁干擾,嚴(yán)重時(shí)會(huì)對(duì)人的安全產(chǎn)生威脅。因此,需要抑制或消除非隔離型光伏并網(wǎng)系統(tǒng)中的共模電流,基于型號(hào)TPH3006PS的GaN雙buck并網(wǎng)逆變器有效解決了這個(gè)問題。經(jīng)實(shí)驗(yàn)證明,其效率達(dá)到98.63%[27]。
4.3.2 POL
隨著負(fù)載點(diǎn)技術(shù)(Point of Load,POL)在信息通信技術(shù)ICT設(shè)備中的應(yīng)用,開關(guān)頻率達(dá)到30 MHz時(shí),減少寄生阻抗成為GaN基同步DC/DC變換器的最大挑戰(zhàn)[28]。Akagi等人通過設(shè)計(jì)柵極驅(qū)動(dòng)IC并在上面加入3D堆疊電源SoC(Stacked-on-Chip),使變換器在30 MHz下最大效率達(dá)到了59%,優(yōu)化后最高效率預(yù)計(jì)為85%。可見,型號(hào)為EPC8002的GaN FET在高頻上頗有優(yōu)勢(shì)。
目前,GaN FET在電力電子裝置應(yīng)用廣泛。研究者主要是利用GaN FET高的開關(guān)頻率、低的開關(guān)損耗等優(yōu)勢(shì),通過提高變換器工作頻率減小裝置體積,進(jìn)而提高裝置效率、降低裝置成本、增加收益。
表4給出了GaN FET變換器在其他方面的應(yīng)用研究情況。從表中可以看到,GaN FET目前多用在中小功率變換器上,隨著開關(guān)頻率的提高,變換器效率降低,但基本在90%及以上。實(shí)驗(yàn)證明,效率的降低與開關(guān)損耗機(jī)理有關(guān)[29]。當(dāng)然,除了提高效率,用GaN FET設(shè)計(jì)的功率1 kW以上的變換器,輸出電壓和電流紋波很小[30-31]。此外,采用GaN FET并聯(lián)技術(shù)[32-34]有可能使其應(yīng)用到10 kW及以上的大功率場(chǎng)合。可見,GaN FET在變換器的應(yīng)用前景廣闊。

5 結(jié)論
通過對(duì)GaN FET的器件結(jié)構(gòu)、驅(qū)動(dòng)電路以及應(yīng)用的研究,可以看出只要解決GaN FET高頻下獨(dú)特的柵極振蕩問題,就能極大地推動(dòng)它的發(fā)展。一般可從兩方面著手,一是設(shè)計(jì)性能更好的器件結(jié)構(gòu);二是設(shè)計(jì)更合理的驅(qū)動(dòng)電路。雖然GaN FET目前在中小功率場(chǎng)合更有優(yōu)勢(shì),但未來,隨著對(duì)GaN FET性能的不斷改進(jìn)和提高,更多大功率場(chǎng)合也必然有GaN FET的一席之地。
參考文獻(xiàn)
[1] OTSUKA N,KAWAI Y,NAGAI S.Recent progress in GaN devices for power and integrated circuit[C].IEEE 12th International Conference on ASIC(ASICON),2017:928-931.
[2] FENG J,HE Z,EN Y,et al.The ESD behavior of enhancement GaN HEMT power device with p-GaN gate structure[C].IEEE International Power Electronics and Application Conference and Exposition(PEAC),2018:1-4.
[3] POSTHUMA N E,YOU S,STOFFELS S,et al.Gate architecture design for enhancement mode p-GaN gate HEMTs for 200 and 650V applications[C].IEEE 30th International Symposium on Power Semiconductor Devices and ICs(ISPSD),2018:188-191.
[4] 趙勇兵,程哲,張韻,等.具有高閾值電壓和超低柵漏電的400 V常關(guān)型槽柵AlGaN/GaN金屬氧化物半導(dǎo)體高電子遷移率晶體管[J].電工技術(shù)學(xué)報(bào),2018,33(7):1472-1477.
[5] 白欣嬌,袁鳳坡,李曉波,等.增強(qiáng)型GaN HEMT凹槽柵刻蝕技術(shù)研究進(jìn)展[J].微納電子技術(shù),2018,55(10):762-767,774.
[6] CHEN Z,GUITART J R.Dv/dt Immunization Limit of LV MOSFET in Cascode GaN FET and Dv/dt Safe Chart for MOSFETs[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2017:1946-1949.
[7] YU J,ZHANG W J,SHORTEN A,et al.A smart gate driver IC for GaN power transistors[C].IEEE 30th International Symposium on Power Semiconductor Devices and ICs(ISPSD),2018:84-87.
[8] HARI N,LONG T,SHELTON E.Investigation of gate drive strategies for high voltage GaN HEMTs[J].Energy Procedia,2017,117:1152-1159.
[9] GUAN Y,WANG Y,XU D,et al.A 1 MHz half-bridge resonant DC/DC converter based on GaN FETs and planar magnetics[J].IEEE Transactions on Power Electronics,2017,32(4):2876-2891.
[10] KIM D S,JOO D M,LEE B K,et al.Design and analysis of GaN FET-based resonant DC-DC converter[C].IEEE 9th International Conference on Power Electronics and ECCE Asia(ICPE-ECCE Asia),2015:2650-2655.
[11] CHE S,NAGAI S,NEGORO N,et al.A 1 W power consumption GaN-based isolated gate driver for a 1.0 MHz GaN power system[C].IEEE 29th International Symposium on Power Semiconductor Devices and IC′s(ISPSD),2017:33-36.
[12] AHMAD B,MARTINEZ W,KYYRA J.Common mode noise analysis for a high step-up converter with GaN devices[C].IEEE Energy Conversion Congress and Exposition(ECCE),2018:1240-1246.
[13] WU H,F(xiàn)AYYAZ A,CASTELLAZZI A.P-gate GaN HEMT gate-driver design for joint optimization of switching performance,freewheeling conduction and short-circuit robustness[C].IEEE 30th International Symposium on Power Semiconductor Devices and ICs(ISPSD),2018:232-235.
[14] UMEGAMI H,HATTORI F,NOZAKI Y,et al.A novel high-efficiency gate drive circuit for normally off-type GaN FET[J].IEEE Transactions on Industry Applications,2014,50(1):593-599.
[15] HIROTA T,INOMATA K,YOSHIMI D,et al.Nine switches matrix converter using Bi-directional GaN device[C].IEEE International Power Electronics Conference(IPEC-Niigata 2018-ECCE Asia),2018:3952-3957.
[16] DYMOND H C P,WANG J,LIU D,et al.A 6.7-GHz active gate driver for GaN FETs to combat overshoot,ringing, and EMI[J].IEEE Transactions on Power Electronics,2018,33(1):581-594.
[17] 羊志強(qiáng),徐大偉,李新昌,等.基于GaN HEMT同步整流Buck變換器研究[J].電力電子技術(shù),2017,51(9):20-23.
[18] SUN B,BURGOS R,BOROYEVICH D.Ultralow input-output capacitance PCB-embedded dual-output gate-drive power supply for 650 V GaN-based half-bridges[J].IEEE Transactions on Power Electronics,2019,34(2):1382-1393.
[19] ELRAJOUBI A M,GEORGE K,ANG S S.Design and analysis of a new GaN-based AC/DC topology for battery charging application[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2018:2959-2964.
[20] UMETANI K,MATSUMOTO R,HIRAKI E.Prevention of oscillatory false triggering of GaN-FETs by balancing gate-drain capacitance and common-source inductance[J].IEEE Transactions on Industry Applications,2019,55(1):610-619.
[21] 陳雷雨,和軍平,俞作良,等.基于增強(qiáng)型氮化鎵器件的兩級(jí)DC/DC變換器設(shè)計(jì)[J].電力電子技術(shù),2017,51(9):12-15.
[22] 任小永,季澍,穆明凱.氮化鎵功率晶體管三電平驅(qū)動(dòng)技術(shù)[J].電工技術(shù)學(xué)報(bào),2013,28(5):202-207.
[23] 羅智文,王奎,張新燕,等.基于高壓GaN器件的雙有源橋設(shè)計(jì)[J].電力電子技術(shù),2017,51(9):16-19.
[24] NAGAI S,KAWAI Y,TABATA O,et al.A high-efficient driving isolated drive-by-microwave half-bridge gate driver for a GaN inverter[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2016:2051-2054.
[25] LAUTNER J,PIEPENBREIER B.Performance comparison of cascode GaN HEMT and Si MOSFET based inverter for motor drive applications[C].IEEE 12th International Conference on Power Electronics and Drive Systems(PEDS),2017:81-87.
[26] FARACI E,SEEMAN M,GU B,et al.High efficiency and power density GaN-based LED driver[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2016:838-842.
[27] 閆琪,李艷,王路.基于GaN器件的雙Buck逆變器共模與損耗[J].電工技術(shù)學(xué)報(bào),2017,32(20):133-141.
[28] AKAGI T,MIYANO S,ABE S,et al.A silicon based multi-tens MHz gate driver IC for GaN power devices[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2017:1978-1982.
[29] HOU R,LU J,CHEN D.Parasitic capacitance eqoss loss mechanism, calculation, and measurement in hard-switching for GaN HEMTs[C].IEEE Applied Power Electronics Conference and Exposition(APEC).IEEE,2018:919-924.
[30] MORSY A S,BAYERN M,ENJETI P.High power density single phase inverter using GaN FETS and active power decoupling for google little box challenge[C].IEEE 3rd Workshop on Wide Bandgap Power Devices and Applications(WiPDA),2015:323-327.
[31] 唐剛,劉軍,黃森,等.氮化鎵器件在四相交錯(cuò)并聯(lián)DC/DC變換器上的應(yīng)用[J].自動(dòng)化應(yīng)用,2018(3):94-96.
[32] LU J L,HOU R,CHEN D.Opportunities and design considerations of GaN HEMTs in ZVS applications[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2018:880-885.
[33] 盧俊誠,陳迪.氮化鎵器件在大功率電力電子系統(tǒng)中的應(yīng)用[J].電力電子技術(shù),2017,51(9):1-2.
[34] LU J L,CHEN D.Paralleling GaN E-HEMTs in 10 kW-100 kW systems[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2017:3049-3056.
[35] GAMAND F,LI M D,GAQUIERE C.A 10-MHz GaN HEMT DC/DC boost converter for power amplifier applications[J].IEEE Transactions on Circuits and Systems II:Express Briefs,2012,59(11):776-779.
[36] YAJING Z,ZHENG T Q,YAN L.Loss analysis and soft-switching characteristics of flyback-forward high gain DC/DC converter with GaN FET[C].IEEE International Power Electronics Conference(IPEC-Hiroshima 2014-ECCE ASIA),2014:2899-2903.
[37] PUUKKO J,XU J,LIU L.Consideration of flyback converter using GaN devices[C].IEEE 3rd Workshop on Wide Bandgap Power Devices and Applications(WiPDA),2015:196-200.
[38] 張雅靜,鄭瓊林,李艷.考慮寄生參數(shù)的高壓GaN高電子遷移率晶體管的逆變器動(dòng)態(tài)過程分析[J].電工技術(shù)學(xué)報(bào),2016,31(12):126-134.
[39] 李艷,張雅靜,黃波,等.Cascode型GaN HEMT輸出伏安特性及其在單相逆變器中的應(yīng)用研究[J].電工技術(shù)學(xué)報(bào),2015,30(14):295-303.
作者信息:
伍文俊,蘭雪梅
(西安理工大學(xué) 自動(dòng)化與信息工程學(xué)院,陜西 西安710048)

