文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.2017.01.015
中文引用格式: 李夢(mèng)琳,鄭東飛. 三維疊層模塊溫度監(jiān)測(cè)及故障分析技術(shù)[J].電子技術(shù)應(yīng)用,2017,43(1):57-59.
英文引用格式: Li Menglin,Zheng Dongfei. 3D-Stacked memory module temperature monitoring and fault analysis tchnology[J].Application of Electronic Technique,2017,43(1):57-59.
0 引言
三維疊層封裝是近年來新興的一種集成電路封裝技術(shù),通過堆疊、灌封、切割、表面金屬化等工藝過程,在單個(gè)封裝體內(nèi)堆疊多個(gè)封裝芯片或裸芯片,突破了傳統(tǒng)平面封裝的概念,能夠?qū)崿F(xiàn)更大功能密度的MCM(Multi Chip Module)模塊產(chǎn)品,特別適用于DRAM、SRAM、EEPROM、Nand Flash、Nor Flash等存儲(chǔ)器類型產(chǎn)品的立體封裝,可以有效降低航空、航天電子信息存儲(chǔ)系統(tǒng)的體積和重量。
大容量存儲(chǔ)器是航天電子系統(tǒng)關(guān)鍵元器件,用于各種空間試驗(yàn)或探測(cè)數(shù)據(jù)的采集、存儲(chǔ)以及在軌數(shù)據(jù)處理。三維疊層存儲(chǔ)器將多片存儲(chǔ)器芯片堆疊組合在一起,其功能密度較高,測(cè)試難度較大,一方面,因三維疊層存儲(chǔ)器單個(gè)外引腳連接多個(gè)內(nèi)部芯片引腳,一個(gè)或者多個(gè)引腳開路無法及時(shí)發(fā)現(xiàn);另一方面,在進(jìn)行高、低溫測(cè)試時(shí),無法準(zhǔn)確監(jiān)測(cè)模塊內(nèi)部芯片的實(shí)際溫度。
在GJB2438A-2002混合集成電路通用規(guī)范里面,規(guī)定了電路需進(jìn)行高、低溫測(cè)試,但未規(guī)定具體的測(cè)試試驗(yàn)方法。一般來說,進(jìn)行電路高、低溫測(cè)試有兩種方法,一是利用氣流罩為電路提供穩(wěn)定的溫度環(huán)境,氣流罩升、降溫速率較高,提供溫度穩(wěn)定,缺點(diǎn)是容積較小,一次一般只能測(cè)試一只電路,測(cè)試效率較低;二是設(shè)定高、低溫箱溫度比要求溫度嚴(yán)格,將待測(cè)電路放置在高、低溫箱中保溫一定時(shí)間,待溫度穩(wěn)定后,從溫箱中取出,迅速進(jìn)行測(cè)試,該方法比較適合較小批量的存儲(chǔ)器測(cè)試,主要缺點(diǎn)是電路暴露在室溫中的時(shí)間與操作相關(guān),不能精確控制操作時(shí)間,導(dǎo)致實(shí)際測(cè)試狀態(tài)的溫度與要求溫度可能存在較大偏差。
為了保證電路實(shí)際測(cè)試溫度滿足規(guī)范的要求,在采用第二種方案進(jìn)行高、低溫測(cè)試時(shí),需要對(duì)電路的實(shí)際溫度進(jìn)行監(jiān)測(cè)。無論是紅外測(cè)溫、點(diǎn)式溫度計(jì)測(cè)溫方法均是測(cè)量測(cè)試板或模塊外部的溫度,不能獲得內(nèi)部芯片的實(shí)際溫度。
本文針對(duì)存儲(chǔ)器的特點(diǎn),對(duì)存儲(chǔ)器端口寄生二極管結(jié)構(gòu)進(jìn)行分析,提出了一種通過ATE測(cè)試機(jī)接觸測(cè)試方法,測(cè)試存儲(chǔ)器端口并聯(lián)二極管正向壓降,通過分析二極管正向壓降與溫度的關(guān)系,從而得出模塊內(nèi)部芯片實(shí)際溫度并有效識(shí)別并聯(lián)二極管一個(gè)或多個(gè)端口開路的故障模式。根據(jù)ATE設(shè)備通/短路設(shè)計(jì)原理進(jìn)行試驗(yàn)驗(yàn)證,證明了該方法行之有效,幾乎不增加測(cè)試成本,可以用來進(jìn)行三維存儲(chǔ)器模塊的測(cè)試和修正,并且本方法也可用于SoC、SiP等復(fù)雜結(jié)構(gòu)電路的測(cè)試。
1 引腳寄生二極管的正向?qū)▔航?/strong>
存儲(chǔ)器等集成電路芯片是靜電敏感器件,芯片對(duì)外引腳端均有ESD保護(hù)電路,一般由二極管構(gòu)成,可提供靜電泄放路徑,如圖1所示。這個(gè)結(jié)構(gòu)不僅用來進(jìn)行ESD保護(hù),也可以用來進(jìn)行電路連通性測(cè)試,并能根據(jù)PN結(jié)正向壓降監(jiān)測(cè)芯片的實(shí)時(shí)溫度。
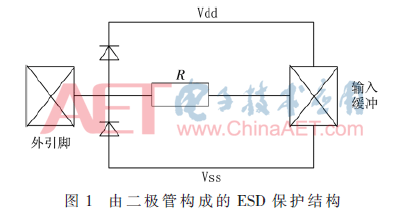
1.1 單個(gè)二極管正向?qū)▔航蹬c溫度的關(guān)系
根據(jù)Shockely的PN結(jié)方程[1],PN結(jié)兩端的電壓V和流過PN結(jié)的電流I之間的關(guān)系為式(1)。

式中,Is為反向飽和電流,k為玻耳茲曼常數(shù),T為熱力學(xué)溫度,q為電子電量,n為理想因子。
對(duì)于I>>Is,硅材料取n=1,式(1)改寫為:

反向飽和電流Is是一個(gè)溫度相關(guān)函數(shù)[2],可以近似為式(3)。

其中,K、r、Vg0是與溫度無關(guān)的常數(shù),K表示PN結(jié)幾何尺寸的因子,r表示基極少數(shù)載流子的移動(dòng)性,Vg0表示在絕對(duì)0 ℃下的材料能帶寬度。
由式(2)、式(3)可以推出PN結(jié)兩端正向壓降V與溫度T、電流I的關(guān)系式(4)。

其中rlnT較小,可忽略不計(jì),式(4)表明在-55 ℃(218 K)到125 ℃(398 K)的模塊工作溫度范圍內(nèi),對(duì)于給定的電流,二極管PN結(jié)正向壓降與溫度基本上是一個(gè)線性關(guān)系,可以通過式(5)計(jì)算出PN結(jié)的溫度。其中,V1、V2分別是溫度T下給定電流I1、I2對(duì)應(yīng)的PN結(jié)壓降。

1.2 并聯(lián)結(jié)構(gòu)二極管正向?qū)▔航蹬c并聯(lián)數(shù)量的關(guān)系
三維疊層存儲(chǔ)器將多片芯片封裝在一個(gè)模塊中,單個(gè)外引腳會(huì)連接多個(gè)內(nèi)部芯片引腳,因此多個(gè)ESD保護(hù)二極管形成并聯(lián)結(jié)構(gòu),如圖2所示。

相同結(jié)構(gòu)的二極管電流導(dǎo)通能力相同,根據(jù)式(2),對(duì)于N個(gè)并聯(lián)的二極管的PN結(jié)兩端的壓降VN和流過PN結(jié)的總電流IN之間的關(guān)系為式(6)、式(7)。

從上式可以看出,對(duì)于N個(gè)并聯(lián)的PN結(jié),正向?qū)▔航蹬c溫度仍然保持近似線性關(guān)系。與單個(gè)PN結(jié)相比,并聯(lián)的PN結(jié)正向?qū)▔航狄档蚹T/q·lnN,其中KT/q為溫度電壓當(dāng)量,在T=300 K時(shí),KT/q≈26 mV。
根據(jù)式(7),可以通過對(duì)外引腳提供恒定的電流,測(cè)量寄生二極管的正向壓降以監(jiān)測(cè)內(nèi)部芯片溫度,并且可以通過比較正向壓降的大小來定位三維疊層存儲(chǔ)器模塊引腳是否出現(xiàn)了開路失效,也就是可以利用ATE測(cè)試設(shè)備的接觸測(cè)試來進(jìn)行存儲(chǔ)器模塊的故障模式定位和溫度監(jiān)測(cè)。
2 ATE接觸測(cè)試方法
接觸測(cè)試是一種DC直流測(cè)試方法,利用芯片引腳寄生ESD保護(hù)二極管來檢測(cè)引腳間是否存在開路或短路的情況。接觸測(cè)試方法如圖3所示,將芯片所有引腳接GND,通過將信號(hào)引腳定義為輸入,輸入VIL=0 V,將所有電源引腳(VDD、VSS)也連接到GND,利用動(dòng)態(tài)電流負(fù)載為VDD保護(hù)二極管提供400 ?滋A偏置電流,負(fù)載參考電壓設(shè)定在+3 V。
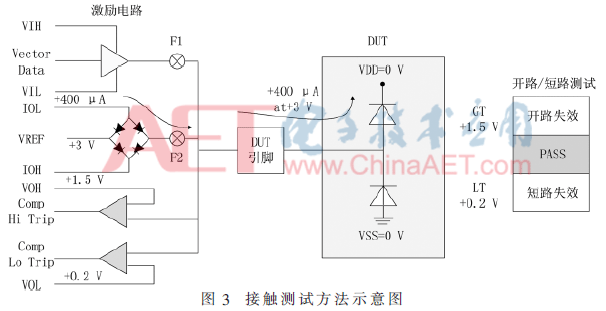
接觸測(cè)試時(shí)分別對(duì)每個(gè)引腳進(jìn)行如下測(cè)試。時(shí)序圖圖4表示的是1 MHz的測(cè)試周期,周期起始階段關(guān)閉DUT的引腳驅(qū)動(dòng),打開電流負(fù)載,900 ns后二極管的正向壓降穩(wěn)定后進(jìn)行檢測(cè)。如果接觸正常,壓降在0.65 V左右;如果存在短路,DUT引腳電壓會(huì)被拉到0 V;如果存在開路,DUT引腳電壓會(huì)被拉到3 V。設(shè)定短路失效門限為0.2 V,開路失效門限為1.5 V,可通過測(cè)試壓降判斷引腳是否存在開路或短路失效。

3 試驗(yàn)驗(yàn)證與分析
為了驗(yàn)證上述理論的有效性,利用ATE測(cè)試機(jī)的接觸測(cè)試方法,在不同溫度下,對(duì)不同并聯(lián)數(shù)量的三維疊層存儲(chǔ)器模塊引腳導(dǎo)通壓降進(jìn)行測(cè)試,得出測(cè)試結(jié)果如圖5所示。

從圖5中,可以看出單個(gè)引腳的二極管正向?qū)▔航蹬c溫度成線性關(guān)系,且隨著溫度的增加而降低;多個(gè)引腳并聯(lián)的二極管正向?qū)▔航蹬c溫度亦為線性關(guān)系,且并聯(lián)引腳數(shù)量越多,導(dǎo)通壓降越小;此結(jié)論與理論分析一致。
此外,若模塊并聯(lián)的引腳中有一個(gè)或多個(gè)引腳存在開路失效現(xiàn)象,則可通過比較相同功能端的二極管導(dǎo)通壓降有效識(shí)別該現(xiàn)象,如圖6所示,三維疊層存儲(chǔ)器模塊地址端A0-A12中,A3地址端有一個(gè)并聯(lián)引腳開路,則其導(dǎo)通壓降明顯大于其余同功能地址端,此試驗(yàn)結(jié)果與理論分析一致。

4 結(jié)語
本文通過理論分析與試驗(yàn)驗(yàn)證,得出存儲(chǔ)器端口寄生二極管正向?qū)▔航蹬c溫度之間的線性關(guān)系,并隨著并聯(lián)二極管數(shù)量的增加,導(dǎo)通壓降減小,利用該結(jié)論,可有效地進(jìn)行三維疊層存儲(chǔ)器內(nèi)部芯片的溫度監(jiān)測(cè)以及開路故障分析,該方法可以用于三維存儲(chǔ)器模塊的測(cè)試和修正,測(cè)試成本低,有效提升三維存儲(chǔ)器模塊的測(cè)試效率。
參考文獻(xiàn)
[1] SZE S M.Physics of semiconductor devices,2nd Edition,John Wiley & Sons,New York,1981.
[2] SHAUKATULLAH H.A method of using thermal test chips with diodes for thermal characterization of electronic packages without calibration,Eleventh IEEE Semi-Therm Symposium,1995.
[3] SHARMA A K.先進(jìn)半導(dǎo)體存儲(chǔ)器[M].曾瑩等,譯.北京:電子工業(yè)出版社,2001.
作者信息:
李夢(mèng)琳,鄭東飛
(西安微電子技術(shù)研究所,陜西 西安710054)

