文獻標識碼: A
DOI:10.16157/j.issn.0258-7998.2017.01.005
中文引用格式: 劉家齊,趙元富,王亮,等. 65 nm反相器單粒子瞬態(tài)脈寬分布的多峰值現(xiàn)象[J].電子技術(shù)應用,2017,43(1):20-23.
英文引用格式: Liu Jiaqi,Zhao Yuanfu,Wang Liang,et al. The multi-peak phenomenon in 65 nm inverters single event transient pulse width distribution[J].Application of Electronic Technique,2017,43(1):20-23.
0 引言
隨著半導體工藝尺寸減小到納米級,單粒子瞬態(tài)(Single Event Transient,SET)已經(jīng)成為集成電路軟錯誤的主要來源[1]。器件特征尺寸減小,其節(jié)點電容減小、延時縮短,而單粒子瞬態(tài)脈寬并沒有等比例縮小。在納米工藝下,單粒子瞬態(tài)脈寬已經(jīng)和正常信號寬度在同一量級,導致單粒子瞬態(tài)更容易在電路中無損傳播;而電路運行頻率的提高,使得單粒子瞬態(tài)脈寬與時鐘周期的比值增大,單粒子瞬態(tài)更容易被捕獲產(chǎn)生軟錯誤。因此,納米集成電路中單粒子瞬態(tài)將會越來越嚴重。瞬態(tài)脈沖寬度作為SET的重要特征,決定了SET能否在集成電路中傳播和被捕獲。獲取單粒子瞬態(tài)脈寬特征對分析SET傳播規(guī)律、指導加固設計有著重要作用。特別是對采用時域濾波方式進行加固的單粒子瞬態(tài)加固方法,根據(jù)單粒子瞬態(tài)脈寬分布特征,制定合理的加固策略,對于加固設計有著重要的指導作用。因此,對SET脈寬特征及其影響因素的研究成為近年來的熱點[2-4]。
MATTHEW J對90 nm體硅工藝的脈寬測量結(jié)果顯示脈寬分布在高溫條件下呈現(xiàn)出多峰現(xiàn)象[3],但作者并未注意該現(xiàn)象。直到對65 nm工藝下專門設計的脈寬檢測電路進行不同條件下的實驗,在實驗分析時首次關(guān)注了瞬態(tài)脈寬分布的多峰現(xiàn)象[5]。在低線性能量傳遞(Linear Energy Transfer,LET)情況下,SET脈寬沒有出現(xiàn)多峰現(xiàn)象;在高LET情況下,瞬態(tài)脈寬分布會呈現(xiàn)多峰分布的現(xiàn)象。因此推測多峰現(xiàn)象產(chǎn)生的原因是在高LET情況下,由于寄生雙極效應,粒子攻擊PMOS產(chǎn)生脈寬遠大于粒子攻擊NMOS產(chǎn)生脈寬。反相器作為集成電路最基本的單元之一,其SET瞬態(tài)脈寬分布最具有代表性。本文通過設計的脈寬檢測電路結(jié)果,詳細對比了反相器多峰現(xiàn)象與LET值、溫度、閾值電壓間的關(guān)系,并通過TCAD仿真分析了其產(chǎn)生的原因,對抗輻射加固設計提供了指導。
1 實驗詳情
1.1 實驗樣品
設計的單粒子瞬態(tài)脈寬檢查電路包含靶電路和脈寬檢測單元。靶電路包括5種不同的目標鏈路,為了減小脈沖在傳播過程中展寬,鏈路由邏輯門和較短單元鏈組成。每條鏈路基本單元面積相同,并且基本單元在數(shù)量上占絕大多數(shù),發(fā)生的單粒子轟擊在基本單元上的概率極大。組成目標鏈的基本單元分別是常規(guī)閾值電壓反相器(INV)、與非門(NAND)、或非門(NOR)、低閾值電壓反相器(INV_LVT),以及PMOS在單獨的N阱中、NMOS同在P襯底的反相器(INV_sw)。脈寬檢測單元的作用在于檢測靶電路發(fā)生單粒子效應時輸出的脈沖寬度。脈沖的寬度由脈寬檢測單元中觸發(fā)器的固有延時度量確定,脈寬測試的精度為±28.5 ps。本文主要關(guān)注反相器脈寬的分布。
1.2 實驗設置
通過重離子加速器獲得單一能量的重離子,重離子垂直測試片轟擊,用到的重離子及其線性能量傳遞(LET)值、能量值分列于表1。測試電路在最低電源電壓1.08 V,室溫、高溫條件下同時開始測量。
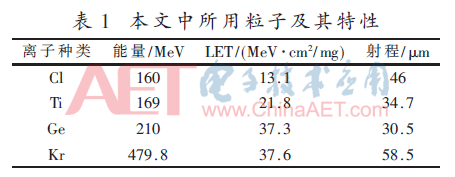
2 試驗結(jié)果與討論
典型單元的SET脈寬分布應該符合高斯分布[7],脈寬數(shù)量應該只有一個峰值,而試驗結(jié)果中,SET脈寬分布出現(xiàn)多個峰值的現(xiàn)象。如圖1所示,在Kr離子轟擊下,反相器脈寬在199.5~256.5 ps出現(xiàn)了一個峰值,在313.5~370.5 ps出現(xiàn)了第二個峰值,與第一個峰值一起構(gòu)成了雙峰。為了探究多峰現(xiàn)象的成因,比較了多峰現(xiàn)象和LET、溫度、閾值電壓間的關(guān)系,分析了出現(xiàn)多峰現(xiàn)象可能的原因及影響因素。
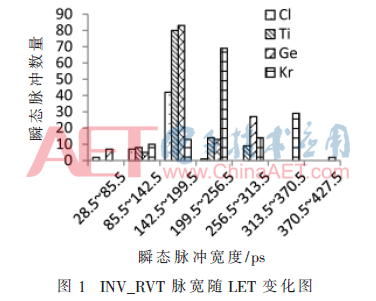
2.1 多峰現(xiàn)象與LET的關(guān)系
低LET離子(氯離子、鈦離子)轟擊時沒有出現(xiàn)多峰現(xiàn)象,瞬態(tài)脈寬分布符合高斯分布;高LET離子(鍺離子、氪離子)轟擊時,開始出現(xiàn)多峰現(xiàn)象。且隨著LET的升高,多峰現(xiàn)象更加明顯,次峰的高度與主峰的高度越來越接近。試驗結(jié)果如圖1所示。
通過分析認為,瞬態(tài)脈寬在低LET時沒有呈現(xiàn)多峰分布,而在高LET時呈現(xiàn)多峰分布可能的原因是在高LET情況下,由于PMOS的寄生雙極效應,離子轟擊PMOS產(chǎn)生較寬脈寬。在低LET情況下,離子攻擊PMOS電離的電荷量較少,阱電勢波動較小,PMOS寄生雙極效應并不明顯,離子攻擊PMOS產(chǎn)生的瞬態(tài)脈寬與離子攻擊NMOS產(chǎn)生的瞬態(tài)脈寬相差不大,因此脈寬分布符合高斯分布,沒有多峰值現(xiàn)象;而在高LET情況下,離子攻擊PMOS電離產(chǎn)生大量電子空穴對,N阱收集電子使得阱電勢降低,PMOS由于寄生雙極效應,產(chǎn)生脈寬較寬的SET,由于離子轟擊PMOS產(chǎn)生的瞬態(tài)脈寬遠大于離子轟擊NMOS產(chǎn)生的瞬態(tài)脈寬,因此在脈寬分布上呈現(xiàn)2個峰值。
2.2 多峰現(xiàn)象與溫度的關(guān)系
選取在鍺離子(Ge)輻照條件下多峰現(xiàn)象隨溫度的變化情況。在高溫情況下,SET數(shù)量和最大脈沖寬度均大于常溫情況,且在高溫情況下,多峰現(xiàn)象更加嚴重,次峰與主峰的比值進一步增大。如圖2所示,在高溫情況下反相器(INV_HT)次峰與主峰的比值比低溫情況下反相器(INV_NT)次峰與主峰的比值增大了1倍以上。表明器件在高溫情況下,器件更容易產(chǎn)生SET,且寬SET增加速度要大于窄SET的增加速度。文獻[5,7]等研究表明,高溫條件下PMOS的寄生雙極效應會更加嚴重,使得離子攻擊PMOS更容易產(chǎn)生寬脈沖SET。因此,在高溫情況下,反相器瞬態(tài)脈寬分布的多峰現(xiàn)象更加明顯。
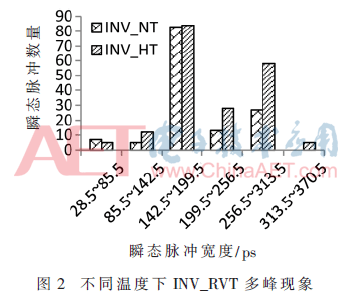
2.3 多峰現(xiàn)象與閾值電壓的關(guān)系
不同閾值電壓下,反相器的多峰現(xiàn)象趨勢一致,差異并不明顯,如圖3所示。不同閾值電壓器件在粒子轟擊下電荷收集情況不同,同時恢復管的電流也受閾值電壓影響。實測結(jié)果表明,不同閾值電壓對器件的脈寬和多峰現(xiàn)象的影響并不明顯。不同閾值下,器件脈寬分布差別不明顯的原因可能是閾值電壓對器件SET脈寬的影響較小,在測試電路現(xiàn)有的分辨率下無法體現(xiàn)。

3 仿真分析
為了確定脈寬分布呈現(xiàn)多峰現(xiàn)象的原因,采用TCAD仿真軟件對反相器由NMOS和PMOS產(chǎn)生的SET進行仿真分析。將反相器中的PMOS和NMOS分別建立3D模型,采用混合模式仿真的形式,對不同LET及溫度情況下,NMOS和PMOS在重離子攻擊下的電荷收集和脈沖寬度進行仿真,仿真結(jié)果如圖4、圖5所示。圖4為NMOS受重離子攻擊下的瞬態(tài)脈沖,圖5為PMOS受重離子攻擊下的瞬態(tài)脈沖。
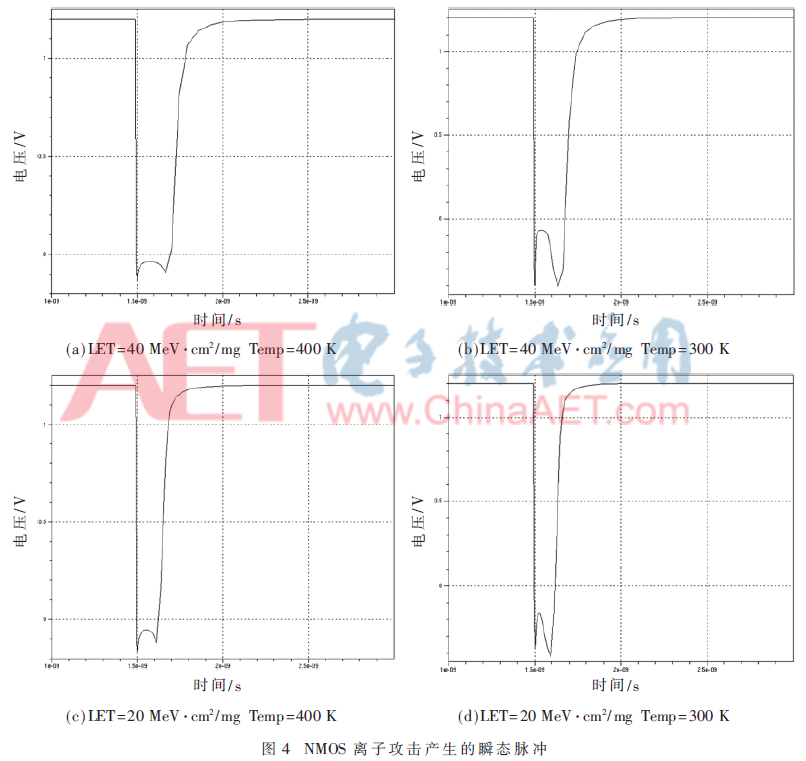
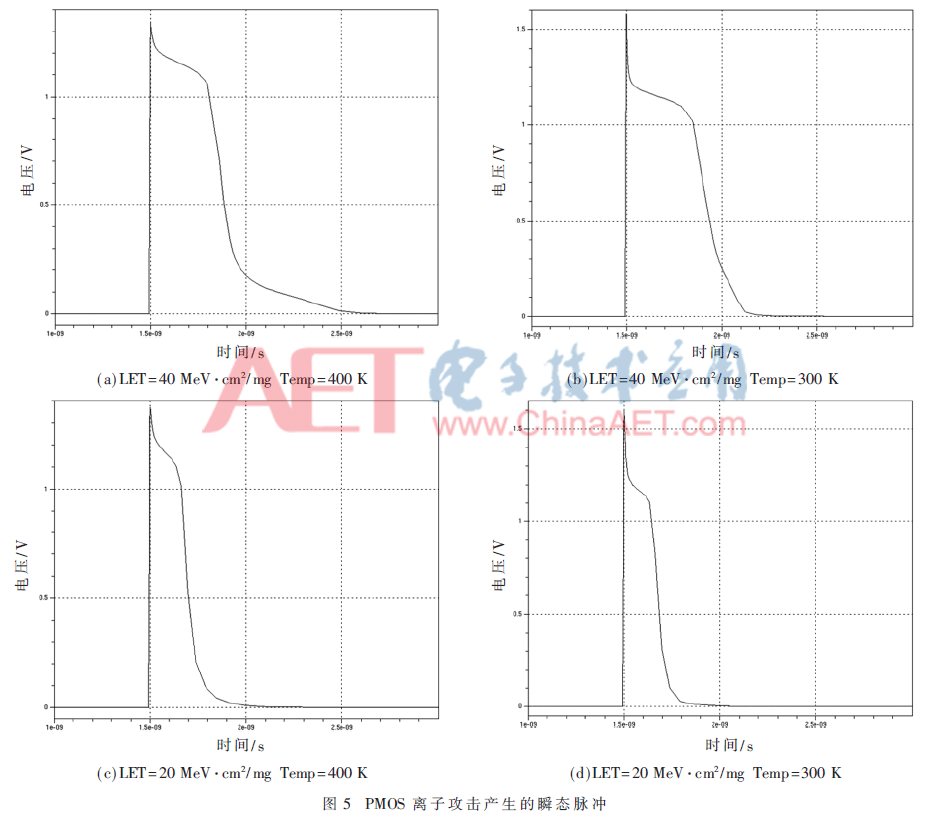
由圖4(a)、圖4(b)與圖5(a)、圖5(b)對比可知,在高LET情況下,離子攻擊NMOS產(chǎn)生的SET脈寬仍在200 ps左右,但是離子攻擊PMOS產(chǎn)生的SET脈寬則是在400 ps左右。由圖4(c)、圖4(d)與圖5(c)、圖5(d)對比可知,在低LET情況下,離子攻擊NMOS產(chǎn)生的SET脈寬與離子攻擊PMOS產(chǎn)生的SET脈寬均在200 ps左右,且離子攻擊PMOS與NMOS產(chǎn)生的SET脈寬相差不大。
由圖4、圖5對比可知,在低LET情況下,離子攻擊PMOS產(chǎn)生的瞬態(tài)脈沖寬度與離子攻擊NMOS產(chǎn)生的瞬態(tài)脈沖寬相差不大,因此脈寬分布表現(xiàn)為一個峰值。在高LET情況下,離子攻擊PMOS產(chǎn)生的SET寬度明顯大于粒子攻擊NMOS產(chǎn)生的SET寬度,因此脈寬分布表現(xiàn)為兩個不同的峰值。由此可確認SET脈寬分布的多峰現(xiàn)象是由PMOS在高LET離子攻擊下產(chǎn)生較寬脈寬的SET引起。高溫下離子攻擊產(chǎn)生的SET脈寬略有增加,但是增加幅度并不明顯。因此高溫情況下瞬態(tài)脈寬分布的多峰現(xiàn)象更加明顯的原因是:高溫情況下,PMOS寄生雙極效應會更加嚴重,使得離子攻擊產(chǎn)生寬脈寬SET的概率增加。
4 結(jié)論
本文針對65 nm體硅CMOS工藝下反相器單粒子瞬態(tài)脈寬分布形態(tài)的多峰現(xiàn)象,創(chuàng)新性地通過試驗數(shù)據(jù)的分布統(tǒng)計特征分析了其原因,并采用TCAD仿真進行驗證,為抗輻射加固設計提供了指導。分析了多峰現(xiàn)象和LET、溫度、閾值電壓的關(guān)系。通過TCAD仿真確認單粒子瞬態(tài)脈寬分布呈現(xiàn)多峰形態(tài)的主要原因是由于PMOS的寄生雙極效應,在高LET離子攻擊下產(chǎn)生寬瞬態(tài)脈沖。由于高溫情況會加劇PMOS的寄生雙極效應,因此在高溫條件下,脈寬分布的多峰現(xiàn)象更加明顯。因此在抗輻射加固設計時,需要注意PMOS在高LET下寄生雙極效應產(chǎn)生寬脈寬的瞬態(tài)脈沖,對PMOS進行針對性的加固。
參考文獻
[1] Zhao Yuanfu,Wang Liang,Yue Suge,et al.SEU and SET of 65 nm bulk CMOS flip-flops and their implications for RHBD[J].IEEE Transactions on Nuclear Science,2015,62(6):2666-2672.
[2] AHLBIN J R,GADLAGE M J.Effect of multiple-transistor charge collection on single-event transient pulse widths[J].IEEE Trans.Device Mater.Reliab.,2011,11(3):401-406.
[3] GADLAGE M J,AHLBIN J R.Increased single-event transient pulsewidths in a 90-nm bulk CMOS technology operating at elevated temperatures[J].IEEE Trans.Device Mater.Reliab.,2010,10(1):157-163.
[4] JAGANNATHAN S,GADLAGE M J.Independent measurement of SET pulse widths from N-Hits and P-Hits in 65-nm CMOS[J].IEEE Trans.Nucl.Sci.,2010,57(6):3386-3391.
[5] Yue Suge.Single event transient pulse width measurement of 65-nm bulk CMOS circuits[J].Journal of Semiconductor,2015,36(11).
[6] AHLBIN J R,GADLAGE M J,BALL D R,et al.The effect of layout topology on single-event transient pulse quenching in a 65 nm bulk CMOS process[J].IEEE Trans. Nucl. Sci.,2010,57(6):3380-3385.
[7] Chen Shuming,Liang Bin.Temperature dependence of digital SET pulse width in bulk and SOI technologies[J].IEEE Trans. Nucl. Sci.,2008,55(6):2914-2920.
作者信息:
劉家齊1,趙元富1,2,王 亮1,鄭宏超1,舒 磊2,李同德1
(1.北京微電子技術(shù)研究所,北京100076;2.哈爾濱工業(yè)大學,黑龍江 哈爾濱150001)

