文獻標識碼: A
DOI:10.16157/j.issn.0258-7998.2017.01.002
中文引用格式: 文惠東,林鵬榮,,曹玉生,,等. 高溫存儲下不同成分Sn-Pb凸點可靠性研究[J].電子技術(shù)應(yīng)用,,2017,,43(1):10-12,,19.
英文引用格式: Wen Huidong,Lin Pengrong,,Cao Yusheng,,et al. Study on reliability of different Sn-Pb bumps with high temperature storage[J].Application of Electronic Technique,2017,,43(1):10-12,,19.
0 引言
倒裝焊技術(shù)由于芯片引出端采用面陣列排布方式,,具有信號傳輸距離短、高密度,、高頻性能優(yōu)異,、低串擾和高可靠等特點,是解決高密度先進封裝最為有效的途徑之一,,已經(jīng)廣泛應(yīng)用于高密度集成電路封裝中,。倒裝焊工藝中,首先在芯片引出端焊盤上制備凸點,,然后使芯片翻轉(zhuǎn),,并與外殼焊盤焊接,以實現(xiàn)機械互連和電氣互連,。凸點制備通常采用Sn-Pb焊料,,主要依靠焊料中的Sn與UBM發(fā)生冶金反應(yīng),焊料中的Pb并不發(fā)生反應(yīng),。研究表明,,當Sn含量不同時,界面處形成的金屬間化合物不盡相同[1],,而金屬間化合物則是直接影響凸點焊接質(zhì)量及長期可靠性的關(guān)鍵因素之一,,尤其在高溫存儲條件下,金屬間化合物的成分、厚度及晶粒形態(tài)等均會發(fā)生顯著變化,,進而影響倒裝焊器件的長期可靠性,,因此進行高溫存儲條件下不同成分Sn-Pb凸點可靠性研究就顯得尤為必要。
1 材料準備及試驗方法
選用共晶Sn-Pb焊球(63Sn37Pb)及3種常見的高鉛焊球(10Sn90Pb,、5Sn95Pb及3Sn97Pb),,使之分別與常見的Ti-Cu-Ni結(jié)構(gòu)UBM發(fā)生冶金反應(yīng)形成凸點,焊球直徑為100 ?滋m,;選用適用于高溫Sn-Pb焊料的助焊劑,,最高可承受360 ℃高溫;選用菊花鏈芯片,,UBM為Ti-Cu-Ni結(jié)構(gòu),,直徑為85 μm。
選用不同成分的Sn-Pb焊球,,經(jīng)助焊劑印刷并回流形成凸點,,然后對帶有凸點的芯片樣品進行高溫存儲試驗,存儲溫度為150 ℃,,存儲時間節(jié)點分別為100 h,、500 h及1 000 h。利用剪切拉脫測試儀對凸點進行剪切強度測試,;利用掃描電鏡觀察凸點的微觀組織及IMC形貌,;利用Photoshop軟件對IMC厚度進行提取,對IMC生長情況進行分析,。通過上述手段分析高溫存儲對凸點可靠性的影響,。
2 凸點可靠性分析
2.1 凸點力學(xué)性能分析
4種Sn-Pb凸點抗剪切強度隨高溫存儲的變化情況如圖1所示。

對于3Sn97Pb和10Sn90Pb凸點而言,,其剪切強度隨高溫存儲試驗的進行,,整體上均呈現(xiàn)出先增加后減小的趨勢,10Sn90Pb凸點的剪切強度數(shù)值始終大于3Sn97Pb,。在高溫存儲過程中,,5Sn95Pb凸點的剪切強度呈逐漸下降的趨勢,63Sn37Pb凸點的剪切強度變化不大,,整體較為穩(wěn)定,。高溫存儲試驗中,63Sn37Pb凸點的剪切強度始終最大,,其次為10Sn90Pb,。3種高鉛凸點中,10Sn90Pb凸點的力學(xué)強度最大,,且剪切強度值的波動幅度最小,,這說明在高溫存儲過程中,相較于其他兩種高鉛凸點,10Sn90Pb的力學(xué)性能最好,。
2.2 凸點界面反應(yīng)分析
經(jīng)過高溫存儲后不同凸點的橫截面照片如圖2~圖5所示,。



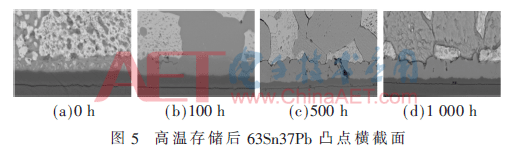
由圖2可知,在高溫存儲過程中,,3Sn97Pb凸點界面處IMC層厚度無明顯增大,,100 h高溫存儲后在界面處可觀測到團簇狀晶粒的存在,;當高溫存儲進行到500 h時,,界面處IMC層較100 h更為平坦,但能觀測到細齒狀凸起,;當高溫存儲進行到1 000 h時,,團簇狀晶粒橫向尺寸明顯增大,并開始出現(xiàn)扇貝化趨勢,。
由圖3和圖4可知,,5Sn95Pb凸點在高溫存儲過程中界面處IMC層厚度略有增大,當高溫存儲達到1 000 h時,,界面處IMC層呈現(xiàn)扇貝狀結(jié)構(gòu),。在高溫存儲過程中,10Sn90Pb凸點界面處IMC層始終保持為連續(xù)的層狀結(jié)構(gòu),,隨著時間的延長,,IMC層厚度不斷增大。
由圖5可知,,63Sn37Pb凸點界面處IMC層的形態(tài)在高溫存儲過程中存在較為明顯的變化,,回流完成時IMC層厚度很小,且能觀測到細長狀的凸起,,焊料內(nèi)部的富Sn相尺寸很小,,彌散分布在凸點中;當高溫存儲進行到100 h時,,IMC層厚度已明顯增大,,約變?yōu)榛亓骱蟪跏己穸鹊?倍,IMC層較為平坦,,不同區(qū)域的IMC層厚度較為一致,,此外焊料內(nèi)部出現(xiàn)大面積的Sn的富集;隨著高溫存儲時間的繼續(xù)進行,,IMC層厚度和焊料內(nèi)部的富Sn相尺寸繼續(xù)增大,;當高溫存儲進行到1 000 h時,界面處IMC層厚度為初始厚度的7.5倍左右,,呈現(xiàn)出扇貝狀形態(tài),,焊料內(nèi)部的富Sn相大面積橋連。
高溫存儲過程中不同成分凸點IMC層厚度的變化情況如圖6所示。由圖6可知,,隨著高溫存儲的進行,,4種成分凸點界面處IMC厚度逐漸增加,在高溫存儲初期,,63Sn37Pb界面處IMC厚度增長最快,,其次為10Sn90Pb,3Sn97Pb和5Sn95Pb凸點IMC厚度增長速度相差不大,,這與二者的Sn含量相近有關(guān),。此外,隨高溫存儲過程的進行,,4種凸點界面處IMC厚度增長速度均有不同程度的減緩,,當高溫存儲進行到500 h左右時,3Sn97Pb凸點IMC厚度即不再發(fā)生變化,。1 000 h高溫存儲完成后,,3Sn97Pb和5Sn95Pb凸點界面處IMC層厚度值相差無幾,63Sn37Pb凸點界面處IMC厚度值最大,。在相同的條件下,,界面處IMC層的厚度仍與焊料中Sn元素的含量有關(guān),Sn含量越高,,高溫存儲后形成的IMC層也越厚[2],。

高溫存儲后不同成分凸點界面處IMC的top view形態(tài)如圖7所示。

由圖7可知,,在高溫存儲試驗過程中,,4種成分凸點的IMC晶粒形態(tài)均發(fā)生了明顯變化。當高溫存儲進行到100 h時,,4種凸點界面處IMC晶粒形態(tài)均出現(xiàn)棱晶狀向貝殼狀轉(zhuǎn)變的趨勢[3],。通過EDX分析后可知,此時3Sn97Pb和5Sn95Pb凸點界面處IMC的主要成分為Ni3Sn2和Ni3Sn,,10Sn90Pb和63Sn37Pb 凸點界面處IMC的主要成分為Ni3Sn4,。
當高溫存儲進行到500h時,5Sn95Pb和10Sn90Pb凸點的IMC中均觀測不到細軸狀晶粒的存在,,晶粒出現(xiàn)粗化,,呈現(xiàn)出不規(guī)則的扇貝狀結(jié)構(gòu),而此時63Sn37Pb凸點的IMC晶粒嚴重粗化,,轉(zhuǎn)變?yōu)槲菁範罱Y(jié)構(gòu),。3Sn97Pb凸點界面處IMC晶粒仍保持棱晶狀。對于3Sn97Pb和5Sn95Pb凸點而言,,高溫存儲500h后,,IMC的主要成分仍為Ni3Sn2和Ni3Sn,,這是因為與其他兩種焊料相比,3Sn97Pb和5Sn95Pb焊料中Sn含量最少,,因此,,即使經(jīng)過長時間的高溫存儲,Sn原子有充足的時間可擴散至IMC/焊料的界面處,,但是擴散的Sn原子數(shù)量相較于Ni原子而言仍然非常少[4],,所以在界面處只能形成Ni3Sn和Ni3Sn2。
此時10Sn90Pb凸點界面處IMC的主要成分為Ni3Sn4和Ni3Sn2,。在靠近焊料的一側(cè),,IMC的主要成分為Ni3Sn4,靠近焊盤的一側(cè)IMC主要成分為Ni3Sn2,,這種現(xiàn)象是由原子濃度梯度不同導(dǎo)致的[5],。由Ni-Sn二元相圖可知,,在10Sn90Pb凸點回流焊初始階段,,焊盤中的Ni不斷溶解到熔融焊料中,Ni和Sn原子供應(yīng)均充足,,此時形成的金屬間化合物主要是Ni3Sn4,。在回流之后,隨著高溫存儲的不斷進行,,Sn原子濃度逐漸降低,,導(dǎo)致Sn原子供應(yīng)不足,而在IMC/焊盤的界面處,,Sn原子通過擴散作用到達該處,,與焊盤中的Ni原子發(fā)生反應(yīng)形成IMC,此時Ni原子相對過量,,因此形成Ni3Sn2,。高溫存儲過程中,63Sn37Pb界面處IMC的主要成分始終為Ni3Sn4,。
在高溫存儲過程中,,不同成分凸點中IMC晶粒尺寸的增加速度也呈現(xiàn)出較為明顯的差異:在高溫存儲試驗前期,63Sn37Pb凸點IMC生長速度最快,,晶粒粗化現(xiàn)象也最為嚴重,;10Sn90Pb凸點IMC晶粒生長速度其次,隨著焊料中Sn含量的降低,,在高溫存儲過程中IMC晶粒的生長速度也逐漸降低,;當高溫存儲試驗進行到一定時間后,不同成分的凸點界面處IMC晶粒的生長速度均有所減慢,。經(jīng)過500h高溫存儲后,,63Sn37Pb凸點IMC晶粒尺寸最大,,3Sn97Pb凸點中晶粒尺寸最小。
3 結(jié)論
本文通過對比經(jīng)歷高溫存儲試驗前后3Sn97Pb,、5Sn95Pb,、10Sn90Pb以及63Sn37Pb凸點的力學(xué)性能、IMC層厚度及IMC晶粒形貌,,得出以下結(jié)論:
(1)隨著高溫存儲試驗的進行,,不同成分凸點的剪切力整體上呈現(xiàn)先增加后減小的趨勢,其中10Sn90Pb凸點剪切強度波動幅度最??;
(2)界面處IMC層厚度與焊料中Sn元素含量有關(guān),Sn含量越高,,高溫存儲后形成的IMC層越厚,,63Sn37Pb界面IMC變化最為明顯;
(3)焊料中Sn含量越低,,高溫存儲過程中IMC晶粒的生長速度越低,,其中63Sn37Pb凸點IMC生長速度最快,晶粒粗化現(xiàn)象最為嚴重,,10Sn90Pb凸點IMC生長速度其次,;
(4)高溫存儲過程中,63Sn37Pb界面處IMC的主要成分始終為Ni3Sn4,,10Sn90Pb凸點界面處IMC的主要成分為Ni3Sn4和Ni3Sn2,。
參考文獻
[1] 楊雪霞.電子封裝中金屬間化合物力學(xué)性能的研究及焊點可靠性分析[D].太原:太原理工大學(xué),2013:29-35.
[2] 楊曉華.Sn-Pb共晶焊接接頭中IMC的形成及時效演變[J].有色金屬,,2007,,59(3):37-42.
[3] Wang Kaizheng,CHEN C M.Intermetallic compound formation and morphology evolution[J].Journal of Electronic Materials,,2005,,12(34):128-133.
[4] 楊光育,徐欣,,董義.無鉛合金與錫鉛合金性能對比分析[J].電子工藝技術(shù),,2008,29(6):328-333.
[5] HE M,,KUMARA A,,YEO P T.Interfacial reaction between Sn-rich solders and Ni-based metallization[J].Thin Solid Films,2004,,11(9):387-394.
作者信息:
文惠東,,林鵬榮,曹玉生,,練濱浩,,王 勇,,姚全斌
(北京微電子技術(shù)研究所,北京100076)

