文獻標(biāo)識碼: A
DOI:10.16157/j.issn.0258-7998.2017.01.007
中文引用格式: 張宇,郭坤. 基于瞬態(tài)熱仿真的宇航厚膜SSPC可靠性設(shè)計研究[J].電子技術(shù)應(yīng)用,2017,43(1):28-31,38.
英文引用格式: Zhang Yu,Guo Kun. Reliability design of space thick-film SSPC based on transient thermal simulation[J].Application of Electronic Technique,2017,43(1):28-31,38.
0 引言
熱分析與計算是電子產(chǎn)品可靠性設(shè)計中一個非常重要的方面,合理確定電子產(chǎn)品的溫度分布及準(zhǔn)確的溫度計算對于提高電子產(chǎn)品的可靠性至關(guān)重要。據(jù)統(tǒng)計,溫度過高引起的電子產(chǎn)品失效率高達55%[1]。
厚膜即厚膜混合集成電路,是以絲網(wǎng)印制工藝為基礎(chǔ),在絕緣基片上印制各種無源元件、互聯(lián)線和焊區(qū),并采用適宜的組裝技術(shù),裝上半導(dǎo)體有源器件和有特殊要求的無源元件所組成的具有一定功能的電路[2]。宇航固態(tài)功率控制器(Solid State Power Controller,SSPC)是集繼電器的轉(zhuǎn)換功能和熔斷器的電路保護功能于一體的功率開關(guān)器件,是航天器配電系統(tǒng)中控制負(fù)載通斷的核心器件。由于其具有無觸點、無電弧、無噪聲、響應(yīng)快、電磁干擾小、壽命長、可靠性高以及便于計算機遠(yuǎn)程控制等優(yōu)點而廣泛應(yīng)用到航天、航空等領(lǐng)域的電子產(chǎn)品中。
宇航厚膜SSPC的主要功能是通過SSPC內(nèi)部的控制電路對MOS管的開通和關(guān)斷的控制以實現(xiàn)對電源到負(fù)載的開通與關(guān)斷的控制。本文以北京衛(wèi)星制造廠研制的某型宇航厚膜SSPC為研究對象,簡述了產(chǎn)品的工作原理、產(chǎn)品的熱設(shè)計、產(chǎn)品熱阻的理論計算;同時為了驗證產(chǎn)品在負(fù)載異常的情況下,產(chǎn)品工作的可靠性與穩(wěn)定性,分別識別出了“負(fù)載短路時開通”、“容性負(fù)載開通”、“開通后負(fù)載短路”3種極端瞬態(tài)工況;為研究這樣的極端瞬態(tài)工況,以瞬態(tài)的熱仿真為基礎(chǔ),分析出MOS管的瞬態(tài)溫度變化曲線和溫度變化趨勢,提取了MOS芯片在瞬態(tài)工況下達到的最高溫度及相關(guān)的熱態(tài)特性,據(jù)此優(yōu)化產(chǎn)品的設(shè)計,提高產(chǎn)品使用的可靠性,同時為產(chǎn)品的可靠性設(shè)計提供重要的數(shù)據(jù)支撐。
1 熱設(shè)計在宇航厚膜SSPC可靠性設(shè)計中的應(yīng)用研究
產(chǎn)品應(yīng)根據(jù)其工作特點進行合理有效的熱設(shè)計,既要保證穩(wěn)態(tài)工作時在正常工作溫度范圍內(nèi)所有元器件使用安全,又要保證承受瞬態(tài)很大功耗時元器件不出現(xiàn)異常。
1.1 宇航厚膜SSPC的熱設(shè)計
宇航厚膜SSPC內(nèi)部根據(jù)熱耗、功能需求采用了區(qū)分功能電路設(shè)計:控制電路部分與功率電路部分,如圖1所示。
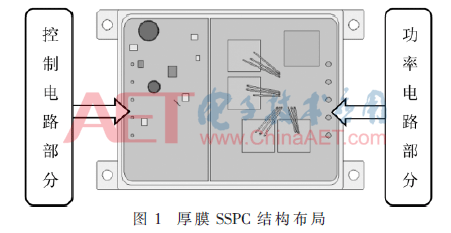
宇航厚膜SSPC內(nèi)部采用區(qū)分基板設(shè)計,通過基板與DBC覆銅基板相結(jié)合的方式用以解決控制電路部分、功率電路部分不同的散熱需求,DBC覆銅基板導(dǎo)熱快、散熱效果好,非常適用于大功率電路散熱。
宇航厚膜SSPC殼體與基板采用導(dǎo)熱耦合設(shè)計: 基板與殼體之間為焊料焊接,基板為網(wǎng)格結(jié)構(gòu),焊料點入基板的網(wǎng)格內(nèi),焊接過程中焊料呈流熔狀態(tài),擠出基板與殼體之間的空氣體,保證基板與殼體的緊密接觸,提高基板與殼體的導(dǎo)熱耦合性。
宇航厚膜SSPC內(nèi)部MOS與基板通過合理的工藝控制措施將焊接氣泡率控制到小于10%,能有效減小熱阻,提高散熱性能。
1.2 宇航厚膜SSPC結(jié)殼熱阻理論計算
厚膜SSPC中元器件產(chǎn)生的熱量主要靠熱傳導(dǎo)方式向外殼傳遞,熱量傳到外殼后以少量熱輻照向周圍環(huán)境傳遞熱量。在熱量流進截面較大的部位時,會產(chǎn)生熱擴散現(xiàn)象[3],從圖2中可以看出,熱量是沿著熱流線方向即與器件垂直方向成α擴展角方向向外擴展。
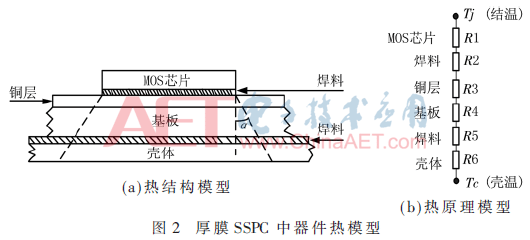
厚膜SSPC內(nèi)部芯片到外殼間有MOS芯片、焊料、銅層、基板、焊料、殼體,所以總熱阻等于元器件與封裝殼之間散熱途徑中每種材料熱阻的總和。
熱阻計算方程即熱擴展方程如下[4]:

式中,Q為熱阻,單位℃/W;S是x的函數(shù)且等于在任何截面上熱垂直通過的面積,單位m2;K為導(dǎo)熱系數(shù),單位W/(m·℃)。
描述熱擴展的方程非常復(fù)雜,一個簡化的假定是熱以45°角的方向擴展,即擴展角α為45°;由于厚膜SSPC中的功率MOS芯片是一個類似于方形的芯片,即圖3中a=b;由于擴展角假設(shè)為45°,則式(1)可簡化為:

式中,x為各層材料厚度,a為發(fā)熱器件的邊長。

利用式(3)可計算厚膜SSPC內(nèi)部功率MOS芯片到殼體各層材料熱阻,如表1。

2 瞬態(tài)熱仿真分析在宇航厚膜SSPC可靠性設(shè)計中的應(yīng)用研究
2.1 產(chǎn)品的瞬態(tài)工況及熱耗
厚膜SSPC內(nèi)部使用功率MOSFET實現(xiàn)開關(guān)控制功能;內(nèi)部電路按原理可劃分為控制電路部分和功率電路部分。控制電路包括MOS驅(qū)動、過流保護、狀態(tài)檢測、輔助電源等功能電路,功耗與厚膜SSPC工作狀態(tài)無關(guān);功率電路主要包括功率MOS和功率電阻,功耗與厚膜SSPC工作狀態(tài)相關(guān)。
(1)控制電路部分
控制電路部分的發(fā)熱器件及散熱措施見表2。

(2)功率電路部分
厚膜SSPC長期工作狀態(tài)為開通狀態(tài)或者關(guān)斷狀態(tài),開通過程、關(guān)斷過程、過流保護過程為瞬態(tài)工作狀態(tài)。開通狀態(tài)下,功率MOS完全導(dǎo)通,按額定電流核算實際功耗;關(guān)斷狀態(tài)下,功率MOS截止,漏電流小于10 ?滋A,不考慮功耗;瞬態(tài)工作狀態(tài)中“開通后負(fù)載短路”、“最大負(fù)載電容能力開通”工況下MOS功耗最大。
功率電路穩(wěn)態(tài)功耗統(tǒng)計如表3所示,其中MOS功耗按125 ℃導(dǎo)通阻抗核算。

負(fù)載短路時開通、容性負(fù)載開通、開通后負(fù)載短路時功率電路部分中的開通功率MOS承受較大功耗,按照厚膜SSPC應(yīng)用母線電壓最大值120 V時實測MOS承受的電壓和電流波形,核算瞬態(tài)熱耗如圖4所示。

2.2 熱仿真分析模型
熱仿真分析建立熱仿真模型的基本原則為:
(1)用一個金屬塊或熱源來模擬整個元器件[5];
(2)基板上功耗大、溫度梯度大的地方,節(jié)點劃分應(yīng)加處理密;
(3)熱功耗大于100 mW的元器件單獨劃分節(jié)點;
(4)不大于100 mW的元器件不單獨劃分節(jié)點,熱功耗均勻分布到基板上。
熱模型的網(wǎng)格劃分時采用嵌入式網(wǎng)格,在重要及溫度梯度大的部位進行局部網(wǎng)格加密[6],如圖5所示。
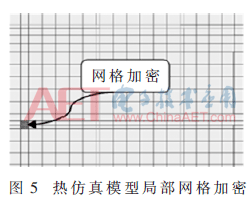
根據(jù)基板在熱傳導(dǎo)中具有的各向異性的特點,其中Kn為沿基板表面垂直方向的熱傳導(dǎo)率,Kp為沿基板表面平行方向的熱傳導(dǎo)率[7],如圖6所示。

2.3 瞬態(tài)熱仿真分析
2.3.1 負(fù)載短路開通瞬態(tài)工況
負(fù)載短路開通前厚膜SSPC為關(guān)斷狀態(tài),即MOS初始時刻功耗為0 W。
MOS與基板焊接面會殘留氣泡,影響散熱,實際工藝控制焊接氣泡率小于10%,熱仿真分析時考慮焊接氣泡率10%情況展開熱仿真分析。
由負(fù)載短路開通瞬態(tài)工況的特點及功率MOS變化曲線,擬合出熱仿真輸入曲線,如圖7所示;提取了此種瞬態(tài)工況下功率MOS溫度變化曲線,如圖8所示;提取了此種瞬態(tài)工況下功率MOS在各時間步內(nèi)整機的溫度分布,如圖9所示。

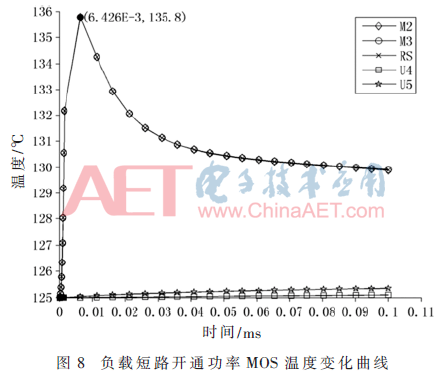

從各時間步上溫度分布云圖演變和功率器件溫度變化曲線來看,功率MOS在1.5 ms左右由125 ℃上升至135.8 ℃左右,溫升為10.8 ℃左右,由于功率MOS芯片的許用最高溫度為150 ℃,說明在此種瞬態(tài)工況下功率MOS使用安全。
2.3.2 容性負(fù)載開通瞬態(tài)工況
容性負(fù)載開通前厚膜SSPC為關(guān)斷狀態(tài),即MOS初始時刻功耗為0 W。
MOS與基板焊接面會殘留氣泡,影響散熱,實際工藝控制焊接氣泡率小于10%,熱仿真分析時考慮焊接氣泡率10%情況展開熱仿真分析。
由容性負(fù)載開通瞬態(tài)工況的特點及功率MOS變化曲線,擬合出熱仿真輸入曲線,如圖10所示;提取了此種瞬態(tài)工況下功率MOS溫度變化曲線,如圖11所示;提取了此種瞬態(tài)工況下功率MOS在各時間步內(nèi)整機的溫度分布,如圖12所示。
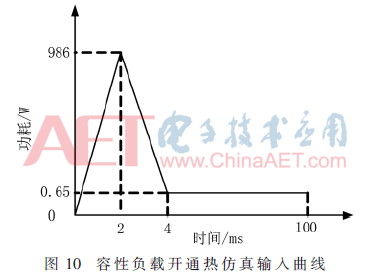
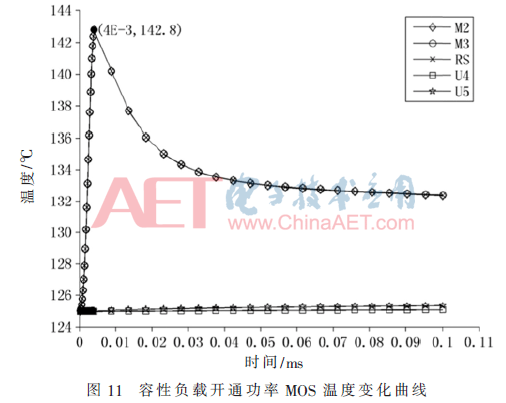
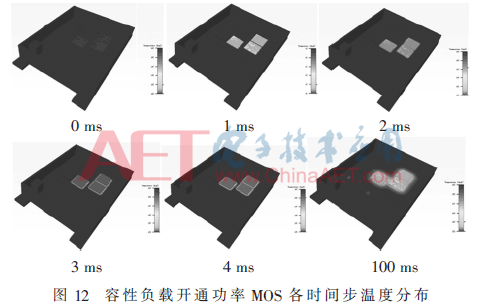
從各時間步上溫度分布云圖演變和功率器件溫度變化曲線來看,功率MOS在3 ms左右由125 ℃上升至142.8 ℃左右,溫升為17.8 ℃左右,由于功率MOS芯片的許用最高溫度為150 ℃,說明在此種瞬態(tài)工況下功率MOS使用安全。
2.3.3 開通后負(fù)載短路瞬態(tài)工況
開通后負(fù)載短路前厚膜SSPC為開通狀態(tài),即MOS初始時刻功耗為0.65 W。
MOS與基板焊接面會殘留氣泡,影響散熱,實際工藝控制焊接氣泡率小于10%,熱仿真分析時考慮焊接氣泡率10%情況展開熱仿真分析。
由開通后負(fù)載短路瞬態(tài)工況的特點及功率MOS變化曲線,擬合出熱仿真輸入曲線,如圖13所示;提取了此種瞬態(tài)工況下功率MOS溫度變化曲線,如圖14所示;提取了此種瞬態(tài)工況下功率MOS在各時間步內(nèi)整機的溫度分布,如圖15所示。
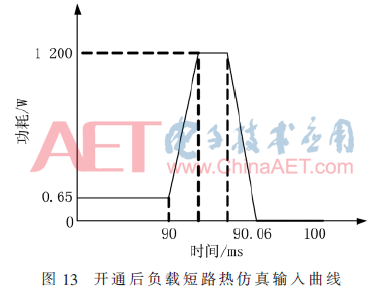
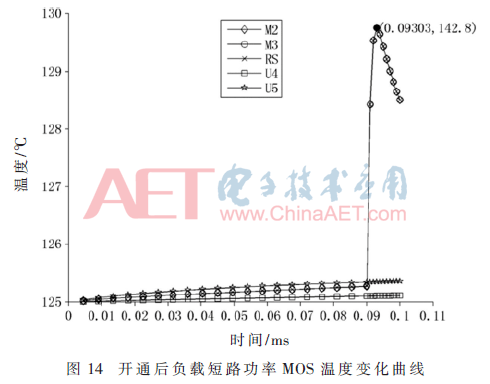

從各時間步上溫度分布云圖演變和功率器件溫度變化曲線來看,功率MOS在90.03 ms左右由125 ℃上升至129.8 ℃左右,溫升為4.8 ℃左右,由于功率MOS芯片的許用最高溫度為150 ℃,說明在此種瞬態(tài)工況下功率MOS使用安全。
3 結(jié)論
本文對厚膜SSPC進行合理的熱設(shè)計,提高了產(chǎn)品的可靠性指標(biāo);同時進行了瞬態(tài)的熱仿真分析,闡述了產(chǎn)品的熱態(tài)特性,分析了產(chǎn)品對各種復(fù)雜瞬態(tài)工況使用的適應(yīng)性,優(yōu)化產(chǎn)品設(shè)計,拓寬產(chǎn)品使用適應(yīng)界限,驗證了產(chǎn)品在在多種復(fù)雜瞬態(tài)工況下使用的可靠性。
參考文獻
[1] 于慈遠(yuǎn).計算機輔助電子設(shè)備熱分析熱設(shè)計及熱測量技術(shù)的研究[D].北京:北京航空航天大學(xué),2000.
[2] 孔憲祺.防空導(dǎo)彈彈載電子設(shè)備的結(jié)構(gòu)設(shè)計及集成工藝[M].北京:宇航出版社,2000.
[3] 王長龍.航天器電子產(chǎn)品可靠性設(shè)計概述[Z].航天五院可靠性工程培訓(xùn),2005.
[4] LICARI J J,ENLOW L R.混合微電路技術(shù)手冊-材料、工藝、設(shè)計、試驗和生產(chǎn)(第2版)[M].朱瑞廉,譯.北京:電子工業(yè)出版社,2004.
[5] VISWANATH R,ALI I A.Thermal modeling of high performance packages in portable computers[J].IEEE Transactions on Components,Packing,and Manufacturing Technology,1997,20(2):230-240.
[6] 劉勇,梁利華,曲建民.微電子器件及封裝的建模與仿真[M].北京:科學(xué)出版社,2010.
[7] D·皮茨,L·西索姆.傳熱學(xué)[M].葛新石,譯.北京:科學(xué)出版社,2002.
作者信息:
張 宇1,郭 坤2
(1.北京衛(wèi)星制造廠,北京100080;2.北京市空間電源變換與控制工程研究中心,北京100080)

