文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.2015.09.005
中文引用格式: 曹合適,粟雅娟,張斌珍,等. 微納機(jī)電開(kāi)關(guān)研究現(xiàn)狀[J].電子技術(shù)應(yīng)用,2015,41(9):21-24,32.
英文引用格式: Cao Heshi,Su Yajuan,Zhang Binzhen,et al. Research progresses on MEMS/NEMS switch[J].Application of Electronic Technique,2015,41(9):21-24,32.
0 引言
互補(bǔ)金屬氧化物半導(dǎo)體(CMOS)的出現(xiàn)為半導(dǎo)體行業(yè)的發(fā)展提供了強(qiáng)大的動(dòng)力,在制作微型化、快速、低成本的電子產(chǎn)品方面取得了巨大的成功[1]。隨著大規(guī)模集成電路的發(fā)展,CMOS晶體管的特征尺寸進(jìn)入納米級(jí)別,CMOS正面臨巨大的發(fā)展瓶頸,柵極泄漏、短溝道效應(yīng)、結(jié)漏等[2-3]極大地阻礙了微電子技術(shù)的發(fā)展,微納機(jī)電開(kāi)關(guān)的出現(xiàn)在很大程度上彌補(bǔ)了半導(dǎo)體開(kāi)關(guān)的不足。微納機(jī)電開(kāi)關(guān)是在微機(jī)電系統(tǒng)的基礎(chǔ)上發(fā)展起來(lái)的特征尺寸在微米或納米量級(jí)內(nèi)的機(jī)械開(kāi)關(guān),包括微機(jī)電(MEMS)開(kāi)關(guān)和納機(jī)電(NEMS)開(kāi)關(guān)。微納機(jī)電開(kāi)關(guān)具有體積小、速度快、功耗低等特點(diǎn),由于物理氣隙的存在,其斷路時(shí)的泄漏電流幾乎為0,而且具有延遲效應(yīng)。隨著科技的進(jìn)步,航空航天、通信、計(jì)算機(jī)等高端前沿領(lǐng)域?qū)Φ凸奈⑿推骷男枨笞兊糜葹槠惹校趥鹘y(tǒng)的半導(dǎo)體開(kāi)關(guān)已不能滿足這種需求的同時(shí),微納機(jī)電關(guān)極可能擔(dān)當(dāng)起這一重要使命。
1 微納機(jī)電開(kāi)關(guān)應(yīng)用
微納機(jī)電開(kāi)關(guān)的研究受到了各國(guó)學(xué)者的重視,目前,部分微納機(jī)電開(kāi)關(guān)已經(jīng)實(shí)現(xiàn)商業(yè)化應(yīng)用,特別是在MEMS開(kāi)關(guān)與射頻器件的結(jié)合方面。隨著通信技術(shù)的發(fā)展,小體積、低功耗、高性能、多功能的射頻設(shè)備成為無(wú)線電領(lǐng)域的發(fā)展趨勢(shì),射頻器件朝著微型化和集成化的方向發(fā)展,對(duì)電感、電容、濾波器等的Q值、阻抗匹配、隔離度提出了更高的要求。MEMS開(kāi)關(guān)在射頻器件上的應(yīng)用為解決上述問(wèn)題提供了突破口,RF MEMS開(kāi)關(guān)具有寬帶、低損耗、線性等優(yōu)點(diǎn)。經(jīng)過(guò)20余年的發(fā)展,RF MEMS開(kāi)關(guān)已經(jīng)成為射頻器件中不可或缺的一員,其應(yīng)用領(lǐng)域也擴(kuò)展到防御應(yīng)用的雷達(dá)系統(tǒng)、衛(wèi)星通信系統(tǒng)、無(wú)線電通信系統(tǒng)、儀器系統(tǒng)等。MEMS開(kāi)關(guān)在射頻領(lǐng)域內(nèi)的應(yīng)用已經(jīng)趨于成熟,性能也得到了大幅度的提升。Babak Yousefi Darani等人在2011年研制的微機(jī)電射頻開(kāi)關(guān)通過(guò)增加驅(qū)動(dòng)電極的面積使驅(qū)動(dòng)電壓降到了1.3 V,且電學(xué)性能良好,能夠通過(guò)共面波導(dǎo)傳輸線應(yīng)用在2 GHz~6 GHz頻段中,插入損耗僅為-0.16 dB,而斷開(kāi)時(shí)的隔離度則高達(dá)-35 dB[4]。RF MEMS開(kāi)關(guān)在不停的循環(huán)工作中容易誘發(fā)疲勞失效,因此對(duì)穩(wěn)定性有較高的要求。2013年David等人制作了一種RuO2-Au接觸開(kāi)關(guān),接觸電阻小于4 Ω,在10 GHz的工作頻段下插入損耗為0.4 dB,隔離度28 dB[5],能夠連續(xù)工作100億次,極大地提高了使用壽命。國(guó)內(nèi)的學(xué)者在RF MEMS開(kāi)關(guān)的研究中也做出了突出貢獻(xiàn),東南大學(xué)的研究者將射頻微機(jī)電開(kāi)關(guān)的應(yīng)用頻率提高到了40 GHz,同時(shí)工作電壓降到了0.3~0.55 V之間,插入損耗小于-0.5 dB,隔離度大于-30 dB,這種開(kāi)關(guān)能夠應(yīng)用在甚寬帶通信設(shè)備中[6]。隨著研究的進(jìn)一步深入,相信MEMS開(kāi)關(guān)在射頻器件中的應(yīng)用會(huì)得到更寬的擴(kuò)展。
在過(guò)去的幾十年中,最先進(jìn)的微處理芯片上晶體管數(shù)量已經(jīng)從4.2×108增加到了3×1010[7]。隨著CMOS晶體管的尺寸進(jìn)入納米量級(jí),功耗逐漸成為CMOS晶體管不可忽視的問(wèn)題[8],而且電子元器件經(jīng)常性充放電所造成的泄漏功耗也將降低系統(tǒng)的使用壽命。作為一種機(jī)械開(kāi)關(guān),NEMS開(kāi)關(guān)不存在CMOS晶體管在納米量級(jí)內(nèi)所面臨的問(wèn)題。與MEMS開(kāi)關(guān)相比,NEMS開(kāi)關(guān)的體積更小、速度更快。目前,NEMS開(kāi)關(guān)的應(yīng)用主要集中在數(shù)字邏輯電路和非易失存儲(chǔ)器上。雖然NEMS開(kāi)關(guān)還處在實(shí)驗(yàn)研究階段,但是已有相關(guān)學(xué)者在該領(lǐng)域取得了重大突破。Weon Wi Jang等人在2007年研制的一種適用于記憶芯片的NEMS靜電開(kāi)關(guān)[9]可以克服泄漏電流對(duì)場(chǎng)效晶體管的限制,應(yīng)用在非易失存儲(chǔ)器中。測(cè)試結(jié)果表明,該微型開(kāi)關(guān)具有良好的開(kāi)/關(guān)特性,亞閾值擺幅接近于零(約為4 mV/decade),開(kāi)關(guān)的閉合時(shí)間達(dá)到了3 μs。2013年國(guó)外的Daesung Lee用一種NEMS開(kāi)關(guān)成功組合成了一個(gè)2-1邏輯轉(zhuǎn)換門電路[10],并可以根據(jù)二元決策圖實(shí)現(xiàn)任何邏輯功能,Daesung Lee的研究工作展示了NEMS開(kāi)關(guān)在邏輯電路中的巨大潛能。
2 微納機(jī)電開(kāi)關(guān)分類
微納機(jī)電開(kāi)關(guān)根據(jù)不同的形式可以分為很多類。按照尺寸的大小可以分為微機(jī)電(MEMS)開(kāi)關(guān)和納機(jī)電(NEMS)開(kāi)關(guān),微機(jī)電開(kāi)關(guān)的特征尺寸在微米量級(jí),而納機(jī)電開(kāi)關(guān)的特征尺寸在納米量級(jí)。根據(jù)驅(qū)動(dòng)方式的不同則可以分為熱驅(qū)動(dòng)型、壓電型、電磁型和靜電型[11]。相比其他類型的微型開(kāi)關(guān),靜電驅(qū)動(dòng)型微機(jī)械開(kāi)關(guān)結(jié)構(gòu)簡(jiǎn)單、控制方便,而且功耗小、響應(yīng)頻率高、便于集成,這類開(kāi)關(guān)的研究起始早,原理成熟,是目前微納機(jī)電開(kāi)關(guān)的研究熱點(diǎn)。
微納機(jī)電開(kāi)關(guān)根據(jù)驅(qū)動(dòng)方向的不同又可以分為橫向型和縱向型,這兩種類型的微納開(kāi)關(guān)也有各自的優(yōu)缺點(diǎn)。最初的研究多集中在縱向型,縱向結(jié)構(gòu)更符合微細(xì)加工自上而下的工藝方式,可以方便地優(yōu)化彈性梁結(jié)構(gòu),驅(qū)動(dòng)電極面積、氣隙大小等結(jié)構(gòu)參數(shù),驅(qū)動(dòng)電壓能降到很低,但同時(shí)也會(huì)增加器件尺寸、加大制作難度。其制作工藝往往需要多次光刻,由此產(chǎn)生的套準(zhǔn)誤差將影響開(kāi)關(guān)的性能。近年來(lái)對(duì)于微型開(kāi)關(guān)的研究越來(lái)越趨向于橫向驅(qū)動(dòng)型。與縱向型微型開(kāi)關(guān)相比,橫向驅(qū)動(dòng)納機(jī)電靜電開(kāi)關(guān)有很大的優(yōu)勢(shì)[12]:(1)大多數(shù)的橫向微型開(kāi)關(guān)僅需要一次光刻,工藝簡(jiǎn)單,不存在多次光刻產(chǎn)生的對(duì)準(zhǔn)誤差;(2)尺寸和形狀選擇性大;(3)容易封裝;(4)便于集成。但是橫向開(kāi)關(guān)只能制作一些簡(jiǎn)單結(jié)構(gòu),對(duì)異形梁等復(fù)雜結(jié)構(gòu)則無(wú)能為力,且其氣隙是由光刻精度決定的,因此橫向驅(qū)動(dòng)的微納機(jī)電開(kāi)關(guān)受工藝限制較大。圖1和圖2分別為兩種不同類型的微納機(jī)電開(kāi)關(guān)。
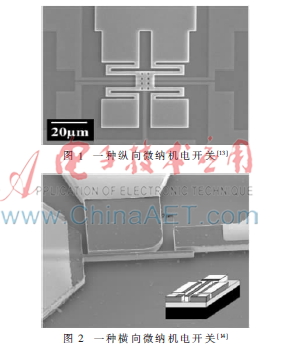
根據(jù)端口數(shù)量,微納機(jī)電開(kāi)關(guān)可以分為兩端口型、三端口型和四端口型[15]。兩端口微納機(jī)電開(kāi)關(guān)僅由彈性梁和一個(gè)電極組成,該電極同時(shí)作為驅(qū)動(dòng)電極和接觸電極,這種類型的開(kāi)關(guān)結(jié)構(gòu)簡(jiǎn)單,但是驅(qū)動(dòng)電壓偏大,且在閉合時(shí)控制電路會(huì)與工作電路產(chǎn)生干涉,因此實(shí)用性不強(qiáng);三端口微納機(jī)電開(kāi)關(guān)在兩端口類型的基礎(chǔ)上增加了一個(gè)電極,實(shí)現(xiàn)了驅(qū)動(dòng)電極和接觸電極的分離,無(wú)論斷開(kāi)還是閉合,驅(qū)動(dòng)電極都不參與開(kāi)關(guān)的工作電路,但是彈性梁在閉合后仍然兼具電極的功能;四端口微納機(jī)電開(kāi)關(guān)在接觸電極和彈性梁之間加了一層絕緣介質(zhì),彈性梁和驅(qū)動(dòng)電極只起控制作用,控制電路和工作電路是完全隔離的,主要劣勢(shì)是制作工藝復(fù)雜。目前微納機(jī)電開(kāi)關(guān)的研究主要集中在三端口類型。
3 微納機(jī)電開(kāi)關(guān)研究進(jìn)展
微納機(jī)電開(kāi)關(guān)作為一個(gè)極具潛力的領(lǐng)域經(jīng)過(guò)近30年的發(fā)展,在尺寸、速度、閾值電壓、穩(wěn)定性等方面取得了巨大突破。隨著電子設(shè)備朝著微型化、集成化、高精度化的方向發(fā)展,小尺寸逐漸成為評(píng)定微納機(jī)電開(kāi)關(guān)性能的標(biāo)準(zhǔn)之一。微細(xì)加工工藝的發(fā)展促進(jìn)了微納機(jī)電開(kāi)關(guān)的小型化,目前,微納機(jī)電開(kāi)關(guān)的特征尺寸已經(jīng)從上世紀(jì)90年代的亞毫米級(jí)、微米級(jí)進(jìn)入了納米量級(jí),其中彈性梁尺寸和氣隙能達(dá)到20 nm左右。Davidson等人便通過(guò)原子層沉積(ALD)技術(shù)成功將微型開(kāi)關(guān)的運(yùn)動(dòng)氣隙縮小到了20 nm[16]。更小的尺寸不僅意味著更輕的質(zhì)量、更小的占用面積,而且能在很大程度上縮小驅(qū)動(dòng)電壓。2010年FENG X L制作出了一種NEMS開(kāi)關(guān),通過(guò)將彈性梁的寬度和氣隙減小到25 nm,使得閾值電壓僅為1.5 V[17],如圖3所示。隨著電子束光刻等超精細(xì)加工技術(shù)的出現(xiàn),微納機(jī)電開(kāi)關(guān)的尺寸和閾值電壓將會(huì)進(jìn)一步減小。

除了尺寸和閾值電壓,穩(wěn)定性和速度也是反應(yīng)微納機(jī)電開(kāi)關(guān)性能好壞的重要指標(biāo)。在最初的研究中,受限于材料和工藝條件,微納機(jī)電開(kāi)關(guān)的穩(wěn)定性很差,不停的閉合工作往往導(dǎo)致疲勞失效,器件僅能正常工作幾百次甚至幾十次。近年來(lái)微納機(jī)電開(kāi)關(guān)的穩(wěn)定性得到了大幅提高,從2010年的1 000次[18]到2011年的5 000 000次[19],再到2012年的109次[15],微納機(jī)電開(kāi)關(guān)的壽命正以指數(shù)形式增長(zhǎng),在穩(wěn)定性方面已經(jīng)能滿足實(shí)際應(yīng)用需求。微納機(jī)電開(kāi)關(guān)在工作過(guò)程中存在機(jī)械延遲,這種特性能被應(yīng)用到非易失存儲(chǔ)器中,但同時(shí)也增加了器件的響應(yīng)時(shí)間,而且由于受實(shí)際加工工藝的影響,氣隙、彈性梁等尺寸參數(shù)不可能無(wú)限減小,多方面的因素使得響應(yīng)時(shí)間成為微納機(jī)電開(kāi)關(guān)的發(fā)展障礙。目前,場(chǎng)效晶體管的響應(yīng)時(shí)間在10 ns之內(nèi),而微米級(jí)別的機(jī)電開(kāi)關(guān)仍然停留在微秒甚至毫秒級(jí)別,雖然可以通過(guò)增加驅(qū)動(dòng)電壓縮短響應(yīng)時(shí)間,但是工作電壓的增加勢(shì)必會(huì)影響微納機(jī)電開(kāi)關(guān)與CMOS器件的集成。理論分析表明,微納機(jī)電開(kāi)關(guān)的速度與器件的尺寸是成反比關(guān)系的,隨著微型開(kāi)關(guān)的特征尺寸進(jìn)入納米量級(jí),其響應(yīng)時(shí)間也縮短到了納秒級(jí)別。在Rhesa Nathanael[15]設(shè)計(jì)的微納機(jī)電開(kāi)關(guān)中,當(dāng)驅(qū)動(dòng)電壓為7.6 V時(shí),開(kāi)關(guān)的響應(yīng)時(shí)間為100 ns左右。而根據(jù)KAM H[20]等人的研究,如果微納機(jī)電開(kāi)關(guān)的尺寸能減小到90 nm,那么其響應(yīng)時(shí)間將能縮減至10 ns,已與晶體管處于同一水平內(nèi)。
金屬良好的導(dǎo)電性和易得性使其成為研究微納機(jī)電開(kāi)關(guān)的主要材料,隨著研究的深入,微納機(jī)電開(kāi)關(guān)的材料選擇正朝著多元化的方向發(fā)展,已由最初的金屬擴(kuò)展到了半導(dǎo)體和陶瓷等材料。2004年出現(xiàn)了以碳納米管為結(jié)構(gòu)材料的NEMS開(kāi)關(guān)[21],該開(kāi)關(guān)的初始?xì)庀稙?50 nm,閾值電壓在6 V左右,在邏輯電路、記憶單元、脈沖發(fā)射器、電流/電壓放大器等高頻率吉赫茲電子器件中有著廣闊的應(yīng)用前景。碳納米管具有良好的物理和化學(xué)性質(zhì),它的重量輕、強(qiáng)度高、耐腐蝕,是制作微納機(jī)電開(kāi)關(guān)的理想材料,但是碳納米管在制作過(guò)程中數(shù)量和位置的不確定性阻礙了其在微納機(jī)電開(kāi)關(guān)上的應(yīng)用。2008年,Weon Wi Jang[22]將目光投向了高熔點(diǎn)、高硬度、耐磨損、導(dǎo)電性良好的TiN金屬陶瓷材料,并將其成功應(yīng)用到微納機(jī)電開(kāi)關(guān)中,研制成功了包括彈性梁式固支梁式的TiN開(kāi)關(guān),如圖4所示。其中,彈性梁式開(kāi)關(guān)泄漏電流為零,亞閾值擺幅小于3 mV/decade,遠(yuǎn)小于CMOS器件在室溫下的理論極限值60 mV/decade。為了能與CMOS結(jié)合以及實(shí)現(xiàn)更好的集成度,多晶硅也正被越來(lái)越多的應(yīng)用到微納機(jī)電開(kāi)關(guān)中,但是鑒于多晶硅的導(dǎo)電性并不是十分理想,往往需要在其表面生長(zhǎng)一層高導(dǎo)電性物質(zhì)。圖1便是用多晶硅制作的微納機(jī)電開(kāi)關(guān),為了防止開(kāi)關(guān)在閉合的過(guò)程中產(chǎn)生“微焊接”并增加導(dǎo)電性,在鍺硅上淀積了一層金屬鎢,其最小氣隙為50 nm,驅(qū)動(dòng)電壓能夠降到2 V左右,整個(gè)開(kāi)關(guān)的占用面積僅為4 μm2,而且具有很高的穩(wěn)定性[13]。材料等相關(guān)領(lǐng)域的發(fā)展會(huì)繼續(xù)擴(kuò)展微納機(jī)電開(kāi)關(guān)的材料選擇,越來(lái)越多的新物質(zhì)將會(huì)被應(yīng)用進(jìn)來(lái)。
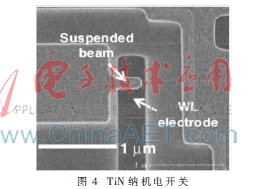
微納機(jī)電開(kāi)關(guān)的高速發(fā)展得益于微加工技工技術(shù)的逐漸成熟。作為MEMS技術(shù)的一個(gè)重要分支,微納機(jī)電開(kāi)關(guān)的制作工藝在初期的研究中多采用MEMS加工技術(shù),如表面微加工技術(shù)、體硅微加工技術(shù)和紫外光刻技術(shù)等,隨著微加工技術(shù)的發(fā)展,目前微納機(jī)電開(kāi)關(guān)的制作包含了氣相淀積(CVD)、紫外光刻技術(shù)(UV-LIGA)、磁控濺射、原子層淀積(ALD)、犧牲層釋放技術(shù)、離子注入、摻雜等多種工藝[23-24]。微納機(jī)電開(kāi)關(guān)的制作正朝著CMOS技術(shù)的方向擴(kuò)展,CMOS與MEMS器件相結(jié)合將是微納機(jī)電開(kāi)關(guān)未來(lái)的發(fā)展趨勢(shì)。與傳統(tǒng)的MEMS工藝相比,CMOS與MEMS的結(jié)合具有以下優(yōu)點(diǎn):(1)CMOS的標(biāo)準(zhǔn)化能大大降低設(shè)備和材料成本。(2)可集成化程度高,縮短了器件的研發(fā)周期。(3)CMOS工藝提高了MEMS/NEMS器件的性能和可靠性。
4 結(jié)語(yǔ)
雖然微納機(jī)電開(kāi)關(guān)在近幾年取得了重要進(jìn)展,但是仍有很長(zhǎng)的路要走。目前,阻礙微納機(jī)電開(kāi)關(guān)發(fā)展的因素主要有兩種:一是現(xiàn)有加工技術(shù)的限制,雖然MEMS加工技術(shù)和CMOS技術(shù)已經(jīng)非常成熟,但是能夠制作特征尺寸在納米量級(jí)內(nèi)器件的手段仍然非常有限,而且大都十分昂貴。另一因素則是器件縮小至納米量級(jí)內(nèi)時(shí)引起的物理、化學(xué)等性質(zhì)的變化,如毛細(xì)力、范德華力等,解決這一障礙牽涉到機(jī)械、物理、化學(xué)、數(shù)學(xué)等多門學(xué)科,需要研究者具有扎實(shí)的理論知識(shí)。將來(lái)對(duì)微納機(jī)電開(kāi)關(guān)的研究工作應(yīng)集中在減小開(kāi)關(guān)尺寸、降低閾值電壓、增加響應(yīng)速度、消除粘附力等方面。而在加工工藝方面,為了實(shí)現(xiàn)與CMOS器件的集成,CMOS技術(shù)在微納機(jī)電開(kāi)關(guān)上的應(yīng)用將是未來(lái)的發(fā)展趨勢(shì)。
參考文獻(xiàn)
[1] PARSA R,SHAVEZIPUR M,LEEK W S,et al.Nanoelec-tromechanical relays with decoupled electrode and suspen-sion[C].Micro Electro Mechanical Systems(MEMS),2011 IEEE 24th International Conference.Cancun,Mexico,2011:1361-1364.
[2] MEINDL J D,CHEN Q,DAVIS J A.Limits on silicon nanoelectronics for terascale integration[J].Science,2001,293:2044-2049.
[3] FRANK D J,DENNARD R H,NOWAK E,et al.Device scaling limits of Si MOSFETs and their application depen-dencies[J].Proc IEEE,2001,89:259-88.
[4] Yousefi Darani B,Abbaspour Sani E,Shayanfar R,et al.Low actuation voltage RF MEMS switch for WiMAX appli-cations[C].RF and Microwave Conference,Seremban,Negeri Sembilan,2011:351-355.
[5] CZAPLEWSKI D A,NORDQUIST C D.RF MEMS switches with RuO2-Au contacts cycled to 10 billion cycles[J].Journal of Microelectro Mechanical Systems,2013,22(3):655-661.
[6] Zhu Yanqing,Han Lei,Wang Lifeng.A novel three state RF MEMS switch for ultrabroadband(DC-40 GHz) applica-tions[J].Electron Device Letters,2013,34(8):1062-1064.
[7] Intel.Your source for Intel product information.[DB/OL].[2015-03-30].http://ark.intel.com/.
[8] ZHIRNOV V V,CAVIN R K,HUTCHBY J A,et al.Limits to binary logic switch scaling-a gedanken model[J].Proceedings of the IEEE,2003,91(11):1934-1939.
[9] Weon Wi Jang,Jeong Oen Lee.A dram-like mechanical non-volatile memory[C].Solid-State Sensors,Actuators and Microsystems Conference,Lyon,F(xiàn)rance,2007:2187-2190.
[10] Daesung Lee,Lee W S.Combinational logic design using six-terminal NEM relays[J].Computer-Aided Design of Integrated Circuits and Systems,2013,32(5):653-666.
[11] RUAN M,SHEN J,WHEELER C B.Latching micromag-netic relays[J].IEEE JMEMS,2001,10:511-517.
[12] Roozbeh Parsa.Nanoelectromechanical relays for low power applications[D].California:Stanford University,2011.
[13] Jack Yaung.NEM relay scaling for ultra-low power digitallogic[D].California:University of California,Berkeley,2013.
[14] HINCHET R,MONTES L.Electrical and mechanical char-acterization of lateral NEMS switches[C].Design,Test,Integration and Packaging of MEMS/MOEMS(DTIP),Aix-en-Provence,F(xiàn)rance,2011:348-351.
[15] NATHANAEL R.Nano-electro-mechanical (NEM) relay devices and technology for ultra-low energy digital inte-grated circuits[D].California:University of California,Berkeley,2012.
[16] DAVIDSON B D,GEORGE S M,BRIGHT V M.Atomic layer deposition(ALD) tungsten nano-electromechanical transistors[C].2010 IEEE 23rd International Micro ElectroMechanical Systems(MEMS) Conference,2010:424-427.
[17] FENG X L,MATHENY M H,ZORMAN C A.Low voltagenanoelectromechanical switches based on silicon carbide nanowires[J].NanoLetters,2010,10(8):2891-2896.
[18] LEE D,LEE W S,PROVINE J.Titanium nitride sidewall stringer process for lateral nano-electromechanical relays[C].IEEE International Conference on Micro Electro MechanicalSystems-MEMS,Hongkong,2010:456-459.
[19] DAVIDSONA B D,SEGHETEB D,GEORGE S M.ALD tungsten NEMS switches and tunneling devices[C].22nd IEEE International Conference on Micro Electro MechnicalSystems,Sorrento,Italy,2009:25-29.
[20] KAM H,POTT V,NATHANAEL R,et al.Design and reliability of a microrelay technology for zero-standby- power digital logic applications[C].International Electron Devices Meeting,Baltimore,MD,2009:809-812,2009.
[21] LEE S W,LEE D S,MORJAN R E.A three-terminal carbon nanorelay[J].Nano Lett,2004,4(10):2027-2030.
[22] Weon Wi Jang,Jun-Bo Yoon,Min-Sang Kim.NEMS switch with 30 nm-thick beam and 20 nm-thick air-gapfor high densitynon-volatile memory applications[C].Semi-conductor Device Research Symposium,College Park,USA,2007:1-2.
[23] Lee W S,CHONG S,PARSA R.Dual sidewall lateral nanoelectromechanical relays with beam isolation[C].Solid-State Sensors,Actuators and Microsystems Conference,Beijing,China.2011:2606-2609.
[24] CHONG S,LEE B.Integration of nanoelectromechanical(NEM) relays with silicon CMOS with functional CMOS-NEM circuit[D].Electron Devices Meeting(IEDM),Wash-ington,USA,2011:30.5.1-30.5.4.

