文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.2015.08.001
中文引用格式: 賈國(guó)慶,林倩,陳善繼. 3D IC-TSV技術(shù)與可靠性研究[J].電子技術(shù)應(yīng)用,2015,41(8):3-8.
英文引用格式: Jia Guoqing,Lin Qian,Chen Shanji. Research of 3D IC -TSV technology and reliability[J].Application of Electronic Technique,2015,41(8):3-8.
0 引言
隨著半導(dǎo)體制作工藝尺寸縮小到深亞微米量級(jí),摩爾定律受到越來(lái)越多的挑戰(zhàn)。首先,互連線(尤其是全局互連線)延遲已經(jīng)遠(yuǎn)超過(guò)門(mén)延遲,,這標(biāo)志著半導(dǎo)體產(chǎn)業(yè)已經(jīng)從“晶體管時(shí)代”進(jìn)入到“互連線時(shí)代”。為此,國(guó)際半導(dǎo)體技術(shù)路線圖組織(ITRS)在 2005 年的技術(shù)路線圖中提出了“后摩爾定律”的概念。“后摩爾定律”將發(fā)展轉(zhuǎn)向綜合創(chuàng)新,而不是耗費(fèi)巨資追求技術(shù)節(jié)點(diǎn)的推進(jìn)。尤其是基于TSV(Through Silicon Via)互連的三維集成技術(shù),引發(fā)了集成電路發(fā)展的根本性改變。三維集成電路(Three-Dimensional Integrated Circuit,3D IC)可以將微機(jī)電系統(tǒng)(MEMS)、射頻模塊(RF module)、內(nèi)存(Memory)及處理器(Processor)等模塊集成在一個(gè)系統(tǒng)內(nèi)[1],如圖1所示,大大提高了系統(tǒng)的集成度,減小了功耗,提高了性能,因此被業(yè)界公認(rèn)為延續(xù)摩爾定律最有效的途徑之一,成為近年來(lái)研究的熱點(diǎn)。
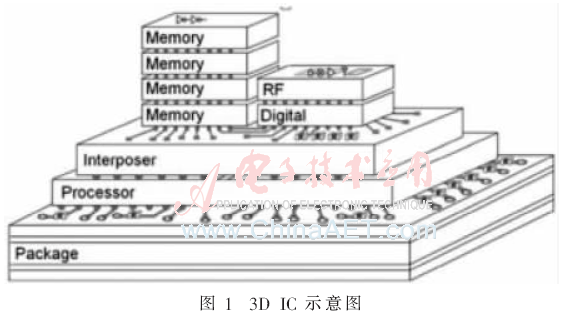
目前3D集成技術(shù)主要有如下三種:焊線連接(Wire-Bonding)、單片集成(Monolithic Integration)和TSV技術(shù)[2]。焊線連接是一種直接而經(jīng)濟(jì)的集成技術(shù),但僅限于不需要太多層間互連的低功率、低頻的集成電路。單片集成是在同一個(gè)襯底上制作多層器件的新技術(shù),它的應(yīng)用受到工藝溫度要求很高和晶體管質(zhì)量較差等約束。基于TSV的3D集成可以實(shí)現(xiàn)短且密的層間互連,有效縮短了互連線長(zhǎng)度,大大提高了系統(tǒng)集成度,降低了互連延時(shí),提高了系統(tǒng)性能,縮小了封裝尺寸,高頻特性出色,芯片功耗降低(可將硅鍺芯片的功耗降低大約40%),熱膨脹可靠性高,同時(shí)還實(shí)現(xiàn)了異構(gòu)集成,成為業(yè)界公認(rèn)使摩爾定律持續(xù)有效的有力保證,所以備受研究者的青睞。
1 TSV技術(shù)與相關(guān)工藝
1.1 TSV技術(shù)介紹
TSV技術(shù)將在先進(jìn)的三維集成電路(3D IC)設(shè)計(jì)中提供多層芯片之間的互連功能[3]。圖2給出了最早的TSV結(jié)構(gòu)示意圖,這是1958年諾貝爾獎(jiǎng)得主WilliamShockley提出的[4]。它是通過(guò)在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,一般用導(dǎo)體材料鎢、鋁、銅、多晶硅或碳納米管構(gòu)成的互連線垂直穿過(guò)硅襯底以實(shí)現(xiàn)上下層芯片的信號(hào)互連[5],需要穿透組成疊層電路的各種材料以及很厚的硅襯底。TSV作為目前芯片互連的最新技術(shù),使芯片在三維方向堆疊密度最大、芯片間的互連線最短、外形尺寸最小,大大改善芯片速度,產(chǎn)生低功耗性能。

使用硅基板和TSV的三維堆疊的結(jié)構(gòu)如圖3所示。在 3D 芯片堆疊結(jié)構(gòu)中,為了充分利用三維集成電路的優(yōu)勢(shì)[6],硅通孔能縮短堆疊芯片之間的垂直互連,硅中介層是在相同襯底上途經(jīng)任何組件的硅襯底。TSV對(duì)通孔進(jìn)行金屬化處理,然后在孔上形成低熔點(diǎn)的凸點(diǎn),使之成為導(dǎo)電通孔,再利用孔內(nèi)的金屬焊點(diǎn)以及金屬層進(jìn)行垂直方向的互連[7]。與目前應(yīng)用于多層互連的通孔不同,TSV技術(shù)尺寸的一般要求如表1 所示。


基于TSV的3D IC堆疊方式有三種,如圖4所示,第一種兩個(gè)晶圓都沒(méi)有切片,稱為晶圓到晶圓堆疊(Wafer-to-Wafer,W2W),這種方式工藝簡(jiǎn)單,產(chǎn)出效率最高,成本最低,但是優(yōu)良率最低;第二種方式是將切片后的晶片堆疊到晶圓上,稱為晶片到晶圓堆疊(Die-to-Wafer,D2W);第三種方式是將切片后的兩層晶片堆疊在一起,稱為晶片到晶片堆疊(Die-to-Die,D2D),這種方式使用已知良晶片(Known-Good-Die,KGD)優(yōu)良率最高,但是工藝最復(fù)雜,產(chǎn)出效率最低。

TSV占據(jù)了相對(duì)較大硅片面積, 影響了器件密度、芯片布局和布線。通常TSV的深寬比是比較重要的工藝參數(shù)。較大范圍深寬比(TSV厚度和直徑)會(huì)引起局部熱膨脹錯(cuò)位,非線性熱應(yīng)力導(dǎo)致銅、硅和電介質(zhì)材料界面間失效,徑向應(yīng)力隨著TSV直徑增大直線增加,深寬比越大增加趨勢(shì)越陡。所以高深寬比TSV可以實(shí)現(xiàn)更短的互連長(zhǎng)度和減小信號(hào)延遲,并能提高封裝密度和運(yùn)行性能,現(xiàn)在已經(jīng)成為3D設(shè)計(jì)中的關(guān)鍵技術(shù)之一。表2為T(mén)SV占用硅片面積隨其深寬比的變化情況,隨著深寬比的減小,TSV在晶片上占用總面積減小,TSV所占面積(相對(duì)集成電路面積)的比例越小。這樣可以減小對(duì)布線的影響。

1.2 TSV關(guān)鍵技術(shù)
TSV的關(guān)鍵技術(shù)主要包括對(duì)準(zhǔn)技術(shù)、鍵合技術(shù)、晶圓減薄技術(shù),下面對(duì)這幾種技術(shù)簡(jiǎn)要介紹。
1.2.1 對(duì)準(zhǔn)技術(shù)
對(duì)準(zhǔn)技術(shù)之所以關(guān)鍵是因?yàn)樗苯佑绊懼?D互連的密度和優(yōu)良率。對(duì)準(zhǔn)前先為待對(duì)準(zhǔn)的兩個(gè)硅片均選定兩個(gè)參考點(diǎn),然后在顯微鏡下采用直接或者間接的方式進(jìn)行對(duì)準(zhǔn)。如果兩個(gè)硅片中有一個(gè)是對(duì)可見(jiàn)光或者紅外線透明的,可以采用直接對(duì)準(zhǔn)。對(duì)準(zhǔn)時(shí)先將兩個(gè)顯微鏡同時(shí)對(duì)準(zhǔn)兩個(gè)硅片,再移動(dòng)襯底來(lái)指導(dǎo)兩層上的兩個(gè)參考點(diǎn)精確對(duì)準(zhǔn)。當(dāng)兩個(gè)硅片都不對(duì)可見(jiàn)光或者紅外線透明,可以采用間接對(duì)準(zhǔn)方式。對(duì)準(zhǔn)時(shí)先將第一個(gè)硅片對(duì)準(zhǔn)到一個(gè)參考點(diǎn)上再抬高一定的距離,之后將第二層硅片對(duì)準(zhǔn)到同一個(gè)參考點(diǎn)上。一般來(lái)說(shuō),間接對(duì)準(zhǔn)沒(méi)有直接對(duì)準(zhǔn)的精確度高。
1.2.2 鍵合技術(shù)
鍵合技術(shù)是借助各種化學(xué)和物理作用連接兩個(gè)或多個(gè)襯底或晶圓。如果鍵合失敗,整個(gè)電路就會(huì)失去功能。目前常見(jiàn)的鍵合技術(shù)有氧化物鍵合、金屬鍵合、粘合劑鍵合和焊接四種。
氧化物鍵合是采用上下兩層芯片表面的隔離層(一般是SiO2)進(jìn)行鍵合,主要特點(diǎn)是可以在低溫下鍵合,與半導(dǎo)體工藝兼容,但需要高質(zhì)量的化學(xué)機(jī)械拋光和事先復(fù)雜的硅片清潔。金屬鍵合可以同時(shí)實(shí)現(xiàn)機(jī)械連接和電連接,鍵合過(guò)程中不會(huì)產(chǎn)生多余的氣體。但是它通常采用銅或金作為金屬材料,對(duì)工藝溫度和壓力的要求比較高。粘合劑鍵合通常采用聚合物鍵合技術(shù),對(duì)鍵合表面的粗糙程度不敏感,可以粘合任何材料,在較低的溫度下進(jìn)行并且與標(biāo)準(zhǔn)的CMOS工藝兼容。焊接是一種在印刷電路板上廣泛應(yīng)用的技術(shù),也可以用于3D集成[8],主要用來(lái)同時(shí)實(shí)現(xiàn)機(jī)械連接和電連接。
1.2.3 晶圓減薄技術(shù)
為了保證整體性能及可靠性,將晶圓/芯片進(jìn)行多層疊層鍵合,還必須滿足總封裝厚度要求,堆疊前對(duì)每層芯片進(jìn)行減薄處理。工藝上要求上層芯片的 TSV高度必須控制在幾十微米以內(nèi)。通過(guò)研磨的方式對(duì)晶片襯底進(jìn)行減薄,可以改善芯片散熱效果并且有利于后期封裝工藝。
當(dāng)晶圓減薄至30 μm極限厚度時(shí),要求表面和亞表面損傷盡可能小,一般采用機(jī)械磨削-化學(xué)機(jī)械拋光、機(jī)械磨削-濕式刻蝕、機(jī)械磨削-干法刻蝕、機(jī)械磨削-干式拋光等四種減薄工藝方案。
1.3 TSV關(guān)鍵工藝
圖5為T(mén)SV工藝模型圖,從中可以看出TSV是連接底面焊料凸點(diǎn)和頂層Cu布線的關(guān)鍵通路,實(shí)現(xiàn)TSV的關(guān)鍵工藝有通孔蝕刻、銅大馬士革工藝、TSV通孔填充工藝等。
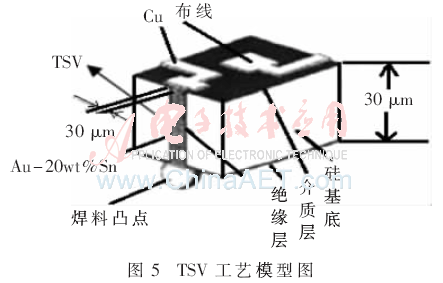
1.3.1 通孔刻蝕
根據(jù)TSV制作的工藝順序,通孔工藝分為前通孔和后通孔[9]。前通孔是在IC制造過(guò)程中制作通孔,又分為前道互連和后道互連[10]。前道互連是在所有的CMOS工藝開(kāi)始之前在空白的硅晶圓上,通過(guò)深度離子蝕刻(DRIE)實(shí)現(xiàn)。由于穿孔后必須承受后續(xù)工藝的大于1 000 ℃的熱沖擊,所以多數(shù)使用多晶硅作為通孔填充材料。后道互連是在制造流程中實(shí)現(xiàn)互連,一般采用金屬鎢或銅作為填充材料。后通孔是在制造完成之后制作通孔。
1.3.2 銅電泳(銅大馬士革)
銅互連線是TSV技術(shù)中典型的互連線之一。對(duì)于大多數(shù)TSV,3D互連也采用銅大馬士革工藝實(shí)現(xiàn)[11]。銅大馬士革(Cu-D)電沉積(ECD)是一項(xiàng)眾所周知的成熟工藝,主要用在TSV填充過(guò)程、涂點(diǎn)工藝、重分布層等的應(yīng)用開(kāi)發(fā)。ECD流程包括反應(yīng)物被輸運(yùn)到生長(zhǎng)表面,通過(guò)臨近表面的流體輸運(yùn)和流體邊界層的擴(kuò)散,在生長(zhǎng)表面經(jīng)由抑制酶作用的吸附和電化學(xué)反應(yīng)實(shí)現(xiàn)沉積。
1.3.3 TSV填充
TSV填充的反應(yīng)物是銅離子和其他幾種有機(jī)分子。TSV 填充需要一種無(wú)空隙、自底向上生長(zhǎng),才能保證在孔的開(kāi)口被封死之前將其填滿,以確保電連接的可靠性。Cu電阻率較小,成為T(mén)SV通孔填充材料首選[12]。通孔銅填充技術(shù)有磁控濺射、CVD、ALD(原子層淀積)、電鍍等,由于電鍍成本更低且淀積速度更快,銅電鍍工藝成為T(mén)SV通孔填充首選。均勻銅電鍍技術(shù)已經(jīng)被廣泛應(yīng)用于低成本圓片級(jí)封裝,電鍍時(shí)通孔側(cè)壁和底部均勻生長(zhǎng),凸出位置生長(zhǎng)速度更快。如被用于深孔填充,底部未完成填充時(shí)通孔開(kāi)口可能已封閉,就會(huì)形成電鍍空洞。均勻電鍍工藝不適用于小孔徑、高深寬TSV深孔填充。為滿足無(wú)孔洞銅電鍍,開(kāi)發(fā)了“自底向上”電鍍工藝[13]。
2 TSV互連技術(shù)可靠性分析
2.1 TSV可靠性分析的重要性
3D IC采用三維堆疊的方式有效提高了系統(tǒng)的集成度,但是系統(tǒng)功率密度急劇增大,多層芯片堆疊對(duì)互連線的熱穩(wěn)定性要求越來(lái)越高,3D IC面臨嚴(yán)重的散熱問(wèn)題,已經(jīng)成為限制三維集成技術(shù)發(fā)展的瓶頸[14]。三維電路芯片單位表面積產(chǎn)生的功率遠(yuǎn)大于二維電路,如果沒(méi)有合適的冷卻設(shè)備,三維疊層芯片可能會(huì)過(guò)熱而燒壞。并且三維疊層封裝的空間太小,很難提供冷卻通道。薄芯片會(huì)導(dǎo)致芯片上有很大的溫度差,中間地帶會(huì)出現(xiàn)極高溫度的熱點(diǎn)。因此,對(duì)于三維集成電路來(lái)說(shuō),迫切需要低成本和高效率的熱設(shè)計(jì)準(zhǔn)則。如何有效實(shí)現(xiàn)三維集成電路中的熱管理[15],解決集成電路中散熱問(wèn)題成為三維集成技術(shù)發(fā)展的關(guān)鍵。
由于工藝和結(jié)構(gòu)的特殊性,TSV面臨的熱可靠性問(wèn)題包括銅填充的TSV在周期性溫度變化的情況下由銅硅熱失配導(dǎo)致TSV開(kāi)裂;TSV與凸點(diǎn)連接金屬間化合物在應(yīng)力作用下的斷裂;使用TSV多層堆疊的芯片的散熱問(wèn)題等等。目前對(duì)TSV互連的可靠性研究仍然不夠充分,缺少相關(guān)的標(biāo)準(zhǔn)和可靠性數(shù)據(jù)。因此可靠性研究對(duì)TSV技術(shù)的發(fā)展和應(yīng)用有著十分重要的意義。
2.2 TSV可靠性分析的研究現(xiàn)狀
3D IC的TSV互連技術(shù)能夠?yàn)榧呻娐贩庋b提供更短的互連線,帶來(lái)更好的性能和更高的封裝效率。目前TSV互連技術(shù)可靠性在消費(fèi)電子、航空航天等領(lǐng)域也引起重視。
為了解決3D IC中的散熱問(wèn)題,已經(jīng)有研究3D IC熱管理理論建模方面研究,采用3D IC溫度分布一維解析模型來(lái)估算其溫度[16],并將熱阻的概念擴(kuò)展成熱阻矩陣[17]。SINGH S G等人提出導(dǎo)熱TSV技術(shù),即TSV不用來(lái)傳輸電信號(hào),而是作為散熱路徑將熱量傳導(dǎo)到底部熱沉中去[18]。新加坡微電子中心研究人員用液體循環(huán)系統(tǒng)將器件工作時(shí)產(chǎn)生的熱量轉(zhuǎn)移到熱沉中,該系統(tǒng)可將模塊中的熱應(yīng)力減少30%~50%,有效改善系統(tǒng)的性能[19]。也有研究者利用具有良好導(dǎo)熱性的碳納米材料來(lái)構(gòu)造焊點(diǎn)[20]或在電路中插入新型材料石墨稀[21]來(lái)實(shí)現(xiàn)3D IC的散熱管理。
2.3 熱應(yīng)力分析
銅作為T(mén)SV填充的主要材料,對(duì)互連結(jié)構(gòu)的熱力學(xué)性能和可靠性具有決定性影響,因此對(duì)銅互連結(jié)構(gòu)的可靠性研究十分必要。銅作為互連材料的主要問(wèn)題包括:熱膨脹導(dǎo)致互連結(jié)構(gòu)失效、尺寸效應(yīng)、阻擋層的影響以及高深寬比下互連結(jié)構(gòu)的可靠性。同時(shí)應(yīng)力梯度導(dǎo)致的銅互連中原子擴(kuò)散也將造成互連的應(yīng)力遷移失效。由于通孔填充材料和硅介質(zhì)的熱膨脹不匹配,在生產(chǎn)工藝和熱周期中TSV結(jié)構(gòu)會(huì)產(chǎn)生的熱應(yīng)力將會(huì)降低對(duì)應(yīng)力敏感產(chǎn)品的可靠性或促進(jìn)3D互連中的裂紋生長(zhǎng),此外熱膨脹不匹配也將導(dǎo)致熱耗散、誘導(dǎo)應(yīng)力、界面失效等。
溫度的變化導(dǎo)致TSV結(jié)構(gòu)中的應(yīng)力和應(yīng)變,而這種應(yīng)變可以通過(guò)不同溫度下的XRD衍射峰的偏移來(lái)測(cè)得。圖6給出不同溫度下TSV結(jié)構(gòu)的應(yīng)力值。由圖可以看出當(dāng)溫度在50 ℃時(shí),測(cè)試結(jié)果表現(xiàn)為接近零應(yīng)力狀態(tài),并且銅的塑性形變發(fā)生在接近100 ℃的低溫條件下。

2.4 傳熱分析舉例
一般的傳熱分析主要過(guò)程是先根據(jù)疊層電子封裝結(jié)構(gòu)的原理設(shè)計(jì)含TSV結(jié)構(gòu)不同模型,然后通過(guò)劃分網(wǎng)格,將參數(shù)代入模型,設(shè)置邊界條件,最后仿真得到TSV不同模型的溫度分布結(jié)果。將最高溫度統(tǒng)計(jì)出來(lái),得出不同TSV間距下不同結(jié)構(gòu)的溫度分布曲線。理論計(jì)算時(shí)先根據(jù)熱阻規(guī)律建立模型熱路圖,再由材料和尺寸算出各個(gè)模塊的熱阻并比較分析。最后根據(jù)仿真結(jié)果和原因的分析,得出TSV工藝散熱性能結(jié)論。這里以含TSV的圓柱模型為例,說(shuō)明TSV傳熱分析的過(guò)程。
2.4.1 仿真分析
首先在ANSYS中建立一個(gè)TSV圓柱體模型,如圖7所示,圖7(a)為仿真俯視圖,圖7(b)圓柱模型的立體圖。建好模型后,通過(guò)劃分網(wǎng)格、參數(shù)代入、邊界條件設(shè)置等,仿真得到溫度分布圖。圖8為T(mén)SV間距為0.2 mm圓柱體模型。圖9為該圓柱體模型的溫度分布圖。



這里為了更好地仿真?zhèn)鳠岬男Ч€分別設(shè)計(jì)了在TSV大圓和小圓上加上熱源的情況,然后將不同情況下的最高溫度統(tǒng)計(jì)出來(lái),得出不同TSV間距下不同結(jié)構(gòu)的溫度分布曲線。如圖10 所示,從圖中可以看出隨著TSV間距的增大,最高溫度隨之上升,散熱效果下降。

2.4.2 理論計(jì)算
應(yīng)用于三維疊層封裝的硅通孔(TSV)建模及傳熱分析計(jì)算過(guò)程如下:先根據(jù)熱阻規(guī)律建立模型熱路圖,如圖11 所示。

再由材料和尺寸計(jì)算各個(gè)模塊的熱阻。熱阻是指熱量傳遞通道上兩個(gè)參點(diǎn)之間的溫度差與兩點(diǎn)間熱量傳輸速率的比值[22],如式(1)所示:

其中:R為兩點(diǎn)間的熱阻(℃/W或K/W),?駐T為兩點(diǎn)間的溫度差(℃),P為兩點(diǎn)間熱量傳遞速率(W)。導(dǎo)熱基本公式如式(2)所示[23]:

其中:L為熱傳導(dǎo)距離(m),S為熱傳導(dǎo)通道的截面積(m2),λ為熱傳導(dǎo)系數(shù)(W/m℃)。根據(jù)式(1)和式(2),得熱傳導(dǎo)模型的熱阻計(jì)算公式,如式(3)所示:

由式(3)可得熱阻由L(長(zhǎng)度)、λ(導(dǎo)熱系數(shù))和S(截面積)共同決定。由于兩工藝的芯片部分的截面積相等,λ為材料固有參數(shù)。
熱阻隨L變化而變化,L越大熱阻越大,所以可通過(guò)改變L來(lái)改變熱阻。越短的熱傳導(dǎo)距離、越大的截面積、越高的熱傳導(dǎo)系數(shù)都會(huì)引起熱阻的降低,這要求設(shè)計(jì)合理的封裝結(jié)構(gòu)和選擇合適的材料。
3 TSV技術(shù)市場(chǎng)化動(dòng)態(tài)和展望
據(jù)法國(guó)調(diào)查公司提供,到2015年,邏輯和存儲(chǔ)器方面的應(yīng)用占TSV應(yīng)用的比例將大于30%,接觸式圖像傳感器、微機(jī)電系統(tǒng),傳感器占30%的市場(chǎng),存儲(chǔ)器堆疊形成的動(dòng)態(tài)隨機(jī)存取存儲(chǔ)器和閃存芯片占20%的市場(chǎng)。根據(jù)國(guó)際半導(dǎo)體技術(shù)路線圖ITRS的預(yù)測(cè),TSV技術(shù)將在垂直方向堆疊層數(shù)、硅品圓片厚度、硅穿孔直徑、引腳間距等方面繼續(xù)向微細(xì)化方向發(fā)展。如堆疊層數(shù)一般為3~7層,最多可達(dá)14層,圓片減薄一般為20~50 μm,最多可達(dá)8 μm,通孔直徑達(dá)一般為4 μm,最小可達(dá)1.6 μm,引腳間距一般為10 μm,最小可達(dá)3.3 μm。
目前,TSV技術(shù)主要應(yīng)用在內(nèi)存條、MEMS、CPU、DRAM、FLASH、CIS、RF等產(chǎn)品當(dāng)中。2009年3月,意法半導(dǎo)體推出首款集成擴(kuò)展景深(EDoF)功能的1/4英寸光學(xué)格式3百萬(wàn)像素Raw Bayer傳感器。2010年11月,F(xiàn)PGA廠商賽靈思采用堆疊硅片互連技術(shù)(SSI)和通硅孔TSV,將四個(gè)不同F(xiàn)PGA芯片在無(wú)源硅中介上互連,生產(chǎn)出含68億個(gè)晶體管、200萬(wàn)個(gè)邏輯單元。2010年12月,臺(tái)積電(TSMC)公開(kāi)了采用TSV三維積層半導(dǎo)體芯片的量產(chǎn)化措施,采用TSV、再布線層以及微焊點(diǎn)等技術(shù),制作了三維積層有半導(dǎo)體芯片和300 mm晶圓的模塊,并評(píng)測(cè)了三維積層技術(shù)對(duì)元件性能和可靠性的影響。美國(guó)升特信號(hào)半導(dǎo)體公司(Semtech)和IBM聯(lián)手,運(yùn)用3D TSV 技術(shù)開(kāi)發(fā)高性能的集成ADC/DSP平臺(tái)。2011年3月,韓國(guó)海力士半導(dǎo)體最先采用TSV技術(shù),開(kāi)發(fā)出晶圓級(jí)封裝二維積層技術(shù),并成功層疊了8層40 nm級(jí)2Gbit DDR3 DRAM芯片,最大容量達(dá)到64 GB。2011年8月,三星電子發(fā)布了內(nèi)存產(chǎn)品方面節(jié)能型單條32 GB DDR3服務(wù)器內(nèi)存模組,使用30 nm級(jí)別工藝制造的DRAM顆粒,運(yùn)行頻率為DDR3-1 333 MHz,功率只有4.5 W,比其普通30 nm級(jí)別工藝的LRDIMM產(chǎn)品功耗平均低約30%,稱為“企業(yè)服務(wù)器用內(nèi)存產(chǎn)品中功耗最低級(jí)別”。2011年10月,意法半導(dǎo)體宣布將TSV技術(shù)引入MEMS芯片量產(chǎn),在其多款MEMS產(chǎn)品如智能傳感器、多軸慣性模塊內(nèi)應(yīng)用。2012年2月,美國(guó)佐治亞理工學(xué)院、韓國(guó)KAIST大學(xué)和Amkor Technology公司在“ISSCC 2012”上,共同發(fā)布了將277 MHz驅(qū)動(dòng)的64核處理器芯片以及容量為256 KB的SRAM芯片三維層疊后構(gòu)筑而成的處理器子系統(tǒng)“3D-MAPS:3D Massively Parallel Processor with Stacked Memory”。
應(yīng)用通硅孔(TSV)技術(shù)的三維集成電路(3D IC)為半導(dǎo)體業(yè)界提供全新境界的效率、功耗、效能及體積優(yōu)勢(shì)。現(xiàn)在TSV的廣泛使用,將再度引發(fā)產(chǎn)業(yè)的變革,讓一些研究中的創(chuàng)新技術(shù)如醫(yī)學(xué)上的人工視網(wǎng)膜、能源應(yīng)用上的智能塵(Smart Dust)傳感器等,能夠成為人們生活中經(jīng)常被使用的產(chǎn)品。TSV技術(shù)已經(jīng)成為微電子領(lǐng)域的熱點(diǎn),也是未來(lái)發(fā)展的必然趨勢(shì),運(yùn)用它將會(huì)使電子產(chǎn)品獲得高性能、低成本、低功耗和多功能性。
4 總結(jié)
本文主要對(duì)3D IC的關(guān)鍵技術(shù)——TSV技術(shù)進(jìn)行了系統(tǒng)的介紹,包括TSV技術(shù)的特點(diǎn),關(guān)鍵技術(shù),關(guān)鍵工藝,TSV互連技術(shù)可靠性分析。通過(guò)舉例說(shuō)明了TSV的傳熱分析過(guò)程。最后對(duì)TSV技術(shù)市場(chǎng)化動(dòng)態(tài)和未來(lái)進(jìn)行了展望:TSV作為目前芯片互連的最新技術(shù),將成為3D IC發(fā)展的必然趨勢(shì)。
參考文獻(xiàn)
[1] KIM J,PAK J S,CHO J,et al.High-frequency scalable electrical model and analysis of a through silicon via(TSV)[J].IEEE Transactions on Components,Packaging,and Manufacturing Technology,2011,1(2):181-187.
[2] BAKIR M S,KING C,SEKAR D,et al.3D heterogeneous integrated systems:liquid cooling,power delivery,and implementation[J].IEEE Custom Integrated Circuits Conference,2008:663-670.
[3] 劉培生,黃金鑫,仝良玉,等.硅通孔技術(shù)的發(fā)展與挑戰(zhàn)[J].電子元件與材料,2012,31(12):76-80.
[4] SHOCKLEY W.Semi-conductive wafer and method of making the same[P].US Patent filed on Oct.1958 and granted on Jul.1962.
[5] MOTOYOSHI M.Through-silicon via(TSV)[J].IEEE proceedings,2009,97(1):43-48.
[6] YOON K,KIM G,LEE W,et al.Modeling and analysis of coupling between TSVs,metal,and RDL interconnects in TSV-based 3D IC with silicon interposer[C].11th Electronics Packaging Technology Conference.Singapore:IEEE,2009.
[7] CASSID Y C,KRAFT J,CARNIELLO S,et al.Through silicon via reliability[J].Trans Device Mater Res,2012,12(2):285-295.
[8] KLUMPP A,MERKEL R,RAMM P,et al.Vertical system integration by usinginter-chip vias and solid-liquid interdiusion bonding[J].Japanese Journal of Applied Physics.2004,43(7A):1-7.
參考文獻(xiàn)9-23因字符有限,此處略掉.

