為了獲得充分的白光LED光束,曾經(jīng)開(kāi)發(fā)大尺寸LED芯片,試圖以此方式達(dá)成預(yù)期目標(biāo)。實(shí)際上在白光LED上施加的電功率持續(xù)超過(guò)1W以上時(shí)光束反而會(huì)下降,發(fā)光效率則相對(duì)降低20%~30%,提高白光LED的輸入功率和發(fā)光效率必須克服的問(wèn)題有:抑制溫升;確保使用壽命;改善發(fā)光效率;發(fā)光特性均等化。
增加功率會(huì)使用白光LED封裝的熱阻抗下降至10K/W以下,因此國(guó)外曾經(jīng)開(kāi)發(fā)耐高溫白光LED,試圖以此改善溫升問(wèn)題。因大功率白光LED的發(fā)熱量比小功率白光LED高數(shù)十倍以上,即使白光LED的封裝允許高熱量,但白光LED芯片的允許溫度是一定的。抑制溫升的具體方法是降低封裝的熱阻抗。
提高白光LED使用壽命的具體方法是改善芯片外形,采用小型芯片。因白光LED的發(fā)光頻譜中含有波長(zhǎng)低于450nm的短波長(zhǎng)光線,傳統(tǒng)環(huán)氧樹(shù)脂密封材料極易被短波長(zhǎng)光線破壞,高功率白光LED的大光量更加速了密封材料的劣化。改用硅質(zhì)密封材料與陶瓷封裝材料,能使白光LED的使用壽命提高一位數(shù)。
改善白光LED的發(fā)光效率的具體方法是改善芯片結(jié)構(gòu)與封裝結(jié)構(gòu),達(dá)到與低功率白光LED相同的水準(zhǔn),主要原因是電流密度提高2倍以上時(shí),不但不容易從大型芯片取出光線,結(jié)果反而會(huì)造成發(fā)光效率不如低功率白光LED,如果改善芯片的電極構(gòu)造,理論上就可以解決上述取光問(wèn)題。
實(shí)現(xiàn)發(fā)光特性均勻化的具體方法是改善白光LED的封裝方法,一般認(rèn)為只要改善白光LED的熒光體材料濃度均勻性與熒光體的制作技術(shù)就可以克服上述困擾。
減少熱阻抗、改善散熱問(wèn)題的具體內(nèi)容分別是:
① 降低芯片到封裝的熱阻抗。
② 抑制封裝至印制電路基板的熱阻抗。
③ 提高芯片的散熱順暢性。
為了降低熱阻抗,國(guó)外許多LED廠商將LED芯片設(shè)在銅與陶瓷材料制成的散熱鰭片表面,如圖1所示,用焊接方式將印制電路板上散熱用導(dǎo)線連接到利用冷卻風(fēng)扇強(qiáng)制空冷的散熱鰭片上。德國(guó)OSRAM Opto Semiconductors Gmb 實(shí)驗(yàn)結(jié)果證實(shí),上述結(jié)構(gòu)的LED芯片到焊接點(diǎn)的熱阻抗可以降低9K/W,大約是傳統(tǒng)LED的1/6左右。封裝后的LED施加2W的電功率時(shí),LED芯片的溫度比焊接點(diǎn)高18℃,即使印制電路板的溫度上升到500℃,LED芯片的溫度也只有700℃左右。熱阻抗一旦降低,LED芯片的溫度就會(huì)受到印制電路板溫度的影響,為此必須降低LED芯片到焊接點(diǎn)的熱阻抗。反過(guò)來(lái)說(shuō),即使白光LED具備抑制熱阻抗的結(jié)構(gòu),如果熱量無(wú)法從LED封裝傳導(dǎo)到印制電路板的話,LED溫度的上升將使其發(fā)光效率下降,因此松下公司開(kāi)發(fā)出了印制電路板與封裝一體化技術(shù),該公司將邊長(zhǎng)為1mm的正方形藍(lán)光LED以覆芯片化方式封裝在陶瓷基板上,接著再將陶瓷基板粘貼在銅質(zhì)印制電路板表面,包含印制電路板在內(nèi)模塊整體的熱阻抗大約是15K/W。

(a) OSRAM LED的封裝方式

(b) CITIZEN LED的封裝方式
圖1 LED散熱結(jié)構(gòu)
針對(duì)白光LED的長(zhǎng)壽化問(wèn)題,目前LED廠商采取的對(duì)策是變更密封材料,同時(shí)將熒光材料分散在密封材料內(nèi),可以更有效地抑制材質(zhì)劣化與光線穿透率降低的速度。
由于環(huán)氧樹(shù)脂吸收波長(zhǎng)為400~450nm 的光線的百分比高達(dá)45%,硅質(zhì)密封材料則低于1%,環(huán)氧樹(shù)脂亮度減半的時(shí)間不到1萬(wàn)小時(shí),硅質(zhì)密封材料可以延長(zhǎng)到4萬(wàn)小時(shí)左右(如圖2所示),幾乎與照明設(shè)備的設(shè)計(jì)壽命相同,這意味著照明設(shè)備在使用期間不需更換白光LED。不過(guò)硅質(zhì)密封材料屬于高彈性柔軟材料,加工上必須使用不會(huì)刮傷硅質(zhì)密封材料表面的制作技術(shù),此外制程上硅質(zhì)密封材料極易附著粉屑,因此未來(lái)必須開(kāi)發(fā)可以改善表面特性的技術(shù)。

圖2 硅質(zhì)密封材料與環(huán)氧樹(shù)脂對(duì)LED光學(xué)特性的影響
雖然硅質(zhì)密封材料可以確保白光LED有4萬(wàn)小時(shí)的使用壽命,然而照明設(shè)備業(yè)界有不同的看法,主要爭(zhēng)論是傳統(tǒng)白熾燈與熒光燈的使用壽命被定義成“亮度降至30%以下”,亮度減半時(shí)間為4萬(wàn)小時(shí)的白光LED,若換算成亮度降至30%以下的話,大約只剩2萬(wàn)小時(shí)。目前有兩種延長(zhǎng)組件使用壽命的對(duì)策,分別是:
① 抑制白光LED整體的溫升。
② 停止使用樹(shù)脂封裝方式。
以上兩項(xiàng)對(duì)策可以達(dá)成亮度降至30%時(shí)使用壽命達(dá)4萬(wàn)小時(shí)的要求。抑制白光LED溫升可以采用冷卻白光LED封裝印制電路板的方法,主要原因是封裝樹(shù)脂在高溫狀態(tài)下,加上強(qiáng)光照射會(huì)快速劣化,依照阿雷紐斯法則,溫度降低100℃時(shí)壽命會(huì)延長(zhǎng)2倍。
停止使用樹(shù)脂封裝可以徹底消滅劣化因素,因?yàn)榘坠釲ED產(chǎn)生的光線在封裝樹(shù)脂內(nèi)反射,如果使用可以改變芯片側(cè)面光線行進(jìn)方向的樹(shù)脂材質(zhì)反射板,由于反射板會(huì)吸收光線,所以光線的取出量會(huì)銳減,這也是采用陶瓷系與金屬系封裝材料的主要原因。LED封裝基板無(wú)樹(shù)脂化結(jié)構(gòu)如圖3所示。

圖3 LED封裝基板無(wú)樹(shù)脂化結(jié)構(gòu)
有兩種方法可以改善白光LED芯片的發(fā)光效率:一種是使用面積比小型芯片(1mm2左右)大10倍的大型LED芯片;另外一種是利用多個(gè)小型高發(fā)光效率LED芯片組合成一個(gè)單體模塊。雖然大型LED芯片可以獲得大光束,不過(guò)加大芯片面積會(huì)有負(fù)面影響,例如芯片內(nèi)發(fā)光層不均勻、發(fā)光部位受到局限、芯片內(nèi)部產(chǎn)生的光線放射到外部時(shí)會(huì)嚴(yán)重衰減等。針對(duì)以上問(wèn)題,通過(guò)對(duì)白光LED的電極結(jié)構(gòu)的改良,采用覆芯片化封裝方式,同時(shí)整合芯片表面加上技術(shù),目前已經(jīng)達(dá)成50lm/W的發(fā)光效率。大型白光LED的封裝方式如圖4所示。有關(guān)芯片整體的發(fā)光層均等性,自從出現(xiàn)梳子狀與網(wǎng)格狀P型電極這后,使電極也朝最佳化方向發(fā)展。

圖4 大型LED的封裝方式
有關(guān)覆芯片化封裝方式,由于發(fā)光層貼近封裝端極易排放熱量,加上發(fā)光層的光線發(fā)射到外部時(shí)無(wú)電極遮蔽的困擾,所以美國(guó)Lumileds公司與日本豐田合作已經(jīng)正式采用覆芯片化封裝方式,芯片表面加工可以防止光線從芯片內(nèi)部朝芯片外部發(fā)射時(shí)在界面處發(fā)生反射,若在光線取出部位的藍(lán)寶石基板上設(shè)置凹凸?fàn)罱Y(jié)構(gòu),芯片外部的取光率可以提高30%左右。經(jīng)過(guò)改良的大型LED芯片封裝實(shí)體可以使芯片側(cè)面射出的光線朝封裝上方的反射板行進(jìn),高效率取出芯片內(nèi)部光線的封裝大小是7mm×7mm左右。大型LED的最后封裝方式如圖5所示。

圖5 大型LED的最后封裝方式
小型LED芯片的發(fā)光效率的提升似乎比大型LED芯片模塊更有效。例如日本CITIZEN公司組合8個(gè)小型LED芯片,達(dá)到60lm/W的高發(fā)光效率。若使用日亞公司制作的0.3mm×0.3mm 小型LED芯片,一個(gè)封裝模塊最多使用12個(gè)這樣的芯片,各LED芯片采用傳統(tǒng)金線粘合封裝方式,施加功率是2W左右。
對(duì)于白光LED輝度與色溫不均勻問(wèn)題,在使用上必須篩選光學(xué)特性類似的白光LED。事實(shí)上減少白光LED發(fā)光特性的不均勻性、使LED芯片發(fā)光特性一致化以及實(shí)施熒光體材料濃度分布均勻化管理是非常重要的。
有關(guān)LED芯片的發(fā)光特性,各廠商都在非常積極地進(jìn)行芯片篩選、發(fā)光特性的均等化處理等以減少LED發(fā)光特性不均勻問(wèn)題,如松下電器公司已通過(guò)芯片的篩選達(dá)成特性一致化的目標(biāo)。該公司利用覆芯片化方式,將64個(gè)LED芯片封裝在一片基板上,最后再分別覆蓋熒光體。在加工時(shí)LED芯片先封裝在次基板測(cè)試發(fā)光特性,接著將發(fā)光特性一致的芯片移植封裝在主基板上。8個(gè)LED芯片封裝在一片基板上,即使LED芯片的發(fā)光特性不均勻,8個(gè)LED芯片合計(jì)的發(fā)光特性在封裝之間的不均勻性會(huì)變得非常小。利用多個(gè)小型LED芯片的組合提高發(fā)光波長(zhǎng)均勻性的效果如圖6所示。
 圖6 利用多個(gè)小型LED芯片的組合提高發(fā)光波長(zhǎng)均勻性
圖6 利用多個(gè)小型LED芯片的組合提高發(fā)光波長(zhǎng)均勻性
白光LED通常是用內(nèi)含熒光體材料的密封樹(shù)脂直接包覆LED芯片,此時(shí)密封樹(shù)脂中熒光體材料的濃度可能出現(xiàn)偏差,最后造成白光LED的色溫分布不均勻。因此,可將含熒光體材料的樹(shù)脂薄片與LED芯片結(jié)合,由于薄片厚度與熒光體材料的濃度經(jīng)過(guò)嚴(yán)格的管理,所以白光LED的色溫分布不均程度比傳統(tǒng)方式減少了4/5。業(yè)界認(rèn)為使用熒光體薄片方式,配合LED芯片的發(fā)光特性,改變熒光體的濃度與薄片的厚度,就可以使白光LED的色溫變化控制在預(yù)期范圍內(nèi)。
雖然說(shuō)隨著白光LED發(fā)光效率的逐步提高,將白光LED應(yīng)用在照明領(lǐng)域的可能性也越來(lái)越大,但是很明顯地,單只白光LED的光通量均偏低,因此以目前的封裝形式是不太可能以單只白光LED來(lái)達(dá)到照明所需要的流明數(shù)。針對(duì)這人問(wèn)題,目前主要的解決方法大致上可分為兩類:一類是較傳統(tǒng)地將多只LED組成光源模塊來(lái)使用,而其中每只白光LED所需要的驅(qū)動(dòng)電源與一般使用的相同(為20~30mA);另一類方法是使用較大面積的芯片,此時(shí)不再使用傳統(tǒng)的0.3mm2大小的芯片,而采用0.6~1mm2大小的芯片,并使用高驅(qū)動(dòng)電流來(lái)驅(qū)動(dòng)這樣的發(fā)光組件(一般為150~350mA,目前最高達(dá)到500mA以上)。但無(wú)論是使用何種方法,都會(huì)因?yàn)楸仨氃跇O小的LED封裝中處理極高的熱量,若組件無(wú)法散去這些熱量,除了各種封裝材料會(huì)由于彼此間膨脹系數(shù)的不同而有產(chǎn)品可靠性的問(wèn)題,芯片的發(fā)光效率更會(huì)隨著溫度的上升而有明顯地下降,并造成使用壽命明顯地縮短。因此,如何散去組件中的熱量,成為目前白光LED封裝技術(shù)的重要課題。
對(duì)于白光LED而言,最重要的是輸出的光通量及光色,所以白光LED的一端必定不能遮光,而需使用高透明效果的環(huán)氧樹(shù)脂材料包覆。然而目前的環(huán)氧樹(shù)脂幾乎都是不導(dǎo)熱材料,因此對(duì)于目前的白光LED封裝技術(shù)而言,主要是利用其白光LED芯片下方的金屬腳座散去組件所發(fā)出的熱量。就目前的趨勢(shì)看來(lái),金屬腳座材料主要是以高熱傳導(dǎo)系數(shù)的材料為主而組成的,如鋁、銅甚至陶瓷材料等,但這些材料與芯片間的熱膨脹系數(shù)差異甚大,若將其直接接觸,很可能因?yàn)樵跍囟壬邥r(shí)材料間產(chǎn)生應(yīng)力而造成可靠性問(wèn)題,所以一般都會(huì)在材料間加上具有適當(dāng)傳導(dǎo)系數(shù)及膨脹系數(shù)的中間材料作為間隔。松下電器將公司多只白光LED制成在金屬材料與金屬系復(fù)合材料所制成的多層基板模塊上以形成光源模塊,利用光源基板的高導(dǎo)熱效果,使光源的輸出在長(zhǎng)時(shí)間使用時(shí)仍能維持穩(wěn)定。Lumileds生產(chǎn)的白光LED基板所使用的材料為具有高傳導(dǎo)系數(shù)的銅材,再將其連接至特制的金屬電路板,就可以兼顧電路導(dǎo)通及增加熱傳導(dǎo)效果。
大功率白光LED產(chǎn)品的芯片制造技術(shù)、封裝技術(shù)似乎已經(jīng)成為高亮度白光LED的主流技術(shù),然而與大芯片相關(guān)的制造技術(shù)及封裝技術(shù)不只是將芯片面積做大,若希望將白光LED應(yīng)用于高亮度照明領(lǐng)域,相關(guān)技術(shù)仍有待進(jìn)一步研究。
白光LED應(yīng)用于一般照明領(lǐng)域還有諸多問(wèn)題需要解決,首先是白光LED的效率提升,例如GaInN系的綠光、藍(lán)光以及近紫外光LED的效率仍有很大的開(kāi)發(fā)裕度。此外,綜合能源效率的內(nèi)部量子效率的提升是最重要的項(xiàng)目,內(nèi)部量子效率由活性層的非發(fā)光再結(jié)合百分比與發(fā)光再結(jié)合百分比所決定,因此可以把焦點(diǎn)鎖定在非發(fā)光再結(jié)合這部分,并設(shè)法降低結(jié)晶缺陷。而減少紫外光LED的轉(zhuǎn)位密度確實(shí)可以明顯提高內(nèi)部量子效率,未來(lái)必須針對(duì)紫外光LED進(jìn)一步降低它的轉(zhuǎn)位密度。不過(guò)這項(xiàng)對(duì)策對(duì)綠光、藍(lán)光LED并沒(méi)有明顯的影響。
綠光與藍(lán)光LED在低電流密度(約1A/cm2)時(shí)具有最大的量子效率,在高電流密度時(shí)量子效率反而會(huì)下降,如圖7所示。從成本觀點(diǎn)考慮時(shí)則希望LED能夠以高電流密度來(lái)驅(qū)動(dòng),同時(shí)盡可能增加組件的輸出功率,因此早日解開(kāi)綠光與藍(lán)光LED高電流密度時(shí)量子效率下降的機(jī)理與原因,不單是材料物理特性探索上的需要,這項(xiàng)研究對(duì)于未來(lái)應(yīng)用也是具有關(guān)鍵性的角色。目前的研究顯示紫光LED(波長(zhǎng)為382nm)即使施加高電流密度(50A/cm2),量子效率也不會(huì)下降。
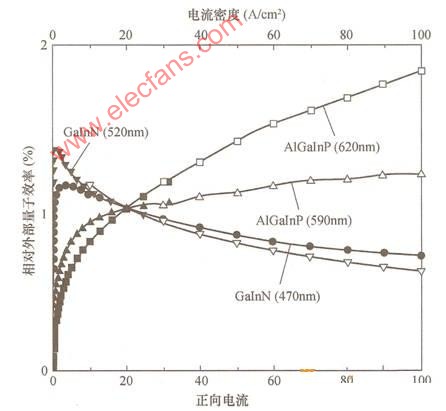
圖7 GaInN 系 LED的量子效率與電流密度的關(guān)系
傳統(tǒng)的白光LED都是將邊長(zhǎng)為200~350μm的正方形芯片封裝成圓頭柱外形,之后為了獲得照明所需要的光束,再將已封裝的多個(gè)白光LED組件排列成矩陣狀。單純以高輸出功率為目的而特別開(kāi)發(fā)出的面積比以往芯片大6~10倍,外形尺寸高達(dá)500μm~1mm的白光LED,雖然封裝后可獲得數(shù)百毫瓦(數(shù)十流明)的輸出功率,但是加大芯片的外形尺寸,反而使白光LED內(nèi)部的光吸收比率增加、外部取光率降低。就以AlGaInP LED為例,芯片的外形尺寸從0.22mm×0.22mm加大為0.50mm×0.50mm后,外部取光率反而降低20%左右。如果改用TIP結(jié)構(gòu),內(nèi)部多重反射的結(jié)果使得內(nèi)部光吸收率降低,外部取光率則明顯提高。GaInN LED 也有相同的效果。如何提高LED芯片的外部取光率是LED應(yīng)用于一般照明領(lǐng)域的關(guān)鍵。此外,高的熱阻抗(150~200K/W)對(duì)高亮度輸出相當(dāng)不利。LED內(nèi)部量子效率對(duì)活性層溫度的依存度極大,因此除了低熱阻抗封裝技術(shù)之外,利用散熱片排除活性層的熱流成為今后研發(fā)的熱點(diǎn)。

