瑞薩電子開(kāi)發(fā)出了對(duì)起因于隨機(jī)電報(bào)噪聲(RTN:Random Telegraph Noise)的SRAM誤操作進(jìn)行觀測(cè)并實(shí)施模擬的方法。利用該方法可高精度地估計(jì)22nm以后尖端LSI中的RTN影響,適當(dāng)設(shè)定針對(duì)RTN的設(shè)計(jì)余度。該公司已在“2010 Symposium on VLSI Technology”(2010年6月15~17日,美國(guó)夏威夷檀香山)上發(fā)表了該成果(論文編號(hào):18.1)。
RTN是一種因晶體管載流子被柵極絕緣膜等中的陷阱捕獲或釋放,而使晶體管閾值電壓隨時(shí)間隨機(jī)變動(dòng)的現(xiàn)象。業(yè)界普遍預(yù)測(cè),今后隨著微細(xì)化的發(fā)展,RTN將成為導(dǎo)致LSI工作故障的主要原因。瑞薩此前一直在推進(jìn)RTN的分析及模型化研究。目前已在RTN公式化以及陷阱能級(jí)分布的推測(cè)方法等方面取得了成果。
此次該公司以SRAM為對(duì)象,開(kāi)發(fā)了用于分析RTN對(duì)電路工作造成的影響,并將分析結(jié)果體現(xiàn)在芯片設(shè)計(jì)中的方法(圖1)。該方法由三項(xiàng)要素構(gòu)成:(1)對(duì)起因于RTN的SRAM誤操作進(jìn)行觀測(cè),掌握其發(fā)生概率的方法,(2)在實(shí)用時(shí)間內(nèi)對(duì)誤操作發(fā)生的概率進(jìn)行模擬的方法,(3)使加速試驗(yàn)的結(jié)果體現(xiàn)在模擬中,以提高精度的方法。此次使通過(guò)(2)、(3)方法導(dǎo)出的計(jì)算結(jié)果與(1)加速試驗(yàn)的結(jié)果實(shí)現(xiàn)了充分吻合。在這一方面,值得一提的是以下兩點(diǎn)。第一,瑞薩以前一直在探討的RTN分析式在預(yù)測(cè)起因于RTN的電路誤工作時(shí)有效。第二,今后通過(guò)提高加速試驗(yàn)的規(guī)模及精度,并體現(xiàn)其結(jié)果,便有望將模擬精度提高到實(shí)用水平。
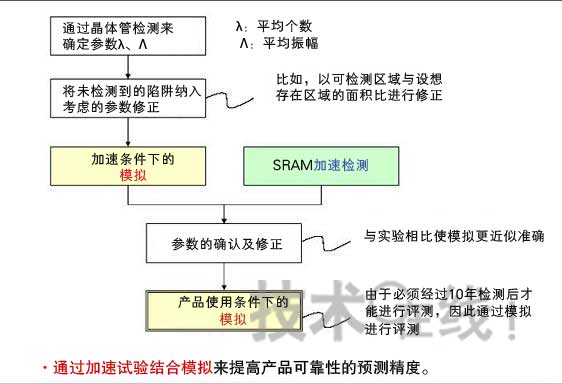
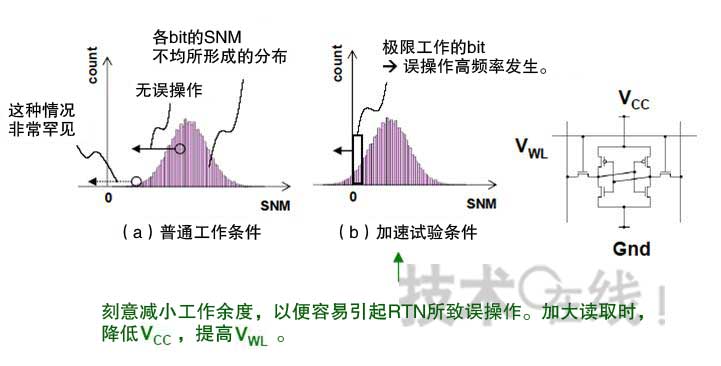

下面分別介紹一下(1)、(2)、(3)的概要。
觀測(cè)與模擬的結(jié)果充分吻合
(1)以電路水平觀測(cè)起因于RTN的誤操作,可以說(shuō)這是一項(xiàng)對(duì)RTN的影響進(jìn)行評(píng)估的基本操作。不過(guò),如果是目有微細(xì)化水平的芯片的話,RTN所致誤操作的發(fā)生頻率非常低,很難進(jìn)行觀測(cè)。因此,瑞薩采用了有意減小SRAM的工作余度,提高RTN所致誤操作頻率的方法(圖2)。即加速試驗(yàn)方法。具體而言,就是通過(guò)降低SRAM電源電壓,提高字線電壓,來(lái)減少讀取數(shù)據(jù)時(shí)的工作余度。通過(guò)在這種狀態(tài)下反復(fù)讀取數(shù)據(jù),使RTN所致誤操作頻發(fā)。
該加速試驗(yàn)的結(jié)果表明,在發(fā)生工作故障的bit數(shù)的讀取次數(shù)增加的同時(shí),其增加傾向與(2)中所述模擬導(dǎo)出的傾向相吻合(圖3)。而且,該加速試驗(yàn)中生產(chǎn)故障的bit還具有再現(xiàn)性。從這些結(jié)果可以推側(cè),由此觀測(cè)到的工作故障起因于器件內(nèi)部存在的,且隨時(shí)間變動(dòng)的偏差,即RTN。
從(2)來(lái)看,一般很難以分析式導(dǎo)出RTN所致SRAM誤操作的概率。其原因在于,RTN盡管是依存于時(shí)間的現(xiàn)象,但卻無(wú)法獲得包括時(shí)間項(xiàng)在內(nèi)的完全分析式。因此,使用模擬手段,將時(shí)間項(xiàng)作為參數(shù)導(dǎo)入計(jì)算的方法十分有效。該方法的優(yōu)點(diǎn)在于,可在計(jì)算中將普通陷阱檢測(cè)方法因時(shí)間常數(shù)及能量過(guò)大或過(guò)小而無(wú)法檢測(cè)的“看不見(jiàn)的陷阱”納入考慮(圖4)。
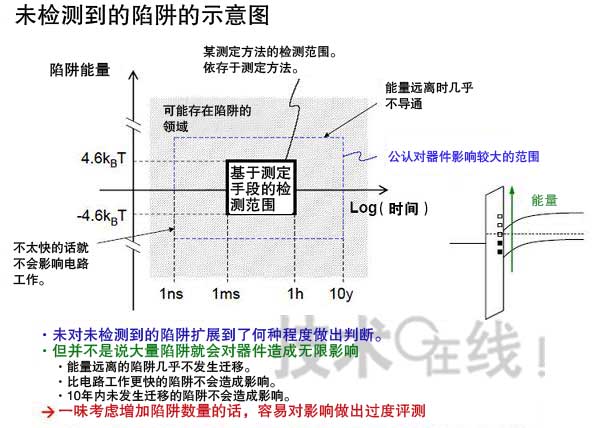

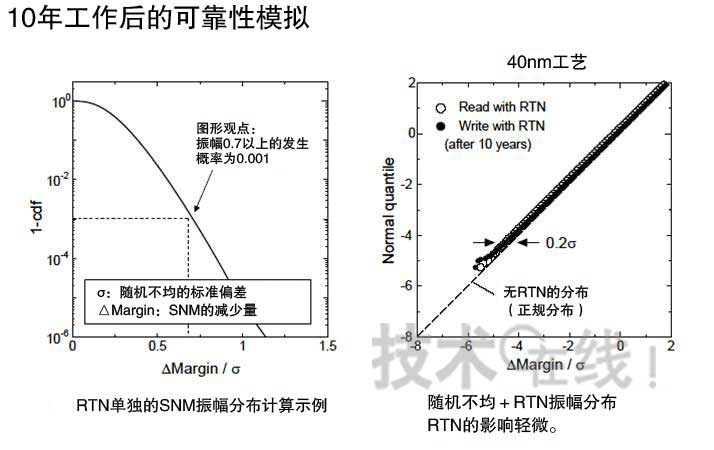
此次瑞薩開(kāi)發(fā)了根據(jù)陷阱個(gè)數(shù)、振幅(陷阱引起的特性變動(dòng)的幅度)及時(shí)間常數(shù)(捕獲和釋放電荷的時(shí)間間隔)的統(tǒng)計(jì)學(xué)分布,以蒙特卡羅法對(duì)一定時(shí)間(比如想保證的產(chǎn)品壽命)內(nèi)晶體管及電路所產(chǎn)生的特性變動(dòng)的最大值進(jìn)行計(jì)算的方法(圖5)。將以往RTN分析式未考慮的陷阱時(shí)間常數(shù)和能量作為參數(shù)進(jìn)行了導(dǎo)入。該計(jì)算方法不進(jìn)行嚴(yán)密的電路模擬,只進(jìn)行概率的計(jì)算和振幅的加算。因此,可在實(shí)用時(shí)間內(nèi)進(jìn)行模擬。
該公司為了獲得SRAM中RTN所致誤操作的發(fā)生概率,對(duì)6個(gè)晶體管構(gòu)成的組件使用了此次了模擬方法,并根據(jù)結(jié)果算出了作為SRAM工作穩(wěn)定性指標(biāo)的SNM(Static Noise Margin)的變化量。對(duì)40nm工藝SRAM進(jìn)行該變化量的計(jì)算后表明,在該工藝中,與雜質(zhì)不均相比,RTN的影響較為輕微(圖6)。
從(3)來(lái)看,在模擬中體現(xiàn)加速試驗(yàn)的結(jié)果以提高精度的手段對(duì)于將此次的方法應(yīng)用于實(shí)際的芯片十分重要。這源于各晶體管中存在的陷阱個(gè)數(shù)、振幅及時(shí)間常數(shù)等無(wú)法通過(guò)測(cè)定手段來(lái)完全掌握。
此次的模擬方法,其計(jì)算結(jié)果會(huì)因?yàn)樽鳛閰?shù)的陷阱時(shí)間常數(shù)和能量存在分布如何進(jìn)行假設(shè),以及計(jì)算中將其納入考慮的范圍有多大而發(fā)生變化。因此,瑞薩以提高模擬精度為目標(biāo),開(kāi)發(fā)了使加速試驗(yàn)結(jié)果在模擬參數(shù)的設(shè)定中得到體現(xiàn)的方法。具體而言,就是從加速試驗(yàn)開(kāi)始考慮SRAM的故障bit數(shù)是以何種趨勢(shì)隨著工作次數(shù)而增加的,并以能夠在模擬中再現(xiàn)這種趨勢(shì)為目的,修正與陷阱時(shí)間常數(shù)和能量存在分布相關(guān)的假設(shè)。

