記得從什么時(shí)候開始,熱分析意味著撤回原型并確定是否需要額外加入兩個(gè)散熱片和一個(gè)風(fēng)扇嗎?現(xiàn)在再嘗試這種方式你將發(fā)現(xiàn)身處泥潭卻無計(jì)可逃。畢竟,熱可能會(huì)影響電氣性能并最終縮短平均無故障時(shí)間。
回顧我年富力強(qiáng)的工程時(shí)代,我在熱分析上從未花費(fèi)太多時(shí)間,因?yàn)槟菚r(shí)真的不需要,我還知道像我這樣的人并不是少數(shù)。但隨著半導(dǎo)體每單位面積的功耗(及相應(yīng)的發(fā)熱)越來越高,以及系統(tǒng)體積不斷縮小,越來越多未進(jìn)行熱分析的系統(tǒng)工程師發(fā)現(xiàn)自己身處困境。
“許多過去由不同器件分擔(dān)的功能現(xiàn)在被整合進(jìn)一個(gè)器件內(nèi)。”Ansys公司的產(chǎn)品經(jīng)理主管Dave Rosato表示。因此,現(xiàn)在SoC類型器件的熱密度要高得多。
“工程師在5至10年前用于設(shè)計(jì)PCB的一般經(jīng)驗(yàn)已完全不適應(yīng)當(dāng)今的設(shè)計(jì)了,”Rosato接著說。“數(shù)年前,PCB作為熱傳輸路徑的角色是被忽略的。現(xiàn)在,你必須將所有的熱傳輸路徑考慮在內(nèi)。”
“簡單解決方案”是指在設(shè)計(jì)周期中盡早實(shí)施熱分析。多早合適呢?最晚應(yīng)在結(jié)構(gòu)圖設(shè)計(jì)階段后立即就進(jìn)行基本熱分析。工程師需下載擬采用器件的數(shù)據(jù)手冊(cè)并從熱的角度體驗(yàn)一下未來將遇到的挑戰(zhàn)。
若該分析指出了潛在的問題,則工程師應(yīng)考慮采用一些熱分析模擬軟件甚至還可能需要與材料廠商合作以確定它是否能制造出與設(shè)計(jì)參數(shù)相適應(yīng)的一些東西。
筆記本電腦中的熱設(shè)計(jì)
最近,我自己的一臺(tái)筆記本電腦因與散熱片/熱管組塊集成在一起的風(fēng)扇電源故障而無法工作了。即使打開機(jī)殼使大量冷空氣流通,這臺(tái)電腦也啟動(dòng)不了,甚至在系統(tǒng)執(zhí)行典型的上電自檢(POST)前,“風(fēng)扇故障”的信息也一直出現(xiàn)。
當(dāng)電腦感知到風(fēng)扇供電不正常時(shí),系統(tǒng)立即停止運(yùn)行。基于的假設(shè)如下:一般的筆記本電腦用戶在裝有空調(diào)的房間內(nèi)不會(huì)打開機(jī)蓋,因此,CPU會(huì)經(jīng)歷致命的“熱失控”。這種方法的不利之處是,由于風(fēng)扇(或連接風(fēng)扇的其它底層電源)不工作,而使整個(gè)系統(tǒng)也無法工作。
這是一個(gè)關(guān)于筆記本電腦制造商明確在沒有強(qiáng)制氣流流經(jīng)與CPU連接的散熱片時(shí),CPU決不啟動(dòng)的好例子。該設(shè)計(jì)按照這些要求進(jìn)行了工程處理,因?yàn)楣P記本電腦設(shè)計(jì)人員知道,不正確的熱管理意味著危險(xiǎn)即將到來。實(shí)際上,英特爾和AMD都非常嚴(yán)肅地對(duì)待這一問題。
例如,“如果外部熱傳感器檢測(cè)到處理器溫度達(dá)到致命的125℃(最大值),或有THERMTRIP#信號(hào)顯現(xiàn),則在500ms之內(nèi),處理器的VCC電源必須關(guān)閉以防止因處理器熱失控造成的永久性硅損壞,”英特爾在其2008年1月版的Core 2 Duo Processor數(shù)據(jù)手冊(cè)中強(qiáng)調(diào)。
“保持合適的熱環(huán)境是系統(tǒng)長期、可靠工作的關(guān)鍵。一個(gè)完善的熱方案包括器件和系統(tǒng)級(jí)熱管理功能,”該數(shù)據(jù)手冊(cè)寫道。
“為保證基于英特爾處理器的系統(tǒng)的最優(yōu)化工作和長期可靠性,系統(tǒng)/處理器熱方案應(yīng)被設(shè)計(jì)為可使處理器維持在最低和最高結(jié)溫(TJ)規(guī)范之間,并遵從相應(yīng)的熱設(shè)計(jì)功耗(TDP)值,”該手冊(cè)指出。
“注意:當(dāng)處理器工作在這些極限指標(biāo)之外,將可能導(dǎo)致處理器的永久性損壞以及系統(tǒng)內(nèi)其它器件的潛在損傷,”該手冊(cè)總結(jié)說。
為什么這些公司對(duì)消除不正確的熱管理如此興師動(dòng)眾?“許多應(yīng)用(系統(tǒng))正變得越來越小,例如Mac Air;而熱路徑不僅變得更短,而且還被重新排列了,”Lord公司高級(jí)微電子技術(shù)科學(xué)家Sara N. Paisner說。
通常,散熱片被直接放置在器件上面。但最新技術(shù)將使熱量向其它方向流動(dòng)。“現(xiàn)在,散熱片可能被放在器件下面,或者,也可能熱通過電路板本身消散掉了,”Paisner指出。
但熱管理不再如此簡單。“外殼材料同時(shí)擔(dān)當(dāng)電磁場(chǎng)(EMF)屏蔽和散熱片的角色,這是由于殼體本身構(gòu)成熱路徑的一部分,”Paisner表示。一個(gè)典型的PCB包括內(nèi)置熱路徑,這使得系統(tǒng)設(shè)計(jì)師重新審視其設(shè)計(jì)策略。所有的器件都在縮小,現(xiàn)在,當(dāng)為一個(gè)較大的區(qū)域散熱時(shí),是由幾個(gè)器件共同分擔(dān)冷卻職責(zé)。
從芯片角度來看,英特爾和AMD針對(duì)正確熱設(shè)計(jì)采取的預(yù)防性措施很有趣。首先,英特爾指出,“為把溫度限制在工作條件內(nèi),處理器需要一個(gè)熱管理方案。”英特爾采用熱二極管、數(shù)字熱傳感器(DTS)和Intel Thermal Monitor來監(jiān)測(cè)裸片溫度。
熱二極管可與熱傳感器一起用于計(jì)算硅溫度。DTS是集成一個(gè)裸片上的傳感器,它不停地監(jiān)測(cè)并輸出相對(duì)于最高熱結(jié)溫的裸片溫度數(shù)據(jù)。當(dāng)DTS中的一個(gè)特定位被置位時(shí),將檢測(cè)到可導(dǎo)致災(zāi)難性后果的溫度條件。
當(dāng)硅片溫度達(dá)到最高限時(shí),Intel Thermal Monitor通過啟動(dòng)一個(gè)熱控制電路來幫助控制處理器溫度。這樣,可以根據(jù)需要依次調(diào)整內(nèi)核時(shí)鐘以使硅片溫度處于掌控中。
此外,如果處理器溫度在熱跳變點(diǎn)以上,則該監(jiān)控器將產(chǎn)生一個(gè)外部信號(hào)(PROCHOT#)。它還以可生成一個(gè)中斷信號(hào)。如果該監(jiān)控器失效,則將產(chǎn)生一個(gè)特殊信號(hào)(THERMTRIP#),以提示若不立即關(guān)斷內(nèi)核電壓,則很快就會(huì)出錯(cuò)。
AMD采用的是一種類似的方法。該公司的“Thermal Design Guidelines”白皮書提供諸如散熱片的最大長度、寬度和高度等規(guī)范以及散熱片和風(fēng)扇材料要求等規(guī)范信息。
雖然由于CPU需消耗很多熱而成為一個(gè)重要的散熱目標(biāo),但也不應(yīng)忽視其它系統(tǒng)部件。此時(shí),一些簡單計(jì)算及一些基本熱管理理論將發(fā)揮作用。
記得從什么時(shí)候開始,熱分析意味著撤回原型并確定是否需要額外加入兩個(gè)散熱片和一個(gè)風(fēng)扇嗎?現(xiàn)在再嘗試這種方式你將發(fā)現(xiàn)身處泥潭卻無計(jì)可逃。畢竟,熱可能會(huì)影響電氣性能并最終縮短平均無故障時(shí)間。
回顧我年富力強(qiáng)的工程時(shí)代,我在熱分析上從未花費(fèi)太多時(shí)間,因?yàn)槟菚r(shí)真的不需要,我還知道像我這樣的人并不是少數(shù)。但隨著半導(dǎo)體每單位面積的功耗(及相應(yīng)的發(fā)熱)越來越高,以及系統(tǒng)體積不斷縮小,越來越多未進(jìn)行熱分析的系統(tǒng)工程師發(fā)現(xiàn)自己身處困境。
“許多過去由不同器件分擔(dān)的功能現(xiàn)在被整合進(jìn)一個(gè)器件內(nèi)。”Ansys公司的產(chǎn)品經(jīng)理主管Dave Rosato表示。因此,現(xiàn)在SoC類型器件的熱密度要高得多。
“工程師在5至10年前用于設(shè)計(jì)PCB的一般經(jīng)驗(yàn)已完全不適應(yīng)當(dāng)今的設(shè)計(jì)了,”Rosato接著說。“數(shù)年前,PCB作為熱傳輸路徑的角色是被忽略的。現(xiàn)在,你必須將所有的熱傳輸路徑考慮在內(nèi)。”
“簡單解決方案”是指在設(shè)計(jì)周期中盡早實(shí)施熱分析。多早合適呢?最晚應(yīng)在結(jié)構(gòu)圖設(shè)計(jì)階段后立即就進(jìn)行基本熱分析。工程師需下載擬采用器件的數(shù)據(jù)手冊(cè)并從熱的角度體驗(yàn)一下未來將遇到的挑戰(zhàn)。
若該分析指出了潛在的問題,則工程師應(yīng)考慮采用一些熱分析模擬軟件甚至還可能需要與材料廠商合作以確定它是否能制造出與設(shè)計(jì)參數(shù)相適應(yīng)的一些東西。
筆記本電腦中的熱設(shè)計(jì)
最近,我自己的一臺(tái)筆記本電腦因與散熱片/熱管組塊集成在一起的風(fēng)扇電源故障而無法工作了。即使打開機(jī)殼使大量冷空氣流通,這臺(tái)電腦也啟動(dòng)不了,甚至在系統(tǒng)執(zhí)行典型的上電自檢(POST)前,“風(fēng)扇故障”的信息也一直出現(xiàn)。
當(dāng)電腦感知到風(fēng)扇供電不正常時(shí),系統(tǒng)立即停止運(yùn)行。基于的假設(shè)如下:一般的筆記本電腦用戶在裝有空調(diào)的房間內(nèi)不會(huì)打開機(jī)蓋,因此,CPU會(huì)經(jīng)歷致命的“熱失控”。這種方法的不利之處是,由于風(fēng)扇(或連接風(fēng)扇的其它底層電源)不工作,而使整個(gè)系統(tǒng)也無法工作。
這是一個(gè)關(guān)于筆記本電腦制造商明確在沒有強(qiáng)制氣流流經(jīng)與CPU連接的散熱片時(shí),CPU決不啟動(dòng)的好例子。該設(shè)計(jì)按照這些要求進(jìn)行了工程處理,因?yàn)楣P記本電腦設(shè)計(jì)人員知道,不正確的熱管理意味著危險(xiǎn)即將到來。實(shí)際上,英特爾和AMD都非常嚴(yán)肅地對(duì)待這一問題。
例如,“如果外部熱傳感器檢測(cè)到處理器溫度達(dá)到致命的125℃(最大值),或有THERMTRIP#信號(hào)顯現(xiàn),則在500ms之內(nèi),處理器的VCC電源必須關(guān)閉以防止因處理器熱失控造成的永久性硅損壞,”英特爾在其2008年1月版的Core 2 Duo Processor數(shù)據(jù)手冊(cè)中強(qiáng)調(diào)。
“保持合適的熱環(huán)境是系統(tǒng)長期、可靠工作的關(guān)鍵。一個(gè)完善的熱方案包括器件和系統(tǒng)級(jí)熱管理功能,”該數(shù)據(jù)手冊(cè)寫道。
“為保證基于英特爾處理器的系統(tǒng)的最優(yōu)化工作和長期可靠性,系統(tǒng)/處理器熱方案應(yīng)被設(shè)計(jì)為可使處理器維持在最低和最高結(jié)溫(TJ)規(guī)范之間,并遵從相應(yīng)的熱設(shè)計(jì)功耗(TDP)值,”該手冊(cè)指出。
“注意:當(dāng)處理器工作在這些極限指標(biāo)之外,將可能導(dǎo)致處理器的永久性損壞以及系統(tǒng)內(nèi)其它器件的潛在損傷,”該手冊(cè)總結(jié)說。
為什么這些公司對(duì)消除不正確的熱管理如此興師動(dòng)眾?“許多應(yīng)用(系統(tǒng))正變得越來越小,例如Mac Air;而熱路徑不僅變得更短,而且還被重新排列了,”Lord公司高級(jí)微電子技術(shù)科學(xué)家Sara N. Paisner說。
通常,散熱片被直接放置在器件上面。但最新技術(shù)將使熱量向其它方向流動(dòng)。“現(xiàn)在,散熱片可能被放在器件下面,或者,也可能熱通過電路板本身消散掉了,”Paisner指出。
但熱管理不再如此簡單。“外殼材料同時(shí)擔(dān)當(dāng)電磁場(chǎng)(EMF)屏蔽和散熱片的角色,這是由于殼體本身構(gòu)成熱路徑的一部分,”Paisner表示。一個(gè)典型的PCB包括內(nèi)置熱路徑,這使得系統(tǒng)設(shè)計(jì)師重新審視其設(shè)計(jì)策略。所有的器件都在縮小,現(xiàn)在,當(dāng)為一個(gè)較大的區(qū)域散熱時(shí),是由幾個(gè)器件共同分擔(dān)冷卻職責(zé)。
從芯片角度來看,英特爾和AMD針對(duì)正確熱設(shè)計(jì)采取的預(yù)防性措施很有趣。首先,英特爾指出,“為把溫度限制在工作條件內(nèi),處理器需要一個(gè)熱管理方案。”英特爾采用熱二極管、數(shù)字熱傳感器(DTS)和Intel Thermal Monitor來監(jiān)測(cè)裸片溫度。
熱二極管可與熱傳感器一起用于計(jì)算硅溫度。DTS是集成一個(gè)裸片上的傳感器,它不停地監(jiān)測(cè)并輸出相對(duì)于最高熱結(jié)溫的裸片溫度數(shù)據(jù)。當(dāng)DTS中的一個(gè)特定位被置位時(shí),將檢測(cè)到可導(dǎo)致災(zāi)難性后果的溫度條件。
當(dāng)硅片溫度達(dá)到最高限時(shí),Intel Thermal Monitor通過啟動(dòng)一個(gè)熱控制電路來幫助控制處理器溫度。這樣,可以根據(jù)需要依次調(diào)整內(nèi)核時(shí)鐘以使硅片溫度處于掌控中。
此外,如果處理器溫度在熱跳變點(diǎn)以上,則該監(jiān)控器將產(chǎn)生一個(gè)外部信號(hào)(PROCHOT#)。它還以可生成一個(gè)中斷信號(hào)。如果該監(jiān)控器失效,則將產(chǎn)生一個(gè)特殊信號(hào)(THERMTRIP#),以提示若不立即關(guān)斷內(nèi)核電壓,則很快就會(huì)出錯(cuò)。
AMD采用的是一種類似的方法。該公司的“Thermal Design Guidelines”白皮書提供諸如散熱片的最大長度、寬度和高度等規(guī)范以及散熱片和風(fēng)扇材料要求等規(guī)范信息。
雖然由于CPU需消耗很多熱而成為一個(gè)重要的散熱目標(biāo),但也不應(yīng)忽視其它系統(tǒng)部件。此時(shí),一些簡單計(jì)算及一些基本熱管理理論將發(fā)揮作用。
把結(jié)點(diǎn)與散熱片連接在一起
熱管理把熱從半導(dǎo)體結(jié)擴(kuò)散到附近環(huán)境中。典型情況是,熱從半導(dǎo)體被傳導(dǎo)到封裝,然后再到熱擴(kuò)散器(散熱器),最終到周邊環(huán)境。你的設(shè)計(jì)也許沒有散熱器,也即采用的是類似風(fēng)扇和管線等其它技術(shù)。
但一般理論是一樣的:把熱從一小區(qū)域擴(kuò)散向一個(gè)大區(qū)域。根據(jù)熱傳導(dǎo)的基本理論,材料的熱導(dǎo)率與熱流動(dòng)的垂直區(qū)域和溫度梯度成比例。
結(jié)溫是半導(dǎo)體結(jié)的工作溫度(一般以℃表示),在這里產(chǎn)生的熱最多。指定參考點(diǎn)(如結(jié)或殼體)的熱阻抗是每單位功耗(一般以W表示)高于一個(gè)外部參考點(diǎn)(如:因腳、殼體或環(huán)境溫度)的有效溫升(一般以℃表示)。
熱阻抗以θLetter1Letter2表示(即:θCA或θJA)。Letter1是指定參考點(diǎn),且該字母一般表示該參考的初始值(即,C=殼體;J=結(jié))。Letter2是外部參考點(diǎn)且具有類似的表述結(jié)構(gòu)(即:A=環(huán)境)。
粗略計(jì)算
當(dāng)執(zhí)行一個(gè)正式熱分析時(shí),目標(biāo)是提供理解熱是如何形成并如何在系統(tǒng)內(nèi)流動(dòng)的完整把握。但在開發(fā)階段初期,一個(gè)簡單的大致估算也許就足夠了。
想法是,在上電后,對(duì)發(fā)熱情況有個(gè)大致把握。另一條規(guī)避無意間招致縮短平均無故障時(shí)間的途徑是使器件或系統(tǒng)過熱。
一旦進(jìn)行計(jì)算,就應(yīng)大致了解你所用熱管理方法所需的復(fù)雜程度。也即,是打算再增加一個(gè)散熱器還是需熱管的更新奇方案或其它一些采用熱擴(kuò)散、強(qiáng)制氣流甚至新材料的混合方案?即使借助簡單的類似增加熱過孔等手段就可滿足要求,未雨綢繆、防患未然也總比事后“付之一炬”好得多。
那如何進(jìn)行粗略熱分析呢?據(jù)Flomerics的電子制冷工程督導(dǎo)Byron Blackmore介紹,首要進(jìn)行的是PCB正反兩面的總體功率密度計(jì)算。“可通過計(jì)算總體功耗并除以表面積來表示它,”他說。
Blackmore還提供一個(gè)大致經(jīng)驗(yàn)規(guī)則:若計(jì)算顯示,你設(shè)計(jì)的功耗密度超過1.5W/in.2,就應(yīng)考慮增加其它措施以避免使熱產(chǎn)生連帶影響。
Paisner還連帶給出了一些指導(dǎo)數(shù)據(jù)。“決定是否采取額外舉措的一個(gè)關(guān)鍵決定性因素是溫度,”她說。85℃以內(nèi)可接受,85℃到100℃可能也行、但要小心從事。但,在100℃以上,一般應(yīng)采取附加措施。當(dāng)然,除絕對(duì)溫度外,你還應(yīng)考慮隨著系統(tǒng)條件的改變,溫度會(huì)如何隨之變化。
如何實(shí)現(xiàn)?“用每個(gè)器件在PCB可能工作的最高溫度下的最大功耗并除以表面積,然后對(duì)PCB的另一面重復(fù)該計(jì)算,”Blackmore說。然后,你必須找到熱阻抗(即:θJA)并乘以預(yù)期的功耗以確定高于環(huán)境溫度的溫升。現(xiàn)在,將該值與器件標(biāo)稱的最高溫度相比。
注意:列出的θJA是就“凝滯的空氣”說的,你必須把其它因素考慮在內(nèi),特別是你計(jì)劃使空氣在系統(tǒng)中流動(dòng)時(shí)。一些數(shù)據(jù)手冊(cè)也許給出在特定氣流流動(dòng)速率下器件的熱阻抗(即:θJMA)。但顯然,若你的設(shè)計(jì)接近這些極限值之一,你或許應(yīng)考慮增加其它熱管理措施,且也許還是該考慮采用仿真軟件的時(shí)候了。
對(duì)給定設(shè)計(jì)來說,這些計(jì)算也許足夠了,特別是若系統(tǒng)框架有許多自由空間時(shí)更是如此。那么,何時(shí)需要額外的熱分析呢?
“理想情況是,你該做兩次熱分析:一次是當(dāng)該項(xiàng)目就PCB大小和將采用的器件有大致概念后;另一次是基本布線完成后,”Rosato說。重復(fù)一遍,根據(jù)你的系統(tǒng),在該布局后階段,你應(yīng)考慮利用熱分析軟件實(shí)施準(zhǔn)確得多的仿真(圖1)。
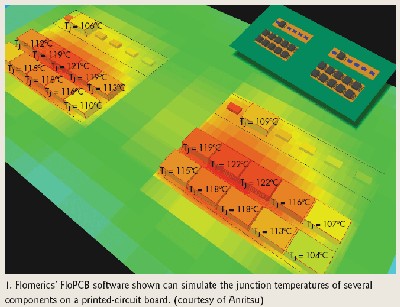
對(duì)布局和機(jī)架的考慮
必須盡早且經(jīng)常進(jìn)行熱分析。一些設(shè)計(jì)師甚至打算在申請(qǐng)專利前考慮該問題,因?yàn)槿舢a(chǎn)品因熱問題而失敗,則問題出在哪里?但其它因素影響系統(tǒng)設(shè)計(jì)。
“系統(tǒng)工程師必須理解材料與各自封裝尺寸和種類間的互動(dòng)有多么不同,”Paisner說。“類似Lord等公司與客戶一道研發(fā)新材料來滿足熱要求。”
Paisner以蘋果的Mac Air筆記本電腦為例說明產(chǎn)品遇到的嚴(yán)峻設(shè)計(jì)挑戰(zhàn),類似的這種設(shè)計(jì)不太可能有充足空間安放大散熱器或其它冷卻技術(shù)。這樣,除非你打算不惜血本采用新奇的熱方案,否則極小的空間限制將是很棘手的障礙。
“熱通路越復(fù)雜,成本越高,”Paisner說。“你必須想方設(shè)法把熱排出系統(tǒng),另外,在材料和布局間,你情愿承受怎樣的平衡。”
另外,從熱角度,器件排布在布局過程中起著關(guān)鍵作用。“建議將高發(fā)熱器件擺放在靠近通風(fēng)孔的地方,但這種要求并非總能滿足,所以,也許需要其它折中,”Rosato說。
另外,功耗很大的器件也許會(huì)產(chǎn)生對(duì)其它器件極易施加影響的“下流”熱。另一個(gè)竅門是把發(fā)熱器件緊鄰著擺放并一般放在氣流回路中。另外,“需要時(shí),可采用分流器(diverter)流布?xì)饬鳎?rdquo;Rosato指出。
從布局角度,應(yīng)充分關(guān)注堆疊裸片和堆疊芯片封裝器件,因更高的器件一般會(huì)妨礙熱通路。另外,可直接焊裝在PCB(器件和PCB間沒有任何氣隙)上的器件可把PCB作為散熱器。另外,還可設(shè)計(jì)進(jìn)熱過孔,但一般情況是你應(yīng)了解應(yīng)在布局前想好把它們放在哪里。
Blackmore介紹,布局中一個(gè)值得仿效的作法是努力使任何冷空氣的“風(fēng)頭”吹過發(fā)熱最多的器件。把器件散布以避免給下游產(chǎn)生熱氣流同樣是明智之舉。最后,“高的器件和連接器可能形成影響氣流向下流通的氣阻,”他說。因此,對(duì)任何高的器件和連接器都應(yīng)特別對(duì)待、進(jìn)一步分析。
無用的輸入輸出
別為你用的器件集假定最大功耗。在計(jì)算階段,最大值對(duì)你大致把握設(shè)計(jì)基本情況有用。但你必須堅(jiān)持采用更真實(shí)的數(shù)據(jù),否則,設(shè)計(jì)有可能變得過工程化、增加不必要的重量和成本。
若你采用了FPGA,則要弄清,其內(nèi)部邏輯是否在所有時(shí)間都工作在最高速度?很可能不是這樣的,所以,請(qǐng)邏輯工程師就更現(xiàn)實(shí)的工作情況給你一個(gè)合理的估算。然后,該你來決定是否需增加一個(gè)修正因數(shù)(fudge factor)。
記住:FPGA制造商的工程團(tuán)隊(duì)、測(cè)試團(tuán)隊(duì)和銷售/營銷部門也許已經(jīng)把三個(gè)不同層次的修正因數(shù)內(nèi)置其中。若你能得到實(shí)際使用數(shù)據(jù)并為此添加些修正,則以后將順手得多。
公司都會(huì)問最重要的問題:錯(cuò)誤比率是多少?提供的數(shù)據(jù)與“真實(shí)數(shù)據(jù)”相比有怎樣的關(guān)聯(lián)?數(shù)值都驗(yàn)證過了嗎?在最終環(huán)境用實(shí)際材料測(cè)試過了嗎?
在采用實(shí)際熱仿真工具的地方,你可得到精準(zhǔn)得多的更好體驗(yàn)。“熱分析仿真工具應(yīng)能讀進(jìn)布線和PCB設(shè)計(jì)信息,包括來自EDA工具的線段、平面和過孔定義等,”Rosato說。
仿真工具還可包含系統(tǒng)封裝、詳盡的器件設(shè)計(jì)參數(shù)等信息。“仿真工具可預(yù)測(cè)工作溫度來評(píng)判是否有可能超過標(biāo)稱結(jié)溫度以及在哪里系統(tǒng)會(huì)出現(xiàn)‘阻滯空氣’”Rosato說。也可采用交互式仿真方法,其中,工程師可演練各種熱管理情況、添加散熱器、若需要?jiǎng)t返回仿真結(jié)果。
類似PCB外形和大小以及諸如金屬層信息等相關(guān)的PCB建構(gòu)數(shù)據(jù)等參數(shù)也被讀進(jìn),Blackmore說。流程的剩余部分涉及系統(tǒng)工程師描述系統(tǒng)將運(yùn)行其中的環(huán)境,包括:框架、通風(fēng)孔、電源和其它器件等信息。然后,將全部信息組合在一起提供一個(gè)熱仿真。
未來發(fā)展
現(xiàn)在,你了解了熱分析的基本原則和重要性以及行之有效的熱管理技術(shù)。但即使考慮了全部其它防范措施,當(dāng)設(shè)計(jì)接近或超過其中一些極限(如:1.5 W/in.2)時(shí)會(huì)出現(xiàn)怎樣的情況?

圖2:Nextreme OptoCooler模塊可用于為TO-56封裝的激光二極管制冷。
你大概了解散熱器、風(fēng)扇、集成了風(fēng)扇的散熱器等技術(shù)間的長短取舍。但對(duì)更先進(jìn)的方案又了解多少?許多公司提供熱產(chǎn)品和方案。
“傳統(tǒng)方案業(yè)已過氣,所以需要增加其它功能來拓展性能范圍,”Nextreme的CTO Seri Lee說。例如,熱管具有固態(tài)制冷所以應(yīng)比單獨(dú)的散熱器和風(fēng)扇先進(jìn),雖然熱管既大且笨還貴又常常需要定制。
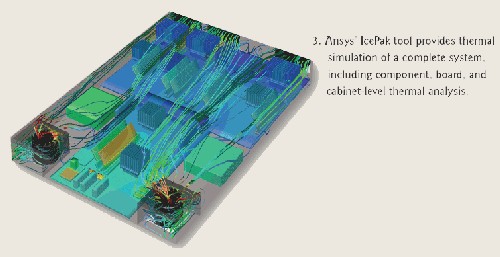
Nextreme有幾項(xiàng)芯片級(jí)創(chuàng)新,它采用比典型方案薄和小10到20倍、但排熱能力卻高10到15倍的技術(shù)主動(dòng)把熱排出(圖2)。Bergquist制造幾種不同的熱材料和熱基板。Ansys也提供熱仿真工具(圖3)。

