MEMS器件的封裝形式是把基于MEMS的系統(tǒng)方案推向市場的關(guān)鍵因素。研究發(fā)現(xiàn),當(dāng)今基于MEMS的典型產(chǎn)品中,封裝成本幾乎占去了所有物料和組裝成本的20%~40%。由于生產(chǎn)因素的影響,使得封裝之后的測試成本比器件級的測試成本更高,這就使MEMS產(chǎn)品的封裝選擇和設(shè)計(jì)更加重要。
MEMS器件設(shè)計(jì)團(tuán)隊(duì)在開始每項(xiàng)設(shè)計(jì)前,以及貫穿在整個(gè)設(shè)計(jì)流程中都必須對封裝策略和如何折中進(jìn)行考慮和給與極大的關(guān)注。許多MEMS產(chǎn)品供應(yīng)商都會把產(chǎn)品封裝作為進(jìn)行市場競爭的主要產(chǎn)品差異和競爭優(yōu)勢。
封裝選擇規(guī)則
設(shè)計(jì)MEMS器件的封裝往往比設(shè)計(jì)普通集成電路的封裝更加復(fù)雜,這是因?yàn)楣こ處煶3R裱恍╊~外的設(shè)計(jì)約束,以及滿足工作在嚴(yán)酷環(huán)境條件下的需求。器件應(yīng)該能夠在這樣的嚴(yán)苛環(huán)境下與被測量的介質(zhì)非常明顯地區(qū)別開來。這些介質(zhì)可能是像干燥空氣一樣溫和,或者像血液、散熱器輻射等一樣嚴(yán)苛。其他的介質(zhì)還包括進(jìn)行測量時(shí)的環(huán)境,例如,沖擊、震動、溫度變化、潮濕和EMI/RFI等。
首先,MEMS器件的封裝必須能夠和環(huán)境進(jìn)行相互影響。例如,壓力傳感器的壓力輸入、血液處理器件的流體入口等。MEMS器件的封裝也必須滿足其他一些機(jī)械和散熱裕量要求。作為MEMS器件的輸出,可能是機(jī)械電機(jī)或壓力的變化,因此,封裝的機(jī)械寄生現(xiàn)象就有可能與器件的功能相互影響和干擾。
例如,在壓阻傳感器內(nèi),封裝應(yīng)力就會影響傳感器的輸出。當(dāng)封裝中不同材料混合使用時(shí),它們的膨脹和收縮系數(shù)不同,因此,這些變化引起的應(yīng)力就附加在傳感器的壓力值中。在光學(xué)MEMS器件中,由于沖擊、震動或熱膨脹等原因而產(chǎn)生的封裝應(yīng)力會使光器件和光纖之間的對準(zhǔn)發(fā)生偏移。在高精度加速度計(jì)和陀螺儀中,封裝需要和MEMS芯片隔離以優(yōu)化性能(見圖1)。
常規(guī)晶圓級封裝
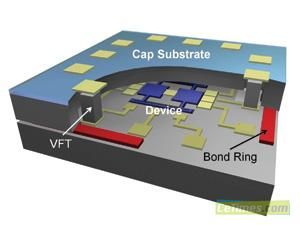
圖1 常規(guī)晶圓級封裝(WLP)結(jié)構(gòu)示意圖
根據(jù)生產(chǎn)的MEMS器件類型的不同,電子性能的考慮可以決定所選封裝類型的策略。例如,電容傳感MEMS器件會產(chǎn)生非常小、并可以被電子器件所識別的電荷,在設(shè)計(jì)時(shí)就需要特別注意電路和封裝中的信號完整性問題。
通常,大多數(shù)基于MEMS的系統(tǒng)方案都對MEMS芯片提供相應(yīng)的電路補(bǔ)償、控制和信號處理單元。因此,一個(gè)MEMS芯片和定制ASIC芯片可以被集成在同一個(gè)封裝內(nèi)。同樣,電路也可以是集成了MEMS器件的單芯片、單封裝(見圖2)。
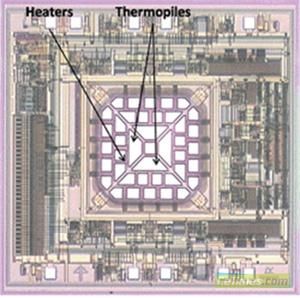
圖2 單芯片恒溫加速度計(jì)
MEMS器件有時(shí)也采用晶圓級封裝,并用保護(hù)帽把MEMS密封起來,實(shí)現(xiàn)與外部環(huán)境的隔離或在下次封裝前對MEMS器件提供移動保護(hù)。這項(xiàng)技術(shù)常常用于慣性芯片的封裝,如陀螺儀和加速度計(jì)。
這樣的封裝步驟是在MEMS流片過程中實(shí)現(xiàn)的,需要在潔凈環(huán)境中按照晶圓處理流程操作。相比而言,集成電路的大部分封裝都是在晶圓被切割完成后的芯片級完成的,對封裝過程的環(huán)境潔凈程度沒有特別高的要求。
MEMS芯片設(shè)計(jì)者更愿意使用成本非常低廉的標(biāo)準(zhǔn)封裝形式,因此采用塑料封裝或與集成電路兼容的封裝,這可以利用集成電路工業(yè)領(lǐng)域的成本優(yōu)勢。使用標(biāo)準(zhǔn)封裝也降低了設(shè)計(jì)和測試時(shí)間,封裝本身的成本也非常低。一個(gè)通行的準(zhǔn)則是,如果MEMS器件可以安裝在PCB板上,它就有可能采用標(biāo)準(zhǔn)集成電路封裝形式(見圖3)。
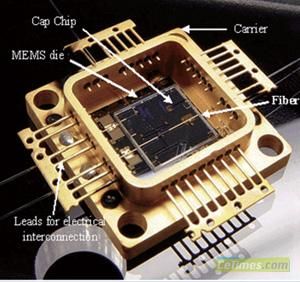
圖3 微型光機(jī)械系統(tǒng)(MOEMS)交換器件的管芯被4條光纖和連接線連接,并封裝在工業(yè)標(biāo)準(zhǔn)的Covar金屬封裝內(nèi)
然而,當(dāng)今絕大多數(shù)MEMS器件封裝都是客戶定制的,并且對特殊應(yīng)用進(jìn)行了優(yōu)化。所以,標(biāo)準(zhǔn)集成電路封裝不能承受前面所描述的那些嚴(yán)酷條件對介質(zhì)所帶來的影響。
MEMS器件封裝的挑戰(zhàn)是未來所大量應(yīng)用的兩個(gè)領(lǐng)域:醫(yī)療電子和汽車電子。在這兩類應(yīng)用中,被測量的介質(zhì)對于MEMS器件來說是非常嚴(yán)酷的。在汽車電子領(lǐng)域,需要測量內(nèi)燃機(jī)機(jī)油、燃油、冷卻液熱輻射、尾氣排放等的壓力或化學(xué)成分。這兩個(gè)領(lǐng)域?qū)ζ骷家缶哂懈呖煽啃院蜆O端堅(jiān)固的特點(diǎn)。所以,長壽命(特別是醫(yī)用可植入設(shè)備)、小尺寸(見圖4)、生物材料兼容性(見圖5)是在選擇封裝設(shè)計(jì)、材料和接口時(shí)所面臨的最大問題。


圖4 無線、無須電池的植入型心臟血流壓力波形監(jiān)視設(shè)備
傳統(tǒng)ME

圖5 高密度耳蝸植入系統(tǒng)使用一個(gè)石英硅帕拉膠封裝工藝,它可以提供良好的生物兼容性、靈活性和長期使用的穩(wěn)固性。
MS器件封裝形式
早期MEMS器件封裝形式采用SOC(System-on-Chip:片上系統(tǒng))技術(shù)、以CMOS工藝組裝一個(gè)或多個(gè)MEMS器件,包括模擬和數(shù)字工藝。MEMS產(chǎn)品也可以采用SIP(System-in-Package:封裝內(nèi)系統(tǒng))技術(shù)在前面討論的封裝中集成兩個(gè)或多個(gè)芯片。搭接線(wire-bonding)用于連接封裝內(nèi)的芯片,包括MEMS芯片。現(xiàn)今,這種技術(shù)正被集成電路生產(chǎn)領(lǐng)域中的倒裝芯片封裝技術(shù)所替代(見圖6)。
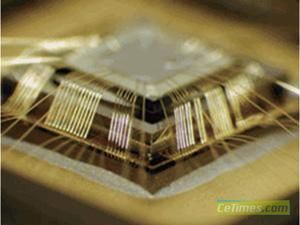
圖6 在電信光交換器件(底層管芯)和CMOS控制電路(頂層管芯)的堆疊連接
在以前,工程師常常把封裝設(shè)計(jì)留在關(guān)鍵傳感器和電路設(shè)計(jì)完成后的最后階段。然而,這種設(shè)計(jì)流程在產(chǎn)品面市壓力和激烈競爭的沖擊下發(fā)生了變化,迫使工程師改變他們的設(shè)計(jì)方法。否則,產(chǎn)品封裝的劣勢將會錯(cuò)過極佳市場窗口。另外,由于設(shè)計(jì)工具匱乏,當(dāng)應(yīng)力或其他影響因素沒有被合理評估時(shí),就使得設(shè)計(jì)失敗。
新型開發(fā)工具
當(dāng)前,用于封裝設(shè)計(jì)的新技術(shù)已經(jīng)接近了MEMS器件制造的水平。硅通孔(TSV)蝕刻技術(shù)可以實(shí)現(xiàn)高達(dá)100多μm的晶圓蝕刻深度。因此,MEMS晶圓廠就可以采用這種和MEMS制造相同級別的技術(shù)來制造封裝了。
硅通孔(TSV)的運(yùn)用使另外一種技術(shù)得以實(shí)現(xiàn),那就是多芯片堆疊技術(shù)。該技術(shù)將多個(gè)芯片的管芯堆疊在一個(gè)封裝中,并通過硅通孔連接在一起。芯片堆疊使芯片的封裝更小,但會使封裝會變得更加復(fù)雜。熱量必須在堆疊得極其接近的芯片之間傳遞,從而產(chǎn)生散熱問題;另外機(jī)械結(jié)構(gòu)的穩(wěn)定性也必須仔細(xì)仿真以確保良好的性能和可靠性。傳統(tǒng)的集成電路封裝工廠目前也開始提供特殊的MEMS器件封裝,而且設(shè)備供應(yīng)商也投入開發(fā)新的封裝和測試設(shè)備。因此,MEMS器件的封裝選擇是很多的。MEMS器件集成多個(gè)傳感器,以及與相應(yīng)的軟件配套來提供更高附加值的系統(tǒng)正逐漸向多芯片封裝解決方案方向發(fā)展。芯片堆疊可以通過一次一片的方式生產(chǎn),也可以通過晶圓級封裝方式進(jìn)行。
未來發(fā)展趨勢
封裝技術(shù)中的一個(gè)重要新方向是使用柔性襯底把多個(gè)剛性器件封裝在一起。多個(gè)傳感器可以和電子單元及功率模塊組合在一起。通過折疊,被封裝在一起的系統(tǒng)尺寸可以做得非常小。這種技術(shù)對于可穿戴人體傳感器非常有吸引力。
當(dāng)集成電路領(lǐng)域的封裝供應(yīng)商關(guān)注其他附加值時(shí),封裝的標(biāo)準(zhǔn)化就有可能了,但這需要很長的時(shí)間。在什么地點(diǎn),由誰來起草這個(gè)標(biāo)準(zhǔn)也需要大量的時(shí)間。這是因?yàn)镸EMS和半導(dǎo)體晶圓廠與傳統(tǒng)封裝廠之間的競爭將使最新和最高性能的封裝技術(shù)得以開發(fā),也使得更多的傳統(tǒng)半導(dǎo)體晶圓廠開始為MEMS業(yè)界提供服務(wù)。

