金屬氧化物半導(dǎo)體場(chǎng)效應(yīng)晶體管(Metal-Oxide-Semiconductor Field-Effect Transistor,MOSFET)是由一個(gè)金氧半(MOS)二機(jī)體和兩個(gè)與其緊密鄰接的P-n接面(p-n junction)所組成。自從在1960年首次證明后,MOSFET快速的發(fā)展,并且成為微處理器與半導(dǎo)體記憶體(memory)等先進(jìn)集成電路中最重要的元件。隨著超大型集成電路(VLSI)的快速發(fā)展,淺溝槽隔離(STI)技術(shù)在MOSFET制成中得到了廣泛的應(yīng)用。當(dāng)MOSFET的有效通道長(zhǎng)度(L)和寬度(W)的尺寸越來(lái)越小時(shí),一種MOS器件的失效模式:雙峰效應(yīng)(double-hump)也越來(lái)越受到人們的重視。
1 雙峰效應(yīng)
圖1是典型的雙峰效應(yīng)示意圖。在圖中虛線方框中,電流Id在閥極電壓Vg很小的時(shí)候出現(xiàn)了一個(gè)峰值。在整個(gè)Id-Vg曲線中出現(xiàn)兩個(gè)峰值,稱(chēng)之為雙峰效應(yīng)。它的表現(xiàn)是在次臨界區(qū)(sub-threshold),MOS還沒(méi)有開(kāi)啟時(shí)(Vg

圖1中,NMOS的W和L分別為10μm和0.18μm;Vsource=0;Vdrain=0.1 V;Vsub=0,-0.45 V,-0.9 V,-1.35 V,-1.8 V;Vg從0升到1.8 V。近幾年,人們對(duì)這種失效現(xiàn)象做了大量的研究。人們普遍接受,晶體管的側(cè)壁寄生晶體管的預(yù)先開(kāi)啟是漏電的根本原因。理論上講,由于粒子注入的有效摻雜濃度在晶體管的中心區(qū)域和側(cè)壁位置的不同,導(dǎo)致了側(cè)壁寄生晶體管的預(yù)先開(kāi)啟。在MOS的基板加有反向電壓時(shí),雙峰現(xiàn)象特別明顯。圖2中TrenchrecesS和Corner out-doping這兩種現(xiàn)象可以被用來(lái)解釋為什么晶體管的側(cè)壁位置粒子注入的摻雜濃度會(huì)不同于晶體管中心位置(通道正下方)。由于Trenchrecess和Corner ou-doping這兩種現(xiàn)象是不可避免的,所以人們嘗試了很多種方法去優(yōu)化摻雜的有效濃度分布,以期降低和消除雙峰效應(yīng)。
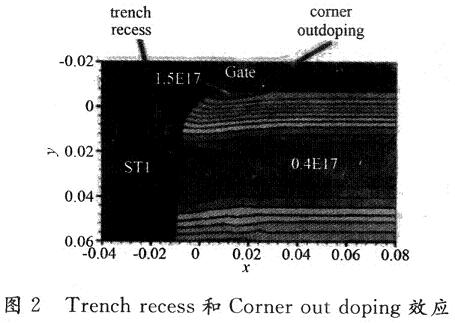
本文將介紹一種雙峰效應(yīng)的簡(jiǎn)單評(píng)估方法,使雙峰效應(yīng)的程度得以量化。并且通過(guò)對(duì)量化數(shù)字的評(píng)估,可以定性和定量地了解和確定最優(yōu)化的摻雜濃度條件。
2 實(shí)驗(yàn)條件
本文分別對(duì)N型MOS的Vt和Punch-through的粒子注入摻雜濃度進(jìn)行了正交試驗(yàn)。其中,Vt注入的濃度分別為:4.55×1012cm-2;6.55×1012cm-2和8.55×1012cm-12。,注入能量為25 kev,雜質(zhì)成分為硼(Boron);Punch-through注入的濃度分別為:4.0×1012cm-2;7.13×1012cm-2和1.0×1013cm-2,注入能量為170 kev,雜質(zhì)成分為銦(Indium);通過(guò)對(duì)不同注入條件的MOS器件的Jd-Vg曲線的測(cè)量和分析,以期能得到摻雜濃度分布和雙峰效應(yīng)的關(guān)系。
3 雙峰效應(yīng)的評(píng)估方法
圖3(a)是N型MOS器件的Id-Vg測(cè)量曲線。MOS器件的W和L分別為10 μm和0.18μm,測(cè)量條件為:Vsource=O;Vdrain=0.1V;Vsub=-1.8 V;Vg從0升到1.8 V;圖中實(shí)線表示Id的測(cè)量值,可以看到很明顯的雙峰現(xiàn)象。由于Vg很小的區(qū)間,測(cè)試電流值很小,而且不準(zhǔn)確,所以取Vg在O.5~1.OV這個(gè)區(qū)間作為雙峰效應(yīng)的評(píng)估區(qū)間。圖3(b)中的虛線為理想的Id-Vg曲線。可以根據(jù)MOS在(Vg比較高)線性區(qū)和飽和區(qū)的測(cè)量值,采用多項(xiàng)式近似曲線擬合法(Polynomi-al Regression Fitting)反向推導(dǎo)得出。圖中實(shí)線測(cè)量值和虛線擬合值的陰影部分表明了MoS器件的漏電程度,用陰影面積來(lái)作為雙峰效應(yīng)的量化評(píng)估值。
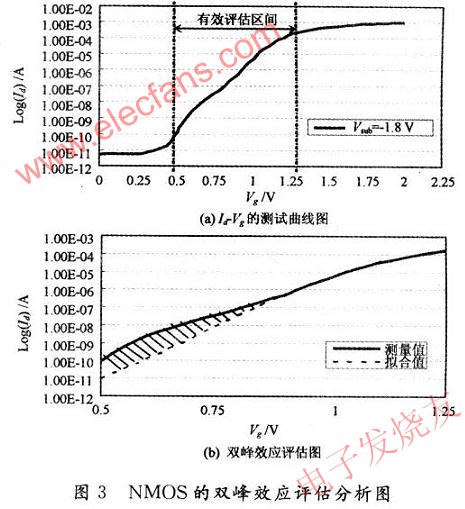
4 試驗(yàn)分析
通過(guò)對(duì)各種實(shí)驗(yàn)條件的Id-Vg曲線的測(cè)量和雙峰效應(yīng)的評(píng)估,以粒子注入的濃度變化作為變量,雙峰效應(yīng)的量化值作為結(jié)果,建立了兩者變化關(guān)系的模型。圖4和圖5分別是模型的精確度評(píng)估圖和注入濃度對(duì)雙峰效應(yīng)的變化模型圖。
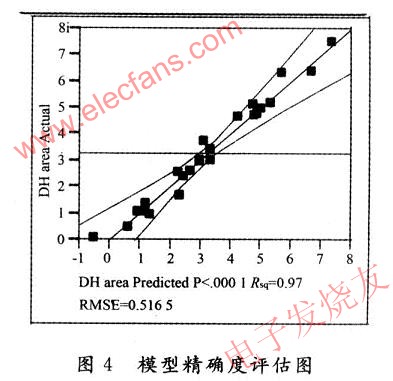

從圖4可以看出模型的精確度(Rsquare)為O.97。這表明,粒子注入濃度和雙峰效應(yīng)具有非常強(qiáng)的相關(guān)性。圖5顯示,雙峰效應(yīng)對(duì)Vt的注入濃度非常敏感。隨著濃度的上升,雙峰效應(yīng)越來(lái)越明顯。這個(gè)現(xiàn)象和現(xiàn)有的理論相吻合。由于Vt的注入能量為25 kev,有效摻雜濃度的峰值靠近MOS通道的表面。并且硼的吸出效應(yīng)(out-doping)明顯,隨著粒子注入濃度的升高,通道正下方的有效摻雜濃度上升,但側(cè)壁位置的有效濃度變化不大,致使這兩個(gè)位置的濃度差異增加。同時(shí),硼的有效濃度的增加,會(huì)導(dǎo)致通道正下方的閾值臨界電壓Vt的上升。這個(gè)變化會(huì)使得MOS通道下方開(kāi)啟時(shí)間延遲,從而側(cè)壁寄生晶體管的預(yù)先開(kāi)啟時(shí)間變長(zhǎng),進(jìn)一步導(dǎo)致漏電量的增加。同理,采用的雙峰效應(yīng)的量化評(píng)估值就會(huì)增加,雙峰效應(yīng)明顯。與Vt注入相比,Punch-through注入的濃度變化對(duì)雙峰效應(yīng)的影響不明顯。這是因?yàn)殂熢氐奈鲂?yīng)不明顯,所以銦的有效濃度的變化對(duì)通道正下方和側(cè)壁位置的有效摻雜濃度的差異貢獻(xiàn)不大,從而雙峰效應(yīng)對(duì)銦的濃度變化相對(duì)不敏感。
本文的模型可以用于定性和定量的分析,但是對(duì)于MOSFET來(lái)說(shuō),V的粒子注入條件也影響晶體管整體的電學(xué)特性。所以,在確定最優(yōu)化的摻雜濃度條件時(shí),要綜合考慮。
5 結(jié) 語(yǔ)
MOSFET的中心區(qū)域和側(cè)壁位置的有效摻雜粒子濃度的均勻分布是解決雙峰效應(yīng)的根本條件。不論這兩個(gè)位置的有效摻雜濃度差異的形成原因,理論上都可以找到一個(gè)比較優(yōu)化的工藝條件,使得有效摻雜濃度分布均勻,從而減少或消除雙峰效應(yīng)的影響。通過(guò)對(duì)雙峰效應(yīng)的量化評(píng)估,建立摻雜濃度和雙峰效應(yīng)相互關(guān)系的模型,從定性和定量的角度進(jìn)一步了解和確定優(yōu)化條件。

