概述
測試半導(dǎo)體器件和晶圓片(Wafer)常常要涉及到測量小電流。其中有些測試工作包括各種泄漏電流的測量。另一些對于晶圓片級半導(dǎo)體的弱電流測量則通常與介電材料(氧化物或化合物)的質(zhì)量有關(guān)。這些弱電流測量工作常常使用靜電計(jì)或源-測量單元。本文將介紹使用源-測量單元測量二極管的泄漏電流以及MOSFET的亞閾區(qū)電流(sub-thresh old current)。
二極管的泄漏電流
在理想的情況下,二極管的反向電流應(yīng)當(dāng)為零。然而,實(shí)際上確實(shí)存在著反向電流。衡量二極管質(zhì)量的一個(gè)方面就是在規(guī)定的反向偏置電壓下的泄漏電流。
圖4-10 示出如何使用236型或6430型SMU來測量二極管的泄漏電流。236型SMU能夠以10fA的分辨率測量電流,并且輸出需要的偏置電壓。6430型SMU的分辨率為10aA。源-測量單元還可以測量其它的二極管參數(shù),包括正向電壓降和擊穿電壓。
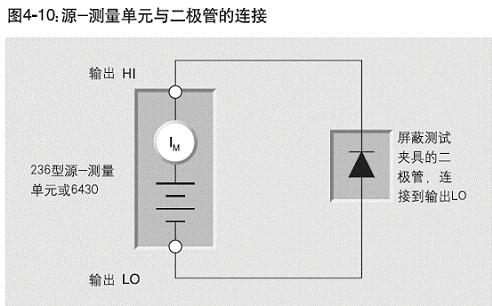
為了避免靜電干擾引起的誤差,應(yīng)當(dāng)將二極管放在屏蔽的測試夾具(test fixture)內(nèi)。該裝置還能提供對光的遮蔽。由于二極管的結(jié)對光敏感,這一點(diǎn)也是很重要的。
MOSFET的亞閾區(qū)電流
各種MOSFET測試都要求進(jìn)行弱電流的測量。這些測試包括柵極漏電、泄漏電流與溫度的關(guān)系、襯底對漏極的漏電和亞閾區(qū)電流等。
亞閾區(qū)電流測試常常在晶圓片級進(jìn)行。它是表示器件打開和關(guān)閉的快慢程度的參數(shù)。圖4-11示出測量亞閾區(qū)電流的典型測試設(shè)置情況。在此配置中,4200型半導(dǎo)體特性分析系統(tǒng)配備了2個(gè)SMU和前置放大器。使用一個(gè)SMU來提供恒定的漏-源電壓(VDS),并測量產(chǎn)生的漏極電流(IDS)。另一個(gè)SMU用來掃描柵-源電壓(VGS)。對這個(gè)SMU來說,應(yīng)當(dāng)將鉗位電流或測量電流值設(shè)置為固定測量量程上的最高期望的柵極電流。
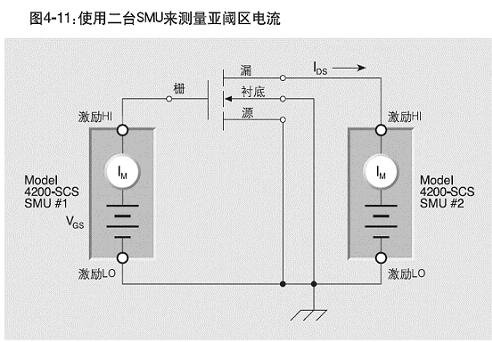
圖4-12 是一個(gè)增強(qiáng)型MOSFET的IDS對VGS曲線。該曲線是在4200- SCS型半導(dǎo)體特性測試系統(tǒng)上得到的。
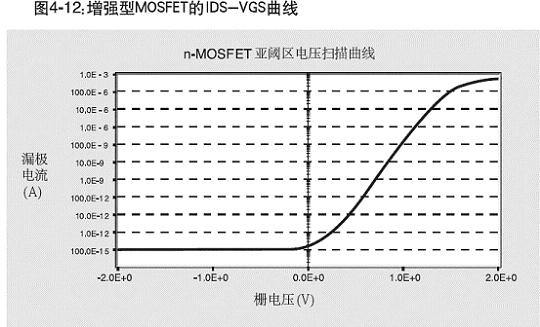
更多I-V測試解決方案,請點(diǎn)擊http://www.keithley.com.cn/semi

