7月12日消息,根據(jù)Business Korea未經(jīng)證實(shí)的報(bào)道稱,AMD計(jì)劃在2025年至2026年期間為其超高性能系統(tǒng)級(jí)封裝(SiP)采用玻璃基板。報(bào)道稱,AMD公司將與“全球零部件公司”合作開展該項(xiàng)目。
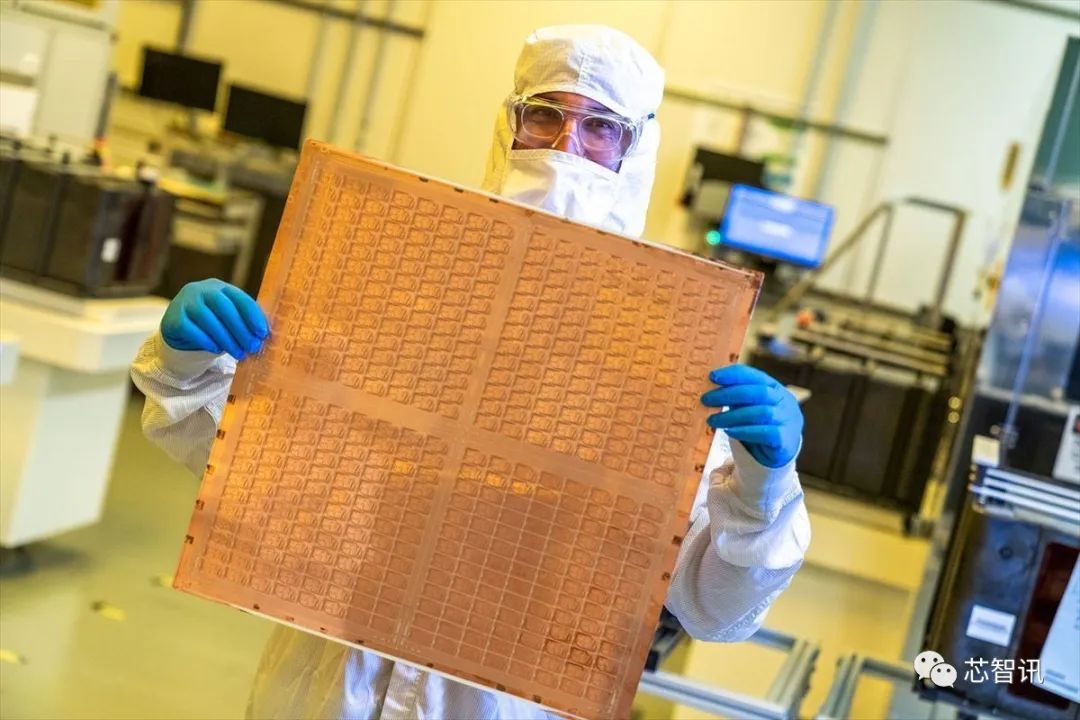
△英特爾展示的玻璃基板
與傳統(tǒng)的有機(jī)基板相比,玻璃基板具有顯著的優(yōu)勢(shì),因此英特爾、三星和其他一些公司正在競(jìng)相在2025年至20230年前使用它們。玻璃基板具有出色的平整度,能夠提高光刻的焦深和尺寸穩(wěn)定性,是包含多個(gè)小芯片(Chiplet)的先進(jìn)SiP互連的理想選擇。此外,玻璃基板具有卓越的熱強(qiáng)度和機(jī)械強(qiáng)度,非常適合高溫和耐用的應(yīng)用。例如面向數(shù)據(jù)中心的SiP。因此,玻璃基板對(duì)AMD、英特爾和英偉達(dá)等高性能計(jì)算芯片公司來說非常有意義。
針對(duì)AI和HPC工作負(fù)載的數(shù)據(jù)中心產(chǎn)品來說,人工智能以及最終的AGI應(yīng)用程序的性能要求幾乎是無限的,因此用于人工智能工作負(fù)載的處理器需要持續(xù)采用最新技術(shù)來獲得所有可能的性能提升。
另外,尖端支持工藝技術(shù)正變得越來越昂貴(有時(shí)產(chǎn)量也越來越復(fù)雜),其晶體管密度增益也越來越小。從良率的角度來看,構(gòu)建大型單片芯片的成本比創(chuàng)建幾個(gè)較小的小芯片并將它們放置在中介層或基板上的成本更高。此外,通過添加小芯片可以獲得更多的性能提升,而不僅僅是使用新的制程節(jié)點(diǎn)。
AMD 已經(jīng)構(gòu)建了 13 個(gè)小芯片(EPYC 9004 系列)甚至 22 個(gè)芯片(Instinct MI300A:3 個(gè) Zen 4 個(gè) CCD + 6 個(gè) CDNA 3 個(gè)計(jì)算芯片 + 4 個(gè)帶 Infinity Cache 的輸入/輸出芯片 + 8 個(gè) HBM3 堆棧 + 1 個(gè) 2.5D 中介層)的系統(tǒng)級(jí)封裝。假設(shè)其未來的產(chǎn)品將變得更加復(fù)雜,鑒于玻璃基板承諾帶來的所有優(yōu)勢(shì),AMD自然會(huì)盡早采用玻璃基板。
英特爾計(jì)劃最快2026年量產(chǎn)玻璃基板技術(shù);三星也將在明年完成玻璃基板的原型技術(shù),并計(jì)劃2026年開始量產(chǎn);LG Innotek今年正組建相關(guān)部門,為進(jìn)軍玻璃基板市場(chǎng)做準(zhǔn)備;韓國(guó)SK集團(tuán)旗下的化工材料公司SKC近日也宣布,其玻璃基板制造子公司Absolics位于美國(guó)佐治亞州科文頓的面向芯片的玻璃基板工廠近日正式竣工,目前已經(jīng)開始批量生產(chǎn)原型產(chǎn)品。
值得一提的是,頭部芯片大廠積極采用玻璃基板的另一個(gè)原因是,它可以在沒有中介層的情況下實(shí)現(xiàn)密集互連,這可能會(huì)降低具有許多小芯片的SiP的價(jià)格,因?yàn)槟壳暗南冗M(jìn)封裝當(dāng)中所需要用到的硅中介層往往很昂貴。


