最新行業(yè)報(bào)告顯示,臺積電正積極上調(diào)系統(tǒng)級集成單芯片(SoIC)的產(chǎn)能計(jì)劃,計(jì)劃到 2024 年年底,月產(chǎn)能躍升至 5000-6000 顆,以應(yīng)對未來人工智能(AI)和高性能計(jì)算(HPC)的強(qiáng)勁需求。
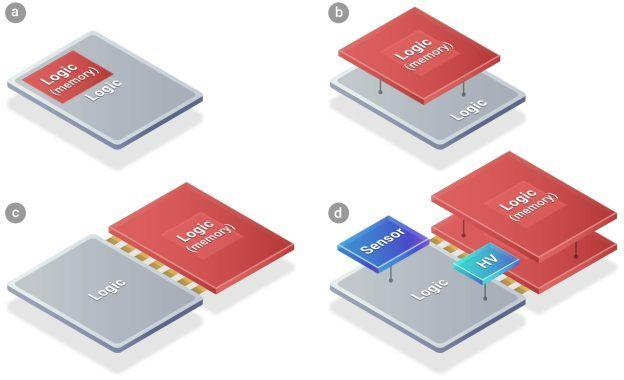
AMD 是臺積電 SoIC 的首發(fā)客戶,其最新 AI 芯片產(chǎn)品 MI300 搭配 SoIC 和 CoWoS 封裝,如果能取得成功,那么將成為臺積電 SoIC 的一大“代表作”。
臺積電最大的客戶蘋果公司對 SoIC 非常感興趣。蘋果計(jì)劃讓 SoIC 搭配熱塑碳纖板復(fù)合成型技術(shù),目前正小量試產(chǎn),預(yù)計(jì) 2025-2026 年量產(chǎn),擬應(yīng)用在 Mac、iPad 等產(chǎn)品,制造成本比當(dāng)前方案更具有優(yōu)勢。

業(yè)內(nèi)人士分析稱,蘋果這一路線主要是基于產(chǎn)品設(shè)計(jì)、定位、成本等綜合考量。若未來 SoIC 順利導(dǎo)入筆電、手機(jī)等消費(fèi)電子產(chǎn)品,有望創(chuàng)造更多需求,并大幅提升其他大客戶的跟進(jìn)意愿。
編者注:臺積電 SoIC 是業(yè)內(nèi)第一個高密度 3D chiplet 堆疊技術(shù)。SoIC 設(shè)計(jì)是在創(chuàng)造鍵合界面,讓芯片可以直接堆疊在芯片上。
封裝技術(shù)主要指標(biāo)為凸點(diǎn)間距(Bump Pitch),凸點(diǎn)間距越小,封裝集成度越高,難度越大,臺積電的 3D SoIC 的凸點(diǎn)間距最小可達(dá) 6um,居于所有封裝技術(shù)首位。
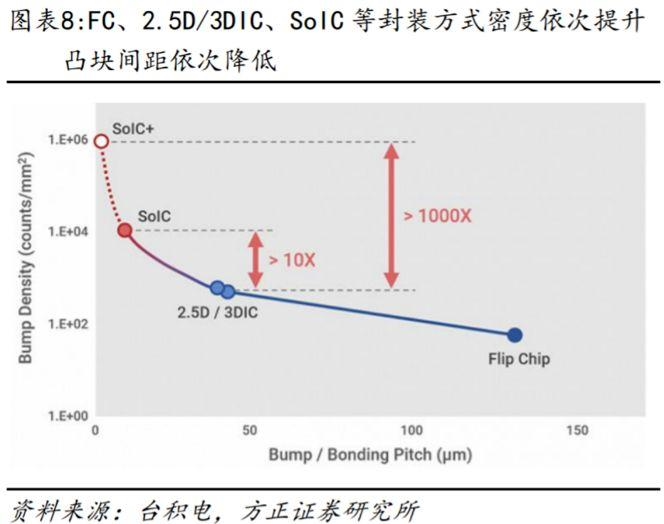
SoIC 是一種“3D 封裝最前沿”技術(shù),是臺積電異構(gòu)小芯片封裝的關(guān)鍵,具有高密度垂直堆疊性能。與 CoWoS 及 InFo 技術(shù)相比,SoIC 可提供更高的封裝密度、更小的鍵合間隔,還可以與 CoWoS / InFo 共用,基于 SoIC 的 CoWoS / InFo 封裝將帶來更小的芯片尺寸,實(shí)現(xiàn)多個小芯片集成。
業(yè)內(nèi)人士表示,SoIC 在 2023 年年底,月產(chǎn)能為 2000 顆,原本計(jì)劃 2024 年擴(kuò)大到 3000-4000 顆,而最新計(jì)劃被上調(diào)至 5000-6000 顆,而且 2025 年目標(biāo)月產(chǎn)能再翻番。
CoWoS 是一項(xiàng)經(jīng)過 15 年發(fā)展的成熟技術(shù),預(yù)計(jì)到今年年底月產(chǎn)能將達(dá)到 30000 至 34000 件。


