DRAM的發(fā)展方向
對(duì)于 DRAM,主要目標(biāo)是繼續(xù)將 1T-1C 單元的封裝尺寸擴(kuò)大到 4F2 的實(shí)際極限。挑戰(zhàn)在于垂直晶體管結(jié)構(gòu)、高 κ 電介質(zhì)以提高電容密度,同時(shí)保持低泄漏。一般來說,DRAM 的技術(shù)要求隨著縮放而變得更加困難。在過去的幾年中,DRAM 引入了許多新技術(shù)(例如,193 nm 氟化氬 (ArF) 浸沒式High NA 光刻技術(shù)和雙圖形技術(shù)、改進(jìn)的單元 FET 技術(shù),包括鰭型晶體管、掩埋字線/單元 FET 技術(shù)等等)。
由于 DRAM 存儲(chǔ)電容器在物理上隨著尺寸縮小而變小,因此等效氧化物厚度 (EOT) 必須急劇縮小以保持足夠的存儲(chǔ)電容。為了擴(kuò)展 EOT,需要具有高相對(duì)介電常數(shù) (κ) 的介電材料。因此,采用高κ(ZrO2/Al2O/ZrO2)的金屬-絕緣體-金屬(MIM)電容器作為接地規(guī)則在48nm和30nm半間距之間的DRAM的電容器。和這個(gè)材料進(jìn)化和改進(jìn)一直持續(xù)到 20 nm HP 和超高 κ(鈣鈦礦 κ > 50~100)材料被釋放。此外,高 κ 絕緣體的物理厚度應(yīng)按比例縮小以適應(yīng)最小特征尺寸。因此,電容器的 3-D 結(jié)構(gòu)將從圓柱形變?yōu)橹巍?/p>
另一方面,隨著外圍CMOS器件的微縮,這些器件形成后的工藝步驟需要低溫工藝流程。這對(duì)于通常在 CMOS 器件形成后構(gòu)建的 DRAM 單元工藝來說是一個(gè)挑戰(zhàn),因此僅限于低溫處理。DRAM 外圍設(shè)備要求可以放寬 Ioff 但需要更多 Ion 的低待機(jī)功耗 (LSTP) 設(shè)備。但是,在未來,將需要高 κ 金屬柵極來維持性能。
另一個(gè)重要主題是從 6F2 到 4F2 cell的遷移。由于半間距縮放變得非常困難,因此不可能維持成本趨勢(shì)。保持成本趨勢(shì)并逐代增加總比特輸出的最有希望的方法是改變單元尺寸因子 (a) 縮放比例(其中 a = [DRAM 單元尺寸]/[DRAM 半間距])。目前 6F2(a = 6)是最常見的。例如,垂直單元晶體管是必需的,但仍然存在一些挑戰(zhàn)。另一種選擇是使用 3D DRAM。
總之,需要保持足夠的存儲(chǔ)電容和足夠的單元晶體管性能以在未來保持保留時(shí)間特性。他們的困難要求正在增加,以繼續(xù)擴(kuò)展 DRAM 設(shè)備并獲得更大的產(chǎn)品尺寸(即 >16 Gb)。除此之外,如果與引入新技術(shù)相比,成本微縮的效率變差,那么DRAM微縮將會(huì)停止,而采用3D單元堆疊結(jié)構(gòu),或者采用新的DRAM概念。
Flash的演進(jìn)方式
有幾種交叉的存儲(chǔ)器技術(shù)具有一個(gè)共同的特征——非易失性。要求和挑戰(zhàn)因應(yīng)用而異,范圍從僅需要 Kb 存儲(chǔ)的 RFID 到芯片中數(shù)百 Gb 的高密度存儲(chǔ)。非易失性存儲(chǔ)器可分為兩大類——閃存(NAND Flash 和 NOR Flash)和非基于電荷的存儲(chǔ)存儲(chǔ)器。非易失性存儲(chǔ)器基本上無處不在,許多應(yīng)用程序使用通常不需要前沿技術(shù)節(jié)點(diǎn)的嵌入式存儲(chǔ)器。More Moore 非易失性存儲(chǔ)器表僅跟蹤前沿獨(dú)立部件的存儲(chǔ)器挑戰(zhàn)和潛在解決方案。
閃存基于簡單的單晶體管 (1T) 單元,其中晶體管既用作訪問(或單元選擇)設(shè)備又用作存儲(chǔ)節(jié)點(diǎn)。目前閃存服務(wù)于99%以上的應(yīng)用。
當(dāng)存儲(chǔ)電子的數(shù)量達(dá)到統(tǒng)計(jì)極限時(shí),即使可以進(jìn)一步縮小器件尺寸,實(shí)現(xiàn)更小的單元,存儲(chǔ)器陣列中所有器件的閾值電壓分布也變得不可控,邏輯狀態(tài)不可預(yù)測(cè)。因此,存儲(chǔ)密度不能通過持續(xù)縮放基于電荷的設(shè)備來無限增加。然而,通過垂直堆疊存儲(chǔ)層可能會(huì)繼續(xù)有效提高密度。
通過完成一個(gè)設(shè)備層然后完成另一層等等來堆疊的經(jīng)濟(jì)性值得懷疑。如圖 MM-9 所示,在堆疊幾層設(shè)備后,每位成本開始上升。此外,由于復(fù)雜處理增加的互連和良率損失導(dǎo)致陣列效率下降,可能會(huì)進(jìn)一步降低此類 3D 堆疊的每比特成本優(yōu)勢(shì)。
在2007 年,業(yè)內(nèi)提出了一種“punch and plug”方法來垂直制造位線串,以大大簡化加工步驟。這種方法使 3D 堆疊設(shè)備只需幾個(gè)步驟,而不是通過重復(fù)處理,從而為 NAND 閃存提供了一條新的低成本擴(kuò)展路徑。圖 MM-9 說明了一種這樣的方法。最初創(chuàng)造的bit-cost-scalable(或 BiCS)架構(gòu)將 NAND 串從水平位置轉(zhuǎn)為垂直位置 90 度。字線(WL)保持在水平面上。如圖 MM-9 所示,這種類型的 3D 方法比完整設(shè)備的堆疊要經(jīng)濟(jì)得多,并且成本效益不會(huì)達(dá)到相當(dāng)高的層數(shù)。
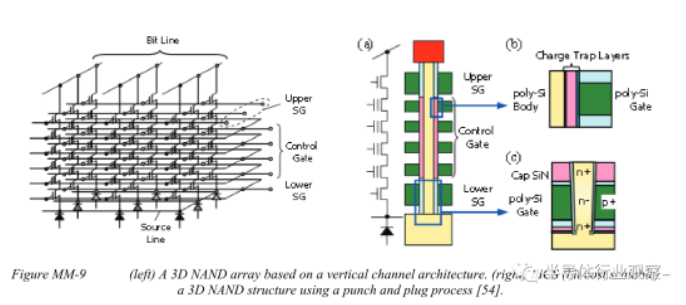
自 2007 年以來,已經(jīng)提出了許多基于 BiCS 概念的架構(gòu),當(dāng)中包括一些使用浮柵而不是電荷捕獲層進(jìn)行存儲(chǔ)的架構(gòu),這些技術(shù)在過去 2-3 年中已經(jīng)投入量產(chǎn)。一般來說,所有 3D NAND 方法都采用了一種策略,即使用比傳統(tǒng) 2D NAND 大得多的面積占用空間。3D NAND 的 x 和 y 尺寸(相當(dāng)于 2D 中的單元尺寸)在 100nm 范圍內(nèi)甚至更高,而最小的 2D NAND 約為 15nm。更大的“單元尺寸”是通過堆疊大量存儲(chǔ)層來實(shí)現(xiàn)具有競爭力的封裝密度的。
3D NAND 的經(jīng)濟(jì)性因其復(fù)雜而獨(dú)特的制造需求而變得更加混亂。盡管較大的單元尺寸似乎放寬了對(duì)細(xì)線光刻的要求,但要實(shí)現(xiàn)高數(shù)據(jù)速率,最好使用large page size尺寸,而這又會(huì)轉(zhuǎn)化為細(xì)間距位線和金屬線。因此,即使單元尺寸很大,金屬線仍然需要約 20nm 的半間距,這只能通過具有雙圖案的 193i 光刻來實(shí)現(xiàn)。深孔刻蝕難度大、速度慢,刻蝕產(chǎn)量一般很低。沉積多層電介質(zhì)和/或多晶硅,以及多層膜和深孔的計(jì)量都是對(duì)陌生領(lǐng)域的挑戰(zhàn)。這些都轉(zhuǎn)化為對(duì)新設(shè)備和占地面積的大量投資,以及對(duì)晶圓流和良率的新挑戰(zhàn)。
最終的未知數(shù)是可以堆疊多少層。
層的堆疊似乎沒有硬性物理限制。超過一定的縱橫比(也許是 100:1?)時(shí),當(dāng)反應(yīng)離子蝕刻過程中的離子被側(cè)壁上的靜電荷彎曲并且不能進(jìn)一步向下移動(dòng)時(shí),蝕刻停止(etch-stop)現(xiàn)象可能會(huì)限制一次操作中可以蝕刻的層數(shù) . 然而,這可以通過堆疊更少的層、蝕刻和堆疊更多的層(以更高的成本)來繞過。
堆疊許多層可能會(huì)產(chǎn)生使晶圓彎曲的高應(yīng)力,盡管這需要仔細(xì)設(shè)計(jì),但它似乎并不是無法解決的物理極限。即使在 200 層(每層約 50nm)時(shí),總堆疊高度約為 10?m,仍然與邏輯 IC 的 10-15 層金屬層處于同一范圍內(nèi)。這種層厚度不會(huì)顯著影響裸芯片厚度(目前最薄約為 40?m)。
然而,在 1000 層時(shí),總層厚度可能會(huì)導(dǎo)致厚die不符合在薄封裝中堆疊多個(gè)die(例如,16 或 32)的形狀因數(shù)。目前量產(chǎn)176層,300+層有望實(shí)現(xiàn),甚至500、800層也有可能。除了處理挑戰(zhàn)之外,堆疊更多層還增加了接觸更多字線所需的面積開銷。該區(qū)域開銷,加上增加的處理復(fù)雜性,最終將通過添加更多層來降低成本效益。
當(dāng)堆疊更多層被證明太困難時(shí),面積 x-y 足跡的重新縮小可能最終會(huì)開始。然而,這種趨勢(shì)并不能保證。如果孔縱橫比是限制因素,那么縮小占位面積不會(huì)降低該比率,因此也無濟(jì)于事。此外,與緊密間距的 2D NAND 相比,更大的單元尺寸似乎至少部分有助于 3D NAND 的更好性能(速度和循環(huán)可靠性)。x-y 縮放是否仍能提供這樣的性能尚不清楚。
因此,未來幾代的路線圖預(yù)測(cè)在 2022 年與當(dāng)前節(jié)點(diǎn)保持一致。另一方面,增加每個(gè)存儲(chǔ)單元的存儲(chǔ)位數(shù)雖然在技術(shù)上具有挑戰(zhàn)性,但似乎取得了進(jìn)展。這在一定程度上是為了利用 3D NAND 器件本質(zhì)上更大,因此存儲(chǔ)的電子更多,更容易制成更多的邏輯電平。
目前 4 位/單元器件 (QLC) 正在量產(chǎn),并且樂觀地認(rèn)為 5 位/單元甚至更多可能在不久的將來變得可行。一個(gè)單元中更多的存儲(chǔ)位需要在性能上做出一些折衷,因?yàn)樗枰L的時(shí)間來編程和讀取,并且在將邏輯電平壓縮在一起時(shí)可靠性會(huì)受到影響。然而對(duì)于許多讀取密集型應(yīng)用程序來說,為了降低成本,這種權(quán)衡是可以接受的。
新興存儲(chǔ)的不確定性
由于存儲(chǔ)電荷太少,2D NAND Flash 縮放受到統(tǒng)計(jì)波動(dòng)的限制,一些不基于電荷存儲(chǔ)的非常規(guī)非易失性存儲(chǔ)器(鐵電或 FeRAM、磁性或 MRAM、相變或 PCRAM,以及電阻或 ReRAM)正在開發(fā)中,形成通常稱為“新興”存儲(chǔ)器的類別。
盡管 2D NAND 正在被 3D NAND 取代(不再受制于電子太少的缺點(diǎn)),但基于非電荷的新興存儲(chǔ)器的一些特性(例如低電壓操作或隨機(jī)存取)正在被各種各樣的應(yīng)用關(guān)注從而獲得繼續(xù)發(fā)展的機(jī)會(huì)。這些新興的存儲(chǔ)器通常具有兩端結(jié)構(gòu)(例如,電阻器或電容器),因此很難同時(shí)用作單元格選擇設(shè)備。存儲(chǔ)單元一般以1T-1C、1T-1R或1D-1R的形式結(jié)合單獨(dú)的存取器件。
1 FeRAM:鐵隨機(jī)存儲(chǔ)器
FeRAM 器件通過切換和感測(cè)鐵電電容器的極化狀態(tài)來實(shí)現(xiàn)非易失性。要讀取內(nèi)存狀態(tài),必須跟蹤鐵電電容器的磁滯回線( hysteresis loop),并且存儲(chǔ)的數(shù)據(jù)被破壞并且必須在讀取后寫回(破壞性讀取,如 DRAM)。由于這種“破壞性讀取”,找到既能提供足夠的極化變化又能在延長的工作周期內(nèi)保持必要穩(wěn)定性的鐵電材料和電極材料是一項(xiàng)挑戰(zhàn)。
許多鐵電材料對(duì)于 CMOS 制造材料的正常補(bǔ)充來說是陌生的,并且可以通過傳統(tǒng)的 CMOS 處理?xiàng)l件退化。FeRAM 速度快、功耗低、電壓低,因此適用于 RFID、智能卡、ID 卡和其他嵌入式應(yīng)用。處理難度限制了它的廣泛采用。最近,提出了基于 HfO2 的鐵電 FET,其鐵電性用于改變 FET 的 Vt,從而可以形成類似于閃存的 1T 單元。如果開發(fā)成熟,這種新存儲(chǔ)器可以用作低功耗且速度非常快的類似閃存的存儲(chǔ)器。
2 MRAM:磁性內(nèi)存
MRAM (Magnetic RAM) 設(shè)備采用磁性隧道結(jié) (MTJ:magnetic tunnel junction) 作為存儲(chǔ)元件。MTJ 單元由兩種鐵磁材料組成,由用作隧道勢(shì)壘的薄絕緣層隔開。當(dāng)一層的磁矩切換為與另一層對(duì)齊(或與另一層的方向相反)時(shí),電流流過 MTJ 的有效電阻會(huì)發(fā)生變化。可以讀取隧道電流的大小以指示存儲(chǔ)的是“一”還是“零”。場(chǎng)切換 MRAM 可能是最接近理想的“通用存儲(chǔ)器”的,因?yàn)樗欠且资缘摹⒖焖俚牟⑶铱梢詿o限循環(huán)。因此,它可以用作 NVM 以及 SRAM 和 DRAM。
然而,在 IC 電路中產(chǎn)生磁場(chǎng)既困難又低效。盡管如此,F(xiàn)ield Switching MTJ MRAM已經(jīng)成功制成產(chǎn)品。然而,當(dāng)存儲(chǔ)元件縮放時(shí),切換所需的磁場(chǎng)會(huì)增加,而電遷移會(huì)限制可用于產(chǎn)生更高 H 場(chǎng)的電流密度。因此,預(yù)計(jì)現(xiàn)場(chǎng)開關(guān) MTJ MRAM 不太可能擴(kuò)展到 65nm 節(jié)點(diǎn)以上。
“STT(spin-transfer torque )”方法的最新進(jìn)展提供了一種新的潛在解決方案,其中自旋極化電流將其角動(dòng)量轉(zhuǎn)移到自由磁性層,從而在不借助外部磁場(chǎng)的情況下反轉(zhuǎn)其極性。在自旋轉(zhuǎn)移過程中,大量電流通過 MTJ 隧道層,這種應(yīng)力可能會(huì)降低寫入耐久性。在進(jìn)一步縮放時(shí),存儲(chǔ)元件的穩(wěn)定性會(huì)受到熱噪聲的影響,因此預(yù)計(jì)在 32nm 及以下需要垂直磁化材料。最近已經(jīng)證明了垂直磁化。
隨著NAND Flash的快速發(fā)展,以及最近推出的有望繼續(xù)等效縮放的3D NAND,STT-MRAM取代NAND的希望似乎渺茫。然而,其類似 SRAM 的性能和比傳統(tǒng) 6T-SRAM 小得多的占用空間在該應(yīng)用中引起了極大的興趣,特別是在不需要高循環(huán)耐久性的移動(dòng)設(shè)備中,例如在計(jì)算中。因此,STT-MRAM 現(xiàn)在大多不被視為獨(dú)立內(nèi)存,而是嵌入式內(nèi)存 ,并且不在獨(dú)立 NVM 表中進(jìn)行跟蹤。
STT-MRAM 不僅是嵌入式 SRAM 替代品的潛在解決方案,也是嵌入式閃存 (NOR) 替代品的潛在解決方案。這對(duì)于物聯(lián)網(wǎng)應(yīng)用來說可能特別有趣,因?yàn)榈凸氖亲钪匾摹A硪环矫妫瑢?duì)于使用更高存儲(chǔ)密度的其他嵌入式系統(tǒng)應(yīng)用,預(yù)計(jì) NOR 閃存將繼續(xù)占據(jù)主導(dǎo)地位,因?yàn)樗匀桓叱杀拘б妗4送猓W存能夠承受 PCB 板焊接過程(約 250°C)而不會(huì)丟失其預(yù)加載代碼,這是眾所周知的,許多新興存儲(chǔ)器尚未能夠證明這一點(diǎn)。
3 PCRAM
PCRAM 器件使用硫?qū)倩锊AВㄗ畛S玫幕衔锸?Ge2Sb2Te5,或 GST)的非晶態(tài)和晶態(tài)之間的電阻率差異來存儲(chǔ)邏輯電平。該器件由頂部電極、硫族化物相變層和底部電極組成。泄漏路徑被與相變?cè)?lián)的存取晶體管(或二極管)切斷。
相變寫入操作包括:(1) RESET,其中硫族化物玻璃通過短電脈沖瞬間熔化,然后快速淬火成具有高電阻率的非晶固體,以及 (2) SET,其中振幅較低但更長脈沖(通常 >100ns)將非晶相退火為低電阻晶態(tài)。1T-1R(或 1D-1R)單元比 NOR Flash 更大或更小,取決于使用的是 MOSFET 還是 BJT(或二極管。該設(shè)備可以被編程為任何最終狀態(tài)而無需擦除先前狀態(tài),從而提供更快的編程吞吐量。簡單的電阻器結(jié)構(gòu)和低電壓操作也使 PCRAM 對(duì)于嵌入式 NVM 應(yīng)用具有吸引力。
PCRAM 的主要挑戰(zhàn)是重置相變?cè)璧母唠娏鳎╢raction of mA),以及相對(duì)較長的設(shè)置時(shí)間和高溫耐受性以在回流焊期間(約 250°C)保留預(yù)加載代碼。熱干擾是 PCRAM 可擴(kuò)展性的潛在挑戰(zhàn)。然而,熱干擾效應(yīng)是非累積的(不像閃存,其中導(dǎo)致電荷注入的編程和讀取干擾是累積的)并且較高溫度的RESET脈沖很短(10ns。相變材料與電極的相互作用可能會(huì)帶來長期的可靠性問題并限制循環(huán)耐久性,是類 DRAM 應(yīng)用的主要挑戰(zhàn)。與 DRAM 一樣,PCRAM 是真正的隨機(jī)存取、位可變存儲(chǔ)器。
已經(jīng)使用碳納米管作為電極證明, PCRAM 器件可以做到 < 5nm 的可擴(kuò)展性,并且復(fù)位電流遵循較大器件的外推線。至少在一個(gè)案例中,證明了 1E11 的循環(huán)耐力。相變存儲(chǔ)器從2011年開始用于功能手機(jī),取代NOR Flash,2012年開始在~45nm節(jié)點(diǎn)量產(chǎn),但此后沒有新產(chǎn)品推出。在過去的幾年中,PCM 存儲(chǔ)器也被瞄準(zhǔn)為嵌入式應(yīng)用程序的 eFlash 替代品的潛在候選者 。在這些工作中,不同類別的相變材料的合金化允許獲得符合焊接回流的存儲(chǔ)器;然而,如此高的溫度穩(wěn)定性是以較慢的寫入速度為代價(jià)的。
4 ReRAM:電阻式存儲(chǔ)器
目前正在研究一大類兩端器件,其中存儲(chǔ)狀態(tài)由金屬-絕緣體-金屬 (MIM:metal-insulator-metal ) 結(jié)構(gòu)的電阻率決定,用于存儲(chǔ)應(yīng)用。其中許多電阻式存儲(chǔ)器仍處于研究階段。由于他們承諾縮小到 10nm 以下,并以極高的頻率 (< ns) 和低功耗運(yùn)行,過去十年中許多工業(yè)實(shí)驗(yàn)室的重點(diǎn)研發(fā)工作使這項(xiàng)技術(shù)被廣泛認(rèn)為是 NAND 的潛在繼承者(包括 3D NAND ).
作為一種雙端器件,高密度 ReRAM 的發(fā)展一直受到缺乏良好選擇器器件的限制。然而,3D XP 內(nèi)存的最新進(jìn)展似乎已經(jīng)解決了這個(gè)瓶頸,如果解決了不穩(wěn)定位等其他技術(shù)問題,ReRAM 可能會(huì)取得快速進(jìn)展。除了 3D XP 陣列(類似于基于 PCRAM 的 3D XP 存儲(chǔ)器)之外,還可以使用 2D 陣列和小字線 (WL) 和小位線 (BL) 半間距制造高密度 ReRAM 產(chǎn)品。
此外,如果最終采用 OTS 類型的選擇器器件,那么使用底部的晶體管和 3D 陣列中每個(gè) ReRAM 器件的 OTS 選擇器來制造 BiCS 型 3D ReRAM 似乎是可行的,如圖 MM-10 所示。盡管由于引入 3D XP 內(nèi)存似乎解決了雙極選擇器設(shè)備的瓶頸,但尚未推出高密度 ReRAM 產(chǎn)品,但可以合理預(yù)期 ReRAM 的進(jìn)展。
然而最近,開發(fā)高密度 ReRAM 的熱情似乎消退了。這可能是由于兩個(gè)原因。(1) 3D NAND Flash的成功增加了進(jìn)入門檻, (2) 難以滿足大型陣列的可靠性要求。(請(qǐng)注意,針對(duì)嵌入式應(yīng)用程序的較小 Mb 大小陣列成功開發(fā) ReRAM 已發(fā)布多項(xiàng)公告。)
在過去的幾年中,上述這些問題似乎注定了高密度 ReRAM 的大規(guī)模應(yīng)用。最初關(guān)于 ReRAM 由數(shù)千個(gè)原子組成,不受統(tǒng)計(jì)波動(dòng)影響的論點(diǎn)現(xiàn)在看來值得懷疑。似乎操作 ReRAM 的燈絲僅由幾個(gè)原子(離子)組成。似乎有證據(jù)表明,即使是相對(duì)較大的 ReRAM 設(shè)備也會(huì)受到統(tǒng)計(jì)波動(dòng)的影響。因此,我們不看好高密度應(yīng)用的 ReRAM。
更多精彩內(nèi)容歡迎點(diǎn)擊==>>電子技術(shù)應(yīng)用-AET<<


