引言:
汽車行業(yè)發(fā)展創(chuàng)新突飛猛進,車載充電器(OBC)與DCDC轉(zhuǎn)換器(HV-LV DC-DC)的應(yīng)用因此也迅猛發(fā)展,同應(yīng)對大多數(shù)工程挑戰(zhàn)一樣,設(shè)計人員把目光投向先進技術(shù),以期利用現(xiàn)代超結(jié)硅(Super Junction Si)技術(shù)以及碳化硅(SiC)技術(shù)來提供解決方案。在追求性能的同時,對于車載產(chǎn)品來說,可靠性也是一個重要的話題。
在車載OBC/DCDC應(yīng)用中,高壓功率半導(dǎo)體器件用的越來越多。對于汽車級高壓半導(dǎo)體功率器件來說,門極氧化層的魯棒性和宇宙輻射魯棒性是可靠性非常重要的兩點。
宇宙輻射很少被提及,但事實是無論什么技術(shù)的高壓功率半導(dǎo)體器件都會受輻射導(dǎo)致幾ns的瞬態(tài)失效,并且很難定位到是宇宙輻射的原因。許多功率半導(dǎo)體應(yīng)用要求單一器件失效率在1-100FIT甚至更低,因此在高壓汽車應(yīng)用里,宇宙輻射的影響需要被認知并得到重視。
因此本文將針對雙向OBC/DCDC這個應(yīng)用,闡述宇宙輻射的影響以及評估系統(tǒng)可靠性的方法。
一、宇宙輻射對可靠性影響機理
1. 汽車級高壓器件可靠性的主要因素
汽車級高壓(650V以上)器件的FIT率主要受門級氧化層魯棒性和宇宙輻射魯棒性影響。門極氧化層的處理,SiC器件與Si器件由于材料硬度,帶隙,陷阱密度等的不同導(dǎo)致處理難度不同。盡管如此英飛凌在SiC方面做出了很多的努力與研究使得門極氧化層魯棒性已經(jīng)達到了很高的水平。
在SiC和Si中,由宇宙輻射引起的失效率隨入射時器件中存在的電場呈指數(shù)級增長。具有相似電場的器件失效率也相似。在過去的幾十年中進行了許多加速試驗,這些試驗表明,當(dāng)施加的電壓被歸一化為實際雪崩擊穿電壓時,由宇宙射線誘發(fā)的失效率相似。就宇宙射線導(dǎo)致的基本失效機制及其與運行條件的關(guān)系而言,Si技術(shù)與SiC 技術(shù)之間只有相當(dāng)細微的差異。 一般而言,垂直型功率器件可以設(shè)計更高的雪崩擊穿電壓,從而可以通過更大的厚度和更低的漂移層或基底層摻雜來實現(xiàn)更強的抗宇宙輻射能力。

圖1:FIT率的主要因素
2. 什么是宇宙輻射
通常描述一定數(shù)量器件的壽命會用浴盆曲線表示。分為早期失效期,偶然失效期以及損耗失效期。早期失效期可以通過早期的測試篩選。對于設(shè)計好的器件,損耗失效期只發(fā)生在規(guī)格書以外的時間段。偶然失效期是產(chǎn)品使用周期內(nèi)發(fā)生失效的主要考慮因素。宇宙輻射對高壓功率器件的失效影響就屬于這一類別。
宇宙輻射造成的單粒子燒毀(SEBs)是高壓MOSFETs偶然失效的因素,雖然失效是偶然的,但是可以通過了解應(yīng)用條件來預(yù)測評估失效率。本文會介紹單粒子燒毀時間以及預(yù)測宇宙輻射導(dǎo)致的高壓MOSFETs失效率的基本方式。

圖2:浴盆曲線
宇宙輻射通過高能粒子轟擊地球,以質(zhì)子,重核為主。少數(shù)情況下,可測得的粒子能量高達1020eV由于大氣層的存在,這些粒子與外大氣層的原子核碰撞,產(chǎn)生了二級粒子,這些二級粒子承載了原粒子的能量。
一般來說,這些二級粒子有足夠的能量在隨后的碰撞中產(chǎn)生更多的粒子,發(fā)生雪崩倍增。但同時,由于大氣層的吸收會讓粒子密度降低。如下圖所示:

圖3:二級粒子的產(chǎn)生
3. 宇宙輻射對功率半導(dǎo)體的影響
當(dāng)二級粒子到達地球表面時,與致密物質(zhì)發(fā)生交互。對于高壓MOSFETs來說,意味著有一定的機率在阻斷區(qū)域被轟擊。粒子通常以幾百MeV(100MeV≈16pJ)的能量轟擊器件,在幾毫米距離里產(chǎn)生電子空穴對。從能譜成分分析,中子是唯一一種數(shù)量多且能把能量集中到一點的粒子,并產(chǎn)生燒毀,稱之為單粒子燒毀(SEBs)。因此中子是最有害的成分。
簡單解釋下單粒子燒毀(SEBs)失效機理:圖4(1)是在中子尚未侵入瞬間反偏狀態(tài)下的p-n節(jié)電場分布:

圖4(1):未侵入瞬間的電場分布
當(dāng)中子與MOSFETs的Si/SiC原子核碰撞時產(chǎn)生反沖離子,離子的動能會引發(fā)在幾毫米范圍內(nèi)產(chǎn)生小范圍電荷爆炸。在關(guān)斷狀態(tài)下,這些電荷載流等離子體將其內(nèi)部與電場屏蔽。在等離子區(qū)邊緣,高峰值電場強度建立。在相應(yīng)碰撞產(chǎn)生的離子化過程中,峰值電場逐漸擴大,從而擴展了離子區(qū)(Plasma zone)范圍。
這種自持式的過程稱之為“streamer”,等離子區(qū)的擴展最終會使得Drain與Source電氣短路,短路的發(fā)熱會使Si融化,最終使MOSFETs結(jié)構(gòu)被破壞,從而失效。

圖4(2):入侵后的電場分布
由于失效機理是由碰撞電離過程導(dǎo)致的,在MOSFETs導(dǎo)通模式下,也就是說沒有高強度電場模式下是不會發(fā)生的,所以在評估失效率時,導(dǎo)通模式不用被考慮。
二、FIT率
1. 定義
一個器件的FIT(failures in time)值是指10億個器件在一定時間里運行失效器件的數(shù)量。比如1FIT/器件。公式如下:

N: 測試器件總數(shù)量
F: 失效器件總數(shù)量
T: 測試總小時數(shù)
圖5是兩代汽車級CoolMOS FIT率與電壓關(guān)系的示意圖,以便于更容易理解:
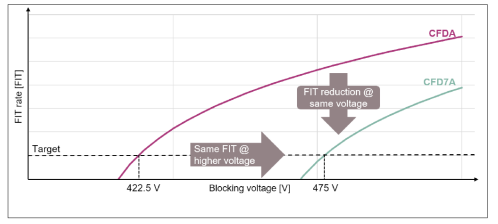
圖5:兩代汽車級的FIT率對比
2.影響因素
FIT率曲線通常是在單位面積下,25℃且0海拔的條件下定義的,從定義中看出FIT跟以下條件是有關(guān)系的:
關(guān)斷電壓:上文提到宇宙輻射失效機制是在關(guān)斷條件下發(fā)生的,因此關(guān)斷電壓跟失效率有很大的關(guān)系,從圖5中也可以看出來。
海拔:高海拔的離子密度越高,海波與失效率呈指數(shù)級別關(guān)系,3000米FIT比海平面高一個數(shù)量級。
結(jié)溫:溫度與失效率呈反向特性,溫度越高,失效率越低,125℃條件下的失效率比25℃低一個數(shù)量級。
芯片面積:失效率跟芯片面積呈線性關(guān)系,面積越大,中子轟擊的幾率也越大。
開通關(guān)斷狀態(tài):FIT跟關(guān)斷時間成線性關(guān)系
3.如何測量輻射失效率
· 自然輻射環(huán)境下的測量
最簡單的方式是存儲試驗,在給定的偏置電壓下對一定數(shù)量的器件進行輻射測量,直至失效發(fā)生,在不同變量,例如Vds, 溫度下進行組合測試。
這種測試方法只適用于在極限電壓附近的失效率。不適用于實際工作電壓與V(BR)DSS偏差大的條件。針對這種情況就需要相對低電壓情況下的加速測試,需要人工輻射源加速,以避免數(shù)年的長時間或者大量的樣本數(shù)量。
· 加速測試
在高海拔處,輻射密度會增加,因此高海拔地區(qū)測試可視為加速測試,這種方式的優(yōu)勢是可以反應(yīng)實際輻射狀態(tài),例如有些機構(gòu)會在海拔2962米的德國祖格峰測試點測試,這種方法的缺點是相對難以接近,并且加速因子幾乎不超過 10。
為了保證測量結(jié)果有一定的統(tǒng)計可信度,需要等待大約 10 次失效, 根據(jù)前文所說,失效率跟Vds呈指數(shù)關(guān)系,典型應(yīng)用電壓通常低于V(BR)DSS, 例如在520V母線電壓下的650V CoolMOS, 假設(shè)10FIT/器件,那就意味著在1000個器件里發(fā)生1個失效需要10年時間。在實際工作電壓條件下為了縮短測試時間且有足夠的失效統(tǒng)計數(shù),基于JEP151建立的高能質(zhì)子或中子束加速測試已建立,加速因子可達109。從而實現(xiàn)半小時完成一輪單次測試,相應(yīng)的不同組合的系列測試也更加快捷。
加速測試中使用的人工輻射源的能譜是有限的或者僅有一種粒子。因此英飛凌基于JEP152且通過存儲試測試以及加速測試二種方法以確保數(shù)據(jù)的一致性。
三、OBC的通用任務(wù)剖面(mission profile)模型建立
準確的任務(wù)剖面文件對于評估高壓半導(dǎo)體在惡劣的汽車應(yīng)用環(huán)境中的穩(wěn)定性至關(guān)重要。下文根據(jù)實際應(yīng)用并設(shè)定某些條件介紹了OBC/HV-LV DC-DC轉(zhuǎn)換器的通用任務(wù)剖面模型。
1.工作狀態(tài)
當(dāng)車輛在行駛狀態(tài),大部分車載電力電子設(shè)備都處于主動運行狀態(tài),包括HV-LV DC-DC。 然而OBC的狀態(tài)相反,僅在汽車停車,交流電源可用,且BMS系統(tǒng)允許充電時才工作。當(dāng)然在V2L, V2G或者V2V反向的應(yīng)用場景下,電池也會向車輛外部的設(shè)備提供能量。
表一展示電動汽車最重要的三種運行模式,并定義了 HV-LV DC-DC 和 OBC 的運行狀態(tài)。

2.工作時間
基于上表,英飛凌基于15年汽車使用時間的設(shè)定,根據(jù)經(jīng)驗創(chuàng)建了一個運行時間模型來評估 OBC 和 HV-LV DC-DC 系統(tǒng)中功率半導(dǎo)體的故障率。 如表二所示:

此表格的OBC工作時間是基于雙向充電的OBC,在充電及車艙預(yù)處理模式下的運行時間高于單向OBC的運行時間。
3.溫度模型
計算FIT率的另一個重要因素是高壓功率半導(dǎo)體的結(jié)溫,結(jié)溫與車內(nèi)的水冷系統(tǒng)耦合。表三展示了車輛狀態(tài)的溫度模型:

4.海拔模型
如前文所述,宇宙輻射引發(fā)故障的一個重要加速因子就是海拔,英飛凌基于全球人口的海拔分布制作了海拔模型,如表四所示:

5.系統(tǒng)模型
電氣條件,環(huán)境條件越精準,F(xiàn)IT結(jié)果越是準確。對于OBC和HV-LV DC-DC我們只考慮高壓器件,因為宇宙輻射對高壓器件影響更嚴重。如圖6中虛線框中所示:

圖6:高壓器件位置
· DC-link母線電壓模型:
母線電壓主導(dǎo)PFC和DCDC原邊。精確的建立長期母線電壓模型至關(guān)重要。設(shè)置常態(tài)母線電壓:
Vstess1.nor=400V
此外,假設(shè)過沖和異常情況下電壓為額定擊穿電壓的80%:
Vstress1.os=520V
假設(shè)在 OBC 的整個工作時間內(nèi),每個開關(guān)周期都會出現(xiàn)一個持續(xù)時間為 50 ns 的矩形過沖電壓。當(dāng)然實際過沖電壓取決于不同的參數(shù),例如 PCB 布局、封裝、負載和柵極驅(qū)動設(shè)置。過沖電壓的簡單矩形模型足以評估宇宙輻射的魯棒性。
此外最惡劣的負載突變情況也要考慮,根據(jù)實際經(jīng)驗,也加入了方波電壓:生命周期里發(fā)生3次,每次10s:
Vstress1.ld=550V。
· 高壓電池包電壓模型
電池電壓取決于充電狀態(tài),圖7是電池電壓模型。此模型中已經(jīng)包含了上述的過沖和異常情況下的瞬態(tài)電壓。
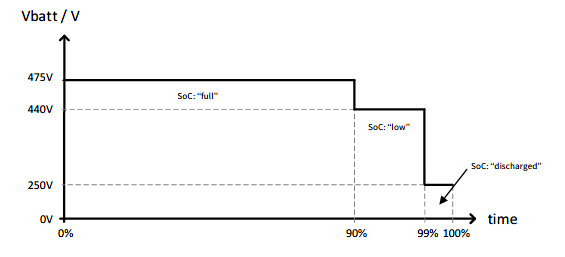
圖7:電池電壓模型
假定90%的時間電池工作在滿電壓狀態(tài):
Vstress2=475V;9%的時間,Vlowsoc=440V;對于剩余 1% 的時間,假設(shè)電池已放電, Vdischg=250V。
· 應(yīng)用條件模型
在定義了 OBC 的電氣應(yīng)力條件后,還需要定義占空比和開關(guān)頻率等應(yīng)用參數(shù),并在表五中進行了說明。
PFC 以連續(xù)導(dǎo)通模式 (CCM) 運行。 PFC 的假定開關(guān)頻率為 100 kHz。 在交流輸入半周期內(nèi),占空比在 3% 到 97% 之間變化。
對于 OBC 中的 DC-DC 級,假設(shè)全橋拓撲在最高頻率 500 kHz ,占空比為 50%。對于 HV-LV DC-DC 模塊,假設(shè)全橋拓撲,最大開關(guān)頻率為 500 kHz,占空比為 50%,與 OBC 中的 DC-DC 級相同。

![]()
四、宇宙輻射評估結(jié)果示例
本章節(jié)展示基于前面的任務(wù)剖面等模型的宇宙輻射評估結(jié)果。以IPW65R048CFDA和IPW65R022CFD7A兩代車規(guī)級CoolMOS為例:
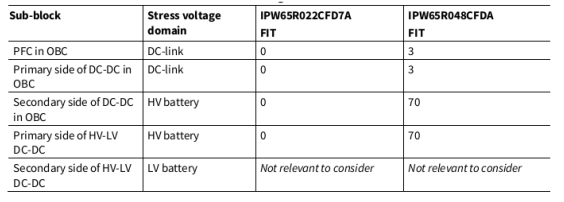
圖8:單個器件失效率
從單個器件角度的結(jié)果看出相比于老一代的CoolMOS, CFD7A系列具有更強的宇宙輻射魯棒性。如果電池電壓是475V, 這個特性就更為重要。老一代的CFDA系列適用于420V的電池電壓。如果從系統(tǒng)角度來看FIT率,只需將FIT值與PFC, DCDC級用的器件數(shù)量相乘即可。在Totem pole PFC慢管以及OBC中DCDC級以CFD7A方案為例,從總FIT率來看,無需進一步的可靠性分析。

圖9:系統(tǒng)級失效率
五、總結(jié)
隨著新能源汽車的滲透率越來越高,尤其在中國地區(qū),已達24%左右。車載OBC/DCDC的可靠性的重要性逐漸凸顯。性能表現(xiàn)在實驗室階段會被容易呈現(xiàn)出來,但是大量產(chǎn)品在數(shù)年的可靠性不容易被感知同時卻又很重要。在OBC/DCDC應(yīng)用中,電壓等級越來越高的情況下,宇宙輻射被提及的并不多,但是重要性不可忽視。
本文針對OBC/DCDC的具體應(yīng)用,解釋了失效機理以及系統(tǒng)級別的FIT率評估方法。可能實際應(yīng)用的任務(wù)剖面模型與本文的通用模型有些許差別,英飛凌會為不同的任務(wù)剖面模型做出具體評估以保證系統(tǒng)級別的可靠性。
參考文獻
1. Infineon-MOSFET_CoolMOS_CFD7A_Cosmic_Radiation_Assessment-ApplicationNotes-v01_00-EN
2. Infineon-MOSFET_CoolMOS_CFD7A_650V-ApplicationNotes-v02_00-EN
3. Infineon-Reliability_of_SiC_power_semiconductors-Whitepaper-v01_02-EN
4. SystemPlus_GaN_on_Si_HEMT_vs_SJ_MOSFET_Technology_and_Cost_comparison
5. Infineon-Physics of Cosmic Radiation-induced Failures in High Voltage Power Devices
更多信息可以來這里獲取==>>電子技術(shù)應(yīng)用-AET<<


