在之前召開的IEDM年度會(huì)議上,,總共進(jìn)行了六次小組討論式的演講。其中,,由IMEC Technology Solutions and Enablement的高級(jí)副總裁Myung‐Hee Na先生做的一個(gè)題為《Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials》的演講最有意思,。本篇開始將逐個(gè)回顧演講內(nèi)容,由于演講內(nèi)容有不充分的地方,,筆者為了讀者易于理解,,適當(dāng)?shù)匮a(bǔ)充了演講內(nèi)容。
需要說(shuō)明的是,雖然這是一個(gè)說(shuō)明未來(lái)CMOS邏輯技術(shù)的講座,,但當(dāng)中卻省略了數(shù)個(gè)基本的前提:
第一,,以MOSFET(MOS晶體管)的結(jié)構(gòu)為前提。在28納米一一22納米的世代,,芯片晶體管采用的是傳統(tǒng)的平面結(jié)構(gòu)MOS晶體管技術(shù),,因此很難繼續(xù)微縮化。到了16/14納米及以后的技術(shù)節(jié)點(diǎn)時(shí)代,,以FinFET為代表的立體結(jié)構(gòu)的MOS晶體管成為了基礎(chǔ)前提,。
第二,是支配CMOS邏輯性能的主要原因,。之前,,能否提升MOS晶體管性能(縮短延遲時(shí)間、增加ON電流)關(guān)系著CMOS邏輯的性能,。但是,,就大型、高速CMOS邏輯而言,,無(wú)法忽視金屬排線引起的時(shí)間延誤(且越來(lái)越大),。對(duì)16/14納米世代以后的技術(shù)節(jié)點(diǎn)而言,縮短排線引起的時(shí)間延誤(或者不延長(zhǎng))對(duì)CMOS邏輯的性能提升極其重要,。
2025年前的CMOS技術(shù)藍(lán)圖
在演講之初,,Myung‐Hee Na先生首先展示了CMOS邏輯生產(chǎn)技術(shù)的微縮化技術(shù)藍(lán)圖。時(shí)間軸(橫軸)范圍為2011年一一2025年,??v軸為用對(duì)數(shù)表示的單位生產(chǎn)成本(美元單元)下晶體管數(shù)量,以2為底數(shù),。在2019年的7納米技術(shù)之前,,幾乎都保持一定比率,從中也可以看出單位生產(chǎn)本下晶體管數(shù)量呈增長(zhǎng)趨勢(shì),。

CMOS邏輯的微縮化技術(shù)節(jié)點(diǎn),、晶體管的生產(chǎn)成本(以美元為單位下的晶體管數(shù)量、以2為底數(shù))推移,。
以上技術(shù)藍(lán)圖詳細(xì)地說(shuō)明了MOS晶體管技術(shù)的變遷,。在28納米技術(shù)世代,平面型MOS晶體管導(dǎo)入了HKMG(High-K Metal Gate,,高介電常數(shù)金屬閘極)技術(shù),。16/14納米技術(shù)節(jié)點(diǎn)下,晶體管走向3D化,,成為了FinFET,。后來(lái),,F(xiàn)inFET持續(xù)了一段時(shí)間。
7納米技術(shù)到5納米技術(shù)器件,,光刻技術(shù)發(fā)生了巨大的變化,。不采用以往的ArF激光浸沒(méi)式光刻,而是導(dǎo)入了EUV(Extreme Ultraviolet,,極紫外光刻)光刻技術(shù),。此外,將鈷(Co)金屬應(yīng)用于MOL(middle of the line)的排線材料也開始被廠商引入,。
4納米以后的技術(shù)則屬于未來(lái),。據(jù)預(yù)測(cè),從4納米技術(shù)到3納米技術(shù),,晶體管將不再采用FinFET,而是納米結(jié)構(gòu)的MOS晶體管,。3納米以后的晶體管技術(shù),即1.5納米技術(shù),、1.0納米技術(shù)后補(bǔ)將會(huì)在下一節(jié)進(jìn)行說(shuō)明,。
就此技術(shù)藍(lán)圖而言,我們應(yīng)該關(guān)注的是時(shí)間軸下面的內(nèi)容,。28納米技術(shù)到20納米技術(shù)之間的演進(jìn),。在這個(gè)階段,支持微縮化(提高晶體管密度)的手段主要是利用光刻技術(shù)使排線和晶體管的節(jié)距(Pitch)縮小,。但是,,20納米以后,節(jié)距無(wú)法再縮短,。于是,,通過(guò)下調(diào)CMOS邏輯的基本單元(Standard Cell)的高度(按照最下層排線的數(shù)量來(lái)計(jì)算),與之前一樣提高了密度,。但是,,越來(lái)越難下調(diào)基本單元的高度。據(jù)預(yù)測(cè),,未來(lái),,會(huì)研發(fā)使副系統(tǒng),、線路邏輯實(shí)現(xiàn)微縮化的技術(shù),。
資料顯示,,在28納米之前,,通過(guò)縮短MOSFET柵極長(zhǎng)度(Gate,, Chanel 長(zhǎng)度)和排線節(jié)距,,邏輯的基本單元(Standard Cell)面積幾乎是每世代縮小一半,,但是,,22納米世代以后,,柵極長(zhǎng)度卻很難像以往一樣縮短了,。短?hào)艠O效果使MOSFET的閾值電壓不均勻,最終導(dǎo)致無(wú)法縮短?hào)艠O長(zhǎng)度,。
因此,16/14納米世代之后開始使MOSFET的柵極3D化,,在不縮短?hào)艠O長(zhǎng)度的情況下,,縮小MOSFET的尺寸(硅基板表面和平行方向的尺寸),。此處立體柵極的代表就是FinFET。通過(guò)縮小作為柵極的Fin的節(jié)距,,繼續(xù)實(shí)現(xiàn)微縮化,。但是,與傳統(tǒng)的平面型MOSFET相比,,尺寸縮小的比例變小了,。這樣下去,就無(wú)法使基本單元的面積縮小一半,。
于是,,通過(guò)降低基本單元的高度(Cell Height),使基本單元的面積縮短至上一代的一半,。基本單元的高度由與Fin保持同樣方向(水平方向)的最下層金屬排線(M0或者M(jìn)1)的數(shù)量(Track數(shù)量)決定。比方說(shuō),,10 Track(10T)的意思是一個(gè)基本單元上有10根金屬排線,。如果在減少Track數(shù)量的同時(shí),縮短節(jié)距,,就可以大幅度降低基本單元的高度,。在16/14納米到5納米的世代中,,降低了基本單元的高度,,這對(duì)縮小基本單元面積,、即提高CMOS邏輯晶體管密度發(fā)揮了巨大作用,。
但是,必須將排線的數(shù)量確保在某個(gè)范圍內(nèi),。金屬排線由電源/接地線,、信號(hào)線構(gòu)成,。都對(duì)CMOS邏輯的基本單元極其重要。
通過(guò)內(nèi)埋電源/接地線,進(jìn)一步減少排線的數(shù)量
Myung‐Hee Na先生的演講中提到,很難將基本單元的Track數(shù)量從6T(Track)降至更低,。下圖的基本單元是CMOS Inverter線路,。在論述縮小基本單元的時(shí)候,,一般會(huì)處理晶體管數(shù)量最小的理論柵極一一Inverter(理論反轉(zhuǎn))。
下圖是imec的技術(shù)藍(lán)圖(相當(dāng)于5納米節(jié)點(diǎn)的基本單元),。Fin數(shù)量如下,2個(gè)p 型FinFET 和n型FinFET,。單元高度為6T,。如果想要進(jìn)一步減少Track數(shù)量,,就存在以下問(wèn)題:難以使電源/接地線的寬度變得更細(xì)(原因是無(wú)法提高電阻)、難以縮小FinFET的尺寸、難以縮小p型FinFET和n型FinFET的距離(為了確保元件分離)。
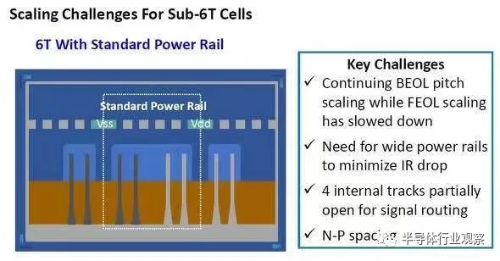
CMOS邏輯基本單元的斷面構(gòu)造圖(FinFET的Fin和最下層金屬排線直接交叉方向的斷面圖),。單元的高度為6Track(6T)。為了進(jìn)一步提高CMOS邏輯的密度,,要想減少Track的數(shù)量,,存在多個(gè)問(wèn)題,。
解決以上問(wèn)題的有效辦法是將電源/接地線埋入基板,即BPR(Buried Power Rails),。利用BPR方法,可將Track數(shù)量減少至5T,,此外,,可以將信號(hào)排線數(shù)量保持為4T,。采用了BPR方法的5T單元,被imec定義為3納米節(jié)點(diǎn)技術(shù)的后補(bǔ),。
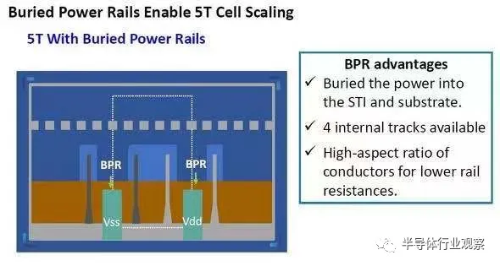
將單元的高度下調(diào)至5T的CMOS邏輯的基本單元的斷面構(gòu)造圖(FinFET的Fin和最下層的金屬排線直接相交方向的斷面圖),。將電源排線和接地排線埋入基板(BPR)。
由于可以提高BPR下的電源/接地線的縱橫比,,因此,,也容易降低電阻。但是,,F(xiàn)inFET的Fin數(shù)量減少為了一個(gè),,與6T 單元相比,晶體管(FinFET)的電流驅(qū)動(dòng)能力(以柵極為單位)會(huì)下降,。晶體管的密度雖然得以提高,,但很可能需要在防止性能下滑方面下功夫。
Myung‐Hee Na先生的演講中提到,通過(guò)采用BPR(Buried Power Rails,,將電源/接地排線埋入基板的技術(shù))技術(shù)和減少FinFET的Fin數(shù)量,,實(shí)現(xiàn)了5T的基本單元?;締卧臄嗝鏄?gòu)造如上文所示,。
導(dǎo)入了BPR之后,基本單元的構(gòu)造將比之前更復(fù)雜,,這是因?yàn)樾枰獜木w管上面排列的電源/接地線網(wǎng)絡(luò)(PDN:Power Delivery Network)向BPR供給電源,。具體而言,為了將PDN的排線網(wǎng)絡(luò)和BPR結(jié)合,,需要具有以下結(jié)構(gòu):在垂直方向形成連接導(dǎo)孔(Via),、電極層等的細(xì)長(zhǎng)柱狀結(jié)構(gòu)。在形成此種結(jié)構(gòu)的工藝中,,增加了晶體管的制造工藝(FEOL),。此外,也增加了基本單元的硅面積,。

采用了BPR(BPR:Buried Power Rails,,將電源/接地線埋入基板的技術(shù))技術(shù)的CMOS邏輯基本單元的斷面結(jié)構(gòu)。需要向BPR供給電源(白色箭頭部分),。
因此,,不需要驗(yàn)證BPR對(duì)基本單元造成的影響,而需要驗(yàn)證對(duì)線路模塊的影響,。實(shí)際上,,對(duì)6T的線路模塊和5T的線路模塊分別進(jìn)行了驗(yàn)證。6T是FinFET的基本單元,,5T是Nano-sheet(NS)FET和BPR的基本單元,。
通過(guò)導(dǎo)入BPR,電源/接地排線引起的電壓下滑約為40%,,與之前相比下降幅度大幅度降低了,。BPR情況下,即使排線較細(xì),,也可以保證高度,,因此,很容易使排線的斷面積做的較大,。即,,可以降低電阻。BPR帶來(lái)的低電阻大大地緩解了電壓下降的問(wèn)題(即有利于電源電壓的穩(wěn)定),。
此外,,通過(guò)優(yōu)化供給電源的排線網(wǎng)絡(luò)(PDN),,線路模組的硅面積大約減少了14%(排除以下:通過(guò)縮小晶體管、減少線路的Track數(shù)量,,削減硅晶圓面積),。
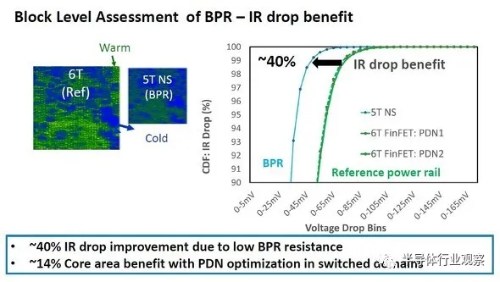
利用線路模塊驗(yàn)證了BPR的結(jié)果,左邊是比較了線路模塊的大小和溫度分布,。就采用了BPR的5T(Track)單元的線路模塊而言,,溫度高的部分(Warm)在逐漸變小。右邊是比較了電壓下降(IR Drop)的累計(jì)分布圖,。在導(dǎo)入了BPR的5T單元的線路模塊中,,電壓的下降幅度約減少了40%,與之前相比下降幅度大幅度降低了,。
我們必須再?gòu)?qiáng)調(diào)一下,,BPR是有希望的后補(bǔ)選項(xiàng),通過(guò)導(dǎo)入BPR,,能夠有效控制電源電壓的下降,。此次,在說(shuō)明BPR復(fù)雜結(jié)構(gòu)的縮略語(yǔ)的同時(shí),,介紹一些金屬材料的備選項(xiàng)。
BPR結(jié)構(gòu)的CMOS基本單元具有非常復(fù)雜的構(gòu)造,。
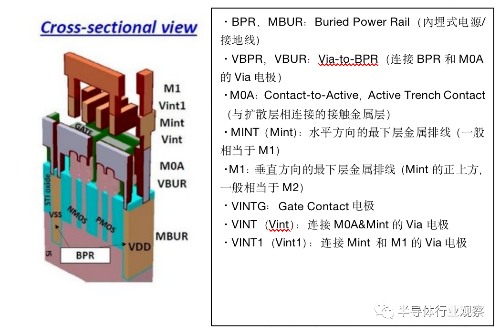
導(dǎo)入了埋入式電源/接地線(BPR)的CMOS基本單元的結(jié)構(gòu)和主要的縮略語(yǔ),,此圖引用自小組演講《Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials》的幻燈片,右圖的縮略語(yǔ)是筆者從imec的學(xué)術(shù)論文中摘選的,。
一般情況下,,金屬排線使用銅(Cu)作為材料。但是,,內(nèi)埋式電源/接地線(BPR)很難使用銅(Cu),。這是因?yàn)樾枰坏牢g刻排線層的工藝。于是,,在BPR結(jié)構(gòu)下,,鎢(W)、釕(Ru),、鈷(Co)等金屬材料是備選項(xiàng),。
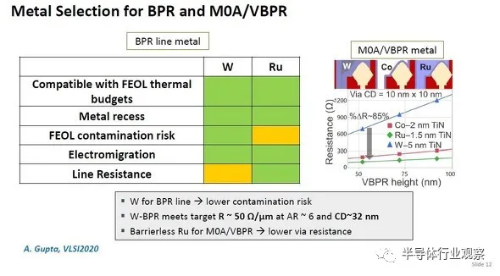
對(duì)于內(nèi)埋式電源/接地線(BPR)的排線結(jié)構(gòu)而言,比較各種金屬,。左邊是比較了BPR材料特性,,右邊是M0A、BPR的材料,、BPR的高度(深度)情況下的不同電阻,。
作為BPR材料,,比較了鎢(W)、釕(Ru),,單位長(zhǎng)度下,,Ru的電阻較低,但是,,釕(Ru)有污染(Contamination)的風(fēng)險(xiǎn),,另一方面,就VBPR和M0A而言,,釕(Ru)和鈷(Co)的電阻更低,。與鎢相比,作為阻擋金屬(Barrier Metal,,氮化鈦TiN,,電阻較高),釕和鈷可以將厚度做的更薄,。
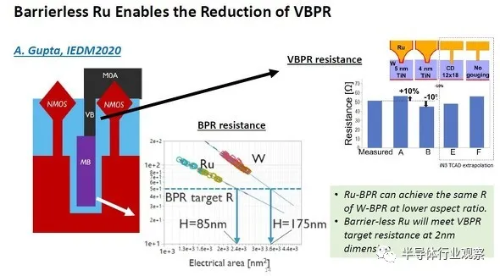
BPR的構(gòu)造(左)和BPR的電阻(中間),、VBPR的電阻(右)。
可以看出,,可將鎢用做BPR的材料,,釕用作VBPR和M0A的材料。鎢可以確保通過(guò)提高縱橫比,,來(lái)降低電阻,。釕具有使阻擋金屬變薄的特性。此外,,釕也可用于不需要阻擋金屬的VBPR,,有望用于2納米。
3納米后,,電源電壓是一大課題
就3納米世代以后的CMOS邏輯而言,,縮小基本單元的有效方法是將電源/接地排線埋入基板內(nèi)的BPR技術(shù),上文已經(jīng)論述,。在電源系統(tǒng)中,,基本單元的電源/接地排線位于最末端。其上端為有電源供給網(wǎng)絡(luò)(PDN:Power Delivery Network),,是用于給大量的基本單元供給電源的,。
通常,PDN分割多層金屬排線的一部分,。通常,,PDN在硅芯片(Silicon Die)的表面(FS:Front Side),這種排線方式被稱為“FS-PDN”,。
在導(dǎo)入BPR之前,,包含各個(gè)基本單元的電源/接地排線的PDN位于硅芯片的表面,。為了縮小基本單元,導(dǎo)入了內(nèi)埋了基本單元的電源/接地排線的BPR,。于是,,就需要一個(gè)從FS-PDN向BPR垂直供給電源的電極排線(VBPR:Via to BPR)。
從削減硅面積的觀點(diǎn)來(lái)看,,VBPR的存在是不被希望看到的,。于是,通過(guò)將PDN配置于硅芯片的背面,,來(lái)削減VBPR,。這被稱為“BS-PDN”。BS-PDN“和BPR之間由細(xì)微的TSV(硅通孔)連接,。
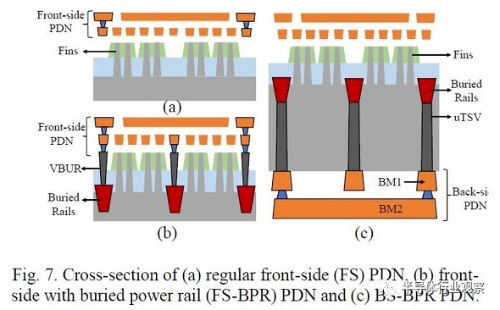
電源供給排線網(wǎng)(PDN:Power Delivery Network)的分布圖,,左上角(a)為傳統(tǒng)的布局。所有的電源排線都包含在多層金屬排線層內(nèi),。左下角(b)為將BPR(內(nèi)埋式電源/接地排線)導(dǎo)入到基本單元的布局,。右邊(c),在導(dǎo)入BPR的同時(shí),,將PDN配置于硅芯片的背面,。
制造BPR和背面的電源供給網(wǎng)(PDN)的工藝極其復(fù)雜。利用細(xì)微的TSV(uTSV或者nTSV)將BPR和BS-PDN連接的同時(shí),,還需要一道在硅晶圓背面形成金屬排線的工藝,。
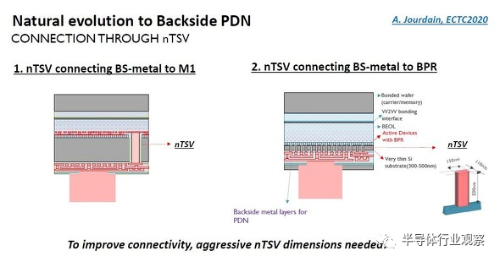
利用了細(xì)微的TSV(nano-TSV,nTSV)的背面排線和表面排線的連接事例,。左邊為一般的連接結(jié)構(gòu)。右邊為用nTSV將背面排線(電源供給排線網(wǎng),,PDN)和內(nèi)埋式電源線(BPR)連接的結(jié)構(gòu),。
比方說(shuō),將具有了BPR的硅晶圓(1st wafer)與其他硅晶圓(2nd wafer)貼合,,然后研磨1st硅晶圓,,在經(jīng)過(guò)蝕刻,使厚度為10um左右,。
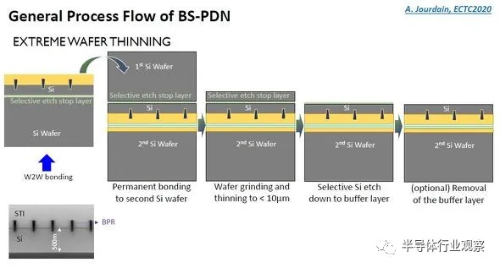
在硅芯片背面制造電源供給排線網(wǎng)(PDN)的工藝(前半部分),。
然后,形成連接了BPR的nTSV,。nTSV的內(nèi)埋金屬是銅(Cu),。形成nTSV后,通過(guò)單邊鑲嵌工藝(Single Damascene),,生產(chǎn)銅排線層的BS-PDN,。
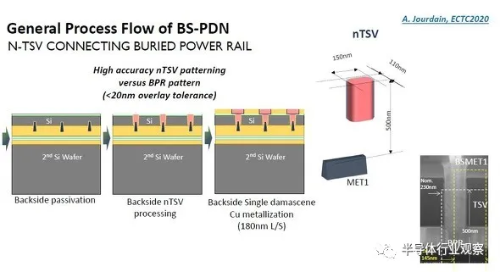
在背面生產(chǎn)電源供給排線網(wǎng)(BS-PDN)的工藝(前半部分),。
此外,還評(píng)價(jià)了CMOS邏輯的基本單元(Standard Cell)的BPR & BS-PDN的效果,。以6T(Track)的基本單元(沒(méi)有BPR,, FC-PDN)為基準(zhǔn)的情況下,導(dǎo)入了BPR的5T(Track)的基本單元(FS-PDN)的線路模塊的面積減少了19%,,電源電壓下降值從45mV減少為35mV,。此處,追加BS-PDN的話,,線路模塊的面積雖然不變化,,電源電壓下降值更低,為25mV,。與6T單元相比,,可將電源電壓的變化控制為45%。
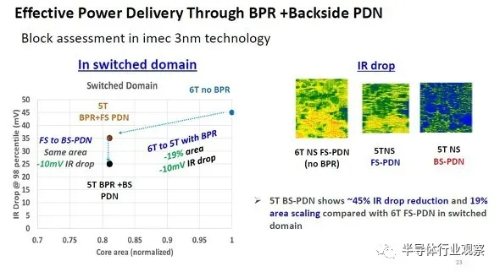
BPR和BS-PDN的效果,。左邊是線路模組(Core)的面積和電源電壓下降的關(guān)系,。右邊是線路模組的溫度分布(反應(yīng)IR Drop的大小),。
3nm后,,F(xiàn)inFET到達(dá)極限
正如我們之前說(shuō)明的一樣,就以FinFET為晶體管的CMOS邏輯而言,,在縮小Fin的節(jié)距的同時(shí),,將Fin抬高,通過(guò)減少與Fin平行的的最下層的金屬排線的數(shù)量(Track數(shù)量),,來(lái)縮小基本單元(Standard Cell),。比方說(shuō),就7.5Track的基本單元而言,,通過(guò)Fin的2個(gè)p型FinFER和n型FinFET,,構(gòu)成CMOS Inverter。就下一代而言,,在保持Fin的數(shù)量的同時(shí),,通過(guò)將Track數(shù)減少為6個(gè),來(lái)縮小基本單元的面積,。
此外,,就下一代而言,預(yù)計(jì)會(huì)將Track數(shù)量減少為5個(gè)的同時(shí),,F(xiàn)in的數(shù)量減少為一個(gè),,從而縮小基本單元的面積。減少Fin的數(shù)量是為了保持p型FinFET和n型FinFET之間的距離(是能夠分割元件的距離),。
此處存在的問(wèn)題是每一代產(chǎn)品對(duì)FinFET的規(guī)格要求都在變化,,同時(shí),,在變得越來(lái)越嚴(yán)格。減少Fin的數(shù)量會(huì)導(dǎo)致FinFET的電流驅(qū)動(dòng)能力變?nèi)?。為不使電流?qū)動(dòng)變?nèi)?,必須要提高單個(gè)FinFET的的電流驅(qū)動(dòng)能力。此外,,如果使Fin做得更薄,、減少節(jié)距,加工尺寸,、異物濃度等帶來(lái)的問(wèn)題影響將會(huì)更大,。

采用了FinFET的CMOS基本單元(Standard Cell)的微縮化和其存在的問(wèn)題。
可以想到的解決方案是將FinFET的Fin由垂直改為平放的Chanel 結(jié)構(gòu)(Nano結(jié)構(gòu))晶體管,。被稱為”Nano-sheet FET“,、”Nano-ribbon FET“。Fin的結(jié)構(gòu)如下:Fin的側(cè)面有2個(gè)柵極(Gate),、頂點(diǎn)有一個(gè)柵極(Gate),,合計(jì)為三個(gè)(Tri-gate);而Nano-sheet結(jié)構(gòu)的優(yōu)勢(shì)如下:上面兩個(gè)柵極,、下面兩個(gè)柵極,,合計(jì)四個(gè)(Gate-All-Around)。在控制短Chanel效果的同時(shí),,由于Chanel的寬度變寬,,所以電流驅(qū)動(dòng)能力得以提高。
此外,,與Fin結(jié)構(gòu)相比,,Nano-sheet結(jié)構(gòu)的晶體管的性能差異更小,且由一片薄薄的Sheet的厚度決定晶體管的電流驅(qū)動(dòng)能力,。在半導(dǎo)體生產(chǎn)工藝中,,厚度(垂直方向的尺寸)由原子層單位控制。Fin的厚度(橫向尺寸)是通過(guò)光刻技術(shù)加工的,,加工尺寸的偏差無(wú)法做到某個(gè)值(比原子層更長(zhǎng)的距離)以下。

從FinFET到Nano-sheet的轉(zhuǎn)換和Nano-sheet的優(yōu)勢(shì),。
另一個(gè)重要的方面是布局(Layout)自由度的增加,。就FinFET而言,F(xiàn)in的數(shù)量由橫向尺寸決定,。由于Fin的數(shù)量是自然數(shù),,因此橫向的尺寸是離散決定的。就Nano-sheet FET而言,,由于是垂直堆疊sheet,,因此,,可以連續(xù)地改變橫向的尺寸。
為了通過(guò)FinFET來(lái)縮小CMOS的基本單元(Standard Cell),,需要采用以下方法:減小Fin的節(jié)距,、減少Fin的數(shù)量、使Fin做得更薄,、抬高Fin,。于是,F(xiàn)inFET的每個(gè)Fin的電流驅(qū)動(dòng)能力雖然得以提高,,卻又需要縮小每個(gè)Fin之間的差異,。這個(gè)問(wèn)題和微縮化一樣,很難處理,。
此處考慮到的方案是將FinFET橫向放置的Chanel結(jié)構(gòu)(Nano-sheet 結(jié)構(gòu))晶體管,。
Nano-sheet 結(jié)構(gòu)的晶體管(或者稱為”Nano-sheet Transistor“)或者”NSH Transistor“的優(yōu)勢(shì)是:電流驅(qū)動(dòng)能力較高,偏差小,。但是,,imec似乎對(duì)于Nano-sheet 結(jié)構(gòu)的開發(fā)并不是十分積極。主要理由如下:對(duì)于晶體管之間的分離元件而言,,Nano-sheet 結(jié)構(gòu)需要與FinFET一樣的距離,。
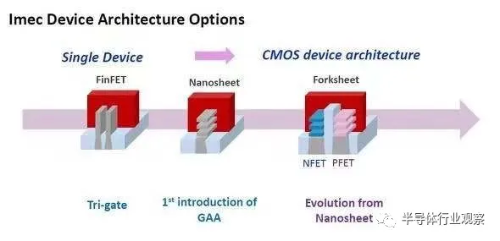
從FinFET到Nano-sheet構(gòu)造、Fork-sheet構(gòu)造的變化,。
Imec主推的是被稱為”Fork-sheet構(gòu)造“的Chanel構(gòu)造的晶體管(也被稱為”Fork-sheet Transistor“或者”FSH Transistor“),。通過(guò)以Nano-sheet構(gòu)造為基礎(chǔ)進(jìn)行重要的改良后,晶體管間的距離似乎縮小了,。對(duì)于2納米以后的世代而言,,F(xiàn)ork-sheet構(gòu)造是晶體管技術(shù)的有力備選項(xiàng)。
就Fork-sheet構(gòu)造而言,,絕緣膜的薄壁位于中間,,p型Nano-sheet和n型Nano-sheet成對(duì)。柵極金屬的斷面結(jié)構(gòu)與作為餐具的叉子形狀類似,,因此被稱為”Fork-sheet“,。
就Fork-sheet構(gòu)造而言,相鄰的Chanel和柵極金屬在物理上是分離的,。因此,,相鄰的晶體管之間的距離已經(jīng)縮小至極限。即,,CMOS邏輯的基本單元可以縮小,。
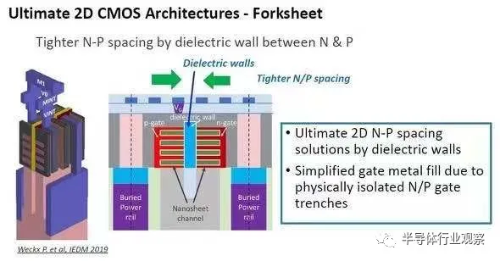
Fork-sheet構(gòu)造,嵌入將p型和n型的晶體管的模式圖。
此外,,與Nano-sheet相比,,F(xiàn)ork-sheet構(gòu)造具有寄生容量較小的優(yōu)勢(shì)。在消耗同樣電力的情況下,,與Nano-sheet構(gòu)造相比,,F(xiàn)ork-sheet構(gòu)造的晶體管可以更高速地工作。反過(guò)來(lái)說(shuō),,在同樣工作頻率的情況下,,F(xiàn)ork-sheet構(gòu)造比Nano-sheet耗費(fèi)的電力更少。從imec在國(guó)際學(xué)會(huì)IEDM 2019上發(fā)布的論文(論文編號(hào):36.5)來(lái)看,,用CMOS Inverter的15段 Ring振蕩器比較后發(fā)現(xiàn),,F(xiàn)ork-sheet構(gòu)造的工作頻率(以同樣的功耗來(lái)比較)提高了10%,功耗(以同樣的工作頻率來(lái)比較)減少了24%,。
Fork-sheet晶體管成為候補(bǔ)的理由
我們已經(jīng)在上文敘述過(guò)使基本單元微縮化的有效辦法,,即減少與Chanel方向(細(xì)長(zhǎng)的Active區(qū)域)平行的最下層的金屬排線數(shù)量(Track數(shù)量,T),。通過(guò)減少Track數(shù)量,,縮短基本單元的高度(CH: Cell Height)。但是,,這種辦法在6T的時(shí)候達(dá)到極限,,據(jù)預(yù)測(cè),可以采用將電源/接地線埋入基板內(nèi)的BPR(Buried Power Rail)方法實(shí)現(xiàn)5T,。
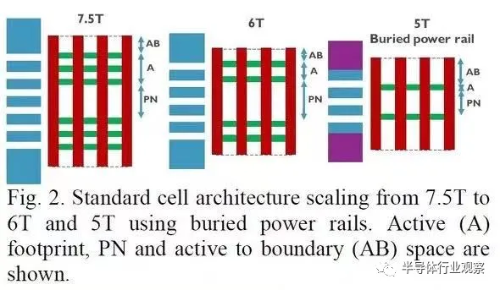
CMOS邏輯基本單元的架構(gòu)和各部分的尺寸,。左邊淡藍(lán)色為最下層的金屬排線,垂直延伸的紅色部分為柵極金屬,、水平延伸的綠色部分為Active區(qū)域,。
就此處規(guī)定基本單元(CMOS Inverter)的高度的定義而言,如下,,從Active區(qū)域到基本單元區(qū)域的距離為”AB(Active to Boundary)“,、Active區(qū)域的高度為”A(Active)“、分割p型晶體管和n型晶體管的距離為”PN(p to n)“,。
接下來(lái),,按照CMOS邏輯技術(shù)的節(jié)點(diǎn),來(lái)逐個(gè)討論基本單元各部分高度(CH)的尺寸,。在14納米(N14),、10納米(N10),40%(甚至更多)的CH由”A“占據(jù),,”PN“、”AB“分別各占三成(甚至更低)。在7納米(N7),,”A“的比例減少至三成,,”PN“、”AB“分別增加至三成多,。早接下來(lái)的5納米(N5),,”PN“的比例進(jìn)一步增加,增至四成,,另一方面,,”AB“的占比減少至2.5成,而”A“的占比反而增加至3.5成,。

各部分在基本單元高度(CH)中的占比和技術(shù)節(jié)點(diǎn)(N)的推移,。
3納米以后,由于導(dǎo)入了BPR技術(shù),,”AB“的比例達(dá)到五成以上,,為最大值。這一比例沒(méi)有什么變化,?!盇“的比例大幅度減少至一成,另一方面,,”PN“占比為3.5成左右,,也比較高。N5以后,,”PN“雖然變得較短,,但是卻是微縮化的關(guān)鍵。
從以上可以看出,,能夠縮短”PN“的”Fork-sheet構(gòu)造“比”Nano-sheet構(gòu)造“更有優(yōu)勢(shì),。這也是imec的觀點(diǎn)。
我們也應(yīng)該認(rèn)識(shí)到,,F(xiàn)ork-sheet構(gòu)造具有單元布局自由的優(yōu)勢(shì),。這是因?yàn)榭梢钥刂啤盤N“、”A“,。在演講中,,提到了使寄生容量最小化的布局、使電流驅(qū)動(dòng)能力最大化的布局,、使單元面積最小化的布局,。
就將寄生容量最小化的布局而言,Active區(qū)域不是很寬,、且適當(dāng)?shù)卮_保了晶體管間的距離,。就使電流驅(qū)動(dòng)能力最大化的布局而言,,在擴(kuò)大Active區(qū)域的同時(shí),縮小了晶體管間的距離,。就使單元面積最小化的布局而言,,Active區(qū)域較細(xì)、縮小了晶體管間的距離,。單元的高度控制為4.4T,。

Fork-sheet構(gòu)造,優(yōu)化了基本單元布局的事例,。左邊為寄生容量最小的布局,、中間為提高了電流驅(qū)動(dòng)能力的布局、右邊為單元面積最小化的布局,。即圖中的”M0A“為”Contact-to-Active, Active Trench Contact(與Active層相連接的接觸金屬層)“,、”MINT“為”水平放下的最下層金屬排線(一般相當(dāng)于M1)“、”BPR“為”Buried Power Rail(埋入式電源/接地線)“,。
接下來(lái),,我們?cè)跀⑹鯢ork-sheet構(gòu)造的CMOS邏輯的生產(chǎn)工藝的同時(shí),也會(huì)公布用電子顯微鏡和熒光X線觀察的晶體管的斷面圖(試作品)的圖像,。
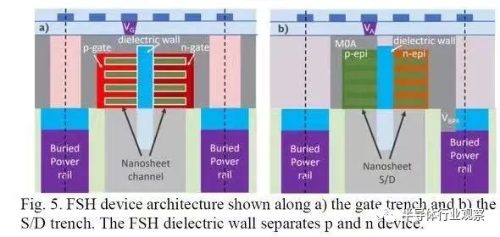
構(gòu)成Fork-sheet(FSH)構(gòu)造的CMOS邏輯的一對(duì)晶體管的斷面構(gòu)造圖,。左邊的構(gòu)造圖(a)是在柵極電極處的斷面。這對(duì)晶體管的左邊是p型,,右邊是n型,。右邊的構(gòu)造圖(b)是Active區(qū)域的斷面(Source/Drain區(qū)域)。用絕緣膜壁用電和物理特性使晶體管分開,。
這一對(duì)Fork-sheet構(gòu)造的晶體管(一對(duì)p型和n型)具有非常復(fù)雜的結(jié)構(gòu),,乍一看,很難想象是以何種工藝制成的,。
以Nano-sheet的生產(chǎn)工藝為基礎(chǔ),,針對(duì)Fork-sheet,追加和變更了一部分,。
根據(jù)Myung‐Hee Na先生的演講,,F(xiàn)ork-sheet構(gòu)造的生產(chǎn)工藝是Nano-sheet構(gòu)造生產(chǎn)工藝的基礎(chǔ)。不僅在Fork-sheet構(gòu)造中追加了特殊的工藝,,還針對(duì)Fork-sheet進(jìn)行了部分工程變更,。
最大的差別是增加了形成絕緣膜壁的工藝(Step)。此外,,將形成內(nèi)部Spacer的工藝和Active(Source,、Drain)層的外延生產(chǎn)工藝、形成RMG(Replacement Metal Gate)的工藝全部改為了針對(duì)Fork-sheet構(gòu)造,。其他工藝與Nano-sheet構(gòu)造的晶體管工藝基本相同,。
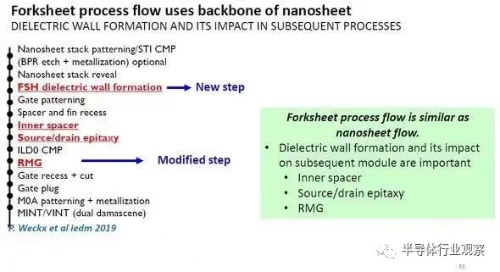
Fork-sheet構(gòu)造晶體管的生產(chǎn)工藝流程
再稍微具體一些說(shuō)明,,首先加工Nano-sheet壓層形狀的模板,形成淺槽分離層(STI:Shallow Trench Isolation),,通過(guò)CMP(Chemical Mechanical Polishing)達(dá)到平坦效果,。接下來(lái),實(shí)施埋入式電源/接地排線(BPR: Buried Power Rail)的蝕刻和成膜工藝(此處的BPR工藝是選擇性的),。然后,使Nano-sheet的壓層結(jié)構(gòu)曝光,,形成用于Fork-sheet的垂直絕緣膜(絕緣膜壁),。
然后,進(jìn)行以下工藝:加工柵極的線路(Pattern),、形成Spacer,、Fin的Recess、內(nèi)部Spacer,、Source/Drain的外延生長(zhǎng),、形成層間絕緣膜(ILD)和CMP、形成RMG,、柵極的Recess和Cut,、形成柵極的Plug、Metallization,。
在演講中,,Myung‐Hee Na還展示了用電子顯微鏡和熒光X線分光設(shè)備觀測(cè)的Fork-sheet構(gòu)造的試作品(是按照以上工藝進(jìn)行試做的)的圖像。由絕緣膜壁分割的一對(duì)晶體管的距離為17納米,??梢钥闯觯瑬艠O絕緣膜和柵極金屬膜很整齊地融入在壓層薄片(Sheet)里,。

試做的Fork-sheet構(gòu)造的斷面圖像,,左邊為用透射電子顯微鏡觀察的圖像。右側(cè)為用能量分散型熒光X線分光設(shè)備(EDS:Energy Dispersive X-ray Spectrometer)拍攝的Mapping 圖像,。
就理論線路單元而言,,與FinFET相比,F(xiàn)ork-sheet構(gòu)造的CMOS邏輯的布局(Layout)自由度更高,。具體而言,,F(xiàn)inFET的CMOS Inverter的連接Track(水平方向的最下層的金屬排線)和柵極的連接位置是受限的。無(wú)法使中間的2個(gè)Track連接,。但是,,如果是Fork-sheet構(gòu)造,可以使中間的2個(gè)Track連接,。
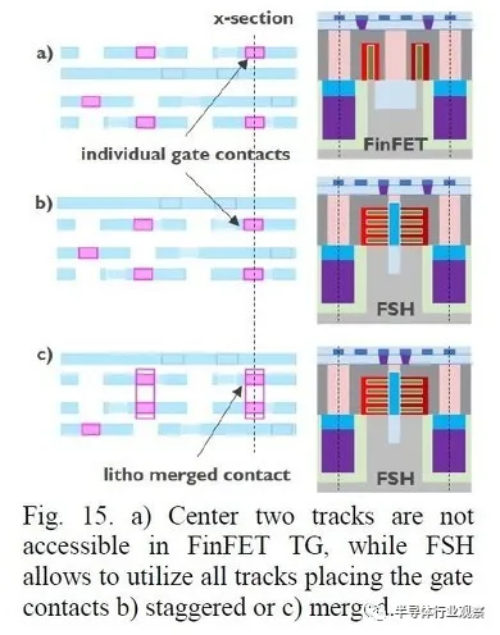
CMOS基本單元(Inverter)的布局(Layout)和柵極連接(Gate Connect)的布局(Layout),。上部(a)的晶體管是FinFET,。水平方向有4個(gè)Track,但中間的2個(gè)Track無(wú)法做到柵極連接,。中間的(b)和下面的(c)的晶體管是Fork-sheet構(gòu)造,。所有的Track都可以與柵極連接。
接下來(lái),,比較一下D類Flip Flop(D-FF)的理論線路單元,。同樣高度的單元,Contact Gate Pitch(CPP 或者”CGP“)數(shù)量會(huì)不同,。Nano-sheet(NSH)構(gòu)造為11Pitch,,F(xiàn)inFET為10 Pitch,F(xiàn)ork-sheet(FSH)構(gòu)造為9 Pitch,。與NSH構(gòu)造相比,,F(xiàn)SH構(gòu)造的D-FF的單元面積小了20%左右。
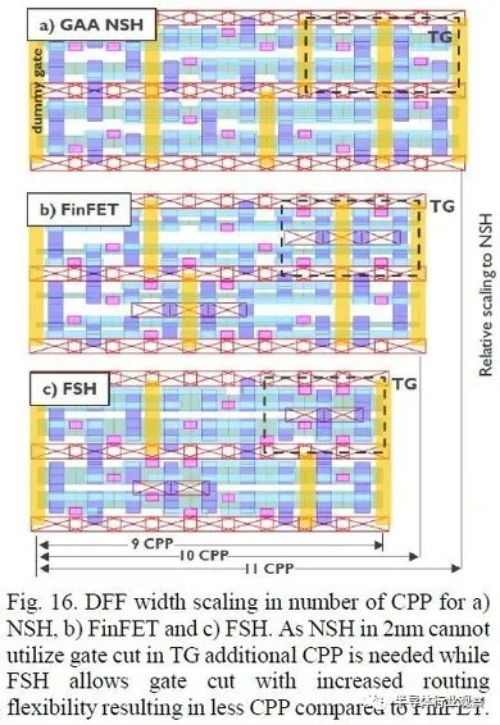
D類Flip Flop(D-FF)的單元布局,。自上而下:Nano-sheet(GAA NSH)構(gòu)造(a),、FinFET(b)、Fork-sheet構(gòu)造(c),。
我們還分別比較了在高性能布局和高密度布局下的Nano-sheet構(gòu)造和Fork-sheet構(gòu)造的SRAM,。就高性能的SRAM單元而言,F(xiàn)ork-sheet構(gòu)造可以縮短p Chanel和n Chanel的距離(PN),,因此,,單元面積可以減少約兩成左右。如果是高密度的SRAM單元,,單元面積可以減少約三成,。
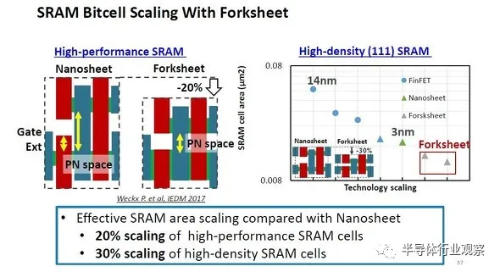
比較了在Nano-sheet構(gòu)造和Fork-sheet構(gòu)造下的SRAM的單元面積。左邊為高性能的SRAM的單元,。右邊為高密度的SRAM的單元,。
2nm后的晶體管選擇
FinFET的”下一代的下一代“技術(shù)指的是Nano-sheet構(gòu)造和Fork-sheet構(gòu)造的下一代。Nano-sheet構(gòu)造和Fork-sheet構(gòu)造被認(rèn)定為屬于同一時(shí)代的技術(shù)(FinFET的下一代),。雖然Nano-sheet構(gòu)造和Fork-sheet構(gòu)造比較類似,,但是晶體管構(gòu)造有很大的不同。Nano-sheet構(gòu)造是晶體管的單獨(dú)構(gòu)造,,F(xiàn)ork-sheet構(gòu)造是以CMOS 邏輯為前提的,。
可以說(shuō),將兩個(gè)晶體管進(jìn)行高密度融合并生產(chǎn)出來(lái),,才是Fork-sheet構(gòu)造,。
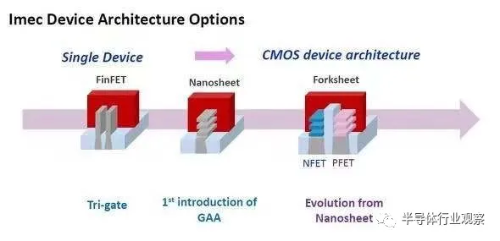
imec所考慮的晶體管的技術(shù)藍(lán)圖。從FinFET到Nano-sheet,、Fork-sheet的各代技術(shù),。平面(2D)構(gòu)造的晶體管已經(jīng)達(dá)到極限,,因此新一代的3D(壓層)構(gòu)造的CFET(Complementary FET)是有希望的備選項(xiàng)。
FinFET的”下一代的下一代“的晶體管的前提與Fork-sheet構(gòu)造相同一樣,、即CMOS邏輯,。Fork-sheet構(gòu)造的特點(diǎn)為”PN距離(為分離p Chanel 和n Chanel的晶體管的距離)較短“,且這一特點(diǎn)還在被改善,。
具體而言,,在p Chanel晶體管的FET上重合n Chanel的FET。硅面積就減少為一個(gè)晶體管的分量,,理論上密度會(huì)提高,。此外,由于”PN 距離“的進(jìn)一步縮短,,理論上CMOS 邏輯的工作速度會(huì)提高。這種晶體管的結(jié)構(gòu)被稱為”互補(bǔ)型FET(C FET,,C=Complementary)“,。
CFET的想法比較簡(jiǎn)單。由平面型的p Chanel MOSFET和n Chanel MOSFET構(gòu)成的CMOS Inverter共同擁有細(xì)長(zhǎng)的柵極電極,。以柵極電極的中線為中心線,,折疊兩個(gè)晶體管。在p Chanel FET的上面重合n Chanel FET的3D壓層結(jié)構(gòu)的晶體管會(huì)是一對(duì)(兩個(gè)),。
之所以把p Chanel FET放在下面是因?yàn)闃?biāo)準(zhǔn)的生產(chǎn)工藝順序,,即首先生產(chǎn)p Chanel,然后生產(chǎn)n Chanel,。理論上來(lái)講,,把n Chanel FET放在下面也可以制成CFET。
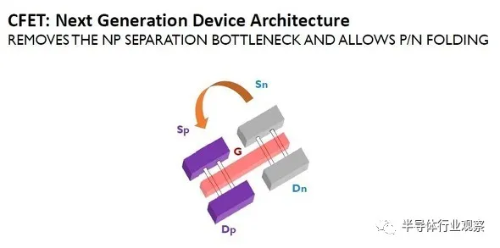
”互補(bǔ)型FET(C FET,,C=Complementary)“,,S為Source、D為Drain,、G為Gate
如果要再次描述一下CFET的特點(diǎn)的話,,首先一點(diǎn)就是縮小CMOS基板單元。與以往的晶體管線路相比,,硅晶圓面積減少了約一半,。可以用接近一個(gè)晶體管的硅面積制作由兩個(gè)晶體管構(gòu)成的CMOS元件,,此外,,p Chanel的材料和n Chanel的材料是可以分別選擇的。
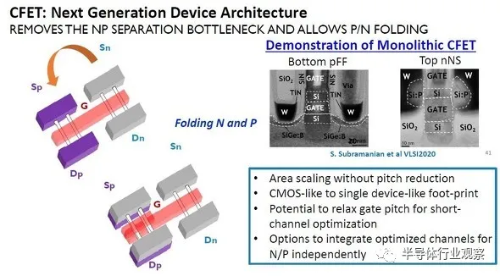
”互補(bǔ)型FET(C FET,,C=Complementary)“的特點(diǎn),、用電子顯微鏡觀察的試做的晶體管的斷面結(jié)構(gòu)圖像,。
在2納米世代技術(shù)以后,CFET會(huì)成為CMOS 邏輯的有力備選項(xiàng),。在1.5納米世代,、1.0納米世代,CFET將會(huì)是必選項(xiàng),。
就CMOS基本單元(Inverter)的布局(Layout)而言,,是多個(gè)Chanel處于水平方向。與Chanel平行布局的最下層的金屬排線數(shù)量(Track:T)決定著單元的高度(CH),。金屬排線數(shù)量的減少直接關(guān)系著單元高度的降低,。
最初,是通過(guò)CMOS基本單元(把晶體管技術(shù)當(dāng)做FinFET)來(lái)減少Track 數(shù)量(T)的,。7.5T和6T都是在FinFET的情況下減少了Track數(shù)量,。但是,5T情況下就很難用傳統(tǒng)技術(shù)來(lái)降低單元的高度了,。首先考慮到的是保持FinFET不變,,然后采用BPR(Buried Power Rail,將金屬排線的電源/接地線埋入基板)方法,。實(shí)際效果如下:減少了兩根金屬排線,。
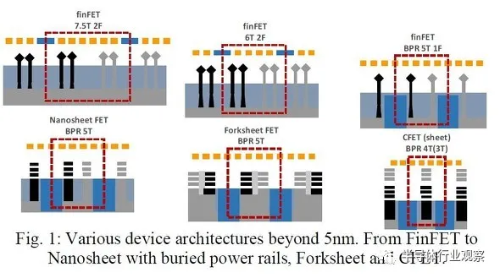
5納米世代以后的晶體管技術(shù)(斷面構(gòu)造圖)的選項(xiàng)。上面三個(gè)是FinFET,,下面自左開始為Nano-sheet FET,、Fork-sheet FET、 CFET,。
通過(guò)融合BPR和FinFET,,5T Fin的數(shù)量是每個(gè)晶體管一張,但是晶體管的性能有可能會(huì)下降,。于是,,通過(guò)將晶體管從FinFET改為Nano-sheet構(gòu)造和Fork-sheet構(gòu)造,與FinFET相比,,晶體管的性能得以提升,,同時(shí),晶體管的密度也易于提高了,。高度為5T的CMOS的基本單元有Fin FET,、Nano-sheet、Fork-sheet三個(gè)選項(xiàng),,且是混合存在的,。
但是,就4T以后的Low Profile而言,如果采用將p Chanel FET 和n Chanel FET放在硅表面的CMOS元件的話,,比較困難,。引進(jìn)將p Chanel FET 和n Chanel FET垂直堆疊在硅表面的CFET(Complementary FET),是業(yè)界所希望的,。
imec認(rèn)為,,可以通過(guò)導(dǎo)入CFET,使CMOS的基本單元的高度降低至4T或者3T,。比方說(shuō),,可以將與6T的2Fin型FinFET具有同樣功能的理論單元(AOI,AND-OR-INVERT )211 Cell和DFQD1 Cell( Flip Flop)布局為3T(是CFET的一半),。
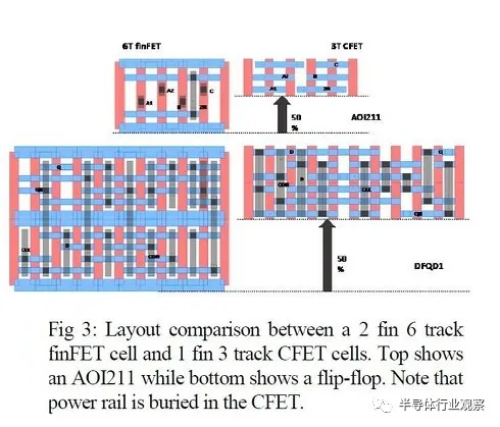
FinFET 的理論線路單元(6T),、CFET的理論線路單元(3T)。運(yùn)用CFET,,可以將理論線路單元的高度縮短為FinFET的一半,。
此外,就拿3納米世代的Arm 處理器來(lái)講,,與5T Nano-sheet構(gòu)造相比,,4T的CFET的核(Core)面積會(huì)減少13.3%。此外,,采用CFET,可以全部使最下層的金屬排線(M0)相互連接(Routing),,因此,,可以將與M0直接相交的第一層金屬排線(M1)分配為輸入、輸出的Pin或者相互連接等,。如果靈活運(yùn)用這一優(yōu)勢(shì),,優(yōu)化金屬排線工序(BEOL),預(yù)計(jì)可以進(jìn)一步將核(Core)的面積減少7%,。
總而言之,,在3nm之后,芯片產(chǎn)業(yè)將迎來(lái)巨大變革,!
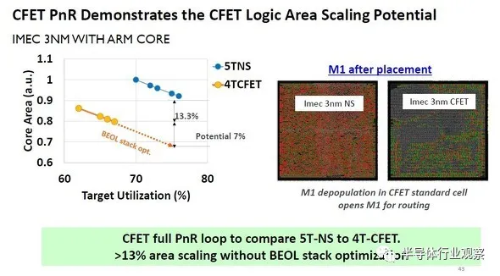
Arm 處理器核的硅面積比較值(相對(duì)值),。與5T的Nano-sheet構(gòu)造相比,4T的CFET的核(Core)的面積減少了13%(左邊),。此外,,CFET情況下,第一層金屬排線(M1)的Routing還有余地(右邊),,因此通過(guò)優(yōu)化金屬排線工藝(BEOL),,可以進(jìn)一步減少核(Core)的面積。


