如果有人跟你說:“嗨,我做的芯片實(shí)現(xiàn)了100%自主可控!”等等,你先不急著崇拜(相信)他,請看完此文再說…
首先,什么叫自主可控,最直觀的理解就是當(dāng)別人“卡脖子”的時(shí)候不會(huì)被卡住。集成電路產(chǎn)業(yè)通常被分為芯片設(shè)計(jì)、芯片制造、封裝測試三大領(lǐng)域,參看下圖:

我們逐一進(jìn)行分析,芯片設(shè)計(jì)主要從EDA、IP、設(shè)計(jì)三個(gè)方面來分析;芯片制造主要從設(shè)備、工藝和材料三個(gè)方面來分析;封裝測試則從封裝設(shè)計(jì)、產(chǎn)品封裝和芯片測試幾方面來分析。
01
芯 片 設(shè) 計(jì)
如何開始一款芯片設(shè)計(jì)呢?
首先要有工具(EDA),然后借助現(xiàn)有的資源(IP),加上自己的構(gòu)思和規(guī)劃就可以開始芯片設(shè)計(jì)了。這里,我們就從芯片設(shè)計(jì)工具EDA,知識(shí)產(chǎn)權(quán)IP,以及集成電路的設(shè)計(jì)流程來分析芯片設(shè)計(jì)。
1.1 EDA
EDA(Electronic Design Automation)電子設(shè)計(jì)自動(dòng)化,常指代用于電子設(shè)計(jì)的軟件。
曾經(jīng)有人跟我說:“EDA有啥呀,不就是個(gè)工具嘛?”是啊,確實(shí)就是個(gè)工具,可是沒這個(gè)工具,你啥也設(shè)計(jì)不了啊!
現(xiàn)在的大規(guī)模集成電路在芝麻粒大小的1平方毫米內(nèi)可以集成1億只以上的晶體管,這些晶體管之間的連接網(wǎng)絡(luò)更是多達(dá)數(shù)億個(gè)。當(dāng)今主流的SoC芯片,其晶體管數(shù)量已經(jīng)超過百億量級。如果沒有精準(zhǔn)的,功能強(qiáng)大的EDA工具,怎么設(shè)計(jì)呢?
EDA是芯片設(shè)計(jì)的必備工具,目前,Synopsys、Cadence和Mentor(Siemens EDA)占據(jù)著超過90%以上的市場份額。在10納米以下的高端芯片設(shè)計(jì)上,其占有率甚至高達(dá)100%。也就是說,現(xiàn)在研發(fā)一款10nm以下的芯片,沒有以上三家的EDA工具幾乎是不可能實(shí)現(xiàn)的。
下表所示是目前芯片設(shè)計(jì)中主流的EDA工具:
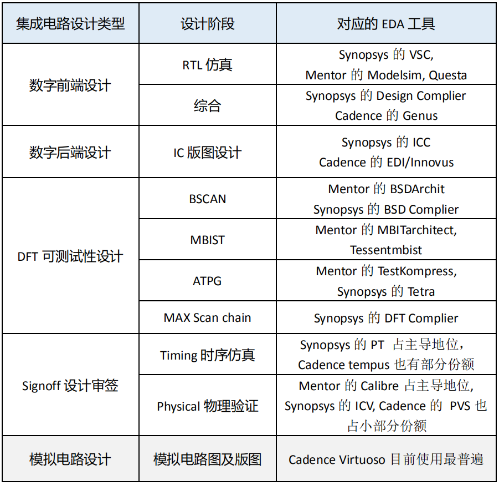
芯片設(shè)計(jì)分為設(shè)計(jì)、仿真、驗(yàn)證等環(huán)節(jié),對應(yīng)的EDA工具分為設(shè)計(jì)工具、仿真工具、驗(yàn)證工具等。設(shè)計(jì)工具解決的是模型的構(gòu)建,也就是從0到1(從無到有)的問題,仿真和驗(yàn)證工具解決模型的確認(rèn),也就是1是1還是0.9或者1.1的問題。因此,從EDA開發(fā)的角度,設(shè)計(jì)工具的開發(fā)難度更大。此外,設(shè)計(jì)規(guī)模越大,工藝節(jié)點(diǎn)要求越高,EDA工具的開發(fā)難度也越大。國產(chǎn)EDA工具目前在一些仿真驗(yàn)證點(diǎn)工具上取得一些成績,在模擬電路設(shè)計(jì)方面也初步具備了全流程工具,但在大規(guī)模集成電路設(shè)計(jì)上和三大廠商還有很大的差距,尤其在高端數(shù)字芯片設(shè)計(jì)流程上基本還是空白。
1.2 IP
IP(Intelligent Property)代表著知識(shí)產(chǎn)權(quán)的意思,在業(yè)界是指一種事先定義、經(jīng)過驗(yàn)證的、可以重復(fù)使用,能完成特定功能的模塊,IP是構(gòu)成大規(guī)模集成電路的基礎(chǔ)單元,SoC甚至可以說是基于IP核的復(fù)用技術(shù)。IP一般分為硬核、軟核和固核。IP硬核一般已經(jīng)映射到特定工藝,經(jīng)過芯片制造驗(yàn)證,具有面積和性能可預(yù)測的特點(diǎn),但靈活性較小;IP軟核以HDL形式提交,靈活性強(qiáng),但性能方面具有不可預(yù)測性;IP固核通過布局布線或利用通用工藝庫,對性能和面積進(jìn)行了優(yōu)化,比硬核靈活,比軟核在性能和面積上更可預(yù)測,是硬核和軟核的折中。
下表為目前全球前10大IP提供商,可以看到中國有兩家入圍前十,但是兩家市場份額加起來也僅有3%,而ARM一家就占據(jù)了40%以上的市場份額,美國的企業(yè)則占據(jù)了30%的市場份額,如果ARM被英偉達(dá)收購,基本上IP市場就是美國的天下了。此外我們也發(fā)現(xiàn),全球最大的兩家EDA公司Synopsys和Cadence,在IP領(lǐng)域也同樣占據(jù)的第二、第三的位置。

下圖所示為IP的種類,其中處理器占51%,接口IP占22.1%,數(shù)字類占8.1%,其他占18.8%,處理器類ARM一家獨(dú)大,在接口類IP中,Synopsys是業(yè)界領(lǐng)導(dǎo)者。

我們需要考慮的是,在設(shè)計(jì)的芯片中那些IP是自主設(shè)計(jì)的,那些是外購的,這些外購的IP是否存在不可控因素?如果你設(shè)計(jì)的SoC僅僅是把別人的IP打包整合,那自主可控性就要大打折扣了。
下面,我們以華為麒麟980為例,了解一下芯片研發(fā)中的IP使用情況。
麒麟980芯片集成的主要部件有CPU、GPU(俗稱顯卡)、ISP(處理拍照數(shù)據(jù))、NPU(人工智能引擎)和基帶(負(fù)責(zé)通信)。
根據(jù)華為官方資料,ISP是華為自研,NPU是華為和寒武紀(jì)合作的成果,至于CPU(Cortex-A76)和GPU(Mali-G76)則是華為向ARM公司購買的授權(quán),包括指令集授權(quán)和內(nèi)核授權(quán)。
如果沒有IP授權(quán),還有沒有可能自研麒麟980芯片,目前看來,沒有 。
1.3 設(shè)計(jì)流程
芯片設(shè)計(jì)流程通常可分為:數(shù)字IC設(shè)計(jì)流程和模擬IC設(shè)計(jì)流程。
數(shù)字IC設(shè)計(jì)流程:芯片定義 → 邏輯設(shè)計(jì) → 邏輯綜合 → 物理設(shè)計(jì) → 物理驗(yàn)證 → 版圖交付。
芯片定義(Specification)是指根據(jù)需求制定芯片的功能和性能指標(biāo),完成設(shè)計(jì)規(guī)格文檔。
邏輯設(shè)計(jì)(Logic Design)是指基于硬件描述語言在RTL(Register-Transfer Level)級實(shí)現(xiàn)邏輯設(shè)計(jì),并通過邏輯驗(yàn)證或者形式驗(yàn)證等驗(yàn)證功能正確。
邏輯綜合(Logic Synthesis)是指將RTL轉(zhuǎn)換成特定目標(biāo)的門級網(wǎng)表,并優(yōu)化網(wǎng)表延時(shí)、面積和功耗。
物理設(shè)計(jì)(Physical Design)是指將門級網(wǎng)表根據(jù)約束布局、布線并最終生成版圖的過程,其中又包含:數(shù)據(jù)導(dǎo)入 → 布局規(guī)劃 → 單元布局 → 時(shí)鐘樹綜合 → 布線。
數(shù)據(jù)導(dǎo)入是指導(dǎo)入綜合后的網(wǎng)表和時(shí)序約束的腳本文件,以及代工廠提供的庫文件。
布局規(guī)劃是指在芯片上規(guī)劃輸入/輸出單元,宏單元及其他主要模塊位置的過程。
單元布局是根據(jù)網(wǎng)表和時(shí)序約束自動(dòng)放置標(biāo)準(zhǔn)單元的過程。
時(shí)鐘樹綜合是指插入時(shí)鐘緩沖器,生成時(shí)鐘網(wǎng)絡(luò),最小化時(shí)鐘延遲和偏差的過程。
布線是指在滿足布線層數(shù)限制,線寬、線間距等約束條件下,根據(jù)電路關(guān)系自動(dòng)連接各個(gè)單元的過程。
物理驗(yàn)證(Physical Verificaiton)通常包括版圖設(shè)計(jì)規(guī)則檢查(DRC),版圖原理圖一致性檢查(LVS)和電氣規(guī)則檢查(ERC)等。
版圖交付(Tape Out)是在所有檢查和驗(yàn)證都正確無誤的前提下,傳遞版圖文件給代工廠生成掩膜圖形,并生產(chǎn)芯片。
模擬IC設(shè)計(jì)流程:芯片定義 → 電路設(shè)計(jì) → 版圖設(shè)計(jì) → 版圖驗(yàn)證 → 版圖交付。
其中芯片定義和版圖交付和數(shù)字電路相同,模擬IC在電路設(shè)計(jì)、版圖設(shè)計(jì)、版圖驗(yàn)證和數(shù)字電路有所不同。
模擬電路設(shè)計(jì)是指根據(jù)系統(tǒng)需求,設(shè)計(jì)晶體管級的模擬電路結(jié)構(gòu),并采用SPICE等仿真工具驗(yàn)證電路的功能和性能。
模擬版圖設(shè)計(jì)是按照設(shè)計(jì)規(guī)則,繪制電路圖對應(yīng)的版圖幾何圖形,并仿真版圖的功能和性能。
模擬版圖驗(yàn)證是驗(yàn)證版圖的工藝規(guī)則、電氣規(guī)則以及版圖電路圖一致性檢查等。
這里,我們做一個(gè)簡單的總結(jié):
芯片設(shè)計(jì):就是在EDA工具的支持下,通過購買IP授權(quán)+自主研發(fā)(合作開發(fā))的IP,并遵循嚴(yán)格的集成電路設(shè)計(jì)仿真驗(yàn)證流程,完成芯片設(shè)計(jì)的整個(gè)過程。在這個(gè)過程中,EDA、IP、嚴(yán)格的設(shè)計(jì)流程三者缺一不可。
目前看來,在這三要素中最先可能實(shí)現(xiàn)自主可控的就是設(shè)計(jì)流程了。
下表列出了當(dāng)前世界前10的芯片設(shè)計(jì)公司,供大家參考。

02
芯 片 制 造
芯片制造目前是集成電路產(chǎn)業(yè)門檻最高的行業(yè),怎么看待門檻的高低呢,投資越高、玩家越少就表明門檻越高,目前在高端芯片的制造上也僅剩下臺(tái)積電(TSMC)、三星(SAMSUNG)和英特爾(Intel)三家了。下面,我們分別從設(shè)備、工藝和材料三個(gè)方面來分析芯片制造,尋找我們和先進(jìn)制造技術(shù)的差距。
2.1 設(shè)備
芯片制造需要經(jīng)過兩千多道工藝制程才能完成,每個(gè)步驟都要依賴特定設(shè)備才能實(shí)現(xiàn)。
芯片制造中,有三大關(guān)鍵工序:光刻、刻蝕、沉積。三大工序在生產(chǎn)過程中不斷重復(fù)循環(huán),最終制造出合格的芯片。
三大關(guān)鍵工序要用到三種關(guān)鍵設(shè)備,分別是光刻機(jī)、刻蝕機(jī)、薄膜沉積設(shè)備。三大設(shè)備占所有設(shè)備投入的22%、22%、20%左右,是三種占比最高的半導(dǎo)體設(shè)備。

下面就以最為典型的光刻機(jī)和刻蝕機(jī)為例進(jìn)行介紹并分析自主可控。
光刻機(jī)
光刻機(jī)的原理其實(shí)像幻燈機(jī)一樣,就是把光通過帶電路圖的掩膜(也叫光罩)Mask投影到涂有光刻膠的晶圓上。60年代末,日本尼康和佳能開始進(jìn)入這個(gè)領(lǐng)域,當(dāng)時(shí)的光刻機(jī)并不比照相機(jī)復(fù)雜多少。
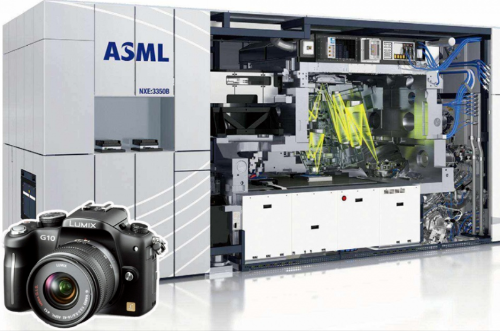
為了實(shí)現(xiàn)摩爾定律,光刻技術(shù)需要每兩年把曝光關(guān)鍵尺寸(CD)降低30%-50%。需要不斷降低光刻機(jī)的波長λ。然而,波長被卡在193nm無法進(jìn)步長達(dá)20年。后來通過工程上最簡單的方法解決,在晶圓光刻膠上方加1mm厚的水,把193nm的波長折射成134nm,稱為浸入式光刻。
浸入式光刻成功翻越了157nm大關(guān),加上后來不斷改進(jìn)的鏡頭、多光罩、Pitch-split、波段靈敏光刻膠等技術(shù),浸入式193nm光刻機(jī)一直可以做到今天的7nm芯片(蘋果A12和華為麒麟980)。
EVU光刻機(jī)
EUV極紫外光刻(Extreme Ultra-Violet)是一種使用極紫外(EUV)波長的新一代光刻技術(shù),其波長為13.5納米。由于光刻精度是幾納米,EUV對光的集中度要求極高,相當(dāng)于拿個(gè)手電照到月球光斑不超過一枚硬幣。反射的鏡子要求長30cm起伏不到0.3nm,相當(dāng)于北京到上海的鐵軌起伏不超過1毫米。一臺(tái)EUV光刻機(jī)重達(dá)180噸,超過10萬個(gè)零件,需要40個(gè)集裝箱運(yùn)輸,安裝調(diào)試要超過一年時(shí)間。
2000年時(shí),日本尼康還是光刻機(jī)領(lǐng)域的老大,到了2009年ASML已經(jīng)遙遙領(lǐng)先,市場占有率近7成。目前,最先進(jìn)的光刻機(jī)也只有ASML一家可以提供了。
國內(nèi)的情況,上海微電子(SMEE)已經(jīng)有分辨率為90nm的光刻機(jī),新的光刻機(jī)也在研制中。

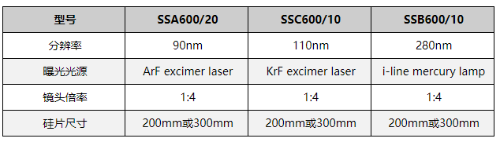
在集成電路制造中,光刻只是其中的一個(gè)環(huán)節(jié),另外還有無數(shù)先進(jìn)科技用于前后道工藝中。
刻蝕機(jī)
刻蝕是將晶圓表面不必要的材質(zhì)去除的過程。刻蝕工藝位于光刻之后。
光刻機(jī)用光將掩膜上的電路結(jié)構(gòu)復(fù)制到硅片上,刻蝕機(jī)把復(fù)制到硅片上的電路結(jié)構(gòu)進(jìn)行微雕,雕刻出溝槽和接觸點(diǎn),讓線路能夠放進(jìn)去。
按照刻蝕工藝分為干法刻蝕以及濕法刻蝕,干法刻蝕主要利用反應(yīng)氣體與等離子體進(jìn)行刻蝕,濕法刻蝕工藝主要是將刻蝕材料浸泡在腐蝕液內(nèi)進(jìn)行刻蝕。
干法刻蝕在半導(dǎo)體刻蝕中占據(jù)主流,市場占比達(dá)到95%,其最大優(yōu)勢在于能夠?qū)崿F(xiàn)各向異性刻蝕,即刻蝕時(shí)可控制僅垂直方向的材料被刻蝕,而不影響橫向材料,從而保證細(xì)小圖形保真性。濕法刻蝕由于刻蝕方向的不可控性,在先進(jìn)制程很容易降低線寬,甚至破壞線路本身,導(dǎo)致芯片品質(zhì)變差。
目前普遍采用多重模板工藝原理,即通過多次沉積、刻蝕工藝實(shí)現(xiàn)需要的特征尺寸,例如14nm制程所需使用的刻蝕步驟達(dá)到64次,較 28nm提升60%;7nm制程所需刻蝕步驟更是高達(dá)140次,較14nm提升118%。
下圖所示為多次刻蝕原理。

和光刻機(jī)一樣,刻蝕機(jī)的廠商也相對較少,代表企業(yè)主要是美國的 Lam Research(泛林半導(dǎo)體)、AMAT(應(yīng)用材料)、日本的TEL(東京電子)等企業(yè)。這三家企業(yè)占據(jù)全球半導(dǎo)體刻蝕機(jī)的94%的市場份額,而其他參與者合計(jì)僅占6%。其中,Lam Research 占比高達(dá)55%,為行業(yè)龍頭,東京電子與應(yīng)用材料分別占比20%和19%。
國內(nèi)的情況,目前刻蝕設(shè)備代表公司為中微公司、北方華創(chuàng)等。中微公司較為領(lǐng)先,工藝節(jié)點(diǎn)已經(jīng)達(dá)到5nm。在全球前十大晶圓企業(yè)中,中微公司已經(jīng)進(jìn)入其中六家,作為臺(tái)積電的合作伙伴協(xié)同驗(yàn)證14nm/7nm/5nm等先進(jìn)工藝。

基于此,如果目前在光刻機(jī)領(lǐng)域我們還無力做出改變,那么已經(jīng)有一定優(yōu)勢的刻蝕機(jī)勢必會(huì)成為國產(chǎn)替代的先鋒。
2.2 工藝制程
芯片制造過程需要兩千多道工藝制程,下面,我們按照8大步驟對芯片制造工藝進(jìn)行簡單介紹。
1. 光刻(光學(xué)顯影)
光刻是經(jīng)過曝光和顯影程序,把光罩上的圖形轉(zhuǎn)換到光刻膠下面的晶圓上。光刻主要包含感光膠涂布、烘烤、光罩對準(zhǔn)、 曝光和顯影等程序。曝光方式包括:紫外線、極紫外光、X射線、電子束等。
2. 刻蝕(蝕刻)
刻蝕是將材料使用化學(xué)反應(yīng)或物理撞擊作用而移除的技術(shù)。干刻蝕(dry etching)利用等離子體撞擊晶片表面所產(chǎn)生的物理作用,或等離子體與晶片表面原子間的化學(xué)反應(yīng),或者兩者的復(fù)合作用。濕刻蝕(wet etching)使用的是化學(xué)溶液,經(jīng)過化學(xué)反應(yīng)達(dá)到刻蝕的目的。
3. 化學(xué)氣相沉積(CVD)
CVD利用熱能、放電或紫外光照射等化學(xué)反應(yīng)的方式,將反應(yīng)物在晶圓表面沉積形成穩(wěn)定固態(tài)薄膜(film)的一種沉積技術(shù)。CVD技術(shù)在芯片制程中運(yùn)用極為廣泛,如介電材料(dielectrics)、導(dǎo)體或半導(dǎo)體等材料都能用CVD技術(shù)完成。
4. 物理氣相沉積(PVD)
PVD是物理制程而非化學(xué)制程,一般使用氬等氣體,在真空中將氬離子加速以撞擊濺鍍靶材后,可將靶材原子一個(gè)個(gè)濺擊出來,并使被濺擊出來的材質(zhì)如雪片般沉積在晶圓表面。
5. 離子植入(Ion Implant)
離子植入可將摻雜物以離子型態(tài)植入半導(dǎo)體組件的特定區(qū)域上,以獲得精確的電特性。離子先被加速至足夠能量與速度,以穿透(植入)薄膜,到達(dá)預(yù)定的植入深度。離子植入可對植入?yún)^(qū)內(nèi)的摻質(zhì)濃度加以精密控制。
6. 化學(xué)機(jī)械研磨(CMP)
化學(xué)機(jī)械研磨技術(shù)具有研磨性物質(zhì)的機(jī)械式研磨與酸堿溶液的化學(xué)式研磨兩種作用,可以使晶圓表面達(dá)到全面性的平坦化,以利后續(xù)薄膜沉積。
7. 清洗
清洗的目的是去除金屬雜質(zhì)、有機(jī)物污染、微塵與自然氧化物;降低表面粗糙度;幾乎所有制程前后都需要清洗。
8. 晶片切割(Die Saw)
晶片切割是將加工完成的晶圓上一顆顆晶粒裸芯片(die)切割分離,便于后續(xù)封裝測試。
雖然不同的Foundry廠的流程大致相同,但不同的工藝控制能力造就了各廠家在先進(jìn)制程上的區(qū)別,隨著制程進(jìn)入5nm,能夠量產(chǎn)的芯片制造商就屈指可數(shù)了,目前能夠量產(chǎn)5nm芯片的只有TSMC和SAMSUNG。兩千多道工藝制程中隱藏著Foundry的無窮的智慧和雄厚的財(cái)力,并不是說有了先進(jìn)的設(shè)備,就能造出合格的芯片。雖然先進(jìn)制程是技術(shù)發(fā)展的方向,我們也不能忽視成熟制程。成熟制程依然有很大市場份額。下圖是按成熟制程(節(jié)點(diǎn)≥40nm)產(chǎn)能排序的全球晶圓代工廠商Top榜單。

可以看出,成熟制程產(chǎn)能排名前四的廠商分別為:臺(tái)積電(市占率28%),聯(lián)電(13%),中芯國際(11%),三星(10%)。成熟制程在2020年非常火爆,產(chǎn)能嚴(yán)重短缺,這給各大晶圓代工廠帶來了巨大的商機(jī)。而從2021年的產(chǎn)業(yè)發(fā)展形勢來看,這種短缺狀況在近期內(nèi)還難以緩解。
2.3 材料
生產(chǎn)集成電路的材料有成千上萬種,我們就以最為典型的硅晶圓和光刻膠進(jìn)行分析。
硅晶圓
硅晶圓是集成電路行業(yè)的糧食,是最主要最基礎(chǔ)的集成電路材料,90%以上的芯片在硅晶圓上制造,目前300mm硅晶圓是芯片制造的主流材料,使用比例超過70%。曾經(jīng),我國300mm半導(dǎo)體硅片100%依賴進(jìn)口,是我國集成電路產(chǎn)業(yè)鏈建設(shè)與發(fā)展的主要瓶頸。
全球主要的半導(dǎo)體硅晶圓供應(yīng)商包括日本信越化學(xué)(Shin-Estu)、日本盛高(SUMCO)、德國Siltronic、韓國SK Siltron以及中國臺(tái)灣的環(huán)球晶圓、合晶科技等公司。五大晶圓供貨商的全球市占率達(dá)到了92%,其中日本信越化學(xué)占27%,日本盛高占26%,臺(tái)灣環(huán)球晶圓占17%,德國Silitronic占13%,韓國SK Siltron占9%。
下表列出了全球10大硅晶圓提供商,供參考。

國內(nèi)的情況,中國大陸半導(dǎo)體硅晶圓銷售額年均復(fù)合增長率達(dá)到41.17%,遠(yuǎn)高于同期全球半導(dǎo)體硅片市場的25.75%。但這塊市場并沒有掌握在本土廠商手中,在打造國產(chǎn)化產(chǎn)業(yè)鏈的今天,還有很大的空間供國內(nèi)晶圓制造商去發(fā)展。
光刻膠
光刻膠是光刻過程最重要的耗材,光刻膠的質(zhì)量對光刻工藝有著重要影響。光刻膠可分為半導(dǎo)體光刻膠、面板光刻膠和PCB光刻膠。其中,半導(dǎo)體光刻膠的技術(shù)壁壘最高。
目前全球光刻膠主要企業(yè)有日本合成橡膠(JSR)、東京應(yīng)化(TOK)、信越化學(xué)(ShinEtsu)、富士電子(FUJI)、美國羅門哈斯(Rohm&Hass)等,市場集中度非常高,所占市場份額超過85%。
下圖顯示的是光刻膠企業(yè)的市場占有率。

高分辨率的半導(dǎo)體光刻膠是半導(dǎo)體化學(xué)品中技術(shù)壁壘最高的材料,日美企業(yè)技術(shù)領(lǐng)先國內(nèi)企業(yè)二十年至三十年。從光刻膠技術(shù)水平來看,國內(nèi)企業(yè)在缺乏經(jīng)驗(yàn)、缺乏專業(yè)技術(shù)人才、缺失關(guān)鍵上游原材料和設(shè)備的條件下,探索出一條自主研發(fā)之路,光刻膠高端技術(shù)短期內(nèi)尚難突破,還要很長的路要走。在PCB領(lǐng)域,國產(chǎn)光刻膠具備了一定的量產(chǎn)能力,已經(jīng)實(shí)現(xiàn)對主流廠商供貨。
03
封 裝 測 試
封裝測試是集成電路三大產(chǎn)業(yè)中的最后一個(gè)環(huán)節(jié)。一般認(rèn)為封裝測試的技術(shù)含量和實(shí)現(xiàn)難度比前兩者低,但是隨著SiP及先進(jìn)封裝技術(shù)的出現(xiàn)和迅速發(fā)展,需要重新定義芯片的封裝和測試。
SiP及先進(jìn)封裝在封裝原來的三個(gè)特點(diǎn):芯片保護(hù)、尺度放大、電氣連接的基礎(chǔ)上,增加了三個(gè)新特點(diǎn):提升功能密度、縮短互聯(lián)長度、進(jìn)行系統(tǒng)重構(gòu),因此其復(fù)雜程度和實(shí)現(xiàn)難度與傳統(tǒng)的封裝相比有很大程度的提升。
同時(shí),SiP及先進(jìn)封裝也給封裝測試提出了新的機(jī)遇和挑戰(zhàn)。
3.1 芯片封裝
我們從封裝設(shè)計(jì)和產(chǎn)品封裝兩方面來分析芯片封裝。
1)封裝設(shè)計(jì)
早先的封裝中沒有集成(Integration)的概念,封裝設(shè)計(jì)是比較簡單的,對工具要求也很低,Auto CAD就是常用的封裝設(shè)計(jì)工具,隨著MCM、SiP技術(shù)的出現(xiàn),封裝設(shè)計(jì)變得越來越復(fù)雜,加上目前SiP、先進(jìn)封裝、Chiplet、異構(gòu)集成概念的市場接受度越來越高,封裝內(nèi)集成的復(fù)雜度和靈活度急劇上升,對封裝設(shè)計(jì)的要求也越來越高,
SiP和先進(jìn)封裝設(shè)計(jì)工具目前只有Cadence和 Siemens EDA(Mentor)兩家,Cadence是老牌的封裝設(shè)計(jì)EDA提供商,市場占有率高,用戶的忠誠度也比較高。
Siemens EDA(Mentor)是封裝設(shè)計(jì)領(lǐng)域的后起之秀,但其技術(shù)先進(jìn)性上則體現(xiàn)了“后浪”的特點(diǎn)。業(yè)界大佬TSMC, Intel, SAMSUNG紛紛選擇Siemens EDA作為其先進(jìn)封裝(HDAP)的首選工具,主要在于兩點(diǎn):先進(jìn)的設(shè)計(jì)工具和強(qiáng)悍的驗(yàn)證工具。
首先我們說說設(shè)計(jì)工具,在一次技術(shù)論壇中,我說:“不同于傳統(tǒng)封裝設(shè)計(jì),先進(jìn)封裝和SiP設(shè)計(jì)對3D環(huán)境要求很高,3D設(shè)計(jì)環(huán)境不在于是否看上去很直觀、絢麗,而在于對客觀元素的精準(zhǔn)描述,包括鍵合線、腔體、芯片堆疊、硅轉(zhuǎn)接板、2.5D集成、3D集成,Bump…”
在這一點(diǎn)上,Siemens EDA的SiP及先進(jìn)封裝設(shè)計(jì)工具已經(jīng)遠(yuǎn)遠(yuǎn)將其競爭對手拋在身后。下圖為先進(jìn)封裝版圖設(shè)計(jì)工具XPD中的封裝設(shè)計(jì)3D截圖,4組芯片堆疊中,每組5顆芯片(4HBM+1Logic)以3D TSV連接在一起,和GPU一起集成在硅轉(zhuǎn)接板(2.5D TSV)上,硅轉(zhuǎn)接板和電阻、電容等一起集成在封裝基板上。
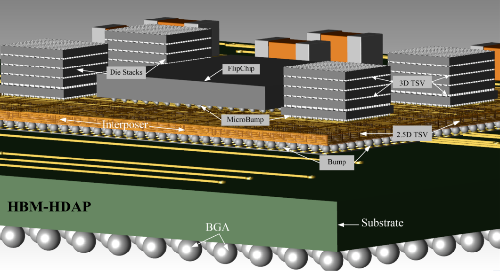
XPD中的先進(jìn)封裝設(shè)計(jì)截圖(3D)
該設(shè)計(jì)中包含了3D集成、2.5D集成、倒裝焊、Bump、多基板集成等多種方式,在XPD設(shè)計(jì)環(huán)境中得到了精準(zhǔn)的實(shí)現(xiàn)。
先進(jìn)封裝驗(yàn)證工具包括電氣驗(yàn)證和物理驗(yàn)證,電氣驗(yàn)證包含80多條規(guī)則,對整個(gè)系統(tǒng)進(jìn)行信號(hào)完整性、電源完整性、EMI\EMC等電氣相關(guān)的檢查和驗(yàn)證,物理驗(yàn)證則是基于IC驗(yàn)證工具Calibre,整合出Calibre 3D STACK,專門用于3D先進(jìn)封裝的物理驗(yàn)證。
隨著封裝內(nèi)的集成度、設(shè)計(jì)復(fù)雜度越來越高,對工具的要求也越來越高,另外,在先進(jìn)封裝領(lǐng)域,封裝設(shè)計(jì)和芯片設(shè)計(jì)的協(xié)同度日益提高,在某種程度上有逐漸融合的趨勢,因此對協(xié)同設(shè)計(jì)的要求也日益提升。
關(guān)于SiP、微系統(tǒng)、先進(jìn)封裝的詳細(xì)設(shè)計(jì)方法和實(shí)際案例,可參考電子工業(yè)出版社近期即將出版的新書:《基于SiP技術(shù)的微系統(tǒng)》
2)產(chǎn)品封裝
根據(jù)材料和工藝不同,封裝可以分為塑料封裝、陶瓷封裝和金屬封裝三種類型。
塑封主要基于有機(jī)基板,多應(yīng)用于商業(yè)級產(chǎn)品,體積小、重量輕、價(jià)格便宜,具有大批量、低成本優(yōu)勢,但在芯片散熱、穩(wěn)定性、氣密性方面相對較差。
陶瓷封裝和金屬封裝則主要基于陶瓷基板,陶瓷封裝一般采用HTCC基板,金屬封裝則多采用LTCC基板,對于大功耗產(chǎn)品,散熱要求高,可選用氮化鋁基板。
陶瓷封裝特點(diǎn)包括:密封性好,散熱性能良好,對極限溫度的抵抗性好,容易拆解,便于問題分析;和金屬封裝相比體積相對小,適合大規(guī)模復(fù)雜芯片,適合航空航天等對氣密性有要求的嚴(yán)苛環(huán)境應(yīng)用;但價(jià)格昂貴,生產(chǎn)周期長,重量和體積都比同類塑封產(chǎn)品大。
金屬封裝特點(diǎn)包括:密封性好,散熱性能良好,容易拆解,靈活性高;但體積相對較大,引腳數(shù)量較少,不適合復(fù)雜芯片,價(jià)格貴,生產(chǎn)周期長,需要組裝金屬外殼和基板,工序復(fù)雜,多應(yīng)用于MCM設(shè)計(jì),航空航天領(lǐng)域應(yīng)用較為普遍。
陶瓷封裝和金屬封裝內(nèi)部均為空腔結(jié)構(gòu),具有可拆解的優(yōu)勢,便于故障查找和問題“歸零”, 因此受到航空航天等領(lǐng)域用戶的歡迎。
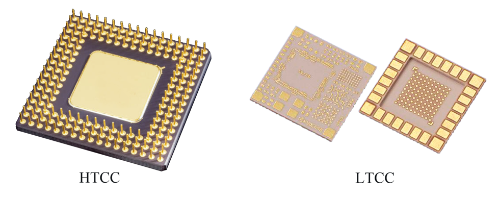
3.2 芯片測試
芯片測試的項(xiàng)目非常多,這里我們重點(diǎn)了解一下機(jī)臺(tái)測試的系統(tǒng)測試。
機(jī)臺(tái)測試
一般是指采用ATE(Automatic Test Equipment)自動(dòng)測試設(shè)備來進(jìn)行芯片測試,測試芯片的基本功能和相應(yīng)的電參數(shù)。機(jī)臺(tái)可以提供待測器件DUT(Device Under Test)所需的電源、不同周期和時(shí)序的波形、驅(qū)動(dòng)電平等。測試向量(Test Vector)是每個(gè)時(shí)鐘周期應(yīng)用于器件管腳的用于測試的邏輯1和邏輯0數(shù)據(jù),是由帶定時(shí)特性和電平特性的波形代表,與波形形狀、脈沖寬度、脈沖邊緣或斜率以及上升沿和下降沿的位置都有關(guān)系。
測試向量可基于EDA工具的仿真向量(包含輸入信號(hào)和期望的輸出),經(jīng)過優(yōu)化和轉(zhuǎn)換,形成ATE格式的測試向量。利用EDA工具建立器件模型,通過建立一個(gè)Testbench仿真驗(yàn)證平臺(tái),對其提供測試激勵(lì),進(jìn)行仿真,驗(yàn)證結(jié)果,將輸入激勵(lì)和輸出響應(yīng)存儲(chǔ),按照ATE向量格式,生成ATE向量文件。

系統(tǒng)測試
系統(tǒng)測試也稱為板級系統(tǒng)測試,是指模擬芯片真實(shí)的工作環(huán)境,對芯片進(jìn)行各種操作,確認(rèn)其功能和性能是否正常。除了機(jī)臺(tái)測試和系統(tǒng)測試之外,還需要對芯片進(jìn)行了一系列的試驗(yàn)和考核,內(nèi)容包括:熱沖擊、溫度循環(huán)、機(jī)械沖擊、掃頻震動(dòng)、恒定加速度、鍵合強(qiáng)度、芯片剪切強(qiáng)度、穩(wěn)態(tài)壽命、密封、內(nèi)部水汽含量、耐濕氣等試驗(yàn)。只有所有的測試都順利通過了,一顆芯片才能算成功,作為合格的產(chǎn)品應(yīng)用到下一個(gè)環(huán)節(jié)。
自主可控總結(jié)
最后,結(jié)合下面表格,我們對自主可控作一個(gè)簡單總結(jié)。

從表格可以看出,我們在IC設(shè)計(jì)流程、封裝(SiP)設(shè)計(jì),以及在產(chǎn)品封裝、芯片測試環(huán)節(jié)的自主可控程度比較高;在刻蝕機(jī)、芯片工藝制程上有一定的自主可控性,而在EDA,IP,光刻機(jī),硅晶元,光刻膠等環(huán)節(jié)自主可控的程度非常低,所以高端芯片很容易被“卡脖子”,因?yàn)楦叨诵酒玫降腅DA,IP,光刻機(jī),硅晶元,光刻膠幾乎全部依賴進(jìn)口。
自主可控相對較高的IC設(shè)計(jì)流程、封裝(SiP)設(shè)計(jì)也幾乎全部依賴進(jìn)口的EDA工具,在產(chǎn)品封裝和芯片測試環(huán)節(jié),封裝設(shè)備和測試設(shè)備大約80%以上是進(jìn)口設(shè)備;工藝制程上高端芯片同樣也無法自主生產(chǎn)。考慮到這些,不由得讓我們無法盲目樂觀,因?yàn)樵酵搭^挖掘,自主可控的比例就越低。
當(dāng)別人不卡脖子的時(shí)候,不要趾高氣揚(yáng),似乎一切盡在掌控;當(dāng)別人卡脖子的時(shí)候,不要突然發(fā)現(xiàn),竟然全身上下都是脖子!
看完此文,如果以后有人告訴你,他做的芯片實(shí)現(xiàn)了100%的自主可控,我們就可以從上面的環(huán)節(jié)逐個(gè)去分析,一顆芯片從最初的構(gòu)思到最終的產(chǎn)品,所經(jīng)歷的過程中,那些環(huán)節(jié)真正是自主可控的?那些環(huán)節(jié)依然是要被卡脖子的?
只有真正認(rèn)識(shí)到自身的不足,實(shí)事求是,踏踏實(shí)實(shí),一步一個(gè)腳印,并持之以恒,才能在激烈的競爭中不致落后,從而減少卡脖子事件的發(fā)生!
另外,即使世界出現(xiàn)了諸多不和諧,甚至在某些方面矛盾有激化的可能,但從長遠(yuǎn)來看,合作依然是人類文明的主流,我們依然要向著這個(gè)方向去看,去努力奮斗!

