京工業(yè)大學(xué)科學(xué)技術(shù)創(chuàng)成研究院特種功能集成研究小組的特聘教授 -- 大場隆之教授于 2020 年 6 月宣布,研發(fā)了不會損傷超薄晶圓、晶圓切片留白(Dicing Street)寬度縮小至原來四分之一的激光切片加工技術(shù)。
根據(jù)日媒 Eetimes.jp 報道,此次新技術(shù)是以東京工業(yè)大學(xué)為主導(dǎo),與研究小組“WOW 聯(lián)盟”(由從事半導(dǎo)體元件設(shè)計、相關(guān)生產(chǎn)設(shè)備、材料的企業(yè)組成)合作研發(fā)的。
圍繞半導(dǎo)體元件的高性能、低功耗技術(shù)研發(fā)在不斷推進(jìn)。比方說,晶圓厚度做到微米級別,運(yùn)用 TSV(Through-Silicon-Via)排線技術(shù)做到三維壓層等。
為了實現(xiàn)三維壓層,切割薄膜晶圓時,需要消除晶圓邊上的裂紋(Chippping)、且縮小切片留白(Dicing Street)的寬度。其中,被稱為隱形切割(Stealth Dicing, SD)的激光切割技術(shù)頗受關(guān)注。
研發(fā)小組在此次研發(fā)中著重致力于薄膜晶圓切割工程中的“晶圓損傷程度與發(fā)生位置的定量分析”、“削減切片留白(Dicing Street)”。
在實驗中,實驗小組制作了線寬、線距分別為 1um 的 TEG(Test Element Group)檢測晶圓。此款用于測試的芯片的 A1 和 Ti 的成膜厚度分別為 30nm。此外,為了檢出晶圓的損害位置,在激光加工區(qū)域(即 Dicing Street 區(qū)域)平行地設(shè)計了間距為 1um 的“監(jiān)測線路”。在切片后,計算了各個監(jiān)測線路的阻值變化率,并評價了激光加工引起的損害。

左上為 TEG 晶圓,左下為排線結(jié)構(gòu)、中間為排線的擴(kuò)大圖,右邊為排線的斷面構(gòu)造圖 (圖片出自:東京工業(yè)大學(xué))
實驗中,使用了 TEG 晶圓,模擬“SDBG(Stealth Dicing Before Grinding)”工藝,使用波長為 1099nm 和 1342nm 的激光進(jìn)行加工,評價了對厚度為 50um 的晶圓的損害程度。
實驗表明,用波長為 1099nm 的激光進(jìn)行加工后,排線的阻值沒有增加,沒有對晶圓造成損害。與之相對,用波長為 1342nm 的激光進(jìn)行加工后,作業(yè)中心附近的排線阻值大幅度增加,且晶圓的加工中心附近被破壞。

左圖:用波長為 1342nm 的激光切割后的排線阻值,右圖:用波長為 1099nm 的激光切割后的排線阻值 (圖片出自:東京工業(yè)大學(xué))
同時也比較了用 SD 方法進(jìn)行切割后的切片留白(Dicing Street)的寬度。在以往的 DBG(Dicing Before Grinding)工藝中,切片留白的寬度為 60um。此次使用 SDBG 工藝后,切片留白的寬度為 15um,寬度縮短了四分之一。芯片的面積越小,寬度的縮短越對提高芯片良率有益。
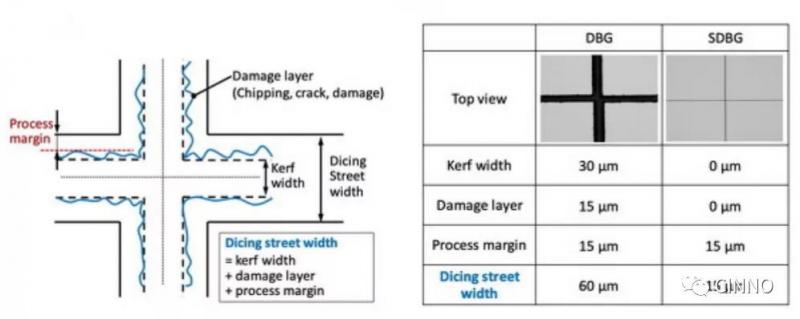
切片留白(Dicing Street)的寬度,左側(cè)為概略圖,右側(cè)為 DBG 和 SDBG 的比較圖 (圖片出自:東京工業(yè)大學(xué))

將留白寬度從 60um 縮短至 15um 后的芯片數(shù)量增長率(圖片出自:東京工業(yè)大學(xué))
未來,針對此次研發(fā)的 Damage Less Dicing(晶圓無損切割)技術(shù)的實用化,此研究小組的目標(biāo)是盡快制造出波長為 1099nm 的激光專用光學(xué)引擎。

