針對5G 通訊毫米波(mm-Wave)開發(fā)趨勢,AiP(Antenna in Package)封裝技術將成為實現(xiàn)手機終端裝置的發(fā)展關鍵。隨著 Qualcomm 于 2018 年 7 月推出的 AiP 模組(QTM052 及 525)陸續(xù)問世后,各家廠商對此無不摩拳擦掌,爭相投入相關模組的技術研制上;其中半導體制造龍頭臺積電及封測大廠日月光投控,對此最為積極。
日月光投控對于 AiP 封裝技術之演進,憑借日月光及矽品對于相關封裝的長期研發(fā),以及旗下環(huán)旭電子增設天線測試實驗室的積極投入態(tài)度,為此將進一步擴充 5G 毫米波之發(fā)展進程。
Qualcomm 推出 AiP 模組后,制造龍頭臺積電與封測大廠日月光等皆已躍躍欲試
面對 5G 通訊毫米波逐步發(fā)展之際,加上 Qualcomm 已推出的 AiP 模組產(chǎn)品,各家 IDM 廠、Fabless 廠、制造及封測代工廠商,對此無不躍躍欲試,試圖加速開發(fā)相關產(chǎn)品,從而應付為數(shù)龐大的射頻前端市場及 5G 應用商機。
為了實現(xiàn) AiP 封裝制造技術,現(xiàn)行除了已開發(fā)出 InFO-AiP 封裝技術的半導體制造龍頭臺積電外,其他封測廠商(如日月光、Amkor、江蘇長電及矽品等)也有相應的布局動作,并采取默默耕耘的發(fā)展態(tài)勢,以求提供后續(xù) 5G 通訊毫米波之市場需要。
其中,若以日月光及矽品發(fā)展動態(tài)為例,現(xiàn)階段 AiP 封裝技術主要采用 RFIC 于底層的設計架構(gòu),相較于臺積電在內(nèi)層及其他廠商于上層之結(jié)構(gòu),整體于制作成本上,相較其他產(chǎn)品將更具吸引力。
日月光與臺積電于 AiP 封裝技術差異,使產(chǎn)品特性及成本已成為選擇難題
針對現(xiàn)行 AiP 封裝技術,進一步比較于臺積電內(nèi)層式之 InFO-AiP 構(gòu)造,以及日月光與矽品于底層式的 AiP 結(jié)構(gòu)差異,可發(fā)現(xiàn) RFIC 的擺放位置,將是決定模組產(chǎn)品之性能表現(xiàn)(天線訊號損耗、散熱機制)及成本高低(制造良率及難易度)的重要指標。
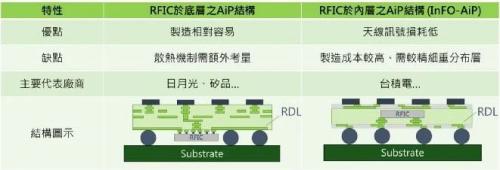
圖:RFIC 于不同位置之 AiP 結(jié)構(gòu)比較表,Source:拓墣產(chǎn)業(yè)研究院整理
其中,以日月光與矽品開發(fā)之 AiP 封裝架構(gòu)為探討主題時,當 RFIC 放置于底層結(jié)構(gòu)中,此結(jié)構(gòu)確實能有效降低封裝成本,并且對于開發(fā)流程上也十分有利;由于封測廠商于相關制作流程中,可獨立開發(fā)重分布層(RDL),并搭配上單獨封裝好的 RFIC,最后再將二者結(jié)合于一體,以完成 AiP 所需的架構(gòu)。
如此之設計理念,對于管控封裝成本而言,已起到節(jié)省工序作用;然而卻也衍生出另一個難題,“如何將底層的 RFIC 在運作時產(chǎn)生之熱源有效導引出來”,這將是后續(xù)亟需克服的關鍵要務之一。
另一方面,臺積電開發(fā)的 InFO-AiP 封裝技術,由于運用本身擅長的線寬微縮技術,當 RFIC 于元件制造完成后,隨之進行一系列的后段封裝程序;也在此時延伸原有的通訊元件金屬線路,將使重分布層得以連結(jié) RFIC 并導引至天線端,從而達到降低天線端訊號衰弱之效果。
整體而言,雖然日月光及矽品的 AiP 結(jié)構(gòu)可有效降低成本,但散熱機制仍需額外考量,且臺積電的 InFO-AiP 能成功增進產(chǎn)品效能,然而整體封測制造成本卻依舊偏高。
由此可見,AiP 封裝技術于產(chǎn)品特性及成本表現(xiàn)之因素中,已成為一項選擇難題,考驗未來客戶在產(chǎn)品設計及應用需求上應該如何取舍。

