前言
長(zhǎng)久以來(lái)顯示應(yīng)用一直是LED發(fā)光組件主要訴求,并不要求LED高散熱性,因此LED大多直接封裝于傳統(tǒng)樹(shù)脂系基板,然而2000年以后隨著LED高輝度化與高效率化發(fā)展,尤其是藍(lán)光LED組件的發(fā)光效率獲得大幅改善,液晶、家電、汽車等業(yè)者也開(kāi)始積極檢討LED的適用性。
在此同時(shí)數(shù)字家電與平面顯示器急速普及化,加上LED單體成本持續(xù)下降,使得LED的應(yīng)用范圍,以及有意愿采用LED的產(chǎn)業(yè)范圍不斷擴(kuò)大,其中又以液晶面板廠商面臨歐盟頒布的危害性物質(zhì)限制指導(dǎo)(RoHS: Restriction of Hazardous Substances Directive)規(guī)范,因此陸續(xù)提出未來(lái)必需將水銀系冷陰極燈管(CCFL:Cold Cathode Fluor-escent Lamp)全面無(wú)水銀化的發(fā)展方針,其結(jié)果造成高功率LED的需求更加急迫。
技術(shù)上高功率LED封裝后的商品,使用時(shí)散熱對(duì)策成為非常棘手問(wèn)題,在此背景下具備高成本效益,類似金屬系基板等高散熱封裝基板的發(fā)展動(dòng)向,成為L(zhǎng)ED高效率化之后另一個(gè)備受囑目的焦點(diǎn)。
接著本文要介紹LED封裝用金屬系基板的發(fā)展動(dòng)向,與陶瓷系封裝基板的散熱設(shè)計(jì)技術(shù)。
發(fā)展歷程
圖1是有關(guān)LED的應(yīng)用領(lǐng)域發(fā)展變遷預(yù)測(cè),如圖2所示使用高功率LED時(shí),LED產(chǎn)生的熱量透過(guò)封裝基板與冷卻風(fēng)扇排放至空氣中。
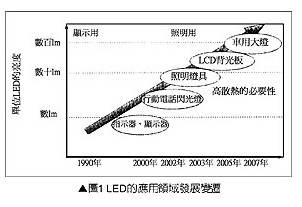
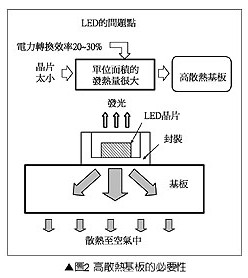
以往LED的輸出功率較小,可以使用傳統(tǒng)FR4等玻璃環(huán)氧樹(shù)脂封裝基板,然而照明用高功率LED的發(fā)光效率只有20~30% ,而且芯片面積非常小,雖然整體消費(fèi)電力非常低,不過(guò)單位面積的發(fā)熱量卻很大。
如上所述汽車、照明與一般民生業(yè)者已經(jīng)開(kāi)始積極檢討LED的適用性(圖3),一般民生業(yè)者對(duì)高功率LED期待的特性分別是省電、高輝度、長(zhǎng)使用壽命、高色再現(xiàn)性,這意味著高散熱性是高功率LED封裝基板不可欠缺的條件。

一般樹(shù)脂基板的散熱極限只支持0.5W以下的LED,超過(guò)0.5W以上的LED封裝大多改用金屬系與陶瓷系高散熱基板,主要原因是基板的散熱性對(duì)LED的壽命與性能有直接影響,因此封裝基板成為設(shè)計(jì)高輝度LED商品應(yīng)用時(shí)非常重要的組件。
金屬系高散熱基板又分成硬質(zhì)(rigid)與可撓曲(flexible)系基板兩種(圖4) ,硬質(zhì)系基板屬于傳統(tǒng)金屬基板,金屬基材的厚度通常大于1mm,硬質(zhì)系基板廣泛應(yīng)用在LED燈具模塊與照明模塊,技術(shù)上它是與鋁質(zhì)基板同等級(jí)高熱傳導(dǎo)化的延伸,未來(lái)可望應(yīng)用在高功率LED的封裝。
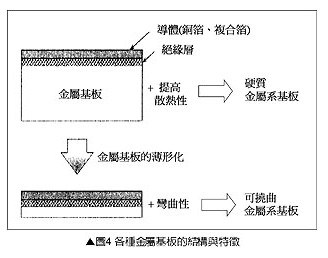
可撓曲系基板的出現(xiàn)是為了滿足汽車導(dǎo)航儀等中型LCD背光模塊薄形化,以及高功率LED三次元封裝要求的前提下,透過(guò)鋁質(zhì)基板薄板化賦予封裝基板可撓曲特性,進(jìn)而形成同時(shí)兼具高熱傳導(dǎo)性與可撓曲特性的高功率LED封裝基板。
硬質(zhì)系基板的特性
圖5是硬質(zhì)金屬系封裝基板的基本結(jié)構(gòu),它是利用傳統(tǒng)樹(shù)脂基板或是陶瓷基板,賦予高熱傳導(dǎo)性、加工性、電磁波遮蔽性、耐熱沖擊性等金屬特性,構(gòu)成新世代高功率LED封裝基板。
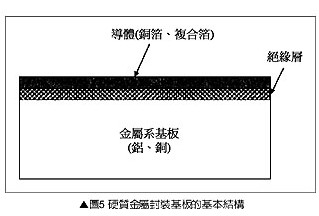
如圖所示它是利用環(huán)氧樹(shù)脂系接著劑將銅箔黏貼在金屬基材的表面,透過(guò)金屬基材與絕緣層材質(zhì)的組合變化,可以制成各種用途的LED封裝基板。
高散熱性是高功率LED封裝用基板不可或缺的基本特性,因此上述金屬系LED封裝基板使用為鋁與銅等材料,絕緣層大多使用充填高熱傳導(dǎo)性無(wú)機(jī)填充物(Filler)的填充物環(huán)氧樹(shù)脂。
鋁質(zhì)基板是應(yīng)用鋁的高熱傳導(dǎo)性與輕量化特性制成高密度封裝基板,目前已經(jīng)應(yīng)用在冷氣空調(diào)的轉(zhuǎn)換器(Inverter)、通訊設(shè)備的電源基板等領(lǐng)域,鋁質(zhì)基板同樣適用于高功率LED的封裝。
圖6是各種金屬系封裝基板的特性比較,一般而言金屬封裝基板的等價(jià)熱傳導(dǎo)率標(biāo)準(zhǔn)大約是2W/m?K,為滿足客戶4~6W/m?K高功率化的需要,業(yè)者已經(jīng)推出等價(jià)熱傳導(dǎo)率超過(guò)8W/m?K的金屬系封裝基板。

由于硬質(zhì)金屬系封裝基板主要目的是支持高功率LED的封裝,因此各封裝基板廠商正積極開(kāi)發(fā)可以提高熱傳導(dǎo)率的技術(shù)。
硬質(zhì)金屬系封裝基板的主要特征是高散熱性。圖7與圖8是仿真分析LED芯片發(fā)熱量為1W時(shí),2W/m ?K一般封裝基板與8W/m?K超高熱傳導(dǎo)封裝基板正常使用狀態(tài)下的溫度分布特性。
由圖8可知使用高熱傳導(dǎo)性絕緣層封裝基板,可以大幅降低LED芯片的溫度。此外基板的散熱設(shè)計(jì),透過(guò)散熱膜片與封裝基板的組合,還可望延長(zhǎng)LED芯片的使用壽命。
金屬系封裝基板的缺點(diǎn)是基材的金屬熱膨脹系數(shù)非常大,類似低熱膨脹系數(shù)陶瓷系芯片組件焊接時(shí),容易受到熱循環(huán)沖擊,如果高功率LED的封裝使用氮化鋁時(shí),金屬系封裝基板可能會(huì)發(fā)生不協(xié)調(diào)問(wèn)題,因此必需設(shè)法吸收LED模塊的各材料熱膨脹系數(shù)差異造成的熱應(yīng)力,藉此緩和熱應(yīng)力提高封裝基板的可靠性。
可撓曲系基板的特性
可撓曲基板的主要用途大多集中在布線用基板,以往高功率晶體管與IC等高發(fā)熱組件幾乎不使用可撓曲基板,最近幾年液晶顯示器為滿足高輝度化需求,強(qiáng)烈要求可撓曲基板可以高密度設(shè)置高功率LED,然而LED的發(fā)熱造成LED使用壽命降低,卻成為非常棘手的技術(shù)課題,雖然利用鋁板質(zhì)補(bǔ)強(qiáng)板可以提高散熱性,不過(guò)卻有成本與組裝性的限制,無(wú)法根本解決問(wèn)題。
圖9是高熱傳導(dǎo)撓曲基板的斷面結(jié)構(gòu),它是在絕緣層黏貼金屬箔,雖然基本結(jié)構(gòu)則與傳統(tǒng)撓曲基板完全相同,不過(guò)絕緣層采用軟質(zhì)環(huán)氧樹(shù)脂充填高熱傳導(dǎo)性無(wú)機(jī)填充物的材料,具有與硬質(zhì)金屬系封裝基板同等級(jí)8W/m?K的熱傳導(dǎo)性,同時(shí)還兼具柔軟可撓曲、高熱傳導(dǎo)特性與高可靠性(表1),此外可撓曲基板還可以依照客戶需求,將單面單層面板設(shè)計(jì)成單面雙層、雙面雙層結(jié)構(gòu)。

高熱傳導(dǎo)撓曲基板的主要特征是可以設(shè)置高發(fā)熱組件,并作三次元組裝,亦即它可以發(fā)揮自由彎曲特性,進(jìn)而獲得高組裝空間利用率。
圖10是高熱傳導(dǎo)撓曲基板與傳統(tǒng)聚亞酰胺(Polyi-mide)撓曲基板,設(shè)置1W高功率LED時(shí)的散熱實(shí)驗(yàn)結(jié)果,聚亞酰胺基板的厚度為25μm,基板的散熱采用自然對(duì)流方式。

根據(jù)實(shí)驗(yàn)結(jié)果顯示使用高熱傳導(dǎo)撓曲基板時(shí),LED的溫度大約降低100℃,這意味著溫度造成LED使用壽命降低的問(wèn)題可望獲得改善。
事實(shí)上除了高功率LED之外,高熱傳導(dǎo)撓曲基板還可以設(shè)置其它高功率半導(dǎo)體組件,適用于局促空間或是高密度封裝等要求高散熱等領(lǐng)域。
有關(guān)類似照明用LED模塊的散熱特性,單靠封裝基板往往無(wú)法滿足實(shí)際需求,因此基板周邊材料的配合變得非常重要,例如圖11的端緣發(fā)光型LED背光模塊的新結(jié)構(gòu),配合~3W/m?K的熱傳導(dǎo)性膜片,可以有效提高LED模塊的散熱性與LED模塊的組裝作業(yè)性。
陶瓷系封裝基板
如上所述白光LED的發(fā)熱隨著投入電力強(qiáng)度的增加持續(xù)上升,LED芯片的溫升會(huì)造成光輸出降低,因此LED的封裝結(jié)構(gòu)與使用材料的檢討非常重要。
以往LED使用低熱傳導(dǎo)率樹(shù)脂封裝,被視為是影響散熱特性的原因之一,因此最近幾年逐漸改用高熱傳導(dǎo)陶瓷,或是設(shè)有金屬板的樹(shù)脂封裝結(jié)構(gòu)。LED芯片高功率化常用手法分別是:
●LED芯片大型化
●改善LED芯片的發(fā)光效率
●采用高取光效率的封裝
●大電流化
雖然提高電流發(fā)光量會(huì)呈比例增加,不過(guò)LED芯片的發(fā)熱量也會(huì)隨著上升。圖12是LED投入電流與放射照度量測(cè)結(jié)果,由圖可知在高輸入領(lǐng)域放射照度呈現(xiàn)飽和與衰減現(xiàn)象,這種現(xiàn)象主要是LED芯片發(fā)熱所造成,因此LED芯片高功率化時(shí)首先必需解決散熱問(wèn)題。
LED的封裝除了保護(hù)內(nèi)部LED芯片之外,還兼具LED芯片與外部作電氣連接、散熱等功能。
LED的封裝要求LED芯片產(chǎn)生的光線可以高效率取至外部,因此封裝必需具備高強(qiáng)度、高絕緣性、高熱傳導(dǎo)性與高反射性,令人感到意外的是陶瓷幾乎網(wǎng)羅上述所有特性。
表2是陶瓷的主要材料物性一覽,除此之外陶瓷耐熱性與耐光線劣化性也比樹(shù)脂優(yōu)秀。

傳統(tǒng)高散熱封裝是將LED芯片設(shè)置在金屬基板上周圍再包覆樹(shù)脂,然而這種封裝方式的金屬熱膨脹系數(shù)與LED芯片差異非常大,當(dāng)溫度變化非常大或是封裝作業(yè)不當(dāng)時(shí)極易產(chǎn)生熱歪斜(thermal strain;熱剪應(yīng)力),進(jìn)而引發(fā)芯片瑕疵或是發(fā)光效率降低。
未來(lái)LED芯片面臨大型化發(fā)展時(shí),熱歪斜問(wèn)題勢(shì)必變成無(wú)法忽視的困擾,有關(guān)這點(diǎn)具備接近LED芯片的熱膨脹系數(shù)的陶瓷,可說(shuō)是熱歪斜對(duì)策非常有利的材料。
圖13是高功率LED陶瓷封裝的外觀;圖14是高功率LED陶瓷封裝的基本結(jié)構(gòu),圖14(b)的反射罩電鍍銀膜。它可以提高光照射率,圖14(c)的陶瓷反射罩則與陶瓷基板呈一體結(jié)構(gòu)。
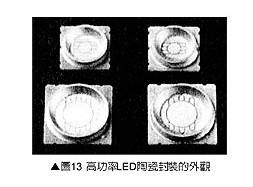

散熱設(shè)計(jì)
圖15表示LED內(nèi)部理想性熱流擴(kuò)散模式,圖15右圖的實(shí)線表示封裝內(nèi)部P~Q之間高熱流擴(kuò)散分布非常平坦,由于熱流擴(kuò)散至封裝整體均勻流至封裝基板,其結(jié)果使得LED芯片正下方的溫度大幅降低。

圖16是以封裝材的熱傳導(dǎo)率表示熱擴(kuò)散性的差異,亦即圖15表示正常狀態(tài)時(shí)的溫度分布,與單位面積單位時(shí)間流動(dòng)的熱流束分布特性。
使用高熱傳導(dǎo)材時(shí),封裝內(nèi)部的溫差會(huì)變小,此時(shí)熱流不會(huì)呈局部性集中,LED芯片整體產(chǎn)生的熱流呈放射狀流至封裝內(nèi)部各角落,換言之高熱傳導(dǎo)材料可以提高LED封裝內(nèi)部的熱擴(kuò)散性。
LED封裝用陶瓷材料分成氧化鋁與氮化鋁,氧化鋁的熱傳導(dǎo)率是環(huán)氧樹(shù)脂的55倍,氮化鋁則是環(huán)氧樹(shù)脂的55倍400倍,因此目前高功率LED封裝用基板大多使用熱傳導(dǎo)率為200W/mK的鋁質(zhì),或是熱傳導(dǎo)率為400W/mK的銅質(zhì)金屬封裝基板。
半導(dǎo)體IC芯片的接合劑分別使用環(huán)氧系接合劑、玻璃、焊錫、金共晶合金等材料。LED芯片用接合劑除了上述高熱傳導(dǎo)性之外,基于接合時(shí)降低熱應(yīng)力等觀點(diǎn),還要求低溫接合與低楊氏系數(shù)等等,符合這些條件的接合劑分別是環(huán)氧系接合劑充填銀的環(huán)氧樹(shù)脂,與金共晶合金系的Au-20%Sn。
接合劑的包覆面積與LED芯片的面積幾乎相同,因此無(wú)法期待水平方向的熱擴(kuò)散,只能寄望于垂直方向的高熱傳導(dǎo)性。
圖17是熱傳導(dǎo)差異對(duì)封裝內(nèi)部的溫度分布,與熱流束特性的模擬分析結(jié)果,封裝基板使用氮化鋁。根據(jù)仿真分析結(jié)果顯示LED接合部的溫差,熱傳導(dǎo)性非常優(yōu)秀的Au-Sn比低散熱性銀充填環(huán)氧樹(shù)脂接合劑更優(yōu)秀。

有關(guān)LED封裝基板的散熱設(shè)計(jì),大致分成:
●LED芯片至框體的熱傳導(dǎo)
●框體至外部的熱傳達(dá)
兩大部位。熱傳導(dǎo)的改善幾乎完全仰賴材料的進(jìn)化,一般認(rèn)為隨著LED芯片大型化、大電流化、高功率化的發(fā)展,未來(lái)會(huì)加速金屬與陶瓷封裝取代傳統(tǒng)樹(shù)脂封裝方式 。此外LED芯片接合部是妨害散熱的原因之一,因此薄接合技術(shù)成為今后改善的課題。
提高LED高熱排放至外部的熱傳達(dá)特性,以往大多使用冷卻風(fēng)扇與熱交換器,由于噪音與設(shè)置空間等諸多限制,實(shí)際上包含消費(fèi)者、下游系統(tǒng)應(yīng)用廠商在內(nèi),都不希望使用強(qiáng)制性散熱組件,這意味著非強(qiáng)制散熱設(shè)計(jì)必需大幅增加框體與外部接觸的面積,同時(shí)提高封裝基板與框體的散熱性。
具體對(duì)策例如高熱傳導(dǎo)銅層表面涂布“利用遠(yuǎn)紅外線促進(jìn)熱放射的撓曲散熱薄膜”等等,根據(jù)實(shí)驗(yàn)結(jié)果證實(shí)使用該撓曲散熱薄膜的發(fā)熱體散熱效果,幾乎與面積接近散熱薄膜的冷卻風(fēng)扇相同,如果將撓曲散熱薄膜黏貼在封裝基板、框體,或是將涂抹層直接涂布在封裝基板、框體,理論上還可以提高散熱性。
有關(guān)高功率LED的封裝結(jié)構(gòu),要求能夠支持LED芯片磊晶接合的微細(xì)布線技術(shù);有關(guān)材質(zhì)的發(fā)展,雖然氮化鋁已經(jīng)高熱傳導(dǎo)化,不過(guò)高熱傳導(dǎo)與反射率的互動(dòng)關(guān)系卻成為另一個(gè)棘手問(wèn)題,一般認(rèn)為未來(lái)若能提高熱傳導(dǎo)率低于氮化鋁的氧化鋁的反射率,對(duì)高功率LED的封裝材料具有正面幫助。
結(jié)語(yǔ)
以上介紹LED封裝用金屬系基板的發(fā)展動(dòng)向,與陶瓷系封裝基板的散熱設(shè)計(jì)技術(shù)。隨著LED大型化、大電流化、高功率化的發(fā)展,事實(shí)上單靠封裝基板單體并無(wú)法達(dá)成預(yù)期的散熱效,必需配合封裝基板周邊的散熱材料,以及LED封裝結(jié)構(gòu)才能進(jìn)行有效的散熱。因此未來(lái)必需持續(xù)開(kāi)發(fā)周邊相關(guān)技術(shù),LED才能夠?qū)崿F(xiàn)次世代光源的終極目標(biāo)。

